倒裝芯片工藝是指通過在芯片的I/0 焊盤上直接沉積,或者通過 RDL 布線后沉積凸塊(包括錫鉛球、無鉛錫球、銅桂凸點及金凸點等),然后將芯片翻轉,進行加熱,使熔融的焊料與基板或框架相結合,將芯片的 I/0 扇出成所需求的封裝過程。倒裝芯片封裝產品示意圖如圖所示。
2023-04-28 09:51:34 3701
3701 
從事半導體行業,尤其是半導體封裝行業的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術。
2023-07-21 10:08:08 3128
3128 
芯片封裝作為設計和制造電子產品開發過程中的關鍵技術之一日益受到半導體行業的關注和重視。本片講述了芯片封裝及底部填充(Underfill)技術。
2023-12-19 15:56:04 3189
3189 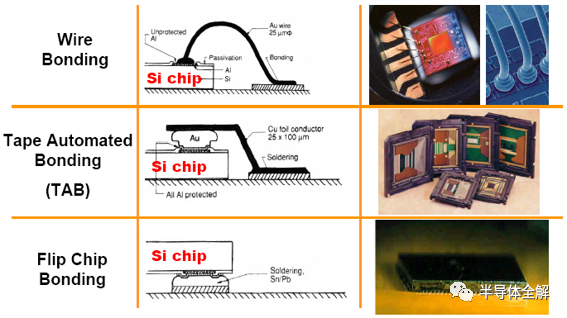
SMT工藝介紹 SMT工藝名詞術語 1、表面貼裝組件(SMA)(surface mount assemblys) 采用表面貼裝技術完成裝聯的印制板組裝件。2、 回流焊(reflow
2016-05-24 14:33:05
<br/>? 九. 檢驗工藝<br/>? 十. SMT生產中的靜電防護技術<br/><
2008-09-12 12:43:03
SMT定義及技術簡介什么是SMT: SMT就是表面組裝技術(SurfaceMountedTechnology的縮寫),是目前電子組裝行業里最流行的一種技術和工藝。 SMT有何特點
2010-03-09 16:20:06
帶來了一定的困難,這已成為當前研究下填充技術的兩個重要方向。除上述的下填充技術以外,芯片上“重新布線層”的制備以及與現有SMT設備的兼容問題是影響FC推廣應用的兩個關鍵。3焊料凸點倒裝芯片工藝典型的焊料
2018-11-26 16:13:59
); (6)下填充。 4.倒裝芯片焊接的關鍵技術 芯片上制作凸點和芯片倒裝焊工藝是推廣倒裝芯片焊接的技術關鍵。 (1)凸點制作 凸點制作工藝很多,如蒸發/濺射法、焊膏印刷-回流法、化鍍法、電鍍法
2020-07-06 17:53:32
的5倍;4、沒有SMT工藝,沒有虛焊隱患,產品可靠性更強;5、散熱能力更快,熱量直接通過PCB板散出,沒有堆積;說起倒裝cob,肯定也會有正裝COB,正裝和倒裝相比,可以簡單理解為倒裝技術可以實現更小
2020-05-28 17:33:22
儀( SEM/EDX),檢查焊點的微觀結構,譬如,微裂紋/微孔、錫結晶、金屬間化合物(IMC)、焊接及潤濕情況,底部 填充是否有空洞和裂紋,分層和流動是否完整等。 完成回流焊接及底部填充工藝后的產品
2018-09-06 16:40:06
“毛 細管效應”進行底部填充的工藝分為以下幾個步驟: ·基板預熱; ·分配填料(點膠): ·毛細流動; ·加熱使填料固化。 為什么倒裝晶片焊接完后都需要進行底部填充呢?我們來看焊接完成之后組件
2018-09-06 16:40:41
為1~27 mm; ④組裝在基板后需要做底部填充。 其實倒裝晶片之所以被稱為“倒裝”是相對于傳統的金屬線鍵合連接方式(WireBonding)與植球后的工藝而言 的。傳統的通過金屬線鍵合與基板連接
2018-11-22 11:01:58
完成后,需要在元件底部和基板之間填充一種膠(一般為 環氧樹脂材料)。底部填充分為基于“毛細流動原理”的流動性和非流動性(No-follow)底部填充。 上述倒裝晶片組裝工藝是針對C4元件(元件焊凸材料為
2018-11-23 16:00:22
助焊劑工藝在倒裝晶片裝配工藝中非常重要。助焊劑不僅要在焊接過程中提供其化學性能以驅除氧化物和油污 ,潤濕焊接面,提高可焊性,同時需要起到黏接劑的作用。在元件貼裝過程中和回流焊接之前黏住元件,使其
2018-11-23 15:44:25
/O引出端分布于整個芯片表面,故在封裝密度和處理速度上Flip chip已達到頂峰,特別是它可以采用類似SMT技術的手段來加工,因此是芯片封裝技術及高密度安裝的最終方向。 倒裝片連接有三種主要類型C4
2018-09-11 15:20:04
、PCB及元器件的設計、工藝的控制和優化等方面提供參考。 為了提高產品的可靠性,可以考慮進行底部填充工藝。對于兩層堆疊,可以對上層元件進行底部填充,也可以兩層元件都進行填充。如果上下層元件外形尺寸一樣
2018-09-06 16:24:30
助焊劑或錫膏,如果需要底部填充工藝 的話,必須考慮助焊劑/錫膏與阻焊膜及底部填充材料的兼容性問題。 頂部元件浸蘸助焊劑還是錫膏,會有不同的考慮。錫膏裝配的優點是:①可以一定程度地補償元件及基板 的翹
2018-09-06 16:24:34
目前有兩種典型的工藝流程,一種是考慮與其他元件的SMT配,首先是錫膏印刷,然后貼裝CSP,回流焊接,最后如果要求底部填充,還需進行底部填充工藝,如圖1所示。為了避免“橋連”或“少錫”缺陷,在組裝
2018-09-06 16:24:04
的是底部填充方法——局部填充,可以應用在CSP或BGA的裝配中。局部填充是將底部填充材料以 點膠或印刷的方式沉積在基板上位于元件的4個角落處或四周(如圖2和圖3所示)。相比毛細流動或非流動 性底部填充
2018-09-06 16:40:03
的熱硬化黏膠、第二個方法使用導電黏膠和絕緣的底部填充膠。每一個測試組件都由測試電路載板和仿真芯片(dummychip)所組成。管腳陣列封裝的載板也被設計在同一片聚亞酰胺載板上,以便于未來用于測試神經訊號
2018-09-11 16:05:39
多數返修工藝的開發都會考慮盡量減少對操作員的依賴以提高可靠性。但是對經過底部填充的CSP的移除 ,僅僅用真空吸嘴不能將元件移除。經過加熱軟化的底部填充材料對元件具有黏著力,此力遠大于熔融的焊 料
2018-09-06 16:40:01
隨著新型基底材料的出現,倒裝芯片技術面臨著新的挑戰,工程師們必須解決裸片
2006-04-16 21:05:16 2035
2035 倒裝芯片工藝挑戰SMT組裝原作者:不詳 1
2006-04-16 21:37:59 1467
1467 倒裝芯片的成功實現與使用包含諸多設計、工藝、設備與材料因素。只有對每一個因素都加以認真考慮和對待才能夠促進工藝和技術的不斷完善和進步,才能滿足應用領域對倒裝芯片技
2011-07-05 11:56:17 1673
1673 過來,故稱其為倒裝晶片。 倒裝芯片的實質是在傳統工藝的基礎上,將芯片的發光區與電極區不設計在同一個平面這時則由電極區面朝向燈杯底部進行貼裝,可以省掉焊線這一工序,但是對固晶這段工藝的精度要求較高,一般很難達到較高的良率。 倒裝晶片
2017-10-24 10:12:25 8
8 在手機的實際制造過程中,往往會加入BGA底部填充膠工藝,這是為了防止在運輸及日常使用中造成BGA芯片焊點開裂甚至損壞,但是這也制約了芯片元件維修的進度,容易因加熱正面造成反面元件空焊,引起新的不良
2018-10-29 08:37:00 5483
5483 倒裝芯片技術分多種工藝方法,每一種都有許多變化和不同應用。舉例來說,根據產品技術所要求的印制板或基板的類型 - 有機的、陶瓷的或柔性的- 決定了組裝材料的選擇(如凸點類型、焊料、底部填充材料),并在
2019-05-31 10:16:45 5985
5985 
正裝小芯片采取在直插式支架反射杯內點上絕緣導熱膠來固定芯片,而倒裝芯片多采用導熱系數更高的銀膠或共晶的工藝與支架基座相連,且本身支架基座通常為導熱系數較高的銅材.
2019-10-22 14:28:34 27507
27507 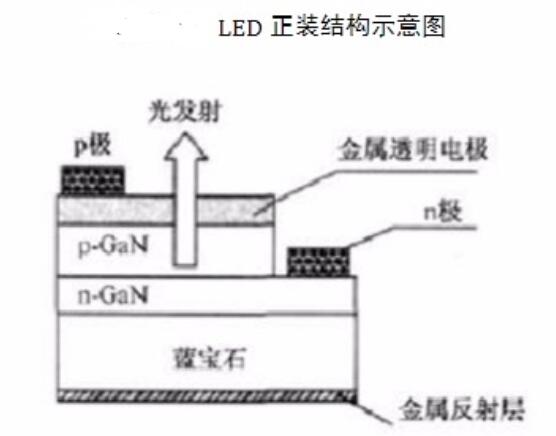
填充點膠加工具有如下優點: PCB板芯片底部填充點膠加工主要用于PCB板的CSP/BGA的底部填充,點膠工藝操作性好,點膠加工后易維修,抗沖擊性能,抗跌落性能,抗振性能都比較好,在一定程度上提高了電子產品的穩定性與可靠性。 PCB板芯片底部填充點膠加工
2020-07-28 10:14:50 6716
6716 倒裝芯片FC、晶圓級CSP、晶圓級封裝WLP主要應用在新一代手機、DVD、PDA、模塊等。 一、倒裝芯片FC 倒裝芯片定義為可能不進行再分布的晶圓。通常,錫球小于150um,球間距小于350um
2020-09-28 14:31:30 5721
5721 隨著電子設備更小、更薄、功能更集成的發展趨勢,半導體芯片封裝的技術發展起到越來越關鍵的作用,而談到高性能半導體封裝,小編覺得很多smt貼片廠商想到的就是引線鍵合技術。 的確如此。不久之前,大多數
2021-03-30 16:14:07 3913
3913 什么是底部填充膠?底部填充膠簡單來說就是底部填充用的膠水,主要是以主要成份為環氧樹脂的膠水對BGA 封裝模式的芯片進行底部填充,利用加熱的固化形式,將BGA芯片底部空隙大面積 (一般覆蓋80%以上)填滿,從而達到加固芯片的目的,進而增強芯片和PCBA 之間的抗跌落性能。
2021-07-19 09:30:50 7986
7986 氣泡一般是因為水蒸汽而導致,水蒸氣產生的原因有SMT(電子電路表面組裝技術)數小時后會有水蒸氣附在PCB板(印制電路板)上,或膠粘劑沒有充分回溫也有可能造成此現象。常見的解決方法是將電路板加熱到一定溫度,讓電路板預熱后再采用三軸點膠機進行底部填充點膠加工;以及使用膠粘劑之前將膠粘劑充分回溫。
2021-07-20 16:08:52 3366
3366 Flip-Chip BGA (FC-BGA)是指將芯片利用倒裝(FC)技術焊接在線路基板上,并制成倒裝芯片 BGA 封裝形式。
2023-04-28 15:09:13 4514
4514 
基本的倒裝芯片工藝在電路制造之后開始,此時在芯片表面創建金屬焊盤以連接到 I/O。接下來是晶圓凸塊,將焊球沉積在每個焊盤上。然后晶圓被切割,這些芯片被翻轉和定位,使焊球與基板焊盤對齊。然后焊球被熔化/回流,通常使用熱空氣,并且安裝的芯片底部填充有電絕緣粘合劑,通常使用毛細管作用。
2023-05-22 16:13:55 650
650 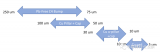
摘要:通過對導熱絕緣膠本征性能、組成配方、印制板組件實際空間位置關系和主要球柵陣列(BGA)器件封裝結構的特點進行分析,設計制作工藝試驗件,進行了導熱絕緣膠填充模型理論研究,探究了黏度、預熱溫度
2022-10-25 09:58:49 620
620 
手機電池保護板MOS管用底部填充膠和表面覆蓋方案由漢思新材料提供1、點膠示意圖2、應用場景某米手機、電池3、用膠需求手機電池保護板MOS管底部填充和表面覆蓋方案MOS管左邊有測試點,右邊有二維碼
2022-11-17 14:36:31 556
556 
平板電腦主板芯片BGA錫球底部填充加固用膠方案由漢思新材料提供01.點膠示意圖02.應用場景平板電腦03.用膠需求主芯片BGA錫球底部填充加固04.客戶難點終端客戶使用3-6個月反饋有15%的功能
2022-11-25 16:43:53 628
628 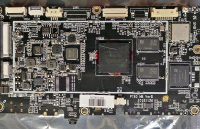
軍工產品PCB板芯片元器件圍壩填充加固防振用底部填充膠方案由漢思新材料提供客戶是一家主要電路板的生產,電子產品表面組裝技術加工、組裝,電子電器產品、新能源產品、汽車材料及零件。主要應用于軍工產品
2023-02-16 05:00:00 634
634 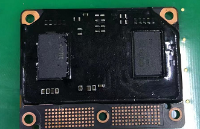
漢思新材料芯片封裝膠underfill底部填充膠點膠工藝基本操作流程一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在容易在填充后有小氣泡產生,在最后的固化環節,氣泡
2023-02-15 05:00:00 1335
1335 
智能家居智能門鎖芯片底部填充膠和外殼結構粘接方案由漢思新材料提供01.點膠示意圖02.應用場景智能門鎖/兒童早教機器人/語音精靈03.用膠需求芯片底部填充和外殼結構粘接方案要求芯片填充(錫球的填充
2023-02-24 05:00:00 533
533 
漢思新材料研發生產半導體(Flipchip)倒裝芯片封裝用底部填充材料為了解決一些與更薄的倒裝芯片封裝相關的問題,漢思化學研發了一種底部填充材料,作用在于通過控制芯片和基板的翹曲來降低封裝產品的應力
2023-03-01 05:00:00 536
536 
、CSP、Flipchip(倒裝芯片)封裝、QFP封裝、QFN封裝得到快速應用,封裝工藝要求越來越高,底部填充膠的作用越來越重要。底部填充膠是一種單組份環氧樹脂密
2023-03-10 16:10:57 466
466 
音視頻設備控制板BGA芯片底部填充膠漢思底填膠應用
2023-03-13 17:32:00 439
439 
WIFI模組控制板BGA芯片底部填充膠應用由漢思化學提供客戶是一家專業從事射頻通訊模組、無線互聯網系列模組應用的方案及產品解決方案的高新技術企業,產品有WIFI模組、GPS模組、藍牙模組
2023-03-14 05:00:00 608
608 
平板電腦觸控筆BGA芯片底部填充膠應用由漢思新材料提供客戶是生產電子設備、通信數據設備、通信產品、網絡通信設備、終端設備的廠家。其中終端設備用到我公司的底部填充膠水。客戶產品為平板電腦的觸控筆
2023-03-15 05:00:00 376
376 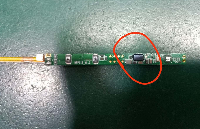
嵌入式模塊板卡BGA芯片膠底部填充膠應用由漢思新材料提供客戶產品為嵌入式模塊板卡客戶產品用膠點:嵌入式模塊板卡兩個BGA芯片要點膠加固。BGA芯片尺寸為:1.14*14mm、錫球289個,2.14
2023-03-16 05:00:00 512
512 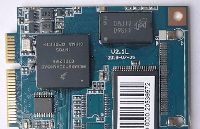
電腦優(u)盤SD卡BGA底部填充膠應用由漢思新材料提供客戶產品:電腦優盤SD卡用膠部位:3個用膠點(1、BGA底部填充2、晶元包封保護3、金線包封保護)芯片大小:參考圖片目的:粘接、固定施膠工藝
2023-03-22 05:30:00 471
471 
臺式電腦顯卡PCB上BGA芯片底部填充膠點膠應用由漢思新材料提供客戶產品:臺式電腦顯卡用膠部位:顯卡PCB電路板上BGA底部填充加固錫球數量:200左右錫球間距:0.35~0.45錫球高度:0.45
2023-03-28 15:20:45 740
740 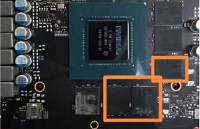
BGA芯片底部填充膠點膠工藝標準和選擇與評估由漢思新材料提供由于BGA芯片存在因應力集中而出現的可靠性質量隱患問題,為了使BGA封裝具備更高的機械可靠性,需對BGA進行底部填充,而正確選擇底部填充
2023-04-04 05:00:00 1847
1847 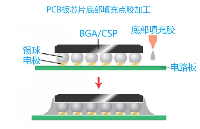
膠,對手機電池保護板芯片底部填充及封裝,提高手機電池芯片系統穩定性和可靠性。對手機電池保護板芯片底部填充及封裝,漢思新材料的低粘度的底部填充膠,可靠性高、流動性大、快
2023-04-06 16:42:16 785
785 
智能手勢化妝鏡手勢識別模組芯片底部填充膠應用案例由漢思新材料提供客戶是一家芯片設計方案公司,專注研發芯片十余年,擁有國內一流的專業技術團隊,為客戶提供優質的產品和解決方案.目前產品涵蓋:Sensor
2023-04-07 05:00:00 468
468 
音響控制板BGA芯片加固保護用膠底部填充膠應用由漢思新材料提供客戶是網絡產品生產商.重點為客戶提供OEM/ODM服務給各類客戶定制與公板近100款,部分產品已經在WIFI音箱/商業WIFI/探針
2023-04-11 05:00:00 473
473 
藍牙模組BGA芯片底部填充膠應用由漢思新材料提供客戶是專注于物聯網產品及服務,提供從模塊,設備,APP開發,云乃至大數據分析的整體解決方案及產品服務主要產品有藍牙模組,智能家居,智能硬件。其中藍牙
2023-04-12 16:30:33 369
369 
電子元件的很多問題,比如BGA、芯片不穩定,質量不老牢固等,這也是underfill底部填充工藝受到廣泛應用的原因之一。BGA和CSP是通過錫球固定在線路板上,存在熱
2023-04-14 15:04:16 1145
1145 
平板電腦主板CPUBGA芯片底部填充膠應用由漢思新材料提供客戶是一家方案公司,專注于數字音視頻、移動互聯產品的研究和開發主要產品有平板電腦,廣告機等。其中平板電腦用到我公司的底部填充膠產品.客戶產品
2023-04-18 05:00:00 484
484 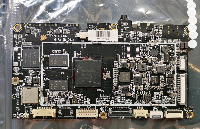
傳感器控制板BGA芯片防止脫焊用底部填充膠應用案例由漢思新材料提供客戶產品為:傳感器控制板用膠部位:傳感器控制板上面有個BGA芯片需要點膠芯片尺寸:25*25mm需要解決的問題:使用過程中
2023-04-19 15:26:25 483
483 
手機SIM卡和銀行卡芯片封裝和bga底部填充膠方案由漢思新材料提供涉及部件:手機SIM卡和銀行卡的CSP芯片封裝和周邊焊點保護工藝難點:客戶目前出現的問題在做三輪實驗時出現膠裂,在點膠時還有個難題
2023-04-25 09:33:08 946
946 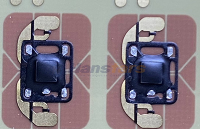
底部填充膠低粘度,流動性好,將膠水填充到芯片底部,確保芯片與PCB板粘接牢固,超聲波熔接后不良率為0,且超聲波熔接40次以上功能測試仍OK,遠超出客戶需求。
2023-04-25 16:44:32 517
517 
LED顯示屏用底部填充膠應用案例分析由漢思新材料提供客戶這個項目是:戶外大型的LED顯示屏項目用膠部位:單顆的LED燈珠之間的縫隙需要填充客戶項目是LED燈面點膠,具體要求如下:1.針頭
2023-05-08 16:22:45 713
713 
移動U盤主板bga芯片底部填充膠應用由漢思新材料提供客戶生產產品:移動U盤用膠部位:移動U盤主板芯片,需要點膠填充加固。BGA芯片尺寸:2個芯片:13*13*1.2mm,152個錫球需要
2023-05-09 16:23:12 525
525 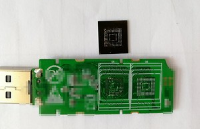
行車記錄儀主板芯片加固補強用底部填充膠由漢思新材料提供客戶生產產品:行車記錄儀主板。客戶產品用膠點:行車記錄儀主板上的BGA加固補強。目前客戶板上有4個IC需要加固。具體尺寸客戶待確認。換膠原
2023-05-15 14:45:20 630
630 
觸摸屏控制板BGA芯片底部填充膠應用由漢思新材料提供我公司工程人員有過去客戶拜訪,現場確認客戶產品及用膠需求如下:客戶產品是:開發一款觸摸屏電子控制板.客戶產品用膠部位:PCB板上面的BGA芯片需要
2023-05-16 05:00:00 480
480 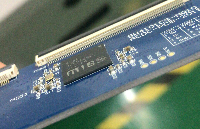
工業計算機電腦主板CPU,BGA芯片底部填充膠應用由漢思新材料提供經過聯系客戶技術工程人員和研究其提供相關參數。了解到以下信息。客戶產品是:工業計算機電腦主板膠水使用部位:cpu/BGA填充對膠水
2023-05-17 05:00:00 611
611 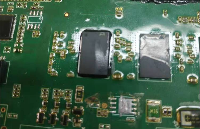
解決的問題是:攝像頭感光芯片底部填充加固,起到防震動的作用和攝像頭螺紋M12定焦固定.芯片尺寸:8*12mm錫球間距:0.35錫球球徑:0.5施膠工藝:半自動點膠固化方式:
2023-05-17 16:56:42 464
464 
光電傳感器WL-CSP封裝芯片底部填充膠應用由漢思新材料提供光電傳感器芯片(CCD)經過聯系客戶工程技術和研究其提供的封裝工藝流程。了解到以下信息。客戶用膠項目是:光電傳感器芯片(CCD
2023-05-18 05:00:00 546
546 
壓力傳感器BGA芯片底部填充膠應用由漢思新材料提供通過和客戶工程人員溝通了解到;客戶產品是:壓力傳感器使用部位:BGA芯片底部填充粘接材質:玻纖PCB板芯片尺寸:2*2mm錫球球徑:140微米
2023-05-19 16:18:13 394
394 
漢思HS700系列underfill膠水芯片底部填充膠是專為手機、數碼相機以及手提電腦等數碼產品而研發生產的,用于這些數碼產品內部芯片的底部填充。那么為什么這些產品需要用到underfill底部填充
2023-05-24 10:25:04 548
548 
電力設備電源控制板BGA芯片底部填充膠應用由漢思新材料提供客戶產品是電力設備電源控制板需求原因:新產品開發.用膠部位:FPC與BGA底部填充施膠用途:填充膠保護BGA芯片膠水顏色:黑施膠工藝:半自動
2023-05-25 09:16:27 349
349 
LED藍燈倒裝芯片底部填充膠應用由漢思新材料提供客戶的產品是LED藍燈倒裝芯片。芯片參數:沒有錫球,大小35um--55um不等有很多個,芯片厚度115um.客戶用膠點:需要芯片四周填充加固
2023-05-26 15:15:45 631
631 
盲人聽書機BGA芯片底部填充膠應用由漢思新材料提供客戶產品是盲人聽書機。盲人聽書機是一款聽讀產品,符合人體工程學的外形設計,讓盲人朋友觸摸時手感舒適,能聽各種影視語音文件,語音朗讀效果可以多種選擇
2023-05-30 10:57:55 292
292 
車載音箱bga芯片底部填充膠應用由漢思新材料提供.客戶產品為車載音箱了解到他們公司主要做PCBA為主,現在他們的施膠設備還是以半自動點膠為主,只是到現在為止,這個項目還是在一個小批量試驗的階段,真正
2023-05-30 15:53:27 361
361 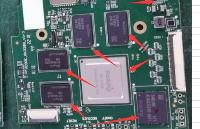
工控級固態硬盤主控芯片BGA底部填充膠應用案例分析由漢思新材料提供.客戶生產產品:工控級固態硬盤用膠芯片:硬盤主控芯片客戶要解決的問題:終端客戶做完TC測試和振動測試后,抽檢20臺設備,3臺設備出現
2023-05-31 05:00:00 470
470 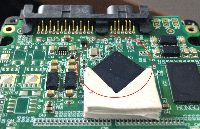
運動DVBGA芯片底部填充膠由漢思新材料提供客戶生產的產品是運動DV,運動DV的主板用膠,經過初步了解,兩個BGA芯片用膠點,均為比較大顆芯片,規格約為1CM*1CM,可以接受150度溫度固化
2023-06-01 09:31:04 263
263 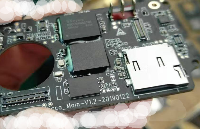
車載定位儀BGA芯片底部填充膠由漢思新材料提供客戶的產品是車載定位儀,需要用膠的是一塊QFN芯片,正方形10mm×10mm,18個腳×4。客戶需要解決芯片加固,防止跌落時芯片脫落。客戶需要做跌落測試
2023-06-01 09:31:15 407
407 
藍牙耳機BGA芯片底部填充膠由漢思新材料提供。通過去客戶現場拜訪了解,客戶開發一款藍牙耳機板,上面有一顆BGA控制芯片需要找一款底部填充的膠水加固。BGA尺寸5*5mm,錫球徑0.35mm,間距
2023-06-05 14:34:52 2002
2002 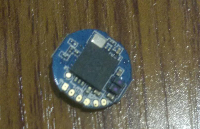
車載導航儀BGA芯片底部填充膠由漢思新材料提供客戶是SMT代加工廠,用膠產品是車載導航儀的BGA芯片。第一次用膠,想加固芯片,顏色白色或黑色.目前是半自動點膠,可接受150度加熱,芯片是A33芯片
2023-06-06 05:00:00 420
420 
跑步機控制板BGA芯片用底部填充膠由漢思新材料提供。客戶開發一款跑步機產品,上面的控制板上有3顆BGA芯片需要底部填充加固,防止運動過程中控制BGA芯片引腳由于震動掉落脫焊,影響跑步機正常工作
2023-06-06 14:27:59 499
499 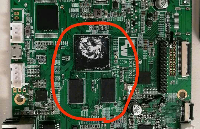
安防監控設備存儲芯片用底部填充膠由漢思新材料提供經過客戶電話了解情況:客戶用膠產品是安防監控設備主板上8顆存儲芯片+1顆處理器芯片存儲芯片規格:長寬高10.5*8.0*1.1mmBGA錫球數78
2023-06-08 09:33:39 573
573 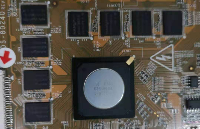
手持or車載式測繪儀器CPU芯片用底部填充膠由漢思新材料提供我司至電客戶工程了解其產品的用膠情況后,了解情況如下:客戶產品為手持or車載式測繪儀器(類似手機),研發后交由代加工廠代工。之前
2023-06-09 15:06:31 393
393 
攝像眼鏡POP芯片用底部填充膠應用案例分析由漢思新材料提供。客戶用膠產品為攝像眼鏡攝像眼鏡是款具有高清數碼攝像和拍照功能的太陽鏡,內置存儲器,又名“太陽鏡攝像機,可拍攝照片和高畫質視頻。主要功能
2023-06-12 17:13:09 613
613 
航空攝像機芯片BGA底部填充膠應用由漢思新材料提供。客戶產品:客戶開發一款航空攝像機產品,上面有兩顆BGA芯片,芯片尺寸:15*15mm,13*12mm。錫球徑0.25mm,間距0.5mm。產品
2023-06-13 05:00:00 452
452 
無人機航空電子模塊用底部填充膠水由漢思新材料提供。客戶產品:客戶開發一款航空電子模塊。用膠部位:三顆BGA芯片需要找一款合適的底部填充膠加固芯片尺寸:20*20mm錫球0.25mm,間距0.5mm
2023-06-16 14:45:44 686
686 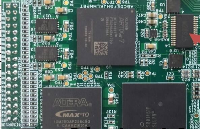
據了解,即使是最平穩的飛機,振動也是一個非常嚴重的問題,振動對于飛機運行的可靠性影響很大。在航空電子產品的制造過程中,往往會加入BGA底部填充膠工藝,以防止振動造成BGA芯片焊點開裂甚至損壞。BGA
2023-06-25 14:01:17 576
576 
車載電腦固態硬盤PCB芯片BGA底部填充加固用膠方案由漢思新材料提供客戶公司是以SMT貼片、DIP插件、后焊、測試、組裝等服務為主的加工廠,主要生產加工銀行自助終端、高清播放器、讀票讀卡系列、汽車
2023-06-26 13:57:55 480
480 
近幾年,我國的科技發現迅速,為了迎合電子市場的需求,市場上涌現出了一批底部填充膠廠家,面對這林林總總的底部填充膠廠家,我們該如何選擇呢?底部填充膠什么牌子好?底部填充膠國內有哪些廠家?下面一起聽一聽
2023-06-28 14:53:17 1218
1218 
射頻電子標簽qfn芯片封裝用底部填充膠由漢思新材料提供客戶產品:射頻電子標簽。目前用膠點:qfn芯片加固。芯片尺寸:0.8MM*1.3MM客戶要求:目前客戶可以接受加熱。顏色目前暫時沒有要求
2023-06-30 14:01:42 554
554 
智能門鎖指紋模組焊點補強加固用底部填充膠由漢思新材料提供。客戶產品:智能門鎖指紋模組,新產品工藝研發價段。產品用膠點:1,QFN芯片底部填充(無錫球,印刷錫膏導通),芯片規格11*13mm,共33
2023-07-04 14:30:11 850
850 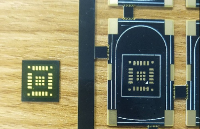
底部填充膠十大品牌排行榜之一漢思底部填充膠應運而生,通過多年驗證及大量的終端客戶反饋,漢思底部填充膠HS700系列完全媲美海外品牌。據了解電子產品的生產商為了滿足終端銷費者的各種需求,也是為了在競爭
2023-07-11 13:41:53 864
864 
手機芯片底部填充膠哪款好?客戶開發一款手機相關的手持終端電子產品(如附圖)。上面有兩顆芯片需要填充加固,芯片具體信息通過客戶確認,了解到。需要點膠的兩顆BGA的相關參數。1.BGA芯片尺寸11
2023-07-18 14:13:29 872
872 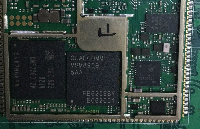
進行底部填充、角部粘接(cornerbond)或邊部粘接。相對于標準的CSP/BGA工藝,堆疊工藝由于需要對多層封裝同時進行點膠操作,因此將面對更多的挑戰。對于Po
2023-07-24 16:14:45 545
545 
底部填充膠被填充在芯片與基板之間的間隙,來降低芯片與基板熱膨脹系數不匹配產生的應力,提高封裝的穩定性。
2023-07-31 10:53:43 387
387 
據了解現在很多3c電子工廠,電子產品都用底部填充膠來保護電路板芯片/BGA電子元件,其中電路板pcb也是有一定的成本,所以底部填充膠的返修也是個重要環節.底部填充膠的返修工藝步驟:1.把CSP
2023-07-31 14:23:56 905
905 
底部填充膠對SMT(電子電路表面組裝技術)元件(如:BGA、CSA芯片等)裝配的長期可靠性有了一定的保障性;還能很好的減少焊接點的應力,將應力均勻分散在芯片的界面上,在芯片錫球陣列中,底部填充膠能有
2023-08-07 11:24:38 354
354 據了解,現在很多電子產品都在使用底部填充膠水來保護PBC板BGA芯片和電子元件,讓產品防摔,抗震,防跌落。漢思化學也進軍BGA芯片用膠領域。漢思化學是面向全球化戰略服務的一家創新型化學新材料科技公司
2023-08-07 14:24:47 718
718 
相對于其他的IC元件,如BGA和CSP等,倒裝晶片裝配工藝有其特殊性,該工藝引入了助焊劑工藝和底部填充工 藝。因為助焊劑殘留物(對可靠性的影響)及橋連的危險,將倒裝芯片貼裝于錫膏上不是一種可采用的裝配方法 。
2023-09-22 15:13:10 352
352 
漢思HS711芯片BGA底部填充膠是專為手機、數碼相機以及手提電腦等數碼產品而研發生產的,用于這些數碼產品內部芯片的底部填充。那么為什么這些手機數碼產品需要用到芯片BGA底部填充膠呢?其實芯片BGA
2023-11-06 14:54:42 154
154 
倒裝芯片技術,也被稱為FC封裝技術,是一種先進的集成電路封裝技術。在傳統封裝技術中,芯片被封裝在底部,并通過金線連接到封裝基板上。而倒裝芯片技術則將芯片直接翻轉并安裝在封裝基板上,然后使用微小的焊點
2024-02-19 12:29:08 480
480 
什么是芯片底部填充膠,它有什么特點?芯片底部填充膠是一種用于電子封裝的膠水,主要用于底部填充bga芯片電子組件,以增強組件的可靠性和穩定性。它通常是一種環氧樹脂,具有良好的粘接性和耐熱性。底部填充
2024-03-14 14:10:51 247
247 
倒裝芯片組裝過程通常包括焊接、去除助焊劑殘留物和底部填充。由于芯片不斷向微型化方向發展,倒裝芯片與基板之間的間隙不斷減小,因此去除助焊劑殘留物的難度不斷增加。這不可避免地會導致清洗成本增加
2024-03-15 09:21:28 107
107 
 電子發燒友App
電子發燒友App











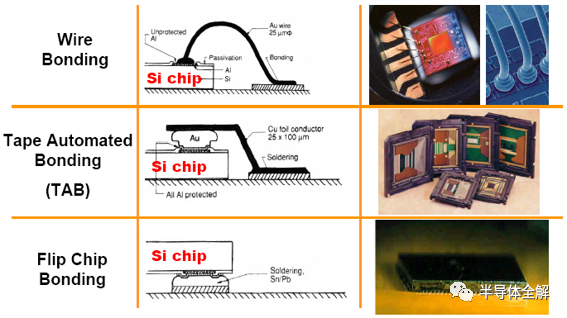


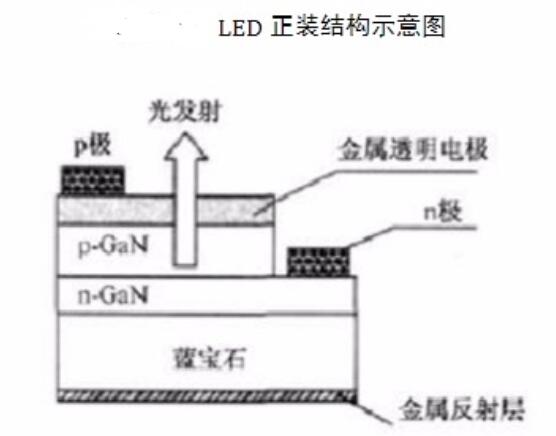

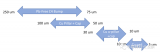


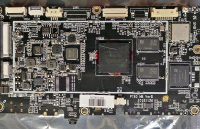
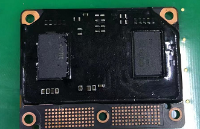






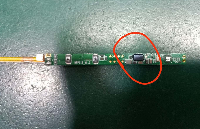
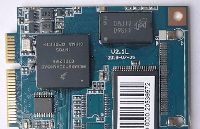

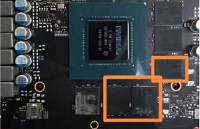
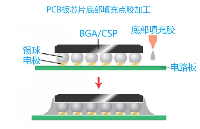





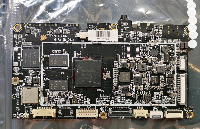

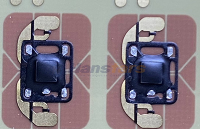


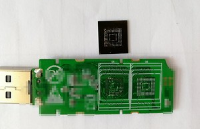

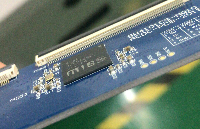
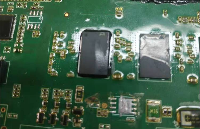







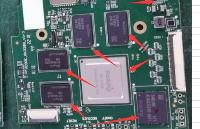
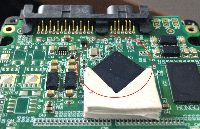
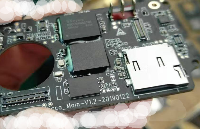

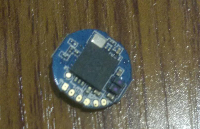

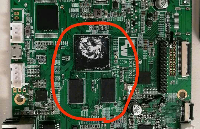
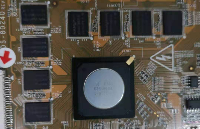



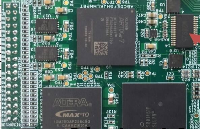




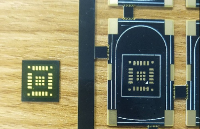

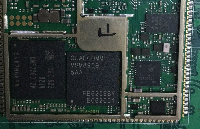

















評論