摘要
溶液中晶片表面的顆粒沉積。然而,粒子沉積和清除機制液體。在高離子中觀察到最大的粒子沉積:本文將討論粒子沉積的機理酸性溶液的濃度,并隨著溶液pH值的增加而降低,在使用折痕。還研究了各種溶液中的顆粒去除效率。在大約0.05∶1∶5(0.05份nh4oh、1份H2O、5份H2O)的比率下,優(yōu)化了nh4oh-1-zO溶液中的nh4oh-1∶5的IH含量。在使用該比率的NHdOH-hzo tFt處理期間,通過表面微觀粗糙度測量的損傷沒有增加。
介紹
QT清洗技術(shù)將繼續(xù)在半導(dǎo)體器件的ULSI制造中發(fā)揮重要作用。隨著ULSI器件圖案密度的增加,需要濕法清洗工藝來去除越來越多的小顆粒,以便獲得更高的器件成品率和增強電路可靠性。為了盡量減少半導(dǎo)體晶片表面的微粒污染,有必要了解微粒沉積和去除的機理。諸如溶液中顆粒的數(shù)量、這些顆粒的ζ電勢和晶片表面的電勢等因素都是顆粒沉積和去除的重要因素。
結(jié)果與討論
A. 晶片表面上的顆粒沉積
在高酸性溶液中觀察到;它隨著溶液pH值的增加而降低。 顯示了眾所周知的pH值對FetO顆粒ζ電位的影響。可以看出,圖1和圖2的曲線幾乎完全匹配。由于顆粒的ζ電勢取決于溶液的pH值,因此溶液的pH值是決定顆粒在晶片表面沉積的最重要因素之一。


隨著超大規(guī)模集成電路器件圖形密度的增加,為了獲得更高的器件成品率和提高電路的可靠性,需要在不增加表面微觀粗糙度的情況下,采用濕法清洗工藝從硅片表面去除更多更小的顆粒。
對于溶液中的粒子沉積機制,半導(dǎo)體晶片表面的行為可以用膠體科學(xué)的充分證明的原理來描述。首先,晶片表面的污染水平與工藝流體的離子強度有關(guān)。這意味著低離子強度和特定濃度的超純水對于濕法清洗過程是必不可少的。第二,在高離子強度酸性溶液中觀察到最大顆粒沉積,并隨著溶液pH值的變化而減少。酸性溶液中的顆粒濃度必須盡可能低。此外,堿性溶液必須足以從晶片表面去除顆粒。
為了在不增加表面微觀粗糙度的情況下建立無顆粒的晶片表面,使用減少NH4 H含量的NH4OH-H2O,H2溶液研究了顆粒去除效率。結(jié)果,我們發(fā)現(xiàn)顆粒去除效率是很高的
針對大約0.05 : 1 : 5的N H、OH含量優(yōu)化(0.05份NH、OH、1份HCO、5份H2O)。這意味著NH4OH含量可以降低到傳統(tǒng)濃度的5 %,同時仍然保持高的顆粒去除效率,并且不增加表面微觀粗糙度。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222627 -
晶片
+關(guān)注
關(guān)注
1文章
403瀏覽量
31576
發(fā)布評論請先 登錄
相關(guān)推薦
濕清洗過程中硅晶片表面顆粒去除
AL-CU互連導(dǎo)線側(cè)壁孔洞形成機理及改進方法
芯片清洗過程中,顆粒洗不掉
刷洗清洗過程中的顆粒去除機理—江蘇華林科納半導(dǎo)體
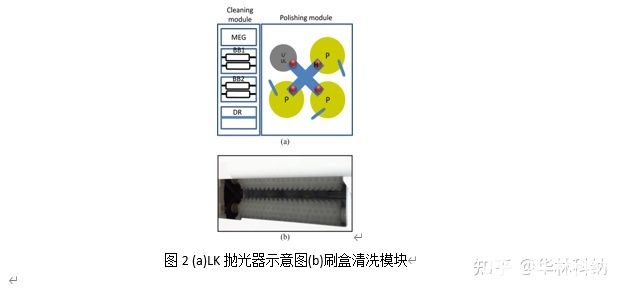
關(guān)于刷洗清洗過程中的顆粒去除機理的研究報告

稀釋HF清洗過程中硅表面顆粒沉積的機理報告
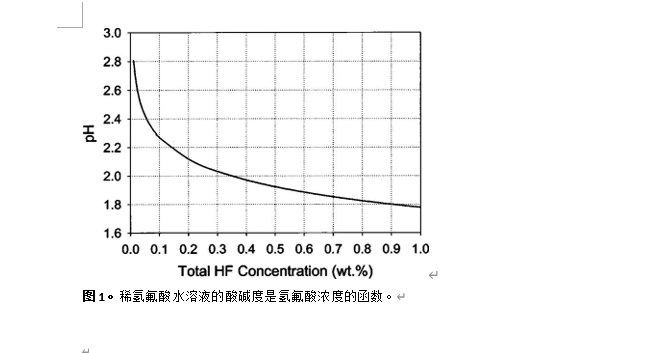
濕法清洗系統(tǒng)對晶片表面顆粒污染的影響

半導(dǎo)體制造過程中的硅晶片清洗工藝
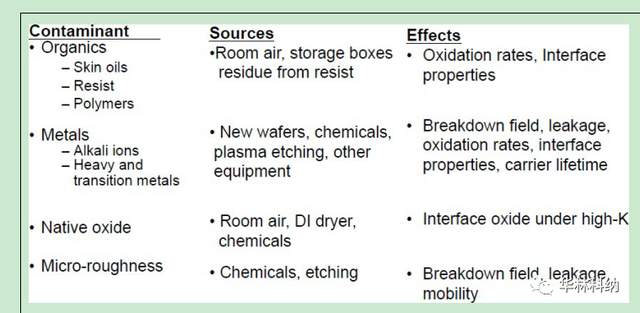
濕法清洗過程中晶片旋轉(zhuǎn)速度的影響
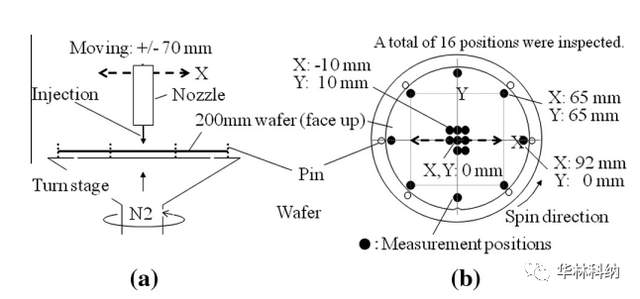
濕法和顆粒去除工藝詳解
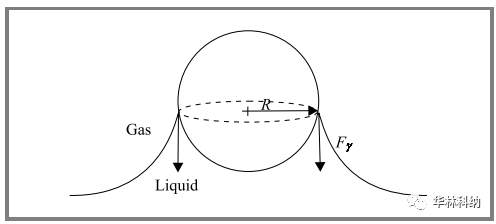
PVA刷接觸式清洗過程中超細(xì)顆粒清洗現(xiàn)象

稀釋SC1過程中使用兆聲波來增強顆粒去除效率





 濕法清洗過程中的顆粒沉積和去除研究
濕法清洗過程中的顆粒沉積和去除研究
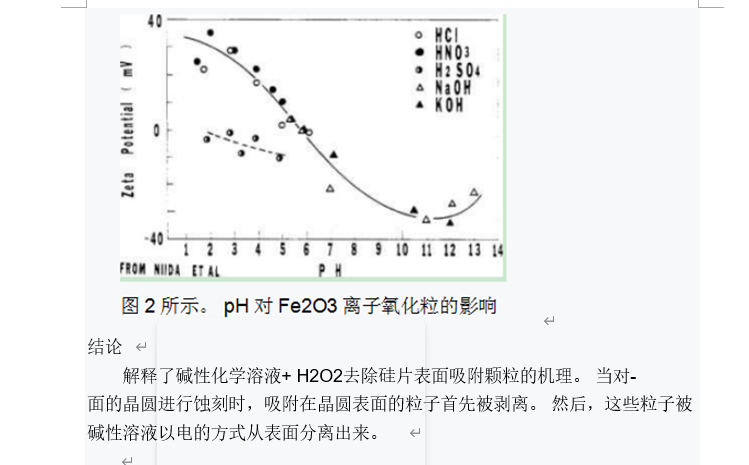

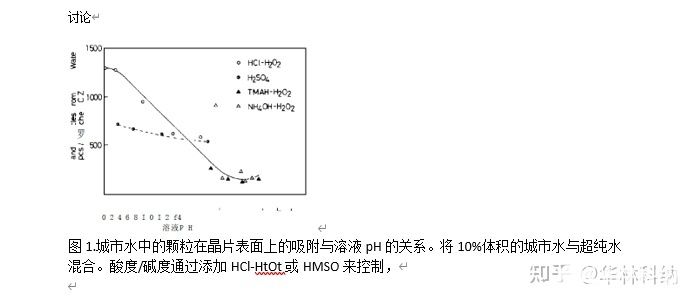










評論