1 引言
碳化硅(SiC)材料作為第三代半導(dǎo)體材料的代表之一,其禁帶寬度達(dá)到 3.26 eV,是硅(Si)材料的 3 倍,臨界擊穿電場強(qiáng)度是 Si 材料的 10 倍,熱導(dǎo)率接近 Si材料的 3 倍,被認(rèn)為是下一代超高壓功率器件的理想材 料。SiC 金 屬 氧 化 物 半 導(dǎo) 體 場 效 應(yīng) 晶體管(Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)是目前最成熟、應(yīng)用最廣的 SiC 功率開關(guān)器件,然而隨著功率器件的阻斷電壓不斷增大,其導(dǎo)通電阻也會(huì)迅速增大,使其很難在超高壓領(lǐng)域發(fā)揮重要作用。絕緣柵雙極晶體管(Insulated Gate BipolarTransistor,IGBT) 作為現(xiàn)如今功率半導(dǎo)體器件的主要代表之一,綜合了功率 MOSFET 和雙極型晶體管(Bipolar Junction Transistor,BJT)兩種器件的結(jié)構(gòu),正常導(dǎo)通狀態(tài)下,會(huì)在其漂移層中發(fā)生電導(dǎo)調(diào)制效應(yīng),從而很好地降低了其漂移層的導(dǎo)通電阻以及整個(gè)器件的導(dǎo)通壓降,極大地克服了高壓 MOSFET 器件的缺點(diǎn)。
早在 2007 年,美國 Cree 公司就報(bào)道了阻斷電壓為 9 kV 的平面柵 P 溝道 4H-SiC IGBT 器件,該器件的微分比導(dǎo)通電阻值為 88 mΩ·cm2,當(dāng)時(shí)之所以采用 P 溝道,是因?yàn)?P 型 SiC 襯底電阻過大,無法支撐其制備 N 溝道 IGBT 器件。2009 年美國普渡大學(xué)利用數(shù) 值 模 擬 軟 件 評(píng) 估 了 10 kV SiC MOSFET 和 SiCIGBT 器件的性能,指出 SiC IGBT 器件更適合應(yīng)用于高壓低頻領(lǐng)域。Cree 公司在 2009 年采用厚度為100 μm、摻雜濃度為 3×1014 cm-3 的 N 型外延成功制備了耐壓超過 13 kV 的 N 溝道 IGBT 器件,其微分比導(dǎo)通電阻值僅為 22 mΩ·cm2,遠(yuǎn)遠(yuǎn)低于 P 溝道 IGBT 器件。2015 年 Cree 公司和美國陸軍實(shí)驗(yàn)室(Army Research Laboratory)共同合作,通過對(duì)比阻斷電壓為15 kV 的 4H-SiC MOSFET 和 N 溝道 4H-SiC IGBT 器件,發(fā)現(xiàn) 15 kV 4H-SiC MOSFET 器件的比導(dǎo)通電阻高達(dá) 204 mΩ·cm2,而同等級(jí)下的 N 溝道 4H-SiC IGBT器件僅為 50 mΩ·cm2,同時(shí)報(bào)道還指出通過在 N 溝道4H-SiC IGBT 器件結(jié)構(gòu)中加入載流子存儲(chǔ)層(Carrier Storage Layer,CSL),可以減小器件 JFET 區(qū)域的導(dǎo)通電阻,從而降低正向壓降。
2014 年 Cree 公司還聯(lián)合了北卡羅來納州立大學(xué)等高校,在 160 μm 的外延層上成功研制了 20 kV SiC N 溝道 IGBT 器件,在導(dǎo)通電流為 20 A 的條件下,其導(dǎo)通壓降為 6.4 V。
2016 年日立(Hitachi)的研發(fā)團(tuán)隊(duì)報(bào)道了具有極低開關(guān)損耗的 N 溝道 4H-SiC IGBT 器件,其漂移層厚度為 60 μm,阻斷電壓能夠達(dá)到 6.5 kV,其開關(guān)損耗只有 1.2 mJ。在近幾年研究發(fā)展過程中,Cree 公司甚至報(bào)道了阻斷電壓為 27 kV 的 N 溝道 SiC IGBT 器件,加入三代半交流群,加VX:tuoke08,器件的微分比導(dǎo)通電阻值僅為 123 mΩ·cm2。
由于受 4H-SiC 單晶質(zhì)量、外延生長技術(shù)的制約,國內(nèi)對(duì)于 SiC IGBT 器件方面的實(shí)驗(yàn)研究起步相對(duì)較晚。南京電子器件研究所 SiC 團(tuán)隊(duì)于 2018 年成功研制出了 13 kV SiC N 溝道 IGBT 器件,但其導(dǎo)通特性較差。近年來通過對(duì)器件結(jié)構(gòu)優(yōu)化以及關(guān)鍵工藝技術(shù)的提升,SiC N 溝道 IGBT 器件取得了重大突破,縮短了與國外的差距。本文介紹了團(tuán)隊(duì) SiC N 溝道 IGBT器件研制的最新成果。
2 器件設(shè)計(jì)與制造
2.1 器件基本結(jié)構(gòu)
超高壓 SiC N 溝道 IGBT 器件元胞的基本結(jié)構(gòu)如圖 1 所示。N+ 區(qū)域定義為源區(qū),相應(yīng)的電極稱為發(fā)射極(Emitter)。背面 P+ 區(qū)域定義為漏區(qū),相應(yīng)的電極稱為集電極(Collector)。超高壓 SiC N 溝道 IGBT 器件與MOSFET 器件一樣都是柵控型器件,柵區(qū)是器件的控制區(qū)域,相應(yīng)的電極稱為柵極(Gate)。器件溝道的形成在緊靠柵區(qū)邊界處,其長度則由 P-well 區(qū)和 N+ 源區(qū)的橫向擴(kuò)散進(jìn)行定義。場截止層(F-S)為高摻雜濃度的N+ 緩沖層,其主要作用在于使正向阻斷狀態(tài)下電場在該層降為 0,從而避免電場對(duì) P+ 襯底的影響。IGBT 器件正面結(jié)構(gòu)與功率 MOSFET 器件正面結(jié)構(gòu)一致,唯一的不同之處在于器件的背面結(jié)構(gòu)。IGBT 器件的背面結(jié)構(gòu)是通過 P+ 外延層實(shí)現(xiàn)的,使得 IGBT 器件的背面結(jié)構(gòu)比功率 MOSFET 器件多一個(gè) PN 結(jié),在導(dǎo)通狀態(tài)下背面注入的少數(shù)載流子和正面的溝道載流子在 N漂移區(qū)復(fù)合,產(chǎn)生電導(dǎo)調(diào)制效應(yīng),大大降低了N漂移區(qū)的導(dǎo)通電阻。
2.2器件仿真設(shè)計(jì)
2.2.1 材料結(jié)構(gòu)仿真設(shè)計(jì)
由于 SiC IGBT 器件的理論擊穿電壓主要由漂移區(qū)的厚度和摻雜濃度決定。為了使器件阻斷電壓超過20 kV,研究團(tuán)隊(duì)通過有限元仿真對(duì)漂移區(qū)的厚度和摻雜濃度進(jìn)行優(yōu)化設(shè)計(jì),仿真結(jié)果如圖 2 所示。觀察得出當(dāng)器件摻雜濃度較高時(shí)其阻斷電壓與外延層厚度無關(guān),而當(dāng)摻雜濃度較低時(shí)阻斷電壓基本正比于外延厚度。這主要是因?yàn)橥庋訉訐诫s濃度較高時(shí),空間電荷區(qū)主要集中在外延層內(nèi)部,此時(shí)外延層內(nèi)電場為三角形分布且并未達(dá)到外延層底部,即使外延厚度發(fā)生變化電場的積分也無變化;而當(dāng)摻雜濃度較低時(shí),此時(shí)電場可近似為矩形,積分近似正比于外延厚度。但不能為了提高阻斷電壓一味提高外延厚度,因?yàn)檫^厚的外延層會(huì)導(dǎo)致正向?qū)娮璧脑黾樱栽诒WC阻斷電壓的同時(shí)要盡量使用較小的外延厚度。考慮到器件終端保護(hù)的效率問題和實(shí)際的器件應(yīng)用需求,研究團(tuán)隊(duì)在設(shè)計(jì)材料參數(shù)時(shí),將材料擊穿電壓需求設(shè)定為25 kV,預(yù)留 20%的設(shè)計(jì)冗余,在此條件下最終選取厚度為 180μm,摻雜濃度為 2×1014 cm-3的 N 型外延材料。
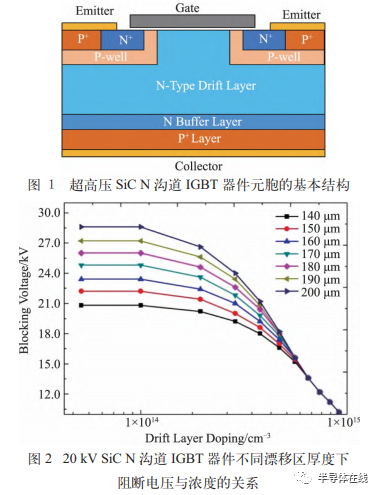
2.2.2 JFET 區(qū)仿真設(shè)計(jì)
理論上,N 溝道 IGBT 器件的導(dǎo)通電阻主要由溝道電阻、漂移區(qū)電阻、JFET 區(qū)電阻以及一系列接觸電阻組成。對(duì)于擊穿電壓超過 20 kV 的 SiC IGBT 器件而言,對(duì)其導(dǎo)通電阻影響最大的是垂直 JFET 區(qū)電阻,而垂直 JFET 區(qū)設(shè)計(jì)優(yōu)化主要是對(duì) JFET 區(qū)的寬度和摻雜濃度進(jìn)行優(yōu)化。加大 JFET 區(qū)的橫向長度和摻雜濃度可以顯著減小器件導(dǎo)通電阻,但在阻斷狀態(tài)時(shí),延伸的耗盡區(qū)不容易夾斷,對(duì)柵氧化層底部電場強(qiáng)度的抑制作用減弱,可能會(huì)引起器件提前擊穿。縮小 JFET區(qū)的橫向長度和摻雜濃度會(huì)增強(qiáng)對(duì)柵氧化層底部電場的抑制作用,器件在高電壓下的穩(wěn)態(tài)性變好,但同時(shí)會(huì)引起器件導(dǎo)通電阻的增加,導(dǎo)致穩(wěn)態(tài)電流的下降,因此需要統(tǒng)籌考慮 JFET 區(qū)對(duì)于器件導(dǎo)通特性和擊穿電壓之間的關(guān)系,不同 JFET 寬度下器件的導(dǎo)通特性以及截取的柵極氧化層電場如圖 3 所示。觀察發(fā)現(xiàn)隨著 JFET 區(qū)寬度從 4 μm 擴(kuò)展至 12 μm 時(shí),增大垂直 JFET 區(qū)的寬度可以降低溝道導(dǎo)通電阻,使導(dǎo)通電流增大。但隨著 JFET 區(qū)進(jìn)一步增大,元胞尺寸的增大效應(yīng)也將變得明顯,使得器件導(dǎo)通電流密度隨 JFET寬度增加而增長的速率減緩,同時(shí)反向偏置狀態(tài)下P-well 區(qū)的夾斷作用降低,柵氧化層底部電場提高。理論上,氧化層擊穿是指氧化層電場在反向阻斷時(shí)超過自身臨界場強(qiáng)的情況,一般認(rèn)為 SiO2 的電場不應(yīng)超過3 MV/cm。因此在保證器件可靠性的同時(shí),為實(shí)現(xiàn)盡可能高的器件導(dǎo)通能力,元胞結(jié)構(gòu)最終采用 6 μm 的JFET 區(qū)域。
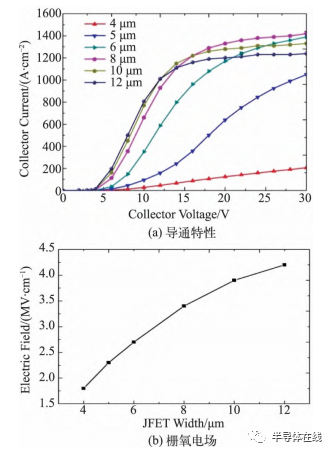
由于 SiC IGBT 器件超高的耐壓要求,器件漂移區(qū)一般保持非常低的摻雜濃度,這往往會(huì)導(dǎo)致垂直JFET 區(qū)電阻大大增加,因此在 20 kV SiC IGBT 器件研制中,通過引入 JFET 區(qū)注入摻雜技術(shù),可更有效地提升器件導(dǎo)通特性,仿真結(jié)果如圖 4(a)所示。觀察發(fā)現(xiàn)隨著 JFET 區(qū)摻雜濃度的增大,器件導(dǎo)通電流隨之增大,主要是因?yàn)?JFET 區(qū)摻雜濃度增大,器件導(dǎo)通時(shí)P-well 區(qū)兩側(cè)的耗盡區(qū)寬度大幅度減小,JFET 區(qū)電阻減小,器件導(dǎo)通電阻也隨之減小。與此同時(shí)該器件反向偏置狀態(tài)下 P-well 區(qū)的夾斷作用降低,柵氧化層底部電場提高,不同 JFET 濃度下柵氧化層電場如圖 4(b)所示。綜合考慮器件的導(dǎo)通壓降和阻斷電壓,元胞結(jié)構(gòu)采用濃度為 1×1016 cm-3 的 JFET 區(qū)注入條件。
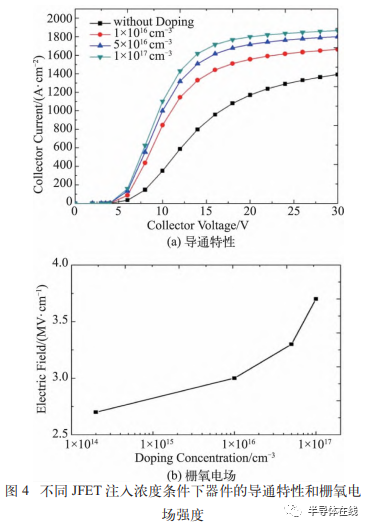
2.2.3 載流子壽命仿真設(shè)計(jì)
高載流子壽命是實(shí)現(xiàn)大功率 SiC 雙極型器件的關(guān)鍵技術(shù)之一。不同載流子壽命下器件的導(dǎo)通特性如圖5 所示。觀察發(fā)現(xiàn)隨著載流子壽命的增加,器件的導(dǎo)通電流增加,主要是因?yàn)樯贁?shù)載流子壽命的增強(qiáng)可以顯著改善雙極型器件的電導(dǎo)調(diào)制效應(yīng),有利于實(shí)現(xiàn)較低的器件導(dǎo)通壓降。仿真結(jié)果顯示,為了達(dá)到較好的導(dǎo)通特性,器件的載流子壽命最好能夠達(dá)到5 μs 以上。
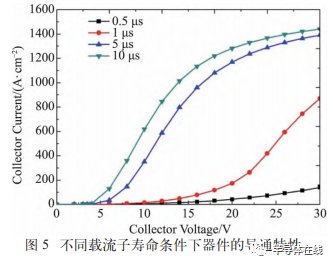
2.3 器件制備
2.3.1 器件制備方案及流程
研究團(tuán)隊(duì)設(shè)計(jì)的 SiC IGBT 器件為 N 溝道 SiC IGBT 器件,N 型 SiC 襯底電阻率約為 0.025 Ω·cm,而P 型 SiC 襯底電阻率約為2.5 Ω·cm,因此如果在350 μm P 型 SiC 襯底上制造 N 溝道 SiC IGBT 器件,此時(shí) P 型襯底電阻值甚至大于所設(shè)計(jì)器件的導(dǎo)通電阻值,再加上目前國內(nèi)很難供應(yīng) P 型 SiC 襯底,因此團(tuán)隊(duì)提出一種在 N 型 SiC 襯底上進(jìn)行器件設(shè)計(jì)與制造的方案。具體的制備方案如圖 6 所示。通過在 N 型4H-SiC 襯底上生長所需的關(guān)鍵外延層,包括 N漂移層,N+緩沖層以及 P+ 集電極層;采用 SiO2 作為各區(qū)域的注入掩模,由多次 P 型離子注入實(shí)現(xiàn) P-well 區(qū)和 P+區(qū)域,多次高劑量 N 型離子注入實(shí)現(xiàn) N+ 區(qū)域。同時(shí)為了有效降低該器件 JFET 區(qū)的電阻,單獨(dú)對(duì) JFET 區(qū)域進(jìn)行 N 型離子注入,所有注入完成后在 1650 ℃的氬氣(Ar)環(huán)境下退火以激活注入離子。退火后,通過犧牲氧化去除表面碳層,濕法表面清洗后放入高溫氧化爐中進(jìn)行干氧氧化,形成柵氧化層。采用一氧化氮(NO)高溫退火技術(shù),有效降低柵氧界面陷阱密度,最終氧化層厚度控制在 50 nm 左右。在柵氧工藝完成后,通過在柵氧化層上沉積多晶硅實(shí)現(xiàn)柵電極的制作。采用氧化硅 / 氮化硅(SiO2/SiN)介質(zhì)實(shí)現(xiàn)柵極和發(fā)射極隔離以及表面鈍化。發(fā)射極的歐姆接觸由金屬鎳(Ni)實(shí)現(xiàn),介質(zhì)孔刻蝕后通過加厚鋁(Al)層完成發(fā)射極單胞之間的互聯(lián)。器件正面結(jié)構(gòu)完成后通過減薄 / 背面研磨的方法去除 N 型襯底,保留部分 P+ 層,接著蒸發(fā)背面歐姆金屬,考慮到普通的背面歐姆制作工藝需要相當(dāng)高的溫度,過程中的高溫會(huì)損傷表面器件結(jié)構(gòu),因此采用激光退火工藝完成背面的歐姆制作。
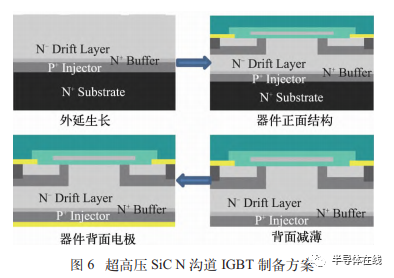
2.3.2 載流子壽命提升工藝
由于 IGBT 器件電導(dǎo)調(diào)制效應(yīng)的存在,使得載流子壽命高低成為影響漂移區(qū)電阻高低的重要因素之一。在 N 型 SiC 材料的早期研究階段,Z1/2 缺陷中心被公認(rèn)為是載流子壽命的“殺手”。到目前為止,國際上主要采用兩種相對(duì)成熟的技術(shù)來消除 Z1/2 缺陷中心:
1)從外部引入過量的碳原子,并且通過高溫退火來促進(jìn)碳原子體區(qū)擴(kuò)散;2)在適當(dāng)條件下,通過長時(shí)間高溫?zé)嵫趸?Z1/2 缺陷中心。考慮到碳注入結(jié)合高溫退火的方法在高能碳離子注入過程中容易引入新的缺陷,同時(shí)受碳注入深度的限制,對(duì)厚層 SiC 外延來說效果不夠理想,因此本研究采用長時(shí)間高溫?zé)嵫趸に噥硖嵘d流子壽命。
研究團(tuán)隊(duì)首先采用 μ-PCD 測量方法測量 SiCIGBT 厚外延片材料的少子壽命,高溫?zé)嵫趸胺植既鐖D 7(a)所示,其少子壽命平均值大約在 1.76 μs,后續(xù)將該外延片經(jīng)過 10 h 的高溫?zé)嵫趸コ砻嫜趸瘜忧逑刺幚砗螅俅螠y量其少子壽命,結(jié)果如圖 7(b)所示,其平均值提升至 5.42 μs。從實(shí)驗(yàn)結(jié)果看,長時(shí)間的高溫氧化工藝對(duì)于器件的少子壽命有較大的提升作用,主要原因在于高溫?zé)嵫趸倪^程中,部分碳原子會(huì)擴(kuò)散到體區(qū)并填補(bǔ)碳空位,消除 Z1/2 缺陷中心。

3 結(jié)果和討論
制備的 20 kV SiC IGBT 器件芯片單胞長度為14 μm,溝道長度為 1.0 μm,器件采用了總寬度為1.4 mm 的場限環(huán)終端,總尺寸達(dá)到 9.2 mm×9.2 mm,其中有源區(qū)面積為 30 mm2。
3.1 阻斷特性
對(duì)超高壓 SiC N 溝道 IGBT 器件的正向阻斷特性進(jìn)行測試,必須將器件的柵極與發(fā)射極接地,在集電極加正電壓。而且考慮到設(shè)計(jì)的器件阻斷電壓大于18 kV,因此在測試過程中,需要將芯片浸泡在高壓測試油中,從而隔絕空氣。室溫下正向阻斷特性測試結(jié)果如圖 8 所示,該器件在室溫下?lián)舸╇妷嚎梢赃_(dá)到20 kV。當(dāng)集電極電壓為 20.08 kV 時(shí),漏電流為 50 μA,為目前國內(nèi)研制的最高擊穿電壓 SiC IGBT 器件。
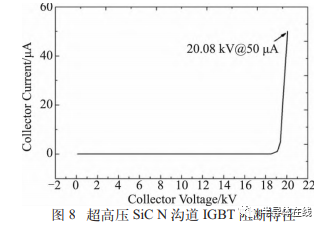
3.2 導(dǎo)通特性
SiC N 溝道 IGBT 器件的正向?qū)ㄌ匦詼y試一般在發(fā)射極接地、柵極加正偏壓的情況下進(jìn)行。不同柵壓下的集電極電流隨著集電極電壓的變化曲線如圖 9所示。室溫下,該器件在柵壓為 20 V,集電極電流為20 A 時(shí),集電極導(dǎo)通電壓為 6.0 V,此時(shí)其微分比導(dǎo)通電阻為 27 mΩ·cm2,該值與國際上相同擊穿電壓器件的微分比導(dǎo)通電阻最低值相當(dāng)。
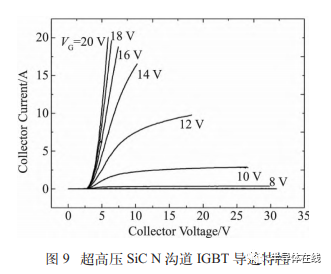
為了更好地反映載流子壽命對(duì)于器件導(dǎo)通特性的影響,本文分析了芯片 A(引入載流子壽命提升工藝)、芯片 B(未引入載流子壽命提升工藝)的實(shí)驗(yàn)結(jié)果以及仿真結(jié)果,具體高溫?zé)嵫趸幚砬昂蟪邏?SiC N 溝道 IGBT 導(dǎo)通特性如圖 10 所示。觀察發(fā)現(xiàn)芯片 B在柵極電壓為 20 V、集電極電流密度為 70 A/cm2 的條件下,器件導(dǎo)通壓降為 16.2 V 左右,引入載流子壽命提升工藝后,芯片 B 在同等測試條件下,其導(dǎo)通壓降降至 6.5 V 左右,這一結(jié)果也恰好驗(yàn)證了載流子壽命的提升能有效提高 SiC N 溝道 IGBT 器件的導(dǎo)通能力。
審核編輯 :李倩
-
IGBT
+關(guān)注
關(guān)注
1269文章
3834瀏覽量
250087 -
碳化硅
+關(guān)注
關(guān)注
25文章
2829瀏覽量
49276
原文標(biāo)題:超高壓碳化硅 N 溝道 IGBT 器件的設(shè)計(jì)與制造
文章出處:【微信號(hào):cetc45_wet,微信公眾號(hào):半導(dǎo)體工藝與設(shè)備】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
光伏MPPT設(shè)計(jì)中IGBT、碳化硅SiC器件及其組合方案對(duì)比
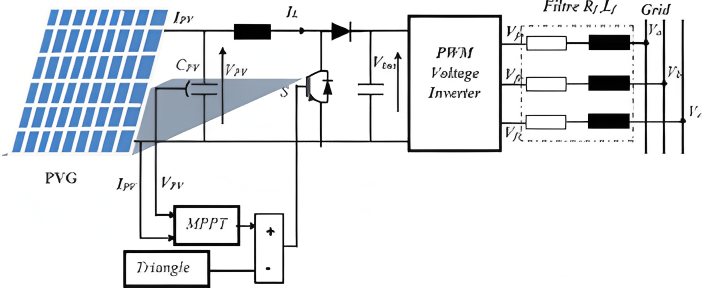
Si IGBT和SiC MOSFET混合器件特性解析
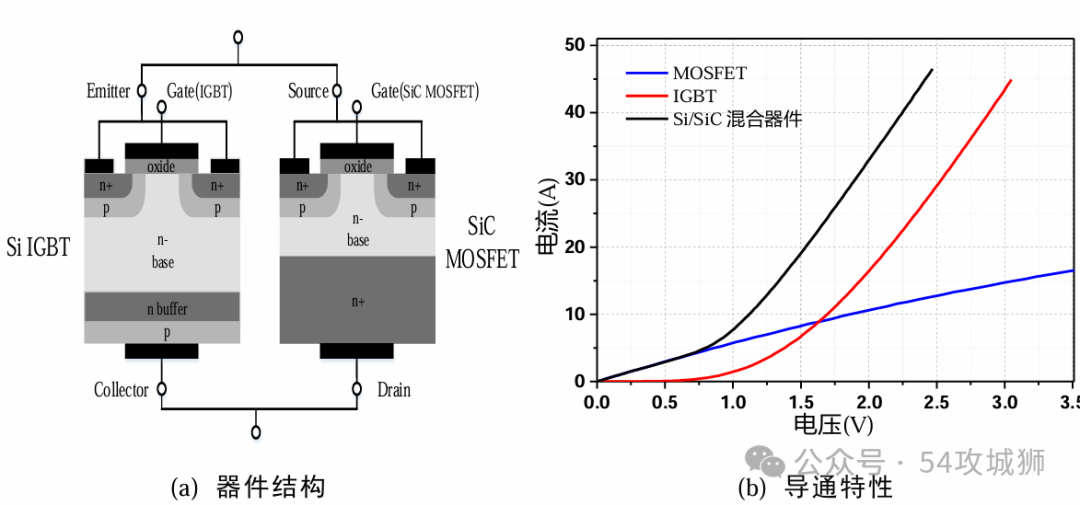
SiC模塊封裝技術(shù)解析

IGBT和SiC封裝用的環(huán)氧材料

N溝道結(jié)型場效應(yīng)管的工作原理
場效應(yīng)管N溝道和P溝道怎樣判斷
P溝道與N溝道MOSFET的基本概念
igbt芯片vce與結(jié)溫的關(guān)系
igbt必須加吸收電容嗎為什么
igbt功率管寄生電容怎么測量大小
igbt驅(qū)動(dòng)電壓過高過低的后果
IGBT功率器件功耗

如何更好地驅(qū)動(dòng)SiC MOSFET器件?
華潤微電子兩項(xiàng)產(chǎn)品入選中央企業(yè)科技創(chuàng)新成果產(chǎn)品手冊
Littelfuse N溝道和P溝道功率MOSFET的比較分析
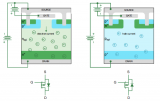




 SiC N溝道IGBT器件研制的最新成果
SiC N溝道IGBT器件研制的最新成果










評(píng)論