引言
介紹了一種蝕刻后殘留物清洗配方,該配方基于平衡氫氟酸的腐蝕性及其眾所周知的殘留物去除特性。在最初由基于高k電介質的殘留物提供的清潔挑戰(zhàn)所激發(fā)的一系列研究中,開發(fā)了一種配方平臺,其成功地清潔了由氧化鉭和類似材料的等離子體圖案化產生的殘留物,同時保持了金屬和電介質的兼容性。這進一步表明,這種溶液的基本優(yōu)點可以擴展到其它更傳統(tǒng)的蝕刻后殘留物的清洗,而不犧牲相容性,如通過對覆蓋膜的測量和通過SEM數(shù)據(jù)所證明的。
關鍵詞:蝕刻后殘留物、選擇性清洗、高K、HfOx、ZrOx、TaOx、鋁、TaN、互連、Cap MIM、選擇性非晶氧化物去除
介紹
自從用于半導體互連的等離子體圖案化出現(xiàn)以來,用于等離子體蝕刻后殘留物(PER)的清除的配方類型已經有了顯著的發(fā)展。在等離子蝕刻變得突出之前,半導體工業(yè)中的濕法化學工藝主要局限于光刻膠剝離、濕法蝕刻和標準清洗。等離子體產生的殘留物的出現(xiàn)(主要)是基于鋁、鎢和氧化硅的圖案化,因此有必要創(chuàng)造新類別的清潔材料,其中一些來自溶劑和蝕刻劑,另一些基于全新的反應化學,例如基于羥胺的清潔化學,以及其他高度工程化的配方混合物。
類似地,受產品性能需求的驅動,半導體行業(yè)在其產品中采用了越來越多的材料。因此,在半導體制造過程中需要清洗的PER的種類隨著時間的推移而增加,但在過去的一二十年中增長最快。沒有改變的是對PER清洗化學物質的一系列要求,簡單來說就是在經常出現(xiàn)敏感的金屬和電介質材料的情況下去除不需要的殘留物。這種去除需要在適中的溫度下快速完成,使用易于沖洗、干燥和化學處理的無害成分,并且成本合理。
材料和工藝需求的激增可能導致各種各樣的清洗化學物質,其中不同種類的化學物質被高度調整用于高度特定的工藝,例如Al線清洗、通孔清洗、銅鑲嵌蝕刻后清洗、Ti蝕刻劑/清洗組合、需要與“稀有”金屬如Co或Ru相容的清洗等。并且在某種程度上已經觀察到這種清潔產品的擴散。
尤其具有挑戰(zhàn)性的是在鉭、鋯和鉿等高k材料的等離子體蝕刻過程中產生的PER的清潔[3]。這些挑戰(zhàn)在早期對金屬氧化物和硅酸鹽進行構圖以用作氧化硅的替代柵極電介質的工作中被觀察到,并且隨著這些類型的材料在MIM(金屬-絕緣體-金屬)中使用的增加而持續(xù)至今去耦和其他電容器和其他電路元件[4]。眾所周知,這些物質具有很強的彈性,很難清除,當清洗過程中出現(xiàn)其他物質,尤其是鋁等金屬時,這一挑戰(zhàn)就變得更加嚴峻。
因此,與難熔金屬氧化物相關的清潔挑戰(zhàn)是在更具化學反應性的金屬和潛在的精密介電材料存在下去除PER并且更雄心勃勃地擴展能夠應對這一挑戰(zhàn)的化學制劑,以成功地實現(xiàn)其它清潔需求,例如上述那些。
解決這些挑戰(zhàn)的最新工作證明了技術水平的顯著提高,并通過精確控制氫氟酸水溶液與水和極性非質子溶劑的結合,建立了用于難熔金屬基殘留物的高選擇性濕法化學清洗產品。因此,稀釋的氫氟酸(DHF)經常被用作這些清洗過程中的活性成分

這項工作說明了這樣做的可能性,通過仔細控制I)溶液pH;ii)水含量和iii)當與弱酸和弱堿配制時,明智地選擇存在的旁觀者抗衡離子,以提供常見的活性物質(主要是水合氫離子、H3O+和氟化物F-)。
最佳pH值和反離子效應的確定。

進一步的研究和化學篩選證實了一些強酸具有很強的能力,能夠將pH值漂移到非常酸性的區(qū)域,從而提高高k基PER的蝕刻速率,同時提高整體鋁兼容性(圖1和圖2)。此外,還觀察到,根據(jù)酸的抗衡離子的性質、性質和大小,可以在金屬相容性和選擇性方面達到額外的性能。
低水環(huán)境中的蝕刻速率和清洗性能。針對不同的密度和摻雜劑量,描述并監(jiān)測了含氫氟酸(HF)的低水含量溶液對HfO2和SiO2的蝕刻速率行為;例如,在文獻[6]中報道,在7/1 DHF中,在35C下,TEOS的速度為12nm/min,濺射氧化物的速度為25-70nm/min[7]。為了進行比較,BOE 10% HF中的HfO2被蝕刻約3-5納米/分鐘,而鋁被蝕刻超過100納米/分鐘,新的配方和成分微調允許保持HfO2的蝕刻速率,同時阻止DHF混合物中的Al侵蝕(表II:Al ER < 1.5納米/分鐘)。
為了擴大這種配方組合的應用空間,在25°c時,在現(xiàn)在商業(yè)上稱為TechniClean IK 73的溶液中,為Ti和TiO2(圖3)以及其他常見材料(表1)生成了類似的數(shù)據(jù)。
Ti和TiO2數(shù)據(jù)非常有趣,說明了IK 73提供的選擇性以及可用于清洗Al/Ti基殘留物的工藝窗口的確定。紅線示出了覆蓋層Ti的去除,并且表明在60秒多一點的時間內沒有發(fā)生鈍化型Ti的去除。相比之下,沉積態(tài)TiO2的去除幾乎立即開始,因此在這種情況下(其中Ti和TiO2的厚度分別為x和y ),存在可用的工藝窗口(由垂直的藍色虛線示出),在該窗口期間,在Ti鈍化的侵蝕之前完全去除TiO2。雖然這些數(shù)據(jù)是關于橡皮布表面的,但是它們表明,結合表II中的值,這種方法對于通常被認為比涉及高k材料的清洗應用更敏感的清洗應用的適用性
審核編輯:符乾江
-
半導體
+關注
關注
334文章
27719瀏覽量
222699 -
蝕刻
+關注
關注
9文章
419瀏覽量
15509
發(fā)布評論請先 登錄
相關推薦
PCB線路板離子污染度的檢測技術與報告規(guī)范

深入剖析半導體濕法刻蝕過程中殘留物形成的機理
半導體濕法刻蝕殘留物的原理
芯片濕法刻蝕殘留物去除方法
參數(shù)分析儀的技術原理和應用場景
錫膏焊接后殘留物如何清洗?

焊接達人必修課:探究金屬材料焊接性的六大要素
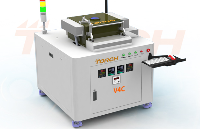
焊接高手進階指南:金屬材料焊接性的影響因素全解析
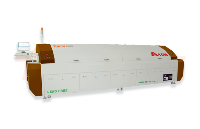
PCBA的助焊劑殘留有什么影響
適用于1-4節(jié)鋰離子電池和鋰聚合物電池BQ25672數(shù)據(jù)表





 適用于清潔蝕刻后殘留物的定制化學成分(1)
適用于清潔蝕刻后殘留物的定制化學成分(1)












評論