
5G手機SoC芯片領域,蘋果自研A15芯片,高通驍龍芯片,聯發科天璣系列芯片,海思麒麟芯片都是市場的主要參與者。臺積電作為全球最大晶圓代工廠,在先進制程領域對于手機SoC的支持也是相當到位。
臺積電(中國)有限公司技術總監陳敏表示,臺積的5納米已經量產超過3年,累計出貨超過200萬片,產品廣泛應用在大家的智能手機、AI,還有HPC的產品。臺積電的3納米產品研發進展非常順利,將在今年下半年實現量產,而2納米產品的量產預計會在2025年實現。
陳敏說:“5納米的家族,臺積電將提供了N4、N4P和N4X,這是5納米的新成員,通過新成員的增加使得客戶在5納米家族的產品可以獲得更好的PPA的表現。TSMC 3D Fabric先進封裝技術涵蓋 2.5D 和垂直芯片堆疊產,是臺積電過去10年以來對于3D IC的不斷完善和開發。客戶采用臺積3D Fabric所生產的產品取得的整個系統效能的提升,都有非常良好的表現。”
就3D Fabric在HPC上、手機上的應用發展。臺積電技術人員表示,wafer level 3D封裝并非在基板上實現,而是通過制造手段實現。這是Chiplet的典型方案,當芯片過于大時,需要將其切割成小芯片。臺積電的SoIC是由三顆Chiplet的小方案組成的。

3D Fabric 在HPC中的應用 HPC的高性能運算主要指網絡產品、網絡通訊產品、CPU、GPU以及使用AI的芯片產品,都屬于HPC的范疇。

這其中會用到一些比較大的芯片。正常芯片最大尺寸是800平方毫米,但GPU和AI芯片需要無限增大時,需要切割。 在HPC中,臺積電會用到3D Chip Stacking。這種流程包括兩種方式,一種方式是 Chip on wafer,就是將切割后的Chip直接放在晶圓上;另一種方式是wafer on wafer,就是直接將晶圓和晶圓對接。
臺積電的3D封裝分為三個類型:一,如果是高密度的互連。芯片需要和基板相連則會使用silicon imterposer,直接使用晶圓作為中介層,進行高密度的連接。二,如果兩個Die之間并非高密度互連,可能使用CoWoS-R或者InFo-2D的RDL。三、CoWoS-L處于以上兩種情況中間,在Die和Die之間高密度互聯區域中存在一個Local silicon。

在邏輯制程上,臺積電2022年已經達到3nm節點。 SoIC-CoW可以做到Top Die和Bondom Die達到7nm,bondingpitch達到9個micron,未來的技術指標將做到5nm和5nm的堆疊,6 micron的尺寸。 SoIC-WoW,達到7nm、0.13DTC。AMD發布的EPYC Processor中,將最占面積的緩存進行了3層的堆疊。 其他的封裝方案還有,CoWoS和InFo。 CoWoS方案上,臺積電推出了三種方式,CoWoS-S、CoWoS-R、CoWoS-L。CoWoS-S是CoWoS中臺積電能夠提供的最成熟技術。
3D Fabric的制造及生態鏈進展
目前,臺積電已經建成了全球第一個全自動化3D Fabric工廠,可以提供:SoIC、CoWoS、InFO、先進測試的服務。
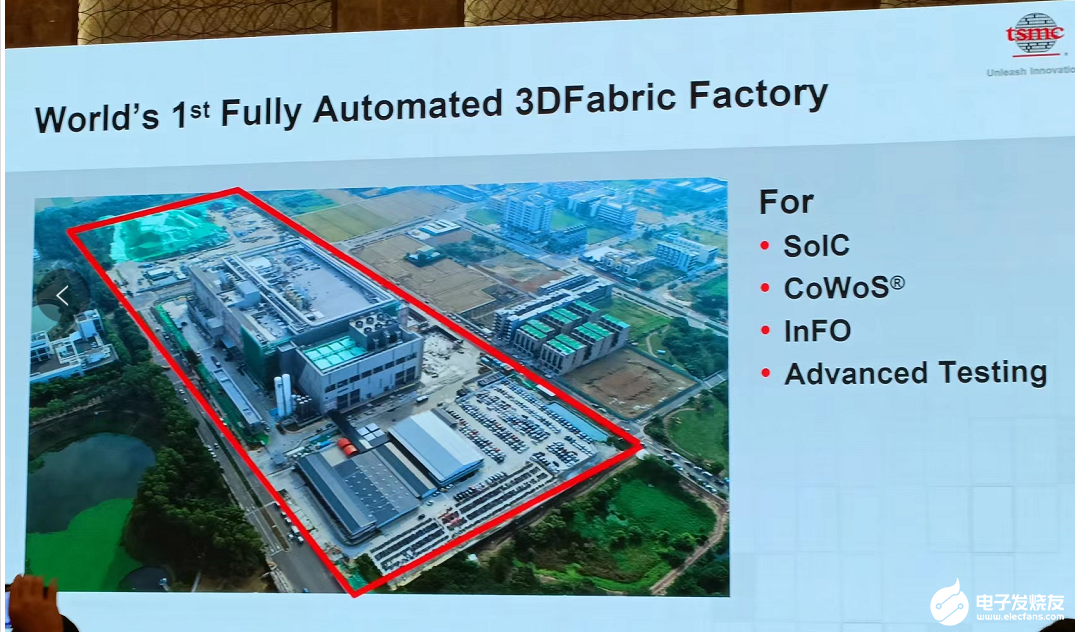
臺積電技術人員表示,3D Fabric仍然面臨著很大挑戰,對此臺積電也在努力推動工業的生態鏈建設,包括基板、存儲、散熱、封裝材料、設備的合作協同。
基板的尺寸大多停留在70*70mm的尺寸,但隨著芯片的逐漸增大,需要的基板尺寸也更大。如何驅動基板廠商與臺積電一起進一步改進,是其中一個問題。 在HPC方面,臺積電將與HBM供應商密切合作,定義和調整HBM3規范,以實現與CoWoS技術的強大工藝集成。在手機領域,將InFo-POP兼容性從定制擴展到主流LPDDR,實現InFO-B工藝與LPDDR組件的集成。 3D Fabric將釋放下一代創新力量。
本文由電子發燒友原創,轉載請注明以上來源。微信號zy1052625525。需入群交流,請添加微信elecfans999,投稿爆料采訪需求,請發郵箱zhangying@elecfans.com。
-
臺積電
+關注
關注
44文章
5685瀏覽量
166996 -
HPC
+關注
關注
0文章
324瀏覽量
23853 -
5G手機
+關注
關注
7文章
1355瀏覽量
51189
發布評論請先 登錄
相關推薦




 5G手機全球出貨量首次超過4G手機 臺積電3D Fabric技術如何助力手機和HPC芯片
5G手機全球出貨量首次超過4G手機 臺積電3D Fabric技術如何助力手機和HPC芯片










評論