3D封裝可大幅提高芯片性能 應用規模有望快速擴大
3D封裝是一種先進封裝工藝,采用三維結構形式對芯片進行三維集成,在不改變封裝尺寸的條件下,于垂直方向上疊加兩個或兩個以上芯片進行一體化封裝。
目前,5nm芯片已經量產。隨著工藝制程不斷縮小,芯片性能提升已經接近物理極限,摩爾定律失效,芯片無法再依靠集成更多的晶體管來提升性能,而市場對處理器與存儲器的計算性能、存儲能力要求還在不斷提高。3D封裝成為解決這一問題的重要方案,在保持芯片尺寸的同時可提高其性能,能夠滿足芯片小型化、高性能化發展需求。
3D封裝可將裸芯片、SoC(系統級芯片)、微電子元件等重新整合進行一體封裝,可以提高芯片性能、實現芯片功能多樣化。若多種電子元件各自封裝,整合在一起制造的半導體器件體積大且質量重,3D封裝集成度更高,運行速度更快,且其尺寸大幅縮小、重量大幅降低、能耗更低,可用于處理器、存儲器等制造領域。
國內外眾多半導體廠商均在發展3D封裝技術,例如英特爾、AMD、臺積電、華為、三星、日月光、安靠科技長電科技、華天科技等,包括芯片設計、制造以及專業封裝廠商。2022年8月,英特爾宣布14代酷睿處理器將采用3D封裝技術。在芯片頭部廠商的帶動下,未來3D封裝應用規模有望快速擴大。
審核編輯 :李倩
-
芯片
+關注
關注
456文章
51192瀏覽量
427323 -
3D封裝
+關注
關注
7文章
135瀏覽量
27209
原文標題:3D封裝可大幅提高芯片性能 應用規模有望快速擴大
文章出處:【微信號:西安集成電路,微信公眾號:西安集成電路】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
SciChart 3D for WPF圖表庫
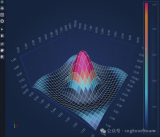
3D打印技術,推動手板打樣從概念到成品的高效轉化
3D封裝玻璃通孔技術的開發

NEO推出3D X-AI芯片,AI性能飆升百倍
探秘2.5D與3D封裝技術:未來電子系統的新篇章
YXC晶振 32.768KHz石英振蕩器,封裝3225,應用于3D打印機
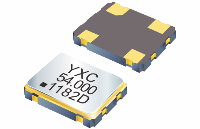




 3D封裝可大幅提高芯片性能 應用規模有望快速擴大
3D封裝可大幅提高芯片性能 應用規模有望快速擴大















評論