01
后段加速
當質譜儀選擇了所需的離子后,離子將進入后段加速區域,射束電流與最后的離子能量被控制在該區內,離子束電流利用可調整的葉片控制,而離子能量則由后段加速電極的電位控制。離子束的聚焦和射線形狀被界定孔徑及電極控制。下圖顯示了射束電流控制及后段加速裝置。
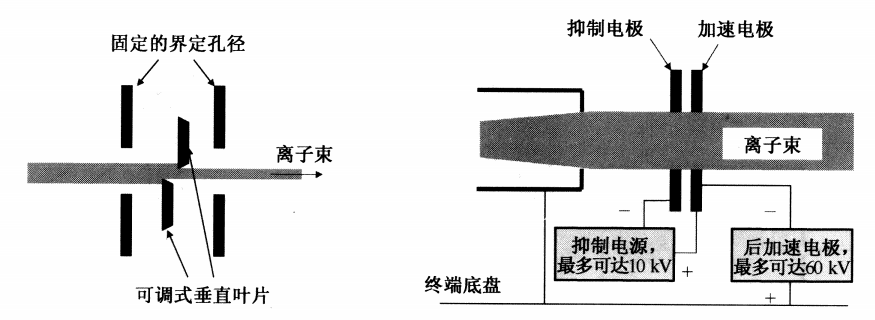
對于主要用于阱區與深埋層注入過程的高能離子注入機,需要將數個高壓加速電極沿著射線方向串聯在一起,這樣可以將離子加速到幾百萬電子伏(MeV)的能量等級。應用在超淺型結(USJ)注入的離子注入機,特別是用于P型硼的注入,后段加速電極以反向方式連接,這樣離子束才會在經過該電極時被減速而不是被加速,產生能量低于0.1keV左右的純凈離子束。
某些注入機后段加速之后,將用一個電極將離子束彎曲一個小角度,例如10°,從而有助于擺脫高能量的中性粒子。當離子的軌跡彎曲并向晶圓移動時,中性粒子保持直線運動(見下圖)。有些注入系統將離子彎曲兩次,并形成“S”形軌跡,這樣可以獲得純度更高的離子源。
02
電荷中性化系統
當離子注入進入硅襯底時,會將正電荷帶入晶圓表面。如果正電荷一直積累,就可能造成晶圓的帶電效應。帶正電荷的晶圓表面將傾向于排斥正離子,這樣將引起所謂的射線放大和不均勻的離子注入,并導致整個晶圓上的摻雜物分布不均勻(見下圖)。

當表面電荷濃度過高時,電荷產生的電場可能高到足以使薄的柵氧化層擊穿,從而將嚴重影響集成電路芯片的成品率。當積累的正電荷增加到某一程度時,會以電弧的形式放電,電弧的火花將在晶圓表面上造成缺陷。
為了處理晶圓帶電問題,需要使用大量帶負電荷的電子中和晶圓表面的正離子。有幾種方法可以使晶圓中性化:等離子體注入系統、電子槍和電子淋浴器都可以提供電子中和正離子,將晶圓的帶電效應降到最低。下圖顯示了一個等離子體注入系統。
在等離子體注入系統中,熱電子從熱的鴇絲表面發射出來并通過直流電源加速。這些熱電子將在反應室中與中性原子碰撞產生帶有電子與離子的等離子體。等離子體中的電子會被吸入離子束中與離子一起流向晶圓表面,形成的等離子體將中和晶圓并將晶圓的帶電效應降到最低。
下圖說明了一個電子槍系統。熱電子由熱燈絲產生并以高能量加速到電子靶上。電子與靶碰撞后產生大量二次電子,這些二次電子由靶的表面通過撞擊離開表面后與離子束一起流向晶圓中和晶圓表面的正離子。
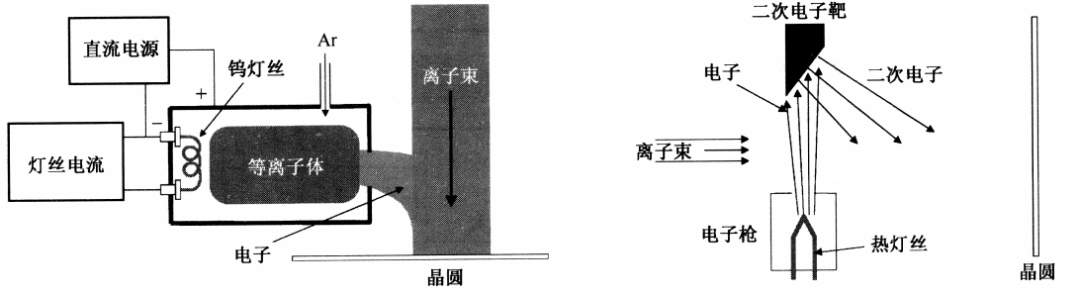
03
晶圓處理器
晶圓處理器最重要的作用是在整個晶圓表面形成均勻的離子注入。離子束的直徑大約為25mm(約1in)。通常需要移動離子束或移動晶圓,而且有些注入機中兩者都需要移動,通過移動使離子束均勻掃描整個晶圓,晶圓直徑可以是300mm的大尺寸。
對于旋轉輪系統,旋轉輪能高速自旋。當晶圓通過離子束時,離子會以離子束的弧形帶狀形式注入到晶圓的部分區域。轉輪的中心會前后擺動,從而可以使離子束均勻地掃描到旋轉輪的每個晶圓部分。下圖說明了一個旋轉晶圓的支撐系統。
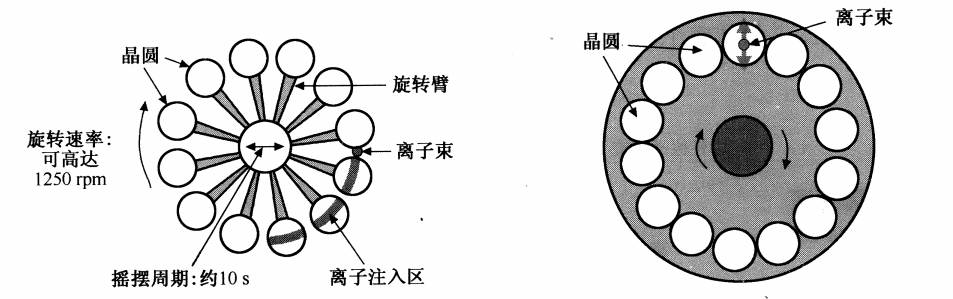
-
處理器
+關注
關注
68文章
19409瀏覽量
231196 -
集成電路
+關注
關注
5392文章
11624瀏覽量
363199 -
晶圓
+關注
關注
52文章
4977瀏覽量
128318 -
質譜儀
+關注
關注
0文章
48瀏覽量
11062
原文標題:半導體行業(一百八十)之離子注入工藝(十)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
半導體制造之離子注入工藝
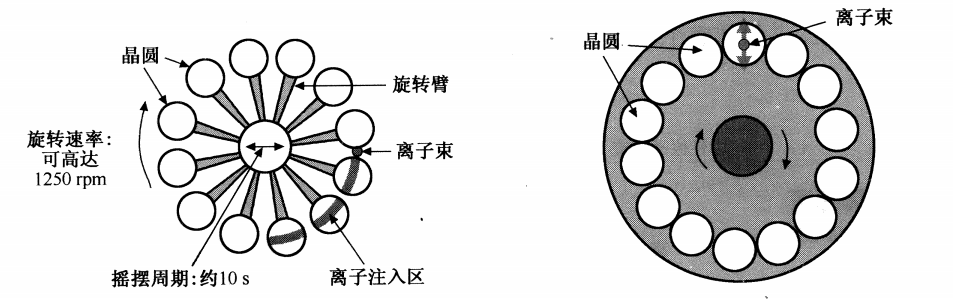




 半導體行業之離子注入工藝(十)
半導體行業之離子注入工藝(十)


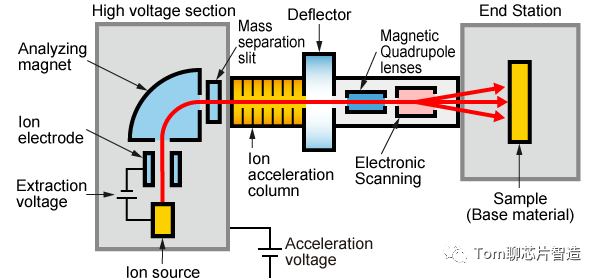
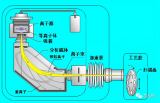











評論