電子通訊產品發展經歷了 1G、2G、3G、4G等幾個階段,目前正邁向第 5 代通訊產品階 段,作為第5代電子通訊,與 4G 相比,5G 在峰值速率、頻譜效率、時延等方面都發生了重 大變化,這給 PCB 和覆銅板材料提出了新的要求,本文章將從 5G 通訊終端產品角度出發, 提出對 PCB 技術、覆銅板技術以及上下游銅箔、玻璃布、樹脂等技術需求,為PCB行業相關領域提供參考。
一、5G關鍵技術指標分析
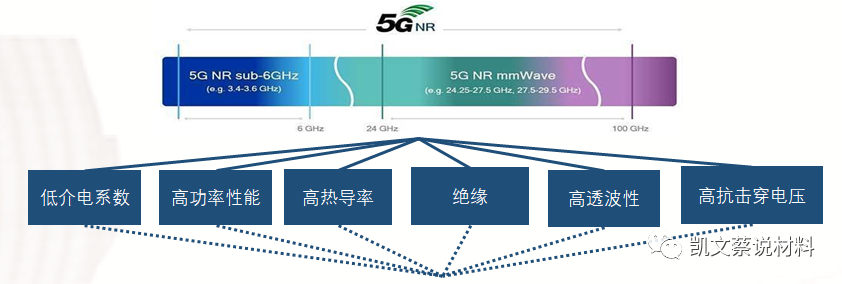
5G產品將給大家帶來無限美好的移動互聯憧憬和體驗,從技術上來講,需要面對很多 挑戰,通過解決這些問題,必將帶來很多技術上的突破和提升。
在5G時代,會有大量MIMO天線應用,在Massive MIMO天線中,由于天線通道數量 的增加,每個天線通道在功率放大器中所對應的通道數也會相應增加,而這一變化會導致功率放大器的整體功率增加,從而需要功率放大器具備更高的功率效率,而作為提升功率效率的辦法之一,如何降低承載功率放大器的PCB板材的損耗、提升PCB板材的導熱率變得尤為重要。
另外,MassiveMIMO天線中輻射單元數量增加,要求PCB板材的硬度更高,以提供更好的支撐效果,并且電路的復雜度增加,較傳統雙面PCB天線而言,多層板天線應用會越來越多。
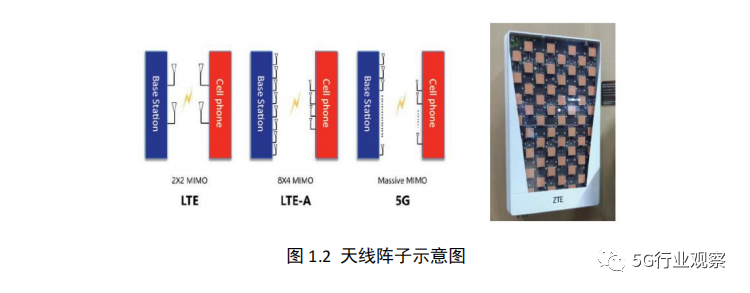
二、5G通訊產品對PCB技術要求和技術難點

隨著通訊產品體積小型化、容量反而增加的趨勢下,嚴重擠壓了產品前端的設計空間, 為了緩解這種設計壓力,通訊芯片廠商只有選擇研發更高速率的IC產品,以滿足大容量、小體積的產品需求。然而速率增加后對于信號完整性工程師的壓力并未緩解反而加重,高速率產品可以使用更少的走線來實現,但速率的增加直接導致信號質量的嚴要求,且裕量越來越少。在10Gbps信號下,信號的UI可以達到100ps的位寬,但在25Gbps信號下,信號的位寬只有40ps,這就意味著在通道的每一個環節都要進行優化設計來爭取每一個ps的裕量。

上圖是一條典型的高速系統全鏈路示意圖,從Driver IC的封裝開始到Receiver IC的封裝 結束,這其中包含IC封裝設計、子卡1PCB設計、背板PCB設計、子卡2PCB設計。對于高速率信號,需要保證主板PCB的成功設計和加工才能保證整條通道信號質量。
5G通訊,作為第五代移動通訊產品,應用了很多新的技術,但無論如何都離不開PCB這個載體,對于PCB的要求越來越嚴苛,尤其是對于PCB基板材料、加工工藝、表面處理等提出非常高的要求。
5G通訊產品工作頻率不斷攀升,對印制板制作工藝帶來新要求,毫米波PCB通常是多層結構,微帶線和接地共面波導電路通常位于多層結構的最外層。毫米波在整個微波領域中屬于極高頻率(EHF)范圍,頻率越高,要求的電路尺寸精度要越高。
2.1.15G與4G對PCB工藝能力要求對比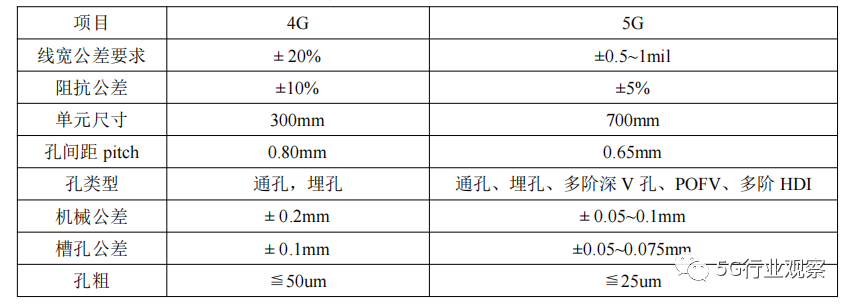
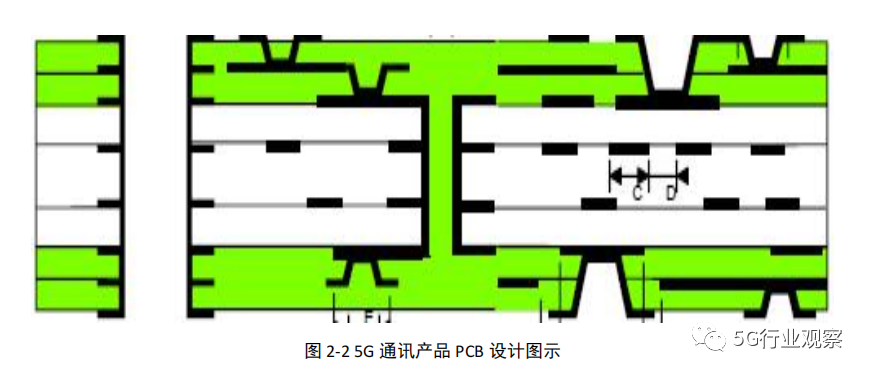
2-2 5G 通訊 PCB 技術難點
5G芯片要求PCB 孔間距更小,最小孔壁間距達 0.20mm,最小孔徑 0.15mm,如此高密 布局對CCL 材料和 PCB 加工工藝都帶來巨大挑戰,如 CAF 問題,受熱孔間裂紋問題等。
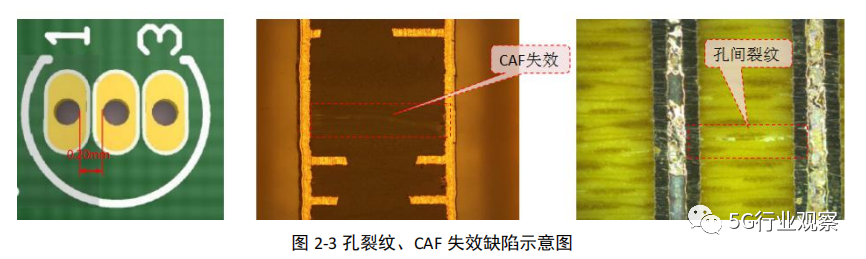

2-3 焊盤起翹
高速高頻PCB為減少信號損耗,希望采用高速材料,并且孔環盡可能小,從孔環5.0mil減小到3.0mil,但高速材料銅箔與樹脂結合力比常規FR4材料要低,再使用小孔環,PCB在經過回流或波峰焊時,由于熱應力沖擊,就發生焊盤起翹或表層PP樹脂開裂缺陷,見下圖2-5。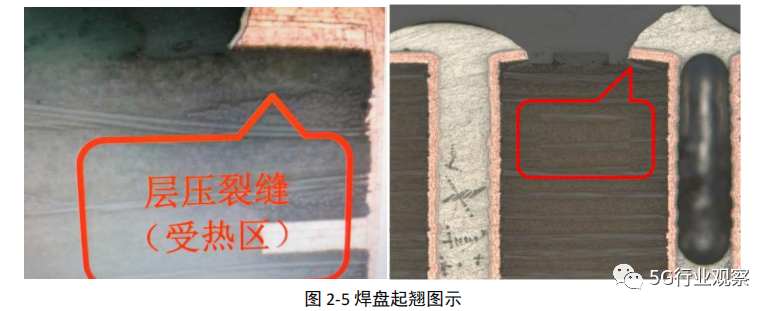 解決方案:高速發展是趨勢,孔環會越來越小,為減少焊盤起翹或PP層開裂缺陷,需 要在樹脂流動性和壓合工藝參數上進行工藝優化。
解決方案:高速發展是趨勢,孔環會越來越小,為減少焊盤起翹或PP層開裂缺陷,需 要在樹脂流動性和壓合工藝參數上進行工藝優化。三、5G通訊對高速高頻覆銅板技術要求

5G通訊產品要求更高頻率和速率,高速高頻信號關注傳輸線損耗、阻抗及時延一致性, 最后在接收端能接收到合適的波形及眼圖,眼圖張開的寬度決定了接收波形可以不受串擾影響而抽樣再生的時間間隔。顯然,最佳抽樣時刻應選在眼睛張開最大的時刻,睜開眼圖的塌陷是由損耗直接引起,介質損耗Df 越小眼圖高度越大,噪音容量越大。
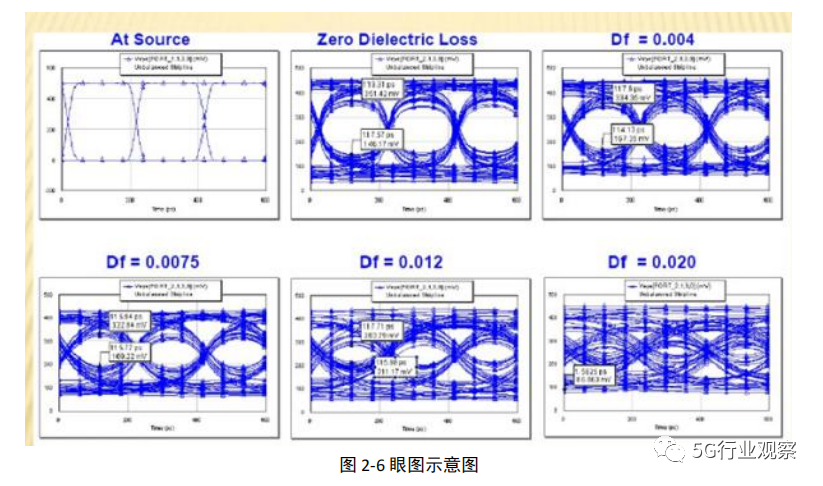
3-1 更低損耗覆銅板材料要求
未來3-5年,萬物互聯5G通訊量產,天地互聯6G將開始預研,將要求高速覆銅板技 術向更低損耗Df,更低介電常數Dk、更高可靠性、更低CTE技術方向發展。相應的,覆銅板主要組成銅箔、樹脂、玻璃布、填料等也要同步往這個方向發展。3.1.1 更低損耗的樹脂材料
要滿足5G通訊高速產品要求,傳統FR4環氧樹脂體系已不能滿足要求,要求覆銅板樹 脂Dk/Df更小,樹脂體系逐漸往混合樹脂或PTFE材料靠近。見下圖所示。
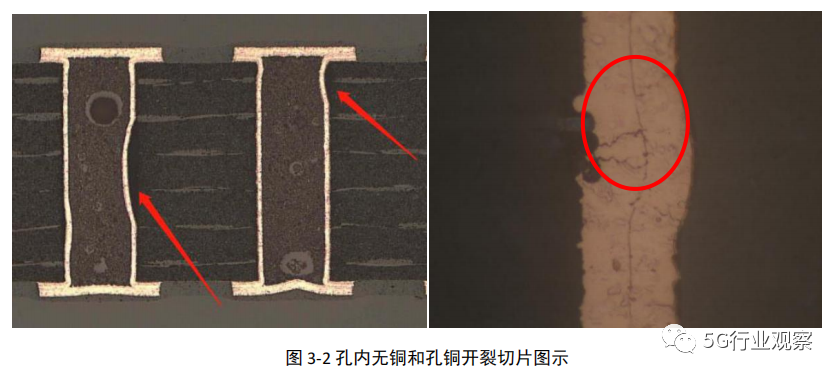
3.1.2 更低粗糙度的銅箔技術
對于高頻PCB而言,高頻CCL材料非常重要,包括基板材料Dk/Df、TCDk、介質厚度穩定性以及銅箔類型等。圖1展示了PCB簡單橫截面圖,其中銅層1(頂部)和層2是用于高頻性能的關鍵層,其中層1是信號導體,層2是接地層。在該介質上傳播的高頻波的大部分電場位于層1的底部和層2的頂部之間,因為信號導體邊緣的電場集中度較高。
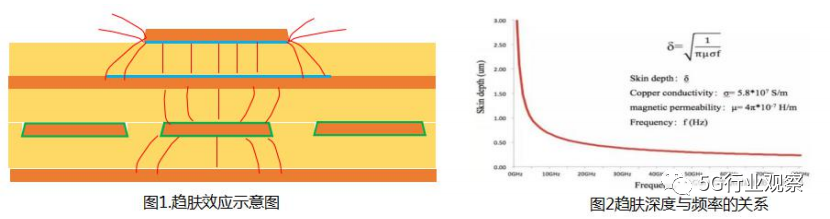


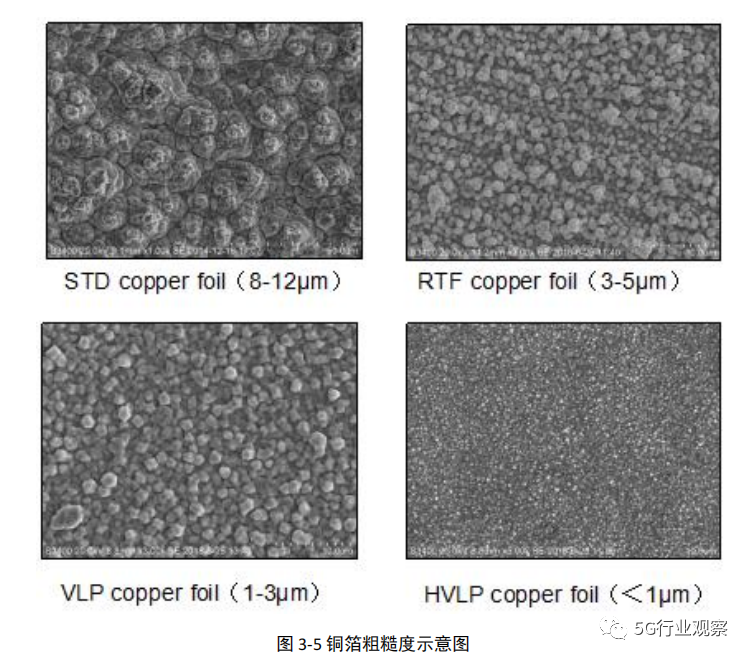
3.1.3 低損耗和低膨脹率的玻璃布技術
要滿足5G通訊產品高速PCB設計及100x100mm大尺寸芯片應用要求,需要高速覆銅板玻璃布的Dk/Df更小,CTE更小。若材料CTE過大,在PCBA組裝焊接時會發生焊點開裂等缺陷,見圖3-6所示。若要開發出Low CTE的高速覆銅板,要求玻璃布的CTE≦3.0ppm/℃等。要達到這個CTE的要求,就需要對玻璃絲原料配方和拉絲工藝技術進行革新,制備出更低CTE的玻璃布,以滿足5G或6G通訊技術需求。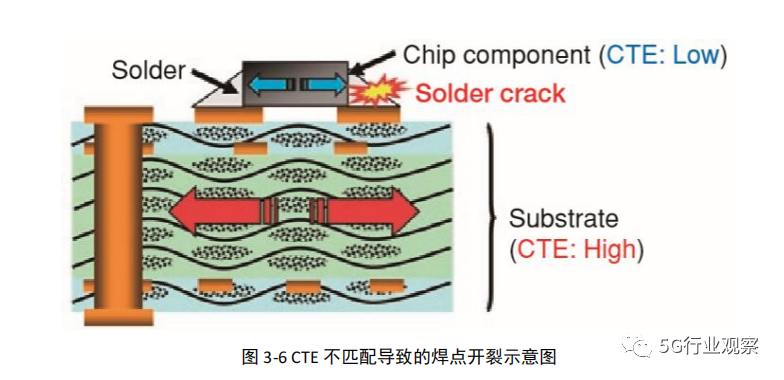
3-3 介質厚度穩定性
介質層結構、組成和厚度的均勻性和波動變化程度影響著特性阻抗值,在相同厚度的介 質層下,分別由106、1080、2116和1035與樹脂組成的介質層,其特性阻抗值是不相同的, 因此可以理解PCB各個介質層中各處的特性阻抗值是不一樣的。所以,在高頻化和高速數字化信號傳輸5G高頻PCB,需要選擇薄型化玻纖布或開纖扁平布為宜,以減少特性阻抗值的波動。批次間材料Dk值必須控制在一定范圍內,介質層厚度均勻性要好。確保Dk變化 值在0.5以內。
3-4 更高導熱率覆銅板板材
一般散熱思路是從電路效率和損耗角度評估溫度上升情況,通過仿真發現,降低材料的Df值來降低溫升的方法,不如選用更高導熱率(TC)的方法有效,對于5G高頻板要選擇相對薄的基板材料,同時選擇高導熱率、銅箔表面光滑、低損耗因子等材料特性有利于降低毫米波頻段下電路的發熱情況。見下圖3-8所示。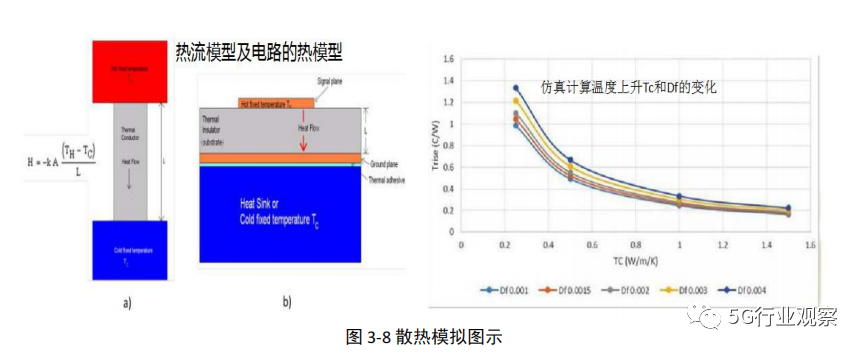
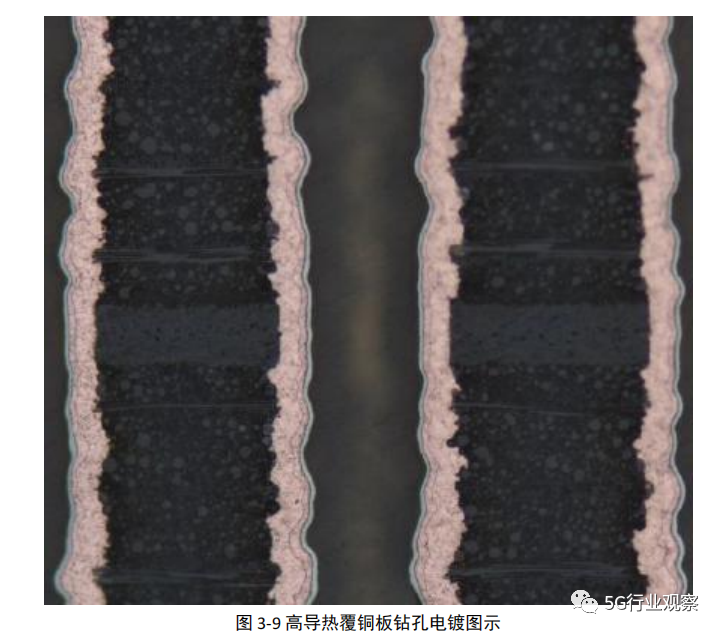
3-5 更高可靠性覆銅板板材
5G通訊產品集成度越來越高,PCB設計密度已從孔間距0.55mm減小到0.35mm,多階HDI工藝單板PCB板厚由3.0mm提升到5.0mm,MOT溫度要求由130℃提升到150℃,要求覆銅板板材耐熱性更好,耐CAF性能也要更高。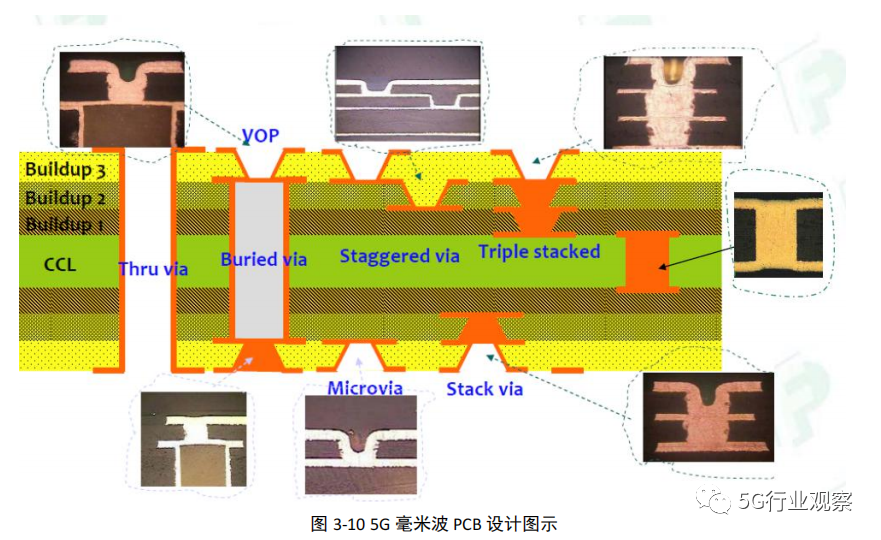
四、5G通訊國內高速高頻銅板技術現狀

五、高速高頻覆銅板發展趨勢

未來通訊產品的速率越來越高,112G基本確定會采用PCB方案,同時224G業界標準已經啟動,從最近的標準會議和業界各個行業的動態來看,224G也可能采取PCB方案,這對高速覆銅板技術演進是非常有利的,但224G技術需要覆銅板技術有本質的提升和技術創新,覆銅板板材向更低介電常數、更低介電損耗、更低CTE、更低吸水率、更高Tg值、更高導熱率方向發展。如下圖5-1所示,覆銅板介質損耗將由目前的-0.70dB/inch降低到-0.60dB/inch, 甚至更低。
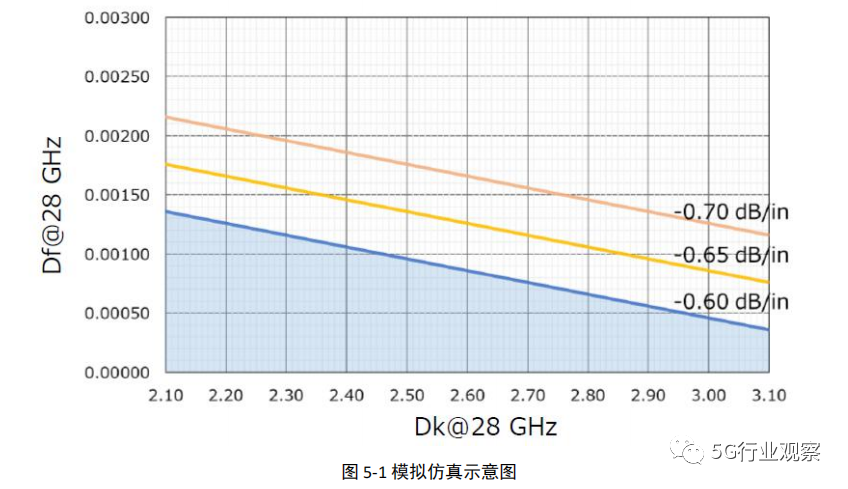
5.1 新的熱固性樹脂將會有更低的Dk/Df和高可靠性
為滿足后5G通訊224G速率高速產品低損耗電性能要求,高速覆銅板的損耗因子將會在112G材料基礎上再提升30%,材料Df≦0.001,新型熱固性樹脂體系由PPO樹脂體系發展為混合樹脂。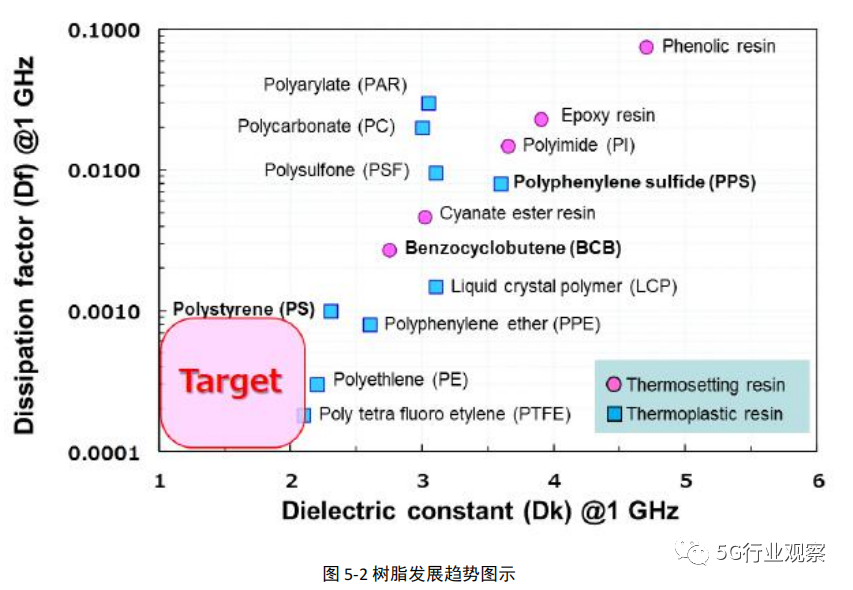
5.2 新的玻璃布具有更低Dk和CTE
玻璃布會由E-Glass布發展到Q-Glass布,low Dk/Df玻璃布在差分線和微帶線上Loss更小。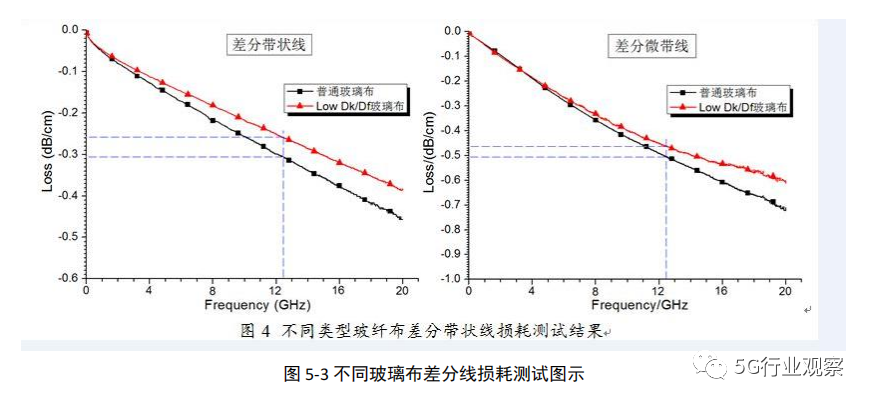
5.3 更低粗糙度銅箔技術
未來通訊產品信號會走到表層,要求銅箔粗糙度越來越小,最終銅牙大小會趨近于零, 但粗糙度降低,如何保證銅箔與基材結合力是覆銅板行業需要解決的問題之一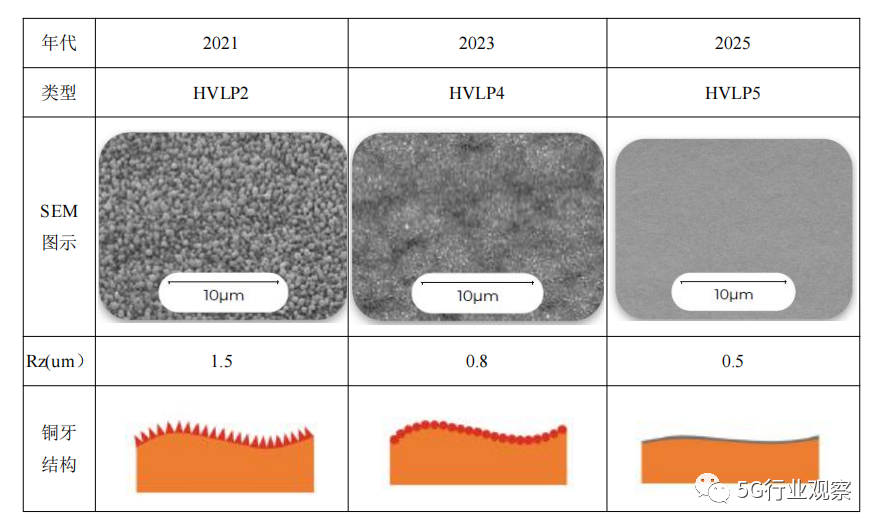
5.4low Dk/Df填料技術
新填料技術將取代舊的填料技術,新填料直徑會更小,Dk/Df更小、導熱率更高,與樹 脂兼容性會更高,但PCB鉆孔難度不能加大。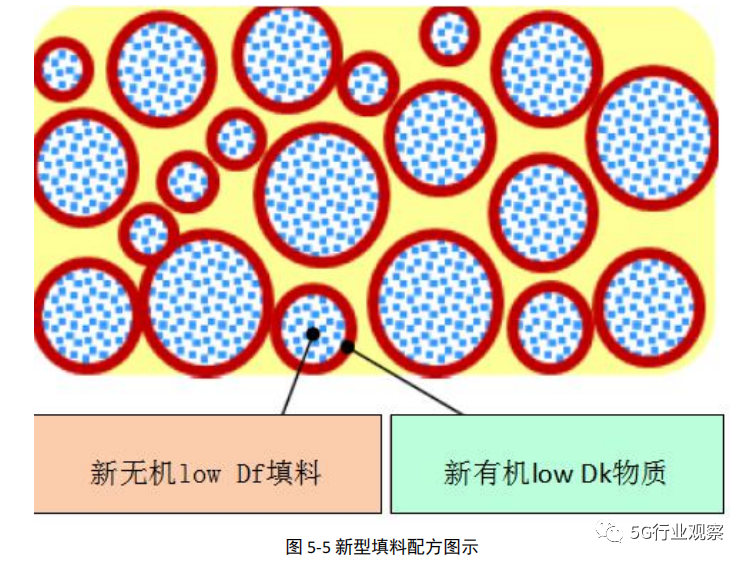
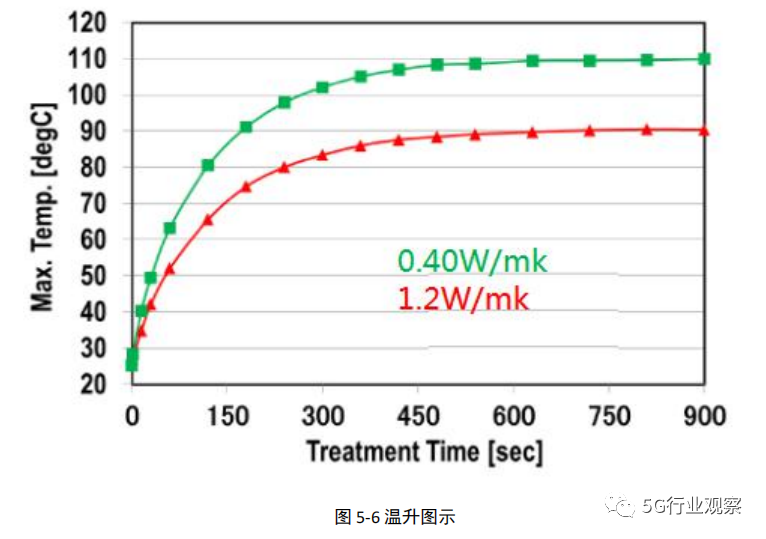
-
pcb
+關注
關注
4326文章
23160瀏覽量
399946 -
5G
+關注
關注
1356文章
48504瀏覽量
566006
發布評論請先 登錄
相關推薦
毫米波雷達的基頻和調制技術 毫米波雷達在機器人導航中的應用
5G毫米波市場蓬勃發展的因素
蘋果自研5G芯片獲重要進展,毫米波技術暫缺席
5G毫米波測試助力突破高頻段設備局限,實現高效外場測試

毫米波雷達是聲波還是電磁波
毫米波雷達具有哪些特點和優勢
愛立信與高通、Dronus共同完成使用5G毫米波無人機的制造與倉儲用例測試
Qorvo收購Anokiwave,以硅晶創新推動毫米波5G商業化





 5G毫米波通訊對高頻PCB覆銅板的技術要求
5G毫米波通訊對高頻PCB覆銅板的技術要求













評論