鍍銀晶圓的材料特性
晶圓經過背面研磨減薄后,經由背面蒸鍍金屬,切片加工而成的芯片將在器件熱阻降低、工作散熱和冷卻、封裝厚度減薄等各個方面實現很大的改善。
在晶圓背面金屬化過程中,一般選擇鈦、鎳、銀作為三層背面金屬,厚度在10μm以內。
通常,切割的晶圓的質量標準是:如果背面碎片的尺寸在10μm以下,忽略不計,當尺寸大于25μm時,可以看作是潛在的受損,50μm的平均大小可以接受。當然,具體切割要求也要根據晶圓的厚度來定。
鍍銀晶圓的應用
晶圓背面金屬化的主要目的是使接觸電極形成良好的歐姆接觸,經過背面金屬化的芯片具有飽和壓降小、焊接可靠、通態源漏電阻小、散熱性好、工作能耗低等特點,常用于中小功率晶體管。
選刀要點
切片系統與刀片之間的協作是必要的,刀片在晶圓切片工藝優化中起著主要的作用。金剛石尺寸、金剛石含量和粘結劑的類型,是決定刀片特性的三個關鍵參數,決定著刀片的壽命和切削質量,改變任何一個這些參數都將直接影響刀片特性與性能。為一個給定的切片工藝選擇最佳的刀片需要在刀片壽命與切削質量之間作出平衡。


西斯特科技
深圳西斯特科技有限公司 (簡稱西斯特SST) ,以“讓一切磨削加工變得容易”為主旨,倡導磨削系統方法論,2015年金秋創立于深圳,根植于技術創新的精神,屹立于創造價值、追求夢想的企業文化。
基于對應用現場的深度解讀、創新性的磨具設計和磨削系統方法論的實際應用,西斯特秉承先進的磨削理念,踐行于半導體、消費電子、汽車零部件等行業,提供高端磨具產品以及“切、磨、鉆、拋”系統解決方案,在晶圓與封裝基板劃切、微晶玻璃和功能陶瓷磨削、汽車零部件精密磨削等領域應用廣泛。
西斯特科技始終以先進的技術、創新的產品、優質服務的理念,引領產業革命,創造無限可能。
-
晶圓
+關注
關注
52文章
4976瀏覽量
128315
發布評論請先 登錄
相關推薦
從晶圓到芯片:劃片機在 IC 領域的應用
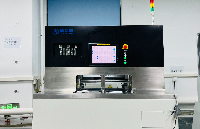
晶圓背面涂敷工藝對晶圓的影響


怎么制備半導體晶圓片切割刃料?

碳化硅晶圓和硅晶圓的區別是什么
Monaco 新款 50W 紫外飛秒激光器,助力晶圓和堆疊 OLED 屏的高效切割

一文看懂晶圓級封裝





 案例分享第七期:背銀晶圓切割實例
案例分享第七期:背銀晶圓切割實例
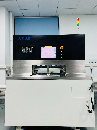
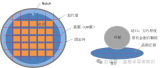















評論