硅通孔(TSV)有望成為電子器件三維芯片堆疊技術(shù)的未來(lái)。TSV互連的結(jié)構(gòu)是通過(guò)首先在晶片表面蝕刻深過(guò)孔,然后用所需金屬填充這些過(guò)孔來(lái)形成的。目前,銅基TSV是最具成本效益的大規(guī)模生產(chǎn)TSV。一旦過(guò)孔的頂部和底部都暴露出來(lái),用銅填充的過(guò)孔就可以通過(guò)晶片提供互連。這提供了由晶片隔離和保護(hù)的堅(jiān)固耐用的互連。它還提供了使用小得多的體積的互連,同時(shí)減少了對(duì)與現(xiàn)代微電子封裝相關(guān)的大多數(shù)封裝的需求。本工作使用兩種方法生產(chǎn)銅基TSV,即ADE方法和盲孔方法。ADE方法引入了一種獨(dú)特的工藝,該工藝可能與后微電子制造兼容。對(duì)兩種方法制造的TSV進(jìn)行橫截面分析,結(jié)果表明成功形成了固體銅TSV。
隨著現(xiàn)代微電子技術(shù)的封裝尺寸迅速縮小,摩爾定律開始準(zhǔn)確地描述集成電路所能容納的技術(shù)數(shù)量的限制。單電子晶體管的開發(fā),如SketchSET;然而,這讓我們看到了晶體管縮放的終結(jié)[1]。隨著摩爾定律的終結(jié),一種更新的方法出現(xiàn)了,稱為“不止摩爾”。這一新趨勢(shì)試圖通過(guò)減小設(shè)備的封裝尺寸來(lái)改進(jìn)系統(tǒng)。這最終提供了更高的組件密度。這將電子世界從經(jīng)典的多芯片模塊(其中多個(gè)芯片用于不同的功能)轉(zhuǎn)變?yōu)槠舷到y(tǒng)(SOC)模型,該模型將所有東西集成到單個(gè)芯片中。然而,用目前的傳統(tǒng)方法生產(chǎn)這種芯片可能是困難的。
封裝尺寸的主要限制因素之一來(lái)自芯片的互連。現(xiàn)代技術(shù)大量使用引線鍵合,這可能需要很少的材料體積,但由于使用引線鍵,它們浪費(fèi)了更多的三維空間。這是因?yàn)闆]有什么能與它們接觸,迫使它們?cè)诳臻g上與芯片和彼此分離。此外,它們必須使用更多的材料進(jìn)行電氣隔離。引線鍵合的主要替代方案是利用硅通孔(TSV)。TSV是穿過(guò)晶片或芯片的互連,允許通過(guò)襯底的電連接。這項(xiàng)技術(shù)正開始在許多不同的設(shè)備中進(jìn)行商業(yè)應(yīng)用,它在包括相機(jī)[2]、攝像機(jī)和DRAM在內(nèi)的許多潛在應(yīng)用中顯示出了良好的前景。
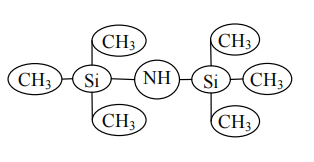
機(jī)械鉆孔在微觀尺度上和在宏觀尺度上是一樣的。它使用的鉆頭比所鉆的孔小,并且由足夠堅(jiān)固的材料制成,以承受與鉆孔相關(guān)的力(即硬質(zhì)合金)[17]。機(jī)械鉆孔的縱橫比可以>10,盡管特征尺寸必須大于300μm,并且粗糙度被認(rèn)為是“平均值”[18]。平均側(cè)壁粗糙度是由于鉆頭的不均勻性,以及可能由于鉆孔力/磨損而產(chǎn)生的微變形。盡管縱橫比和粗糙度可能適用于TSV程序,但特征尺寸太大,在商業(yè)上不可行。
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
456文章
51192瀏覽量
427352 -
封裝
+關(guān)注
關(guān)注
127文章
7997瀏覽量
143417 -
TSV
+關(guān)注
關(guān)注
4文章
115瀏覽量
81569
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
玻璃通孔(TGV)技術(shù)深度解析
芯片先進(jìn)封裝硅通孔(TSV)技術(shù)說(shuō)明

先進(jìn)封裝中的TSV/硅通孔技術(shù)介紹

用平面錐制造100μm深10μm寬的高縱橫比硅通孔

利用全息技術(shù)在硅晶圓內(nèi)部制造納米結(jié)構(gòu)的新方法
硅通孔三維互連與集成技術(shù)

華林科納PFA管在換熱器中的應(yīng)用
一文了解硅通孔(TSV)及玻璃通孔(TGV)技術(shù)

激光微納制造技術(shù)
一文解鎖TSV制程工藝及技術(shù)

基于兩步刻蝕工藝的錐形TSV制備方法





 華林科納的一種新型的硅通孔 (TSV) 制造方法
華林科納的一種新型的硅通孔 (TSV) 制造方法

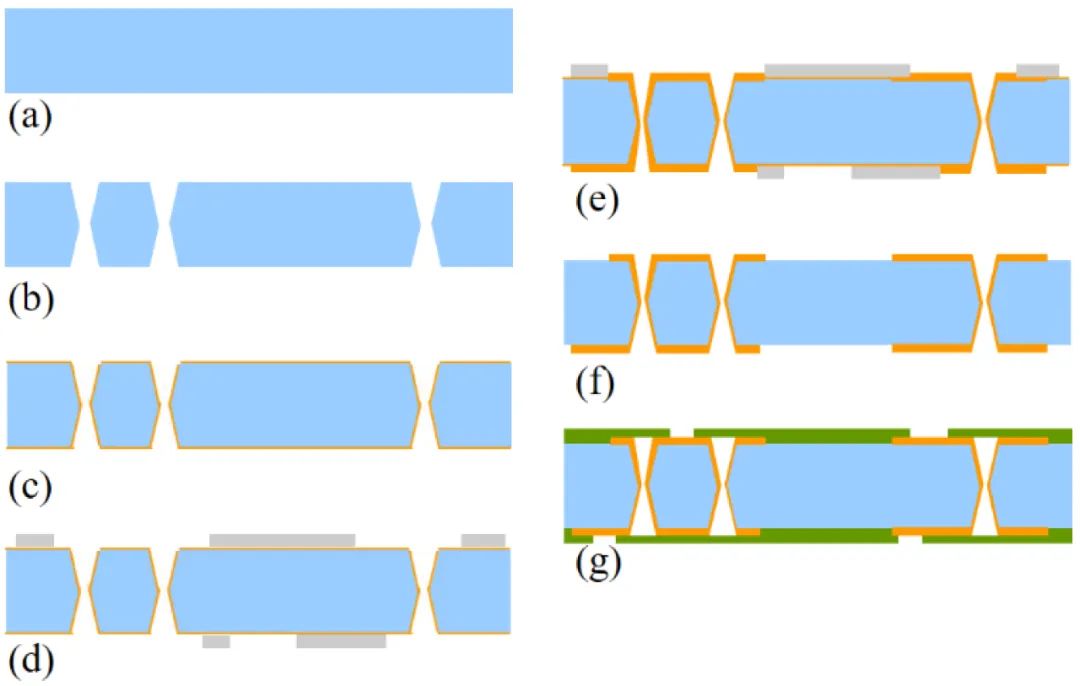












評(píng)論