電子發(fā)燒友網(wǎng)報道(文/李寧遠(yuǎn))先進(jìn)芯片封裝的發(fā)展不可謂不快,根據(jù)Yole統(tǒng)計數(shù)據(jù),2021年到2027年先進(jìn)封裝占比不斷攀升,其中2.5D/3D先進(jìn)封裝市場收入規(guī)模年復(fù)合增長率最高,在先進(jìn)封裝多個細(xì)分領(lǐng)域中位列第一。
封裝的另一大趨勢則是小型化,現(xiàn)階段更小、更薄、更高密度的封裝結(jié)構(gòu)已成為行業(yè)新常態(tài)。為了滿足各種設(shè)計場景對封裝尺寸的苛刻要求,諸多封裝技術(shù)已經(jīng)不再使用膠水來進(jìn)行芯片粘接,而是會選擇使用芯片粘貼膠膜。
引線鍵合封裝的市場趨勢與挑戰(zhàn)
在集成電路封裝互連中,芯片和基板的連接為電源和信號的分配提供了電路連接,引線鍵合是其中很常用的方案。引線鍵合即是使用導(dǎo)線或金屬線(常見的為金線、銀線和銅線)與芯片或其他電子元件的引腳連接起來。
從整個行業(yè)大趨勢來說,由于逐漸逼近物理極限,摩爾定律正在走向終點(diǎn),而且通過工藝節(jié)點(diǎn)的微縮來提升芯片性能這條路線越來越難,成本越來越高。通過封裝優(yōu)化電連接來提升性能變得越來越重要。
引線鍵合作為適配性很廣的封裝,一直在不斷升級。在各個工藝步驟不斷優(yōu)化的發(fā)展下,引線鍵合更高的點(diǎn)性能和更短的引線連接推動了封裝的小型化發(fā)展。現(xiàn)在引線鍵合已經(jīng)可以做到小于80um的芯片厚度以及小于0.3mm的封裝體厚度。
而引線鍵合封裝為了滿足各種設(shè)計場景對封裝尺寸的苛刻要求,其中的芯片粘接環(huán)節(jié)就面臨著不少挑戰(zhàn)。此前的粘接,都使用膠水,膠水的好處是粘接較為靈活,可以使用各種形狀來粘接。不過芯片粘接膠面對不同芯片尺寸需要不同的點(diǎn)膠圖案并對DA的參數(shù)進(jìn)行不同的優(yōu)化。
在DA和固化過程中,還會面臨樹脂溢出,芯片爬膠,材料固化收縮以及揮發(fā)物多的問題。這會導(dǎo)致封裝完成后的種種缺陷。比較常見的缺陷有膠層厚度不一致、膠層存在空洞以及封裝界面分層等。
而且現(xiàn)在很流行芯片堆疊,使用膠水來進(jìn)行堆疊其難度不言而喻,同時也無法保證堆疊一致性。
膠膜解決芯片粘接困難
為了解決封裝環(huán)節(jié)的芯片粘接越來越麻煩的問題,膠膜開始在越來越多的芯片設(shè)計中替代傳統(tǒng)的粘接膠水。
與膠水相比,芯片粘貼膠膜能夠提供可控的厚度和流動性、不會發(fā)生樹脂滲出現(xiàn)象,而且具有均一的爬膠,固化前后均能保持膠層穩(wěn)定性。在穩(wěn)定性上更有把握的芯片粘貼膠膜在應(yīng)對各種設(shè)計場景對封裝的苛刻要求上表現(xiàn)得更為穩(wěn)定。
和我們平時使用膠水一樣,芯片在使用粘接膠水時容易把粘接材料擠壓到芯片表面,低溢出的粘貼膠膜就不會出現(xiàn)這種情況,而且固態(tài)材料可以實(shí)現(xiàn)無樹脂析出的情況。均一的爬膠特性則是直接提高了引線鍵合的打線性能。
除此之外,芯片粘接膠膜的應(yīng)用簡化了引線鍵合封裝中的框架設(shè)計,首先它減少了鍵合線的用量,其次減少了塑封料的用量,這意味著粘接膠膜能用更低的成本來實(shí)現(xiàn)更高的封裝密度。這也讓其應(yīng)用價值在嚴(yán)苛的封裝要求里大大提升。
小結(jié)
在半導(dǎo)體封裝的發(fā)展過程中,對于芯片粘接的技術(shù)要求肯定是會越來越高的,芯片粘接膠膜獨(dú)有的特性讓其在高標(biāo)準(zhǔn)的封裝領(lǐng)域有著更大的應(yīng)用空間,既降低了成本,也提高了打線品質(zhì),未來會有更多應(yīng)用。
發(fā)布評論請先 登錄
相關(guān)推薦
什么是引線鍵合(WireBonding)

引線鍵合檢測的基礎(chǔ)知識
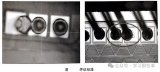
帶你一文了解什么是引線鍵合(WireBonding)技術(shù)?

引線鍵合之DOE試驗(yàn)
半導(dǎo)體制造的鍵合線檢測解決方案
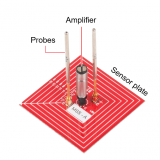
PMMA微流控芯片的鍵合介紹
引線鍵合技術(shù):微電子封裝的隱形力量,你了解多少?

技術(shù)分享 | 芯片粘接空洞的超聲檢測

引線拉力測試儀,引線鍵合測試背后的原理和要求
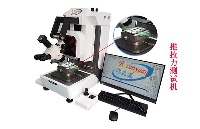
有償求助本科畢業(yè)設(shè)計指導(dǎo)|引線鍵合|封裝工藝
引線鍵合在溫度循環(huán)下的鍵合強(qiáng)度衰減研究





 芯片粘接如何為引線鍵合封裝賦能
芯片粘接如何為引線鍵合封裝賦能














評論