雙波段紅外探測可對復雜的紅外背景進行抑制,在軍用目標識別、醫療診斷和污染監測等方面有重要應用價值。基于二類超晶格的雙波段紅外探測器在成本和性能方面具有很大的優勢,成為新型紅外探測器領域的研究熱點。然而其暗電流和串擾會極大地影響雙波段紅外探測器的性能。
據麥姆斯咨詢報道,近期,北京信息科技大學和華北光電技術研究所的科研團隊在《紅外與激光工程》期刊上發表了以“nBn結構InAs/GaSb超晶格中/長雙波段探測器優化設計”為主題的文章。該文章第一作者為劉文婧,通訊作者為祝連慶和張東亮。
本文設計了nBn結構的InAs/GaSb超晶格中/長波雙波段紅外探測器,通過仿真比較不同結構的器件在不同偏壓下的中波/長波通道的響應率和暗電流大小,分析勢壘層厚度、吸收層厚度、不同區域的摻雜對暗電流和串擾的影響,從而得到最佳的模型參數達到減小暗電流和降低串擾的效果。
器件建模描述
仿真物理模型
InAs/GaSb超晶格探測器的暗電流受溫度的影響較大,高溫下擴散電流為主要的暗電流機制,低溫下以產生復合(GR)電流為主導機制。其中,漂移擴散電流模型是基于玻爾茲曼傳輸理論的推導與近似。SRH復合電流是由缺陷引起的產生復合中心能級,產生復合中心會向導帶和價帶發射電子與空穴,同時導帶上的電子和價帶上的空穴會在產生復合中心復合,這引起的電流為SRH暗電流。陷阱輔助隧穿電流(TAT)是電子在陷阱的輔助下發射至導帶,在上述等式中引入一個場效應因子Γ來反應聲子輔助隧穿等對載流子壽命的影響。
SILVACO器件仿真的運算模型是基于泊松方程,載流子連續性方程,輸運方程。通過調用不同的模型來描述擴散電流、GR電流、隧穿電流、光生電流,其中探測器總體的暗電流會隨著溫度的升高而逐漸變大,但不同溫度下的暗電流主導機制不同。仿真過程中將超晶格材料等效為一層體材料進行能帶參數的定義,如表1和表2所示,這些參數一方面來源于文獻調研,另一方面使用加權平均或由能帶結構計算而來,因此這些參數大多是估算結果。按照如圖1所示的仿真框架進行文中的優化仿真,后續將會通過材料和探測器的各項測試結果進而反饋分析,從而進一步優化仿真結果。
表1 15 MLs InAs/8 MLs GaSb超晶格材料參數等效定義
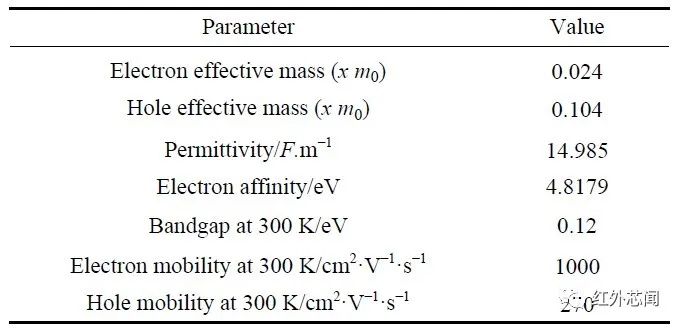
表2 8 MLs InAs/6 MLs GaSb超晶格材料參數等效定義
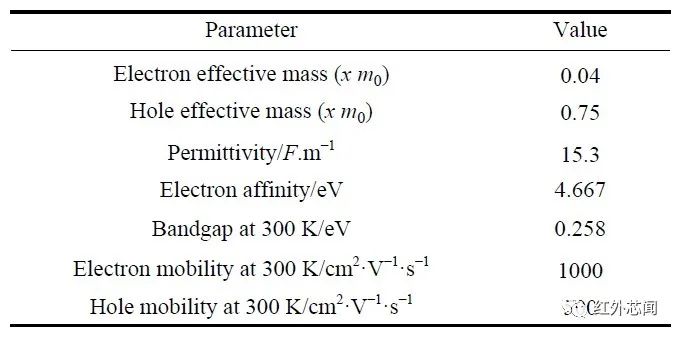

圖1 仿真流程框架圖
器件結構設計
根據設計目標要求,首先使用k.p方法對InAs/GaSb能帶結構進行了計算,得到如圖2(a)和圖2(b)所示,77 K下,15 MLs InAs/8 MLs GaSb超晶格的帶隙為0.123 eV,對應的截止波長為10.058 μm;8 MLs InAs/6 MLs GaSb超晶格的帶隙為0.258 eV,對應的截止波長為4.815 μm。因此選用這兩種超晶格分別作為雙波段探測結構中的長波吸收區和中波吸收區。文中設計的中/長波雙波段niBin探測器結構如圖2(c)所示:從下至上依次是下接觸層-長波吸收層-公共勢壘層-中波吸收層-上接觸層。
外延工藝順序簡要介紹如下:首先,在GaSb襯底層上生長一層GaSb緩沖層用來改善界面粗糙度,實現原子臺階;接著在緩沖層上生長100 nm厚的15 MLs InAs/8 MLs GaSb超晶格,并進行1×101? cm?3的Si摻雜,以此作為長波通道的下接觸層,在下接觸層上生長15 MLs InAs/8 MLs GaSb超晶格長波通道吸收層;然后,在長波吸收層上生長AlGaSb勢壘層,這是長波通道和中波通道公共的勢壘層,阻擋多數載流子(電子)的流通而允許少數載流子(空穴)的流通,勢壘層的加入可以極大程度地減少SRH復合暗電流且抑制串擾;接著,在公共勢壘層上方生長8 MLs InAs/6 MLs GaSb超晶格中波通道吸收層,在中波吸收層上方再生長100 nm的8 MLs InAs/6 MLs GaSb超晶格并進行1×101? cm?3的Si摻雜,以此作為中波通道的上接觸層;最后,分別在GaSb緩沖層上和中波通道的上接觸層8 MLs InAs/6 MLs GaSb超晶格上蒸鍍150 nm的Ti/Pt/Au層用來作為下電極和上電極層。器件尺寸定義為20 μm×20 μm。
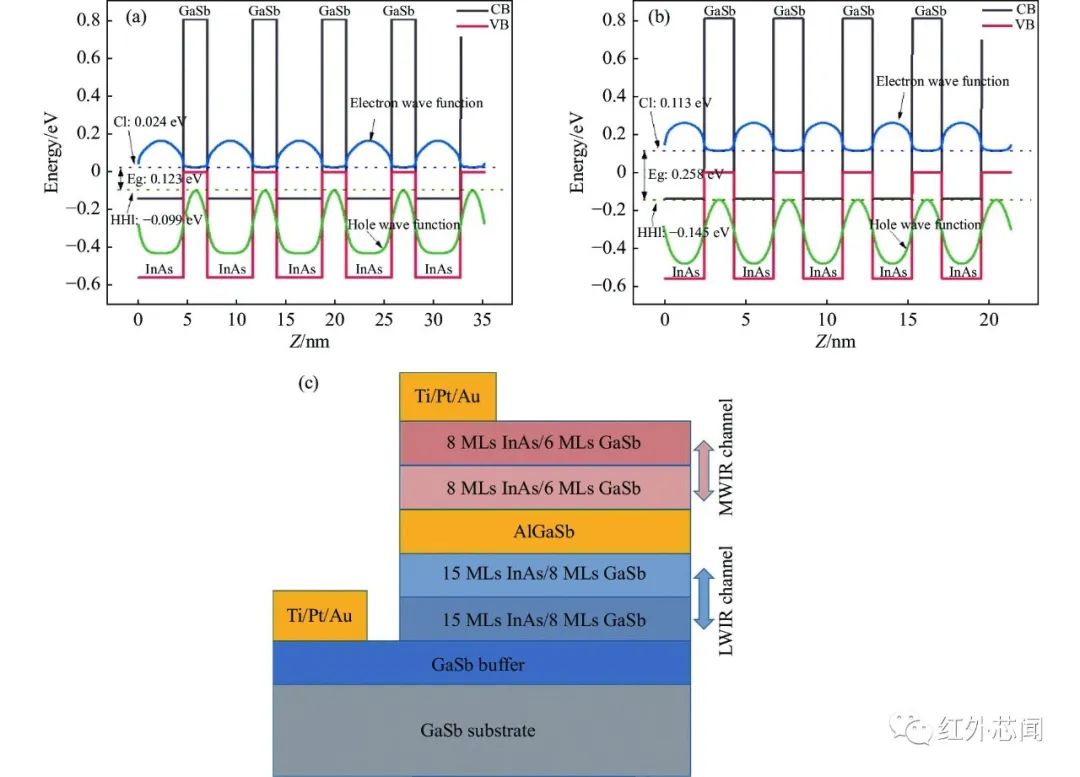
圖2 (a) 15 MLs InAs/8 MLs GaSb長波超晶格的能帶圖;(b) 8 MLs InAs/6 MLs GaSb中波超晶格的能帶圖;(c)中/長波雙波段紅外探測器結構
文中通過分析不同結構和偏壓下的J-V曲線,分析勢壘層、摻雜、吸收層厚度、溫度對暗電流、光響應的影響,來從理論設計方面盡量減小器件的暗電流和提升量子效率。
仿真優化分析
探測器暗電流主要包括擴散電流、產生復合電流、直接隧穿電流、陷阱輔助隧穿電流和表面漏電流。不同的暗電流機制有不同的影響因素,暗電流的四個主要組成機制都與探測器的工作環境溫度有關,溫度對暗電流信號的影響起主要作用,探測器的暗電流會隨著溫度的降低而降低,所以抑制暗電流有效的措施是保持器件在穩定的低溫環境中。通過能帶設計與器件結構設計、鈍化工藝等降低暗電流以提高工作溫度是器件優化的重要方向。其中擴散電流與帶隙的大小有關,高溫下的暗電流主要以擴散電流為主。GR電流主要是SRH復合電流,可通過降低缺陷復合中心和提高吸收區的摻雜來抑制。但當摻雜濃度過大時,電場也會變大,這會在一定程度上增加隧穿電流。同時材料質量和工藝也會影響暗電流。通常低溫下的表面漏電流較為顯著,需要通過鈍化工藝來減少此暗電流。
勢壘層組分對能帶結構的影響
使用SILVACO軟件對上述器件結構進行建模,并設置電子有效質量、電子親和勢、電子遷移率等參數。其中,將15 MLs InAs/8 MLs GaSb超晶格吸收層厚度定為4 μm,摻雜為1×101? cm?3,8 MLs InAs/6 MLs GaSb吸收層厚度為2 μm,摻雜為1×101? cm?3。AlxGa1?xSb的插入是為了在導帶處形成了電子勢壘,阻擋多子電子流通,同時價帶幾乎平齊,能夠允許少子空穴的流動,這樣的能帶結構可以提高光生載流子的收集效率,降低暗電流。通過調節AlxGa1?xSb的組分,x為Al的組分,分別取0.15、0.19、0.2、0.21、0.25、0.3,得到如圖3(a)所示的77 K下的能帶圖,圖中顯示x小于0.2時,AlGaSb的價帶能量較高,與8 MLs InAs/6 MLs GaSb和15 MLs InAs/8 MLs GaSb超晶格吸收區形成較為明顯的價帶帶階;x大于0.2時,AlGaSb的價帶能量較低,同樣會與8 MLs InAs/6 MLs GaSb和15 MLs InAs/8 MLs GaSb形成較為明顯的價帶帶階;因此,取x為0.2,即勢壘層為Al0.2Ga0.8Sb,得到如圖3(b)所示的器件整體的能帶圖。

圖3 (a)不同Al組分的AlxGa1?xSb的能帶圖;(b)器件整體的能帶圖
勢壘層厚度對暗電流和光響應的影響
將15 MLs InAs/8 MLs GaSb超晶格吸收層厚度設為4 μm,摻雜為1×101? cm?3,8 MLs InAs/6 MLs GaSb超晶格吸收層厚度為2 μm,摻雜為1×101? cm?3,勢壘層為Al0.2Ga0.8Sb。在此基礎上分析勢壘層厚度對暗電流的影響。厚度取10~1000 nm,由圖4(a)和圖4(b)所示,正偏下,隨著勢壘層厚度增加,中波通道暗電流逐漸減小,光電流逐漸增加,但增大的并不明顯。反偏下,長波通道暗電流同樣會隨著勢壘層厚度的增大而減小,光電流也隨著勢壘層厚度的增加而逐漸增加,但同時串擾也略有增大。77 K下的暗電流主導機制是SRH電流和隧穿暗電流。同樣電壓下,勢壘層厚度增加會降低電場強度,進而減小SRH暗電流,勢壘層厚度增大也會直接降低隧穿概率,進而降低隧穿暗電流,所以總的暗電流會減小。光電流隨著勢壘層厚度的增加而增加,這是因為降低了吸收區的電場強度進而在一定程度上減小了光生載流子的SRH復合。由于當AlGaSb的厚度過大時,會與超晶格產生較大的晶格失配應力。因此,考慮勢壘層厚度對器件整體的暗電流和光響應的影響,同時簡化器件結構以便于后續實際材料生長和器件工藝,一般將AlGaSb勢壘層厚度定為100 nm。
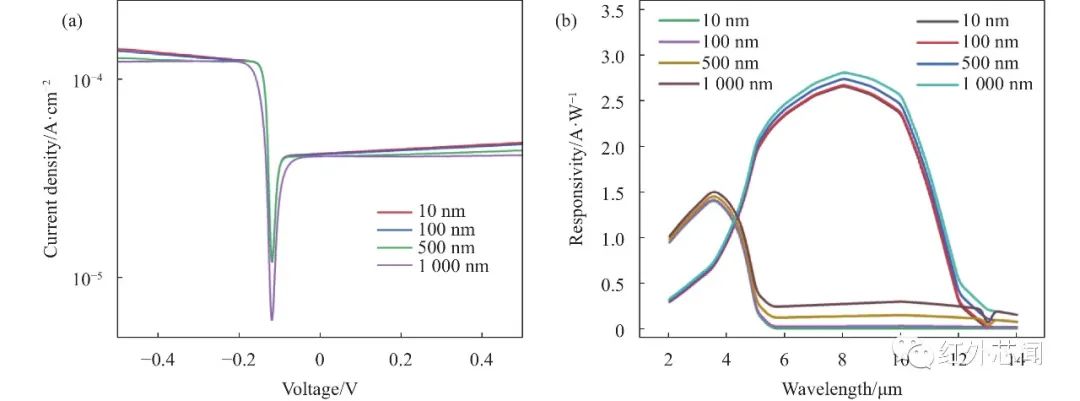
圖4 (a) 77 K下不同勢壘層厚度下的J-V曲線;(b) ±0.3 V下不同勢壘層厚度下的光響應譜
摻雜對暗電流和光響應的影響
將15 MLs InAs/8 MLs GaSb吸收層厚度設置為4 μm,8 MLs InAs/6 MLs GaSb吸收層厚度為2 μm,勢壘層Al0.2Ga0.8Sb厚度為100 nm。在此基礎上研究77 K下吸收層摻雜和勢壘層摻雜對器件暗電流和光響應的影響。對吸收層分別進行1×101?、1×101?、1×101? cm?3的摻雜,圖5(a)中,在0.3 V和?0.3 V的工作電壓下,吸收層摻雜濃度增大時,即電子濃度增大,相應的少子空穴濃度減小,暗電流減小,但增大摻雜濃度對降低暗電流的影響較微弱,且由圖5(b)可以看出高濃度摻雜減小少數載流子空穴的壽命,即帶間復合率增大,使得光生載流子更多的被復合而沒有被電極收集,從而降低光響應。且高濃度摻雜會使得導帶上的電子濃度增大,進而增加自由載流子的光吸收,增加光損耗,從而也會降低光響應。因此,通常吸收層為非故意摻雜。通過對勢壘層分別進行1×101?、1×101?、5×101? cm?3的摻雜,由圖5(c)和圖5(d)可得,在0.3 V和?0.3 V的工作電壓下,當勢壘層摻雜增大時,暗電流會相應地微弱的減小,且基本不影響光響應。但由圖5(e)可以看到,當摻雜過高時會引起較大的帶階,這會阻擋光生電子的傳輸,減小光電流。因此,在實際的材料生長中,采取勢壘層為非故意摻雜。
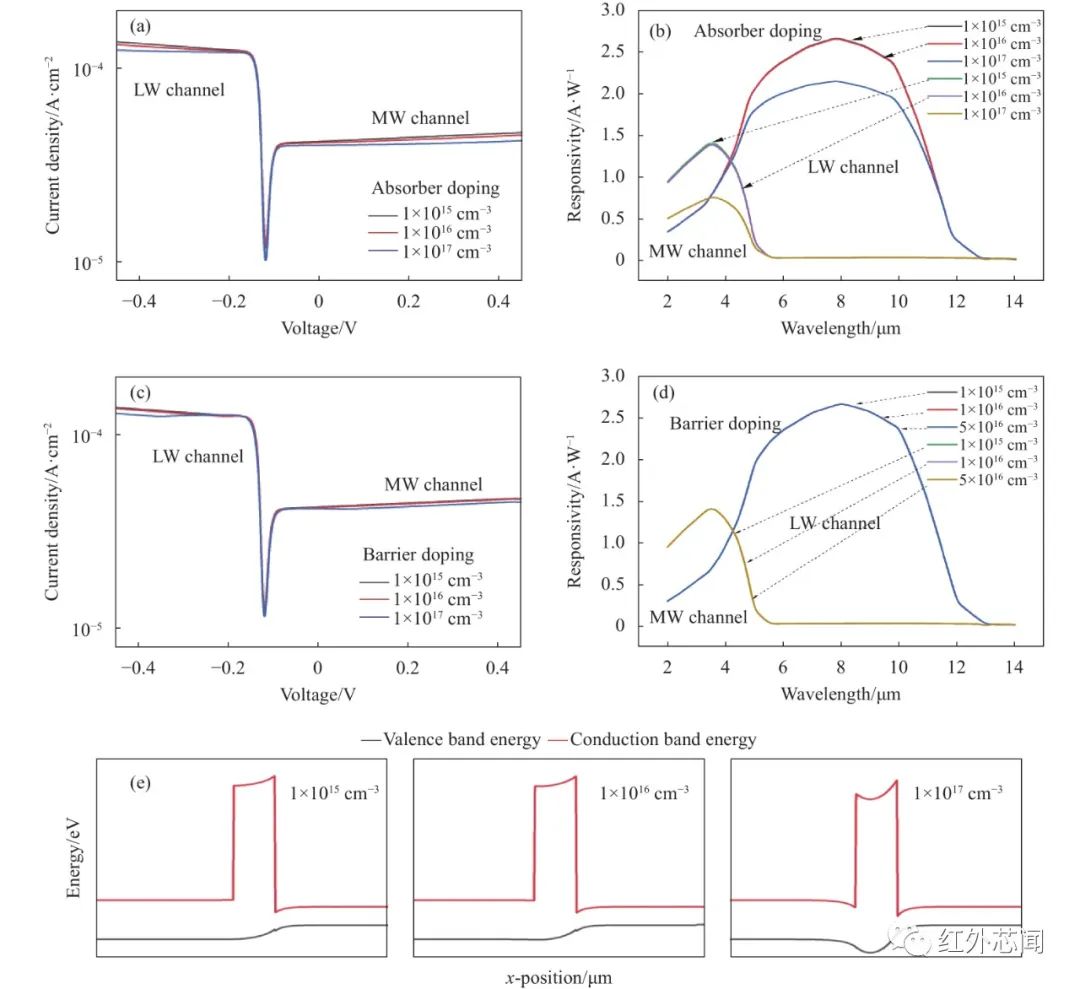
圖5 (a) 吸收層在不同摻雜濃度下的暗電流密度;(b) 吸收層在不同摻雜濃度下的光響應;(c) 勢壘層在不同摻雜濃度下的暗電流密度;(d) 勢壘層在不同摻雜濃度下的光響應;(e) 勢壘層在不同摻雜濃度下的能帶圖
吸收層厚度對光響應和串擾的影響
對于雙波段器件,串擾是一個很大的問題,文中通過優化中波吸收層和長波吸收層的厚度來減小兩個通道間的串擾。將15 MLs InAs/8 MLs GaSb吸收層摻雜設為1×101? cm?3,8 MLs InAs/6 MLs GaSb吸收層摻雜設為1×101? cm?3,勢壘層Al0.2Ga0.8Sb厚度為100 nm,摻雜為1×101? cm?3。
通過將長波吸收區15 MLs InAs/8 MLs GaSb超晶格厚度設為2 μm,改變中波吸收區8 MLs InAs/6 MLs GaSb超晶格的厚度,得到了如圖6(a)所示的光響應圖:隨著8 InAs/6GaSb超晶格厚度增加,中波的光電流逐漸變大,且長波通道對于中波的光響應逐漸減小,且由圖6(c)可以看到,中波通道與長波通道間的串擾逐漸減小。實際在MBE生長材料的過程當中,要生長這么厚的超晶格材料,對于材料質量的把控較為困難,且后續在器件工藝時也存在較大的難度。因此將中波吸收層8 MLs InAs/6 MLs GaSb厚度設為4 μm,在一定程度上減小了串擾,但對于后續的MBE生長也帶來了一定程度地挑戰。
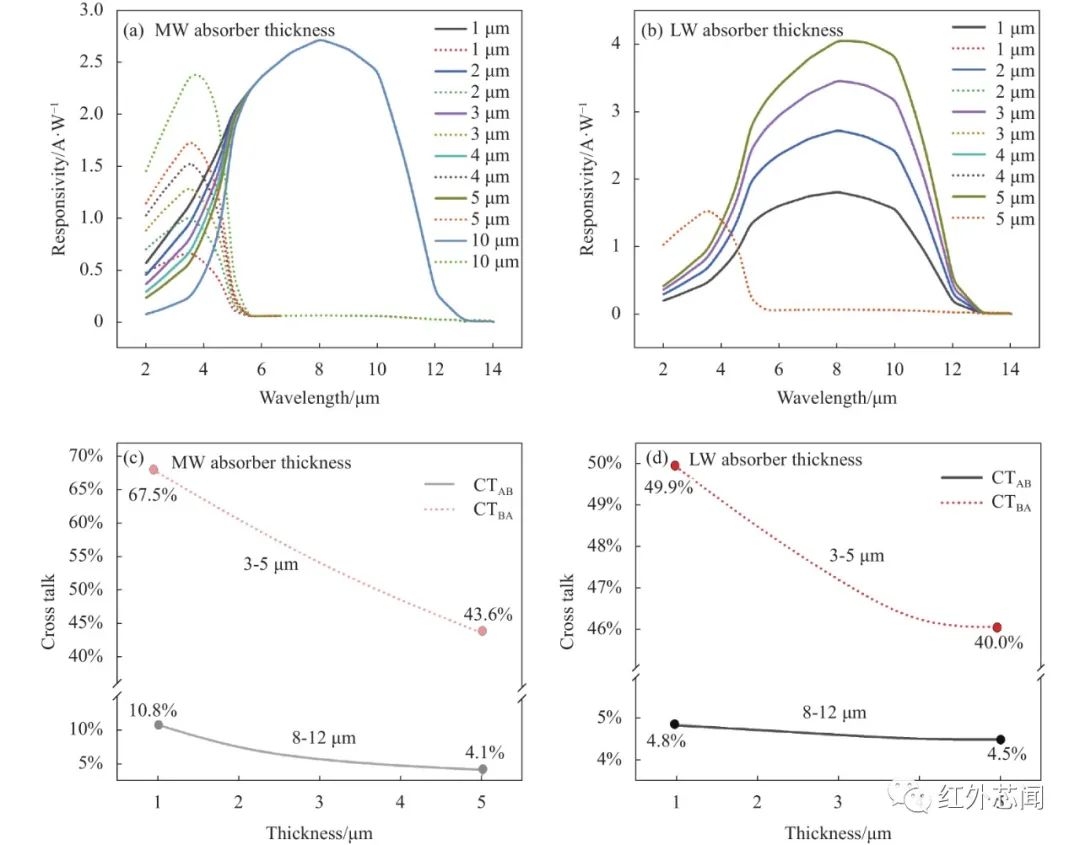
圖6 (a) 不同中波吸收層厚度下的光響應率;(b) 不同長波吸收層厚度下的光響應率;(c) 不同中波吸收層厚度下的串擾;(d) 不同長波吸收層厚度下的串擾
圖6(b)是將中波吸收層8 MLs InAs/6 MLs GaSb超晶格厚度設為4 μm,改變長波吸收層15 MLs InAs/8 MLs GaSb超晶格的厚度,可以看到隨著長波吸收層厚度的增加,長波通道的響應率也逐漸增加,中波通道的響應率沒有發生變化,且由圖6(d)可以看到但長波通道對中波通道的串擾減小的較少,而中波通道對長波通道的串擾幾乎不變。當長波吸收層厚度過大時,材料生長和器件工藝的難度增大,并且對兩通道間的串擾影響不大,因此將長波吸收層15 MLs InAs/8 MLs GaSb的厚度設為2 μm,在一定程度上兼顧量子效率和減小器件的串擾。將中波吸收層厚度定為4 μm,長波吸收層厚度定為2 μm時,中波通道對長波通道的串擾為4.7%,長波通道探測性能良好;但長波通道對中波通道的串擾為48.4%,這可能是仿真時定義的光吸收系數值不夠準確,下一步需要通過實際的器件測試得到準確的吸收系數來進一步指導仿真。
不同溫度下的J-V曲線
將15 MLs InAs/8 MLs GaSb吸收層厚度設為4 μm,摻雜為1×101? cm?3,8 MLs InAs/6 MLs GaSb吸收層厚度為2 μm,摻雜為1×101? cm?3,勢壘層Al0.2Ga0.8Sb厚度為100 nm,摻雜為1×1101? cm?3。為了直觀的看到溫度對器件的影響,仿真得到了不同溫度(77、110、130、150、180、210、240、280、300 K)下的J-V曲線。由圖7(a)可以看到,探測器在反偏下的暗電流隨著溫度的降低而減小。所有的暗電流機制都隨著溫度的增加而增大,但溫度對它們的影響的程度大小不同,因此暗電流的主導機制也隨會著溫度的變化而變化。文中繪制RA-1000/T曲線來分析暗電流機制,通過提取曲線的斜率可以得到不同溫度下的暗電流主導機制。在動態阻抗RA和1000/T的關系圖中,可以得到不同溫度下的暗電流主導機制,圖7(b)中,正偏時,在溫度大于160 K的暗電流主要以擴散電流為主;而在130~160 K的溫度區間內主要以G-R電流為主;在更低的溫度下,隧穿電流將會對器件產生一定的影響,但效果不明顯。反偏下,在大于110 K時,器件的主導暗電流機制為擴散電流和G-R電流,低溫下受隧穿電流影響較大。因此中波通道相較于長波通道,能工作在更高的溫度下。

圖7 (a) 不同溫度下的J-V曲線;(b) 不同溫度下的暗電流主導機制
器件性能分析
響應率是表示器件單位功率的光子產生光生電流的能力,是反映探測器性能的關鍵指標。通過第2小節的優化設計確定了最終的結構:15 MLs InAs/8 MLs GaSb超晶格吸收層厚度為4 μm,摻雜為1×101? cm?3,8 MLs InAs/6 MLs GaSb超晶格吸收層厚度為2 μm,摻雜為1×101? cm?3,勢壘層Al0.2Ga0.8Sb厚度為100 nm,摻雜為1×101? cm?3。圖8(a)為不同偏壓下的光響應率,可以看到在零偏下即可實現中波響應,而長波通道的開啟電壓為?120 mV。
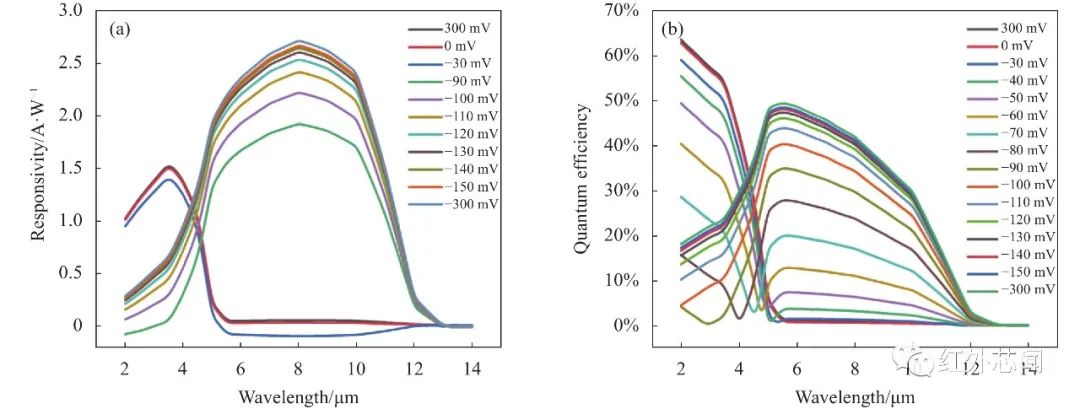
圖8 (a) 不同偏壓下的中波與長波通道的光響應率;(b) 不同偏壓下的中波與長波通道的量子效率
量子效率是電極層收集到的電子空穴對與輸入的光子數量的比值,能夠更為直觀的反映出探測器的性能。圖8(b)為77 K下的不同偏壓下的量子效率。在零偏壓下,中波通道的峰值量子效率為2 μm處的64%;當偏壓為?130 mV時,長波通道的峰值量子效率為5.6 μm處的48%。比探測率是表示探測器歸一化噪聲性能。計算得到的中波通道和長波通道的探測率如圖9所示。在77 K下,中、長波峰值探測率為3.9×1011、4.1×1011 cm·Hz1/2·W?1。
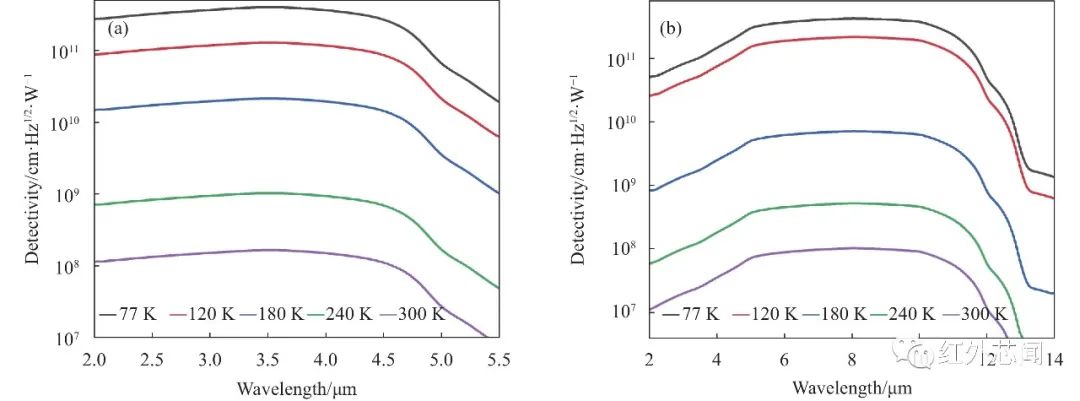
圖9 (a) 不同溫度下的中波通道探測率;(b) 不同溫度下的長波通道探測率
結論與展望
文中通過對nBn型的二類超晶格中/長波雙波段探測器結構進行建模仿真,優化了吸收層和勢壘層的厚度、摻雜濃度等來減小器件的暗電流和中波通道與長波通道間的串擾,得到了器件結構的各個參數,仿真得到了中波通道截止波長為4.8 μm(50%),在77 K下,外加0.3 V偏壓時,暗電流密度為4×10?? A·cm?2,RA為6.7×103 Ω·cm2,峰值量子效率為64%,峰值探測率3.9×1011 cm·Hz1/2·W?1;長波通道截止波長為10.5 μm(50%),在77 K下,外加?0.3 V偏壓時,暗電流密度為1.3×10?? A·cm?2,RA為2.3×103 Ω·cm2,峰值量子效率η為48%,峰值探測率4.1×1011 cm·Hz1/2·W?1,為后續材料生長和器件工藝提供了理論依據。從仿真方面證實了,基于15 MLs InAs/8 MLs GaSb和8 MLs InAs/6 MLs GaSb的nBn結構的中/長波雙波段紅外探測器是可行的。
文中設計的雙波段探測器件具有器件結構簡單和暗電流密度低等優點,性能方面與國外基于nBn結構的InAs/InAsSb紅外探測器和國內基于PπMN結構的InAs/GaSb紅外探測器等同類型器件相比,中波通道探測率相近,但長波通道探測率更高。仿真會與實際的器件性能結果有一定的差別,因此后續將會進行材料生長與器件工藝來進一步反饋仿真,同時在器件結構方面將會做進一步的改進。
這項研究獲得國家自然科學基金項目(62105039)、北京學者計劃研究項目(BJXZ2021-012-00046)、北京教育委員會研究項目(KM202111232019)和北京信息科技大學研究項目(2022XJJO7)的資助和支持。
審核編輯:劉清
-
仿真器
+關注
關注
14文章
1019瀏覽量
83934 -
紅外探測器
+關注
關注
5文章
290瀏覽量
18157 -
暗電流
+關注
關注
0文章
28瀏覽量
10128
原文標題:nBn結構InAs/GaSb超晶格中/長雙波段探測器優化設計
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
Littrow結構中光柵系統的配置與優化
用于光波導系統的均勻性探測器
如何提高金屬探測器探測率
雷達探測器的工作原理 雷達探測器與激光探測器區別
被動紅外探測器和主動紅外探測器的區別

防盜報警系統常用的探測器有哪些

在VirtualLab Fusion中的可編程探測器附加組件
VirtualLab:通用探測器
基于米氏超構表面的像素集成長波多光譜Ⅱ類超晶格探測器
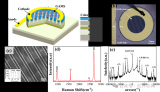
銻化物超晶格紅外探測器研究進展與發展趨勢綜述
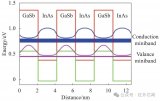




 nBn結構InAs/GaSb超晶格中/長雙波段探測器優化設計描述
nBn結構InAs/GaSb超晶格中/長雙波段探測器優化設計描述











評論