人工智能(AI)是預(yù)計(jì)到2030年將成為價(jià)值數(shù)萬億美元產(chǎn)業(yè)的關(guān)鍵驅(qū)動(dòng)力,它對(duì)半導(dǎo)體性能提出了新的要求。在交付下一代AI能力方面,一些最復(fù)雜的問題來自于需要通過新的刻蝕技術(shù)來解決的器件制造挑戰(zhàn)。
為什么AI對(duì)刻蝕技術(shù)施加特殊壓力?基本原因是AI訓(xùn)練所需的大量數(shù)據(jù)。這些數(shù)據(jù)需要高水平的并行處理、豐富的非易失性存儲(chǔ)器(如NAND)以及快速的數(shù)據(jù)傳輸速率,以將數(shù)據(jù)推入和推出存儲(chǔ)器。先進(jìn)的設(shè)備依賴于在三維中制造的體系結(jié)構(gòu)。作為一種減法過程,刻蝕是塑造這些結(jié)構(gòu)的強(qiáng)大工具。全圍柵(GAA)晶體管、低成本每比特的3D NAND存儲(chǔ)器和高帶寬存儲(chǔ)器是AI未來的關(guān)鍵,它們都需要新的、創(chuàng)新的刻蝕方法來塑造它們的器件結(jié)構(gòu)。
刻蝕一直是一項(xiàng)關(guān)鍵而具有挑戰(zhàn)性的工藝,但為AI提供動(dòng)力的芯片將把這一挑戰(zhàn)推向一個(gè)新的水平。它們不僅要求前所未有的刻蝕精度,還需要能夠有選擇性地去除一種材料而保留另一種材料,修改剩余材料的表面特性,刻蝕具有越來越高縱橫比的結(jié)構(gòu),有時(shí)甚至需要進(jìn)行橫向刻蝕而不僅僅是垂直刻蝕。
垂直刻蝕在AI邏輯中的應(yīng)用
多年來,各向異性定向刻蝕(anisotropic directional etch)一直是集成電路制造中一種非常有價(jià)值的工具。干法等離子體反應(yīng)離子刻蝕(dry plasma reactive ion etch)已被用于實(shí)現(xiàn)低介電常數(shù)(low-κ)的雙柱連線(dual-damascene interconnects)、高介電常數(shù)(high-κ)的金屬柵(metal gates)、FinFET、埋藏柵DRAM和多代3D NAND。但近年來,向全圍柵(GAA)晶體管架構(gòu)的轉(zhuǎn)變要求采用一種新的、具有挑戰(zhàn)性的方法:各向同性、高選擇性刻蝕。通過各向同性刻蝕,不僅僅是從堆疊結(jié)構(gòu)的頂部向下刻蝕,而是同時(shí)在多個(gè)方向上均勻去除材料,這個(gè)過程被稱為垂直刻蝕(perpendicular etch)。
垂直刻蝕是一種新的刻蝕方法,它在GAA晶體管架構(gòu)中發(fā)揮著重要作用。在傳統(tǒng)的晶體管結(jié)構(gòu)中,刻蝕只需要從頂部向下進(jìn)行,但在GAA晶體管中,需要在多個(gè)方向上均勻地去除材料,以形成全圍柵結(jié)構(gòu)。垂直刻蝕可以實(shí)現(xiàn)對(duì)多層材料的同時(shí)刻蝕,從而形成所需的結(jié)構(gòu)。
垂直刻蝕的挑戰(zhàn)在于實(shí)現(xiàn)高度選擇性的刻蝕過程。由于需要在多個(gè)方向上均勻去除材料,必須確保只有目標(biāo)材料被刻蝕,而其他材料保持不變。這需要精確控制刻蝕氣體、工藝參數(shù)和刻蝕時(shí)間,以實(shí)現(xiàn)所需的選擇性。
總之,垂直刻蝕是一種在GAA晶體管架構(gòu)中必不可少的刻蝕方法。它通過各向同性刻蝕的方式,在多個(gè)方向上均勻去除材料,實(shí)現(xiàn)了復(fù)雜的全圍柵結(jié)構(gòu)。隨著技術(shù)的發(fā)展,垂直刻蝕技術(shù)將繼續(xù)演進(jìn),以滿足未來集成電路制造的需求。
審核編輯:湯梓紅
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222627 -
晶體管
+關(guān)注
關(guān)注
77文章
9745瀏覽量
138891 -
AI
+關(guān)注
關(guān)注
87文章
31513瀏覽量
270328 -
蝕刻技術(shù)
+關(guān)注
關(guān)注
0文章
23瀏覽量
7854
原文標(biāo)題:【技術(shù)干貨】蝕刻技術(shù)如何發(fā)展以滿足 AI 時(shí)代的需求
文章出處:【微信號(hào):硬蛋芯力量,微信公眾號(hào):硬蛋芯力量】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
振奮!中微半導(dǎo)體國(guó)產(chǎn)5納米刻蝕機(jī)助力中國(guó)芯
【轉(zhuǎn)帖】干法刻蝕的優(yōu)點(diǎn)和過程
請(qǐng)教碳化硅刻蝕工藝
AOE刻蝕系統(tǒng)
X-CUBE-AI和NanoEdge AI Studio在ML和AI開發(fā)環(huán)境中的區(qū)別是什么?
刻蝕端面Al Ga In As/AlInAs激光器的制作與特
關(guān)于刻蝕的重要參數(shù)報(bào)告
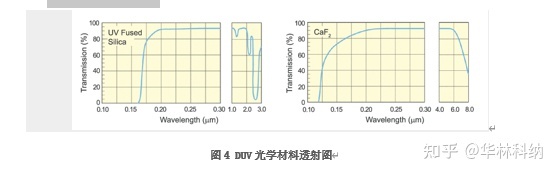
什么是線刻蝕 干法線刻蝕的常見形貌介紹

離子束刻蝕機(jī)物理量傳感器 MEMS 刻蝕應(yīng)用
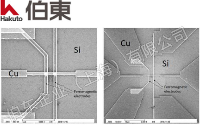
PDMS濕法刻蝕與軟刻蝕的區(qū)別
一文看懂刻蝕角度與ICP-RIE射頻功率的關(guān)系
刻蝕工藝的參數(shù)有哪些

芯片制造中的濕法刻蝕和干法刻蝕





 垂直刻蝕在AI邏輯中的應(yīng)用
垂直刻蝕在AI邏輯中的應(yīng)用












評(píng)論