隨著對高性能半導體需求的增加,半導體市場越來越重視“封裝工藝”的重要性。根據(jù)這一趨勢,SK海力士正在大規(guī)模生產(chǎn)基于HBM3(高帶寬存儲器3)的高級封裝產(chǎn)品,同時專注于投資生產(chǎn)線并為未來封裝技術(shù)的發(fā)展獲取資源。一些以前專注于半導體存儲器制造技術(shù)的企業(yè),現(xiàn)在對封裝技術(shù)的投資超過了OSAT1專門研究這種技術(shù)的公司。這種趨勢是由這樣一種信念推動的,即封裝技術(shù)將增強半導體行業(yè)及其公司的競爭力。
1OSAT(外包半導體組裝和測試):專門從事半導體封裝測試的公司。
他的文章將 提供對…的簡單概述包裝技術(shù)已經(jīng)經(jīng)過深思熟慮的a 困難的主題為這一般 公眾的接近 由于其復雜性。 T包裝的含義、作用和演變技術(shù)將接受檢查, 然后 a調(diào)查 這 發(fā)展薩斯喀徹溫海力士的封裝工藝這導致了到目前對異構(gòu)集成的關(guān)注。最后,的方向公司的未來技術(shù)發(fā)展s 將被介紹。
這M含義和R的oleP確認字符(acknowledgementcharacter)(對他人的話作出反應或表示生氣、惱怒)唔,啊,哎呀強中子發(fā)生器(Intense Neutron Generator的縮寫)T技術(shù)
首先,讓我們看看包裝過程的四個主要功能。第一個也是最基本的目的是保護半導體芯片免受外部沖擊或da魔術(shù)師。第二種是將外部電源傳輸?shù)叫酒糜谄洳僮鳎偷谌菫樾酒峁┎季€,以在操作期間執(zhí)行電信號的輸入和輸出。 T他最后作用是為了適當?shù)厣l(fā)產(chǎn)生的熱量經(jīng)過保證芯片穩(wěn)定運行。最近,散熱或熱分布的功能變得越來越重要。
包裝的作用可以是看見在圖1。例如,兩者之間有很大的差距規(guī)模系統(tǒng)要求和CMOS提供的比例2,但是他們可以通過封裝技術(shù)連接。同樣,還有一個系統(tǒng)要求的密度與密度CMOS可以提供的。這個問題 可以通過包裝過程解決因為它有幫助s增加密度CMOS的。 在其他方面換句話說,封裝技術(shù)是半導體器件和系統(tǒng)之間的橋梁。 T這個的重要性是連接方法,因此,增加漸漸地。
2CMOS(互補金屬氧化物半導體):使用半導體技術(shù)的印刷電路板(PCB)上的集成電路設計。

圖一。內(nèi)存封裝彌合了設備和系統(tǒng)之間的規(guī)模差距
包裝發(fā)展的三個階段:堆棧競爭、性能競爭和融合
當考察包裝技術(shù)的歷史時,它可以分為三大部分年代。在過去,a 單一的包裹將僅實現(xiàn)一個芯片。因此,包裝很簡單,沒有區(qū)別因素包裝技術(shù)的附加值低。然而,在21世紀初,隨著轉(zhuǎn)換 去FBGA3封裝,開始在一個封裝上堆疊多個芯片。這能夠被稱為“堆疊競爭力的時代。”當芯片開始堆疊時,封裝的形式多樣化的各種衍生產(chǎn)品的產(chǎn)生取決于這內(nèi)存芯片。主控制程序4, 哪個實現(xiàn)DRAM而同一封裝中的NAND,也在此時出現(xiàn)。
3FBGA(細間距球柵陣列):一種表面貼裝封裝(芯片載體),用于基于球柵陣列技術(shù)的集成電路。它的觸點更薄,主要用于片上系統(tǒng)設計。
4MCP(多芯片封裝):通過垂直堆疊兩種或多種不同類型的存儲半導體而制成單個封裝的產(chǎn)品。
第二時代開始了2010年后,使用芯片上的凸點進行互連的方法出現(xiàn)了。因此,的變化運行速度和設備財產(chǎn)利潤發(fā)生了。這時期能夠呼叫這“性能競爭力時代”如同2010年之前的封裝技術(shù)通常復雜的連接強中子發(fā)生器(Intense Neutron Generator的縮寫)金屬線,但是介紹突起縮短艾德(男子名)實現(xiàn)更快速度的信號路徑s。同時,堆疊方法使用 TSV5大大增加了I/的數(shù)量Os(輸入/輸出),which導聯(lián)到連接強中子發(fā)生器(Intense Neutron Generator的縮寫) 1,0246寬I/操作系統(tǒng)(Operating System) 實現(xiàn)高運行速度即使在低電壓下。 在這性能競爭時代性能籌碼的變化根據(jù)包裝技術(shù),以及這成為一個重要的因素 在滿足的要求顧客s. 如同企業(yè)的成敗能取決于包裝技術(shù)的存在與否,包裝技術(shù)具有的價值繼續(xù)生長。
第三個也是最后一個紀元開始于 2020 和是 b基于之前所有的 包裝技術(shù)。 它能夠經(jīng)過深思熟慮的 這“融合時代“因為它需要能夠連接v各種類型的籌碼到一個包裹和,同樣,連接許多零件 在到一個模塊當。。.的時候 法人團體強中子發(fā)生器(Intense Neutron Generator的縮寫)一個系統(tǒng)。在th是紀元,包裝技術(shù)本身可以成為系統(tǒng)解決方案,可以為客戶提供定制的包裝解決方案到制造小批量生產(chǎn)成為可能。此時此刻,僅僅擁有包裝技術(shù)將決定一個企業(yè)的成功。
5TSV (Through-Silicon Via):一種互連技術(shù),在DRAM芯片上鉆成千上萬個細孔,并用垂直穿透的電極連接上下兩層的孔。
61,024:標準DRAM高達64 I/操作系統(tǒng)(Operating System),而HBM3的最大寬度I/為1,024操作系統(tǒng)(Operating System)。
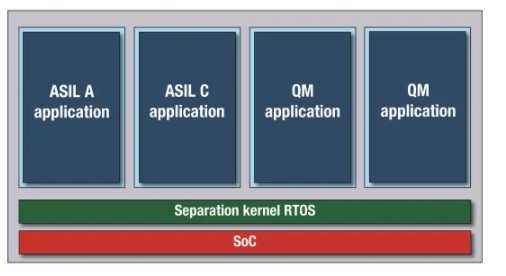
圖二。包裝技術(shù)發(fā)展帶來的變化
SK的歷史海力士的 P包裝T技術(shù)
海力士的封裝工藝 經(jīng)歷了重大的發(fā)展 在整個上述的 年代。 雖然公司美國的封裝技術(shù)沒有明顯的差異直到堆疊競爭力era,隨著性能競爭力時代的開始,薩斯喀徹溫海力士 成為 因其封裝工藝。 特別是, 完工證明書7 技術(shù),它結(jié)合了b裁判員i互連和w憤怒b翁丁,當引座員在 創(chuàng)新這包括 f全速前進和reduc艾德(男子名)費用。它 is目前一項專門技術(shù)應用于SK的生產(chǎn)和制造海力士的 h室內(nèi)運動場densitym奧德萊斯。此外,SK海力士已經(jīng)發(fā)展了MUF先生8技術(shù)并且一直在申請它到HBM產(chǎn)品。這項技術(shù)改進了HBM超過100,000個微凸塊互連的質(zhì)量。 另外,這種包裝技術(shù)充分增加了熱虛設凸塊的數(shù)量雖然散熱性能優(yōu)于其競爭對手,如It應用美國照明工程學會 a m舊的u底部填充(MUF)材料w有嗎高導熱率。 T他的進步幫助了SK海力士增加其在HBM市場的份額,并最終取得領(lǐng)先地位HBM3扇區(qū)中的位置。
7CoC (Chip-on-Chip):一種封裝技術(shù),旨在將兩個(或多個)芯片電連接在一起,無需TSV(硅通孔)。
MUF先生(大規(guī)模回流模制底部填充):MUF先生指的是將半導體芯片附著到電路上,并在堆疊芯片時用一種叫做“液態(tài)EMC”(環(huán)氧模塑料)的材料填充芯片之間的空間和凸起間隙的過程。迄今為止,NCF技術(shù)已被用于這一進程。NCF是一種通過在芯片之間使用一種薄膜來堆疊芯片的方法。與NCF相比,MR-MUF方法具有大約兩倍的熱導率,并且影響工藝速度以及產(chǎn)量。
海力士正在促進發(fā)展使用銅的混合焊接技術(shù)–到–銅鍵合9代替焊接。 此外, 公司I正在復習多種應用各種包裝技術(shù)的選擇,包括移植法這扇出RDL10 技術(shù)。混合粘接技術(shù) 考慮到更精細的間距11 并且因此在封裝高度方面具有優(yōu)勢,因為這是一種無間隙接合技術(shù),不使用s年長的b堆疊芯片時發(fā)出的聲音。此外,扇出RDL技術(shù)適用于各種平臺,因此薩斯喀徹溫海力士計劃使用它當。。.的時候把…合并包裝隨著小芯片12。線條p瘙癢和m多-layer是關(guān)鍵的組件F安全技術(shù)、和SK海力士旨在保護1微米以下的RDL技術(shù),或者在亞微米級別,到2025年。
Cu-to-Cu(銅-銅)鍵合:封裝工藝的混合鍵合方法之一,通過完全避免使用凸點,為10 m及以下的間距提供解決方案。當封裝中的管芯需要彼此連接時,在該工藝中應用直接銅-銅連接。
10RDL(再分布層):集成電路上的一層額外的金屬層,它將芯片上其它需要的輸入輸出焊盤重新布線,以便更好地訪問需要的焊盤。例如,位于芯片中心的凸塊陣列可以重新分布到芯片邊緣附近的位置。重新分布點的能力可以實現(xiàn)更高的接觸密度,并實現(xiàn)后續(xù)的封裝步驟。
11間距:互連線之間的最小中心到中心距離
12小芯片:按用途(如控制器或高速存儲器)劃分芯片的技術(shù),在封裝過程中重新連接芯片之前,將它們制造為單獨的晶片

圖3。SK海力士的最新包裝技術(shù)
P包裝技術(shù)將成為提供 整體的系統(tǒng)解決方案那去 超越一維函數(shù)諸如芯片保護離子和 供應電力。用不了多久c公司需要可能的字母s封裝工藝成為一名領(lǐng)導者在半導體工業(yè)。 幾年前,一個主要的年的鑄造公司東亞不僅創(chuàng)建了新的系統(tǒng)級封裝(啜飲)通過一種叫做 i集成的f出去吧 (信息)包裝,但是它是 也能提高的現(xiàn)有業(yè)務領(lǐng)域 foundry銷售—這意味著薩斯喀徹溫海力士。 就像這樣 公司 因其生產(chǎn)的作用控制器,薩斯喀徹溫海力士 是 有名的 為 生產(chǎn)強中子發(fā)生器(Intense Neutron Generator的縮寫) 高的表演 半導體記憶諸如它的HBM。薩斯喀徹溫海力士還開發(fā)了先進的包裝技術(shù),如異質(zhì)整合和扇出RDL技術(shù)—即將到來的融合時代的關(guān)鍵封裝技術(shù)。 因此,公司是不僅玩強中子發(fā)生器(Intense Neutron Generator的縮寫)一個記憶整合的角色 d埃維切m制造商(IDM)但是也正在成為 a 總數(shù) “s解決方案provider “那能引領(lǐng)未來半導體記憶行業(yè)。
審核編輯:黃飛
-
DRAM
+關(guān)注
關(guān)注
40文章
2325瀏覽量
183868 -
存儲器
+關(guān)注
關(guān)注
38文章
7528瀏覽量
164345 -
SK海力士
+關(guān)注
關(guān)注
0文章
973瀏覽量
38729 -
HBM
+關(guān)注
關(guān)注
0文章
386瀏覽量
14836
發(fā)布評論請先 登錄
相關(guān)推薦
半導體封裝的主要類型和制造方法
倒裝封裝(Flip Chip)工藝:半導體封裝的璀璨明星!

人工智能半導體及先進封裝技術(shù)發(fā)展趨勢

半導體研究所在量子點異質(zhì)外延技術(shù)上取得重大突破

2.5D封裝與異構(gòu)集成技術(shù)解析
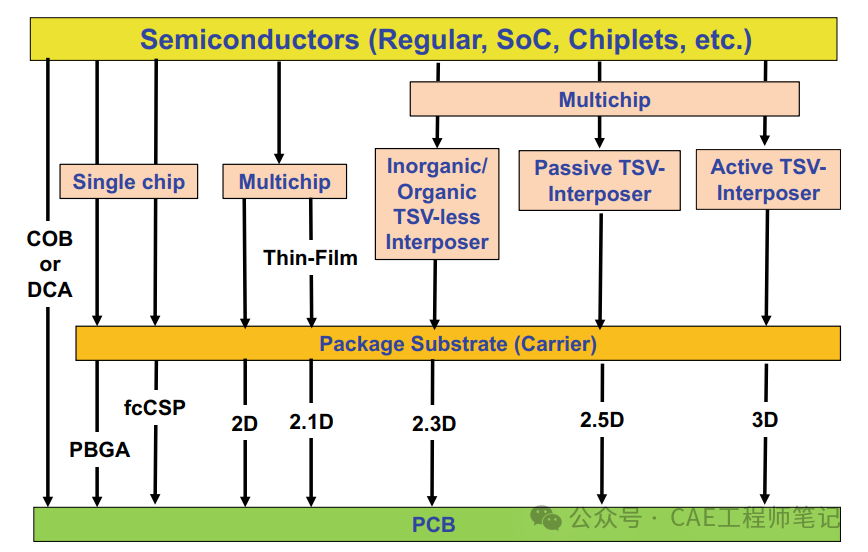
半導體封裝技術(shù)的類型和區(qū)別
led封裝和半導體封裝的區(qū)別
半導體行業(yè)回暖,萬年芯深耕高端封裝

喜訊 | MDD辰達半導體榮獲藍點獎“最具投資價值獎”
半導體封裝技術(shù)的可靠性挑戰(zhàn)與解決方案

半導體發(fā)展的四個時代
半導體發(fā)展的四個時代
半導體封裝工藝的研究分析

半導體先進封裝技術(shù)





 異質(zhì)集成時代半導體封裝技術(shù)的價值
異質(zhì)集成時代半導體封裝技術(shù)的價值











評論