文章來源:SiP與先進封裝技術(shù)
原文作者:Suny Li
先進封裝是什么以及先進封裝相比于傳統(tǒng)封裝的優(yōu)勢
1.引 言
說起傳統(tǒng)封裝,大家都會想到日月光ASE,安靠Amkor,長電JCET,華天HT,通富微電TF等這些封裝大廠OSAT;說起先進封裝,當今業(yè)界風(fēng)頭最盛的卻是臺積電TSMC,英特爾Intel,三星SAMSUNG等這些頂尖的半導(dǎo)體晶圓廠IC Foundry,這是為何呢?
如果你認為這些半導(dǎo)體晶圓大佬們似乎顯得有些"不務(wù)正業(yè)"?那你就大錯特錯了!
傳統(tǒng)封裝的功能主要在于芯片保護、尺度放大、電氣連接三項功能,先進封裝和SiP在此基礎(chǔ)上增加了“提升功能密度、縮短互聯(lián)長度、進行系統(tǒng)重構(gòu)”三項新功能。
正是由于這些新特點,使得先進封裝和SiP的業(yè)務(wù)從OSAT拓展到了包括Foundry、OSAT和System系統(tǒng)廠商。
Foundry由于其先天具有的工藝優(yōu)勢,在先進封裝領(lǐng)域可以獨領(lǐng)風(fēng)騷,系統(tǒng)廠商則是為了在封裝內(nèi)實現(xiàn)系統(tǒng)的功能開始重點關(guān)注SiP和先進封裝。

那么,先進封裝和傳統(tǒng)封裝的分界點到底在哪里?如何界定先進封裝呢?這就是我們這篇文章要重點討論的問題:先進封裝的“四要素”。
2.先進封裝的四要素
先進封裝的四要素是指:RDL,TSV,Bump,Wafer,任何一款封裝,如果具備了四要素中的任意一個,都可以稱之為先進封裝。
在先進封裝的四要素中,RDL起著XY平面電氣延伸的作用,TSV起著Z軸電氣延伸的作用,Bump起著界面互聯(lián)和應(yīng)力緩沖的作用,Wafer則作為集成電路的載體以及RDL和TSV的介質(zhì)和載體,如下圖所示,為先進封裝四要素的功能示意圖。
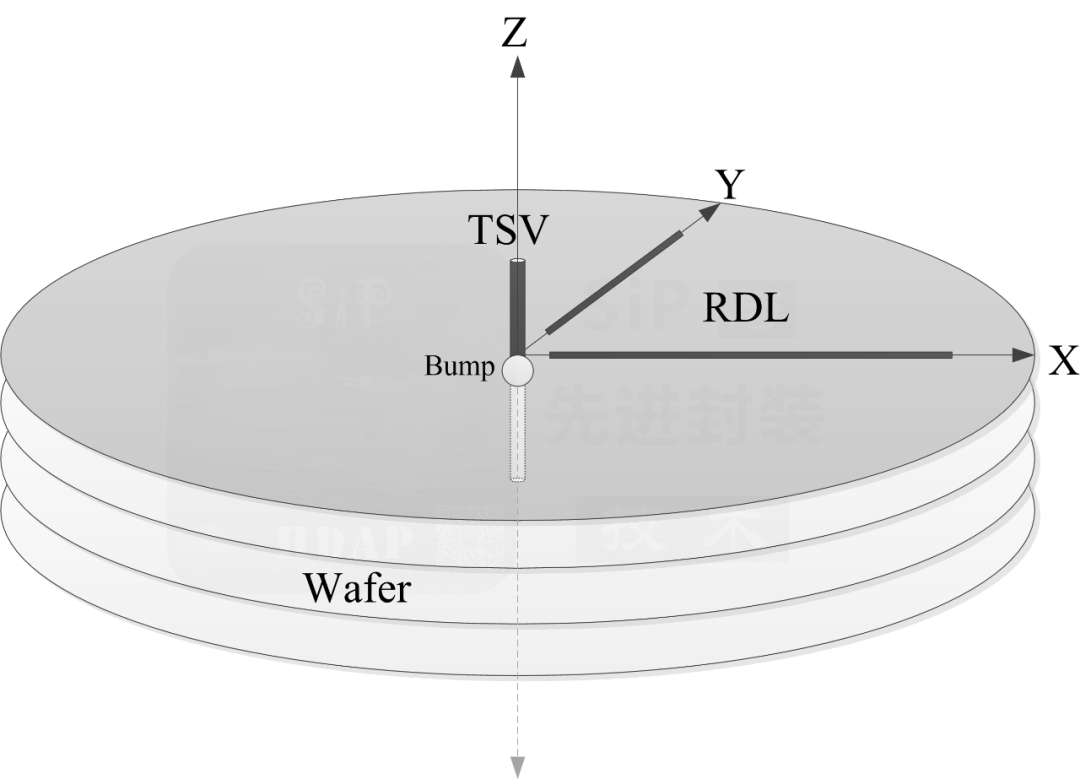
先進封裝的四要素(原創(chuàng))
首先,我們要明確,在特定的歷史時期,先進封裝只是一個相對的概念,現(xiàn)在的先進封裝在未來可能就是傳統(tǒng)封裝。
下圖是作者根據(jù)四要素內(nèi)在的先進性做了簡單排序,大致如下:Bump → RDL → Wafer → TSV。
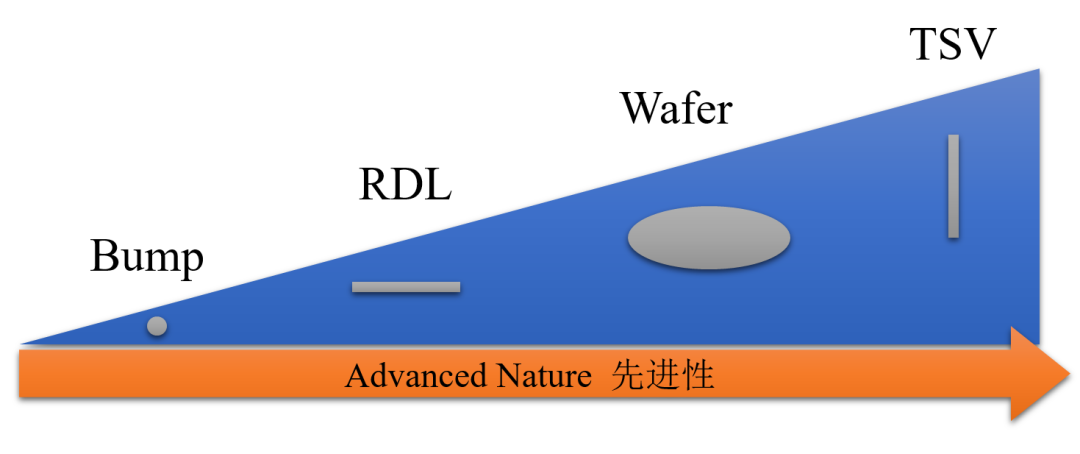
一般來說,出現(xiàn)的越早的技術(shù)其先進性就相對越低,出現(xiàn)越晚的技術(shù)其先進性就相對越高。
下面,我們就逐一闡述先進封裝的四要素。
3.Bump
Bump是一種金屬凸點,從倒裝焊FlipChip出現(xiàn)就開始普遍應(yīng)用了,Bump的形狀也有多種,最常見的為球狀和柱狀,也有塊狀等其他形狀,下圖所示為各種類型的Bump。
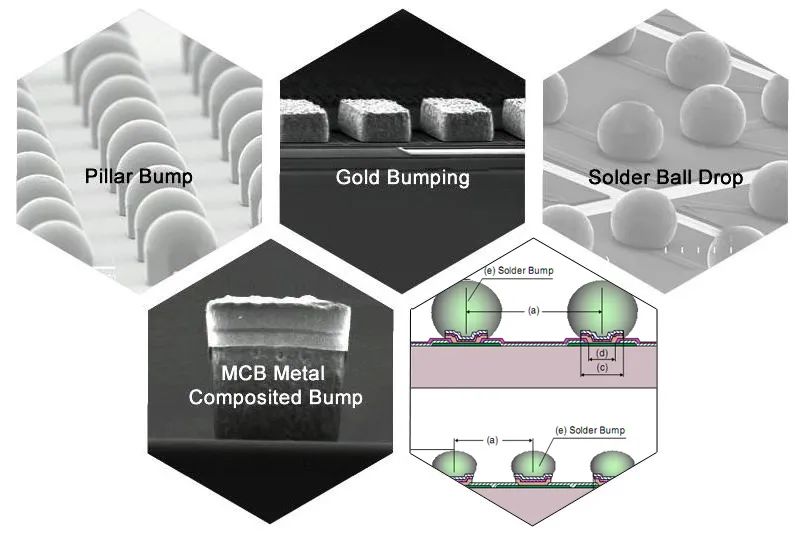
Bump起著界面之間的電氣互聯(lián)和應(yīng)力緩沖的作用,從Bondwire工藝發(fā)展到FlipChip工藝的過程中,Bump起到了至關(guān)重要的作用。
隨著工藝技術(shù)的發(fā)展,Bump的尺寸也變得越來越小,下圖顯示的是Bump尺寸的變化趨勢。

可以看出, Bump尺寸從最初 Standard FlipChip的100um發(fā)展到現(xiàn)在最小的5um。
那么,會不會有一天,Bump小到不再需要了呢?
確實有這種可能,TSMC發(fā)布的SoIC技術(shù)中,最鮮明的特點是沒有凸點(no-Bump)的鍵合結(jié)構(gòu),因此,該技術(shù)具有有更高的集成密度和更佳的運行性能。
4.RDL
RDL(ReDistribution Layer)重布線層,起著XY平面電氣延伸和互聯(lián)的作用。
在芯片設(shè)計和制造時,IO Pad一般分布在芯片的邊沿或者四周,這對于Bond Wire工藝來說自然很方便,但對于Flip Chip來說就有些勉為其難了。
因此,RDL就派上用場了,在晶元表面沉積金屬層和相應(yīng)的介質(zhì)層,并形成金屬布線,對IO 端口進行重新布局,將其布局到新的,占位更為寬松的區(qū)域,并形成面陣列排布,如下圖所示。
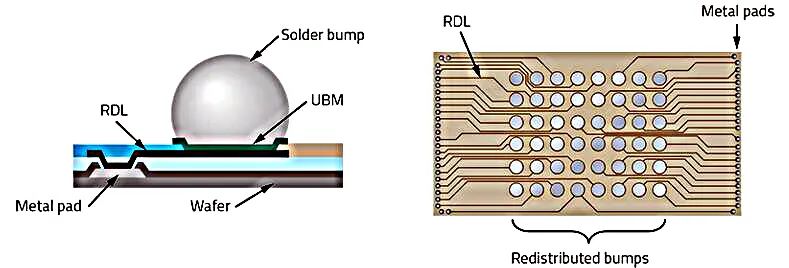
在先進封裝的FIWLP (Fan-In Wafer Level Package) ,F(xiàn)OWLP (Fan-Out Wafer Level Package) 中,RDL是最為關(guān)鍵的技術(shù),通過RDL將IO Pad進行扇入Fan-In或者扇出Fan-Out,形成不同類型的晶圓級封裝。
在2.5D IC集成中,除了硅基板上的TSV,RDL同樣不可或缺,通過RDL將網(wǎng)絡(luò)互聯(lián)并分布到不同的位置,從而將硅基板上方芯片的Bump和基板下方的Bump連接。
在3D IC集成中,對于上下堆疊是同一種芯片,通常TSV就可以直接完成電氣互聯(lián)功能了,而堆疊上下如果是不同類型芯片,則需要通過RDL重布線層將上下層芯片的IO進行對準,從而完成電氣互聯(lián)。
隨著工藝技術(shù)的發(fā)展,通過RDL形成的金屬布線的線寬和線間距也會越來越小,從而提供更高的互聯(lián)密度。
5. Wafer
Wafer晶圓在當今半導(dǎo)體行業(yè)具有廣泛的用途,既可以作為芯片制造的基底,也可以在Wafer上制作硅基板實現(xiàn)2.5D集成,同時可用于WLP晶圓級封裝,作為WLP的承載晶圓。
Wafer最初僅用在芯片制造上,作為集成電路生產(chǎn)的載體,在Wafer上進行光刻、刻蝕、氣相沉積、離子注入、研磨等工序,反復(fù)操作,精密控制,最終制造出集成電路芯片。
隨著先進封裝技術(shù)的快速發(fā)展,Wafer的用途也變得越來越廣泛。
傳統(tǒng)封裝是先進行裸芯片的切割分片,然后進行封裝,而晶圓級封裝WLP是在Wafer基礎(chǔ)上先封裝,然后切割分片。這就提高了封裝效率,節(jié)省了成本,從而得到了廣泛的應(yīng)用。
前面,我們討論了,隨著技術(shù)的發(fā)展,Bump和RDL會變得越來越細小,Bump甚至最終會消失,而Wafer則會變得越來越大,從早先的6英寸到8英寸到現(xiàn)在普遍應(yīng)用的12英寸以及將來要廣泛應(yīng)用的18英寸,都體現(xiàn)了這樣的特點,如下圖所示。
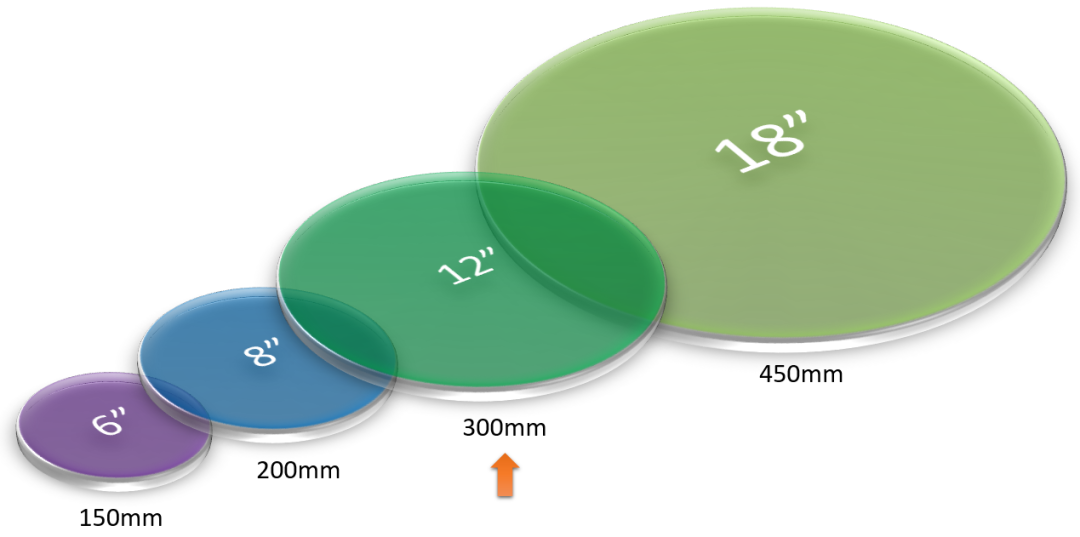
晶圓尺寸越大,同一圓片上可生產(chǎn)的IC就越多,可降低成本,提高效率,但對材料技術(shù)和生產(chǎn)技術(shù)的要求也會更高。
從FIWLP、FOWLP到2.5D集成、3D集成,基本都是在Wafer基礎(chǔ)上進行的。
6.TSV
TSV(Through Silicon Via )硅通孔,其主要功能是Z軸電氣延伸和互聯(lián)的作用。
TSV按照集成類型的不同分為2.5D TSV和3D TSV,2.5D TSV是指的位于硅轉(zhuǎn)接板Inteposer上的TSV,3D TSV 是指貫穿芯片體之中,連接上下層芯片的TSV,如下圖所示。
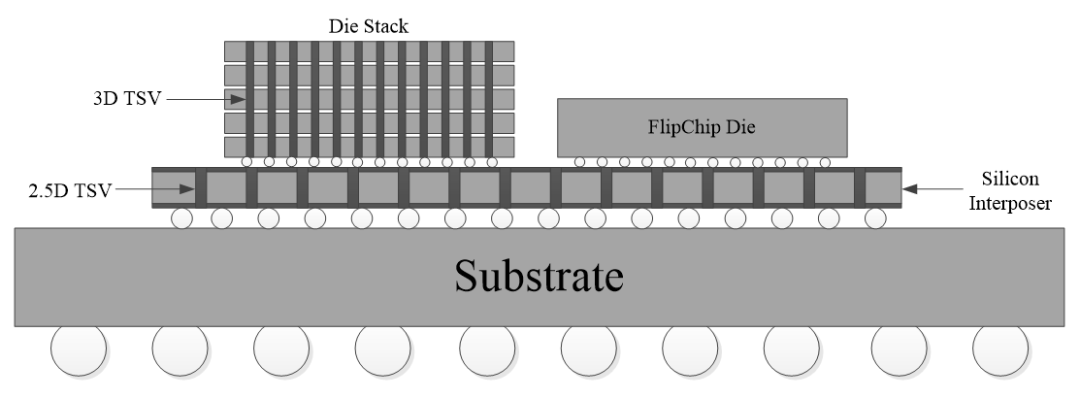
下圖所示為貫穿芯片體的3D TSV 的立體示意圖。
TSV的制作可以集成到生產(chǎn)工藝的不同階段,通常放在晶元制造階段的叫 Via-first,放在封裝階段的叫Via-last。
將TSV在晶圓制造過程中完成,此類硅通孔被稱作Via-first。Via-first TSV又可分為兩種階段,一種是在Foundry廠前端金屬互連之前進行,實現(xiàn)core-to-core的連接。該方案目前在微處理器等高性能器件領(lǐng)域研究較多,主要作為SoC的替代方案。另外一種是在CMOS完成之后再進行TSV的制作,然后完成器件制造和后端的封裝。
將TSV放在封裝生產(chǎn)階段,通常被稱作Via-last,該方案可以不改變現(xiàn)有集成電路流程和設(shè)計。目前,業(yè)界已開始在高端的Flash和DRAM領(lǐng)域采用Via-last技術(shù),即在芯片的周邊進行硅通孔TSV制作,然后進行芯片或晶圓的層疊。
TSV的尺寸范圍比較大,大的TSV直徑可以超過100um,小的TSV直徑小于1um。
隨著工藝水平的提升,TSV可以做的越來越小,密度也越來越大,目前最先進的TSV工藝,可以在芝麻粒大小的1平方毫米硅片上制作高達10萬~100萬個TSV。
和Bump以及RDL類似,TSV的尺寸也會隨著工藝的提高變得越來越小,從而支撐更高密度的互聯(lián)。
**7.總結(jié) **
RDL,TSV,Bump,Wafer是先進封裝的四要素,任何一款封裝,如果具備了四要素中的任意一個,都可以稱之為先進封裝。
在先進封裝四要素中,Wafer是載體和基底,RDL負責(zé)XY平面的延伸,TSV負責(zé)Z軸的延伸,Bump負責(zé)Wafer界面間的連接和應(yīng)力緩沖。
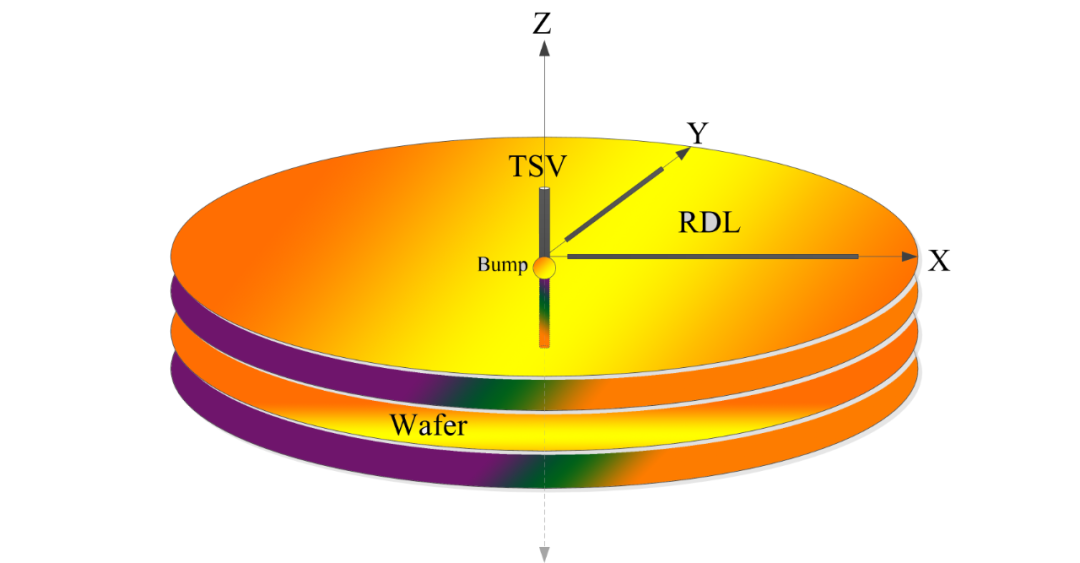
這四要素中,一大三小,一大是指Wafer,三小是指Bump、RDL、TSV。
隨著技術(shù)和工藝的發(fā)展,大要素會越來越大,而小要素則會越來越小。
審核編輯:湯梓紅
-
集成電路
+關(guān)注
關(guān)注
5392文章
11622瀏覽量
363184 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27709瀏覽量
222645 -
晶圓
+關(guān)注
關(guān)注
52文章
4975瀏覽量
128315 -
SiP
+關(guān)注
關(guān)注
5文章
506瀏覽量
105459 -
先進封裝
+關(guān)注
關(guān)注
2文章
427瀏覽量
286
原文標題:先進封裝的“四要素”
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
盤點先進封裝基本術(shù)語

超越芯片表面:探索先進封裝技術(shù)的七大奧秘


#硬聲創(chuàng)作季 【科普向】傳統(tǒng)封裝與先進封裝有何差異?——為什么需要先進封裝

晶振采購需考慮四要素
簡述熔斷保險絲熔斷四要素
簡述氣體放電管選型四要素
淺談半導(dǎo)體封裝技術(shù)和先進封裝技術(shù)解析
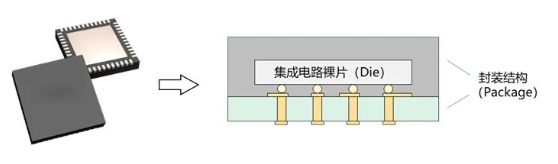
先進封裝技術(shù)的發(fā)展與機遇
先進封裝廠關(guān)于Bump尺寸的管控

淺析先進封裝的四大核心技術(shù)

什么是先進封裝?先進封裝技術(shù)包括哪些技術(shù)

先進封裝技術(shù)-19 HBM與3D封裝仿真





 淺談先進封裝的四要素
淺談先進封裝的四要素











評論