硅通孔技術(TSV,Through Silicon Via)是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導通,實現芯片之間互連的技術,是2.5D/3D 封裝的關鍵工藝之一。通過垂直互連減小互連長度、信號延遲,降低電容、電感,實現芯片間低功耗、高速通訊,增加帶寬和實現小型化。
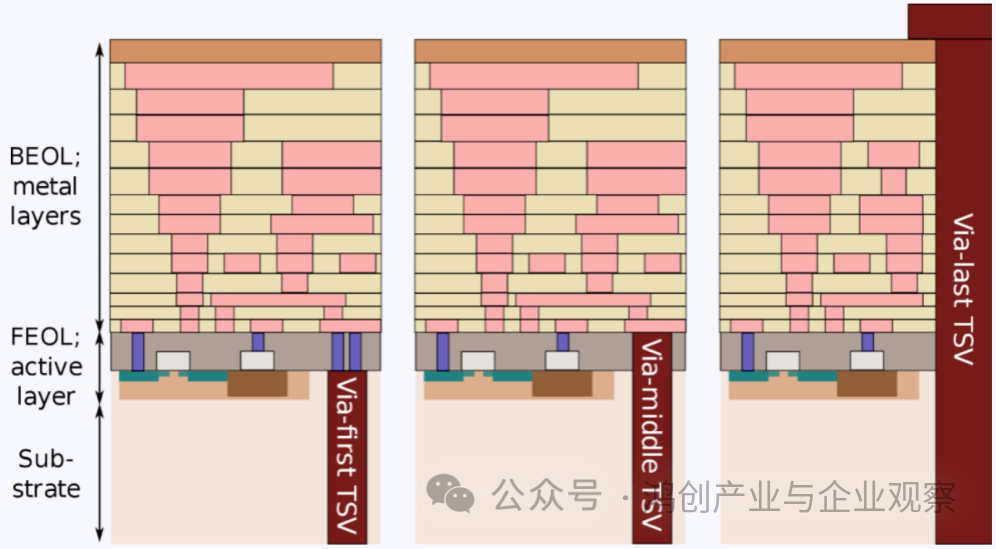
依據TSV 通孔生成的階段 TSV 工藝可以分為:1)Via-First;2)Via-Middle;3)Via-Last。
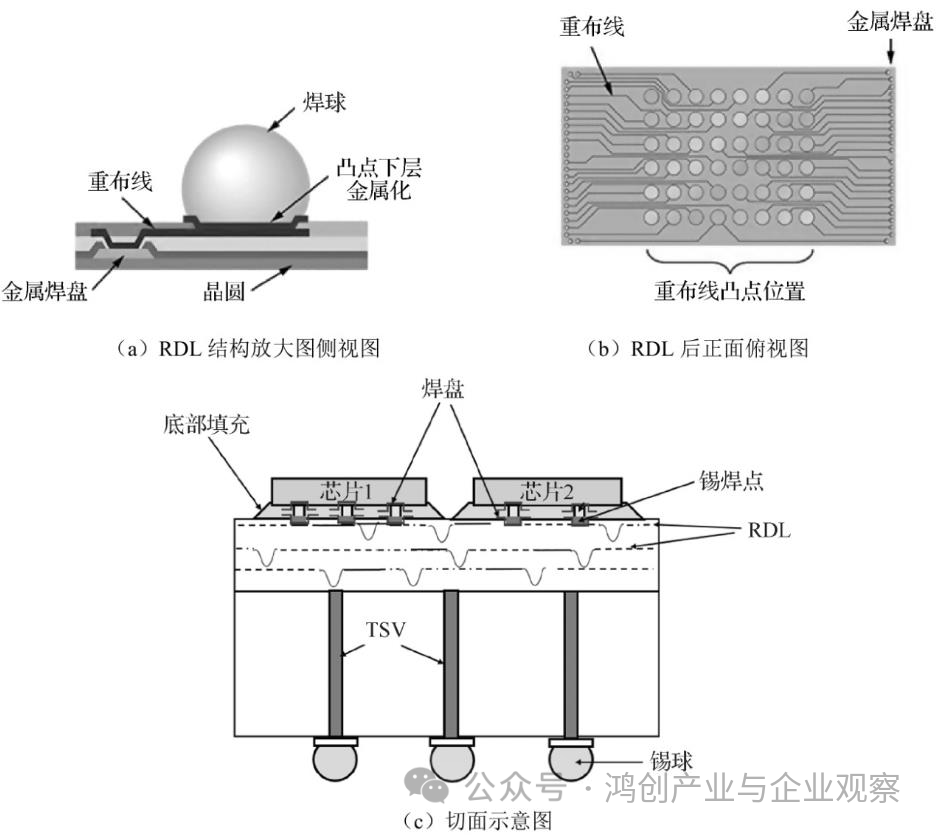
TSV 工藝包括深硅刻蝕形成微孔,再進行絕緣層、阻擋層、種子層的沉積,深孔填充,退火,CMP 減薄,Pad 的制備疊加等工藝技術。
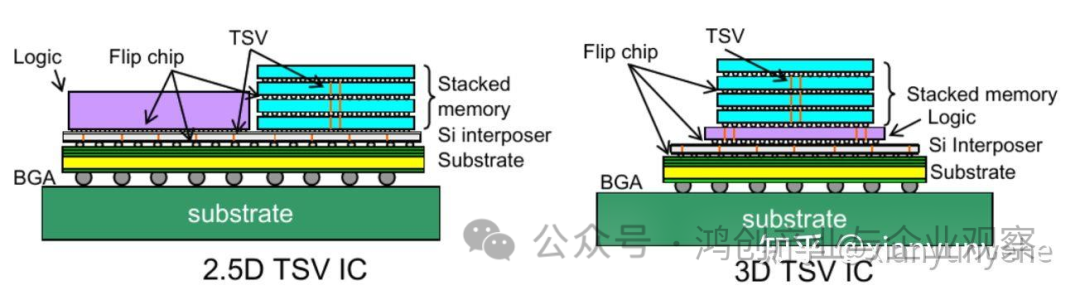
1)孔成型:孔成型的方式有激光打孔、干法刻蝕、濕法刻蝕等。基于深硅刻蝕(Deep Reactive Ion Etching,DRIE)的 Bosch工藝是目前應用最廣泛工藝。反應離子刻蝕(Reactive Ion Etching,RIE)工藝是采用物理轟擊和化學反應雙重作用的刻蝕,Bosch 工藝通過刻蝕和保護交替進行來提高 TSV 的各向異性,保證 TSV 通孔垂直度。
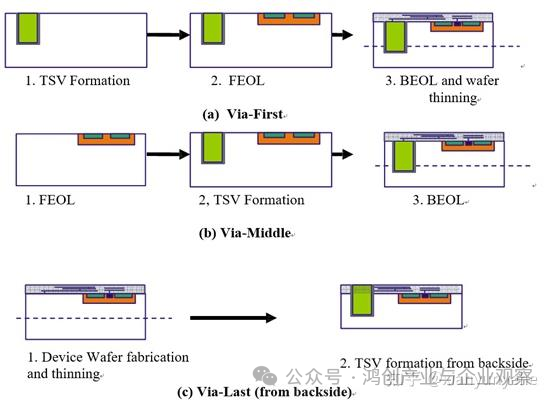
2)沉積絕緣層:TSV 孔內絕緣層用于實現硅村底與孔內傳輸通道的絕緣,防止 TSV通孔之間漏電和串擾。TSV 孔壁絕緣介質材料選用無機介質材料,包括PECVD、SACVD、ALD 和熱氧化法。
3)沉積阻擋層/種子層:在2.5D TSV 中介層工藝中,一般使用銅作為 TSV 通孔內部金屬互聯材料。在電鍍銅填充 TSV 通孔前,需在 TSV 孔內制備電鍍阻擋/種子層,一般選用 Ti、Ta、TiN、TaN 等材料。TSV 電鍍種子層起著與電鍍電極電連接并實現 TSV 孔填充的作用。
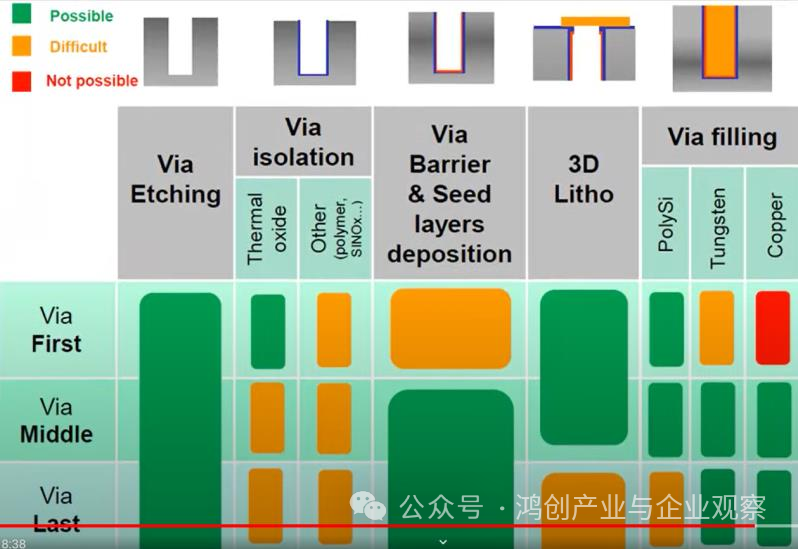
4)電鍍填充工藝:TSV 深孔的填充技術是 3D 集成的關鍵技術,直接關系到后續器件的電學性能和可靠性。可以填充的材料包括銅、鎢、多晶硅等。
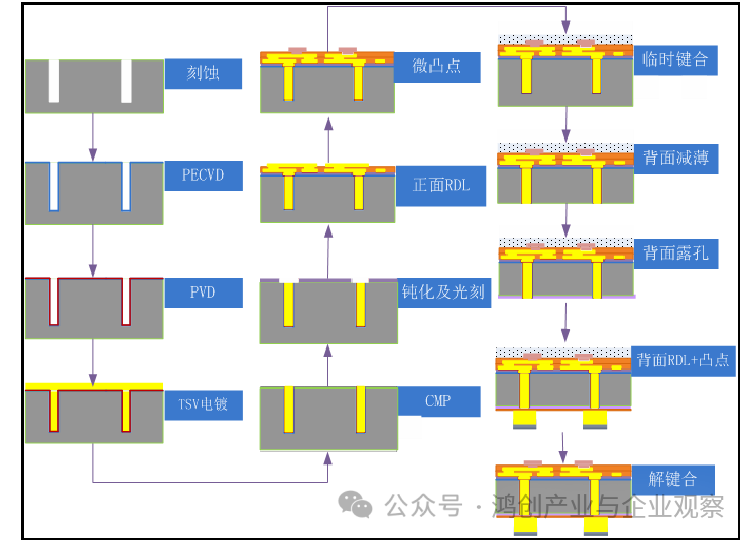
5)CMP(化學機械拋光)工藝和背面露頭工藝:CMP 技術用于去除硅表面的二氧化硅介質層、阻擋層和種子層。TSV 背面露頭技術也是 2.5DTSV 轉接基板的關鍵工藝,包括晶圓減薄、干/濕法刻蝕工藝。
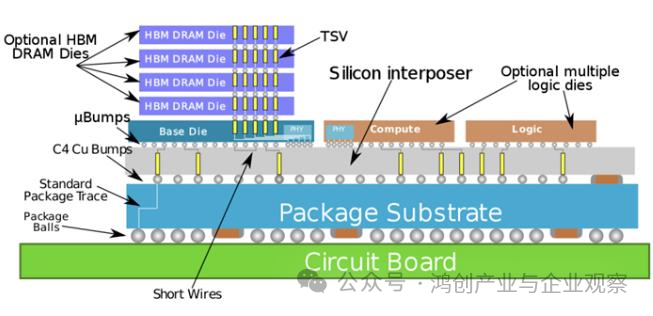
6)晶圓減薄:晶圓表面平坦化后,還需要進行晶圓背面的減薄使 TSV 露出,傳統的晶圓減薄技術包括機械磨削、CMP 和濕法腐蝕等。目前業界主流的解決方案是將晶圓的磨削、拋光、保護膜去除和劃片膜粘貼等工序集合在一臺設備內。
審核編輯:湯梓紅
-
芯片
+關注
關注
456文章
51170瀏覽量
427239 -
晶圓
+關注
關注
52文章
4973瀏覽量
128313 -
TSV
+關注
關注
4文章
115瀏覽量
81565 -
硅通孔
+關注
關注
2文章
24瀏覽量
11871
原文標題:【研究筆記】硅通孔技術(TSV)
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
一文看懂TSV技術
3D IC集成與硅通孔TSV互連

中微推出用于3D芯片及封裝的硅通孔刻蝕設備Primo TSV200E(TM)
基于CAN-WAS的硅通孔TSV測試
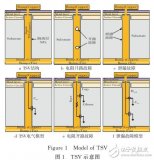
技術資訊 I 3D-IC 中 硅通孔TSV 的設計與制造





 一文詳解硅通孔技術(TSV)
一文詳解硅通孔技術(TSV)

















評論