同為第三代半導(dǎo)體材料,氮化鎵時(shí)常被人用來與碳化硅作比較,雖然沒有碳化硅發(fā)展的時(shí)間久,但氮化鎵依舊憑借著禁帶寬度大、擊穿電壓高、熱導(dǎo)率大、飽和電子漂移速度高和抗輻射能力強(qiáng)等特點(diǎn)展現(xiàn)了它的優(yōu)越性。
雖然沒有碳化硅那么火爆,但氮化鎵的吸金程度也毫不遜色。據(jù)YoleDeveloppement發(fā)布的GaNPower2021報(bào)告預(yù)期,到2026年GaN功率市場(chǎng)規(guī)模預(yù)計(jì)會(huì)達(dá)到11億美元,低調(diào)卻“吸金”。
** “吸金”背后的發(fā)展難題**
毫無疑問,氮化鎵已經(jīng)成為半導(dǎo)體產(chǎn)業(yè)的重要發(fā)展方向,但不可否認(rèn)的是,就像碳化硅一樣,氮化鎵也存在著種種技術(shù)難點(diǎn)問題。
0****1
襯底材料問題
襯底與薄膜晶格的相配程度影響GaN薄膜質(zhì)量好壞。目前使用最多的襯底是藍(lán)寶石(Al2O3),此類材料由于制備簡(jiǎn)單,價(jià)格較低,熱穩(wěn)定性良好,且可以用于生長(zhǎng)大尺寸的薄膜而被廣泛使用,但是由于其晶格常數(shù)和線膨脹系數(shù)都與氮化鎵相差較大,制備出的氮化鎵薄膜可能會(huì)存在裂紋等缺陷。另一方面,由于襯底單晶沒有解決,異質(zhì)外延缺陷密度相當(dāng)高,而且氮化鎵極性太大,難以通過高摻雜來獲得較好的金屬-半導(dǎo)體的歐姆接觸,因此工藝制造較復(fù)雜。
0****2
氮化鎵薄膜制備問題
傳統(tǒng)的GaN薄膜制備主要方法有MOCVD(金屬有機(jī)物氣相沉積法)、MBE法(分子束外延法)和HVPE(氫化物氣相外延法)。其中,采用MOCVD法制備的產(chǎn)量大,生長(zhǎng)周期短,適合用于大批量生產(chǎn),但生長(zhǎng)完畢后需要進(jìn)行退火處理,最后得到的薄膜可能會(huì)存在裂紋,會(huì)影響產(chǎn)品的質(zhì)量;MBE法只能用于一次制備少量的GaN薄膜,尚不能用于大規(guī)模生產(chǎn);HVPE法生成的GaN晶體質(zhì)量比較好,且在較高的溫度下生長(zhǎng)速度快,但高溫反應(yīng)對(duì)生產(chǎn)設(shè)備,生產(chǎn)成本和技術(shù)要求都比較高。
MOCVD反應(yīng)腔
0****3
GaN籽晶獲得問題
直接采用氨熱方法培育一個(gè)兩英寸的籽晶需要幾年時(shí)間,因此如何獲得高質(zhì)量、大尺寸的GaN籽晶也是難題所在。
0****4
其他技術(shù)問題
此外,目前氮化鎵還有2個(gè)技術(shù)上的難題,其一是以目前生長(zhǎng)的基板碳化硅來說,尺寸上尚無法突破6英寸晶圓的大小,同時(shí)碳化硅的取得成本較高,導(dǎo)致目前既無法大量生產(chǎn)、價(jià)格也壓不下來;其二則是要如何讓氮化鎵能在硅晶圓上面生長(zhǎng)、并且擁有高良率,是業(yè)界要突破的技術(shù),如果可以克服并運(yùn)用現(xiàn)有的基礎(chǔ)設(shè)施,氮化鎵未來的價(jià)格跟產(chǎn)量就能有所改善。
由此可見,要想氮化鎵產(chǎn)能提升、成本控制并形成完全的產(chǎn)業(yè)鏈,所面對(duì)的技術(shù)挑戰(zhàn)不容小覷。
有難題的地方就會(huì)有新技術(shù)
當(dāng)然,有難題的地方就會(huì)有科研,有科研的地方就會(huì)有智慧,有智慧的地方顯然也孕育了不少突破性技術(shù)。
中國瑞士聯(lián)合團(tuán)隊(duì)讓氮化鎵器件性能大幅接近理論極限
南方科技大學(xué)電子與電氣工程系助理教授馬俊團(tuán)隊(duì)與瑞士洛桑聯(lián)邦理工大學(xué)(EPFL)和蘇州晶湛半導(dǎo)體有限公司合作研發(fā)了一種多溝道氮化鎵電力電子器件技術(shù),可用于開發(fā)高能效的電能轉(zhuǎn)換系統(tǒng)。
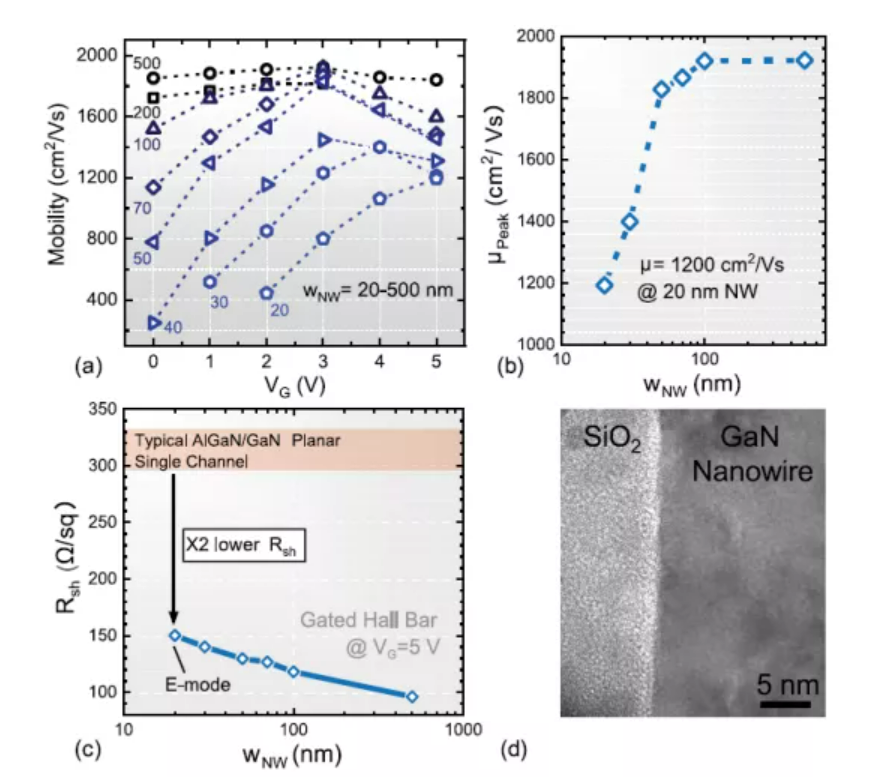
多溝道納米線中的電子傳輸
該技術(shù)解決了兩個(gè)電子器件中基礎(chǔ)性、原理性的挑戰(zhàn)。第一,怎么降低器件的電阻,但又不損失電子的遷移率。第二,如何在低電阻的情況下實(shí)現(xiàn)高擊穿電壓。據(jù)介紹,研究人員通過材料結(jié)構(gòu)的設(shè)計(jì)和外延工藝的提升,在100-200納米的多溝道內(nèi),堆疊了4至5個(gè)導(dǎo)電溝道。此外,從器件設(shè)計(jì)方面,研究人員使用了原創(chuàng)的三維場(chǎng)板結(jié)構(gòu),并申請(qǐng)了專利。
晶湛半導(dǎo)體突破12英寸硅基氮化鎵HEMT外延技術(shù)
除了上述提到的技術(shù)外,晶湛半導(dǎo)體在2021年9月成功將其AlGaN/GaN HEMT外延工藝轉(zhuǎn)移到300mmSi襯底上,同時(shí)保持了優(yōu)異的厚度均勻性和50μm以內(nèi)的低晶圓翹曲。據(jù)了解,這是繼2014年成功推出商用200mmGaN-on-Si HV HEMT外延片后,晶湛半導(dǎo)體的又一次突破。垂直電壓擊穿測(cè)量表明,300mm尺寸的晶圓同樣適合于200V、650V和1200V功率器件應(yīng)用。
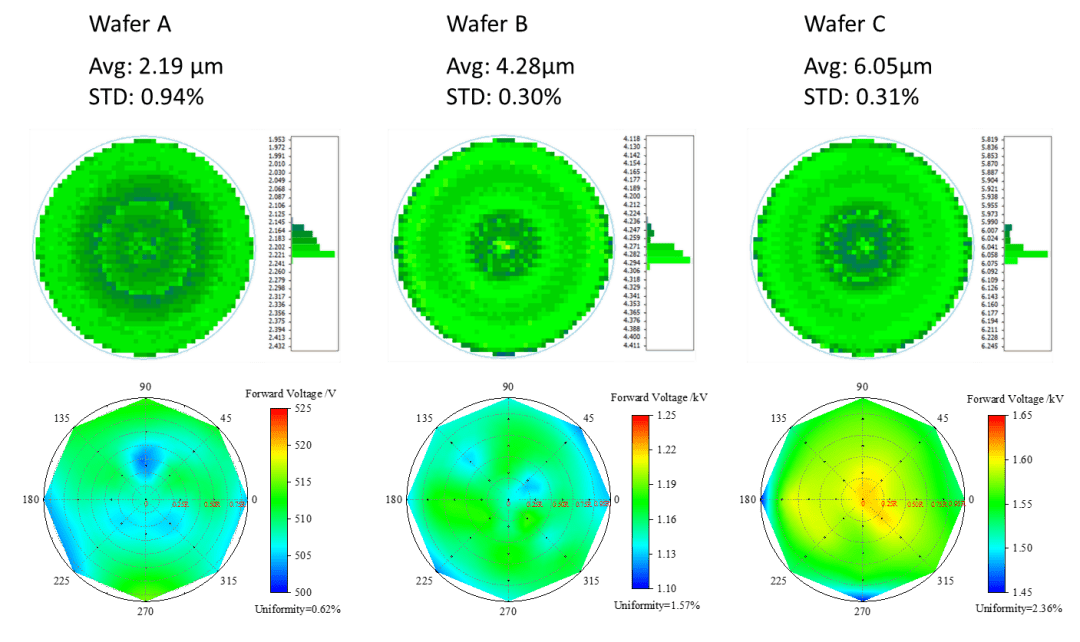
晶湛半導(dǎo)體300mmGaN-on-SiHEMT外延片系列
厚度均勻性分布圖和垂直擊穿電壓分布圖
為解決GaN外延中的晶圓開裂/彎曲和高晶體缺陷等關(guān)鍵問題,晶湛半導(dǎo)體外延生長(zhǎng)從AlN形核層開始,然后是應(yīng)力弛豫緩沖層、GaN溝道層、AlGaN勢(shì)壘層和GaN帽層。窄的XRDAlN(002)峰和良好的半高寬均勻性表明整個(gè)300mm晶圓的晶體質(zhì)量較高。
AIST開發(fā)全球首顆GaN HEMT與SiC SBD的集成單芯片原型
2022年12月12日,日本先進(jìn)工業(yè)科學(xué)技術(shù)研究所(AIST)宣布,成功開發(fā)了全球首顆GaN HEMT與SiC SBD的集成單芯片原型。據(jù)介紹,為解決GaN HEMT的可靠性問題,AIST進(jìn)行了混合晶體管的研究和開發(fā),在同一襯底上,將GaN晶體管和SiC二極管集成在一起(即單片化)。
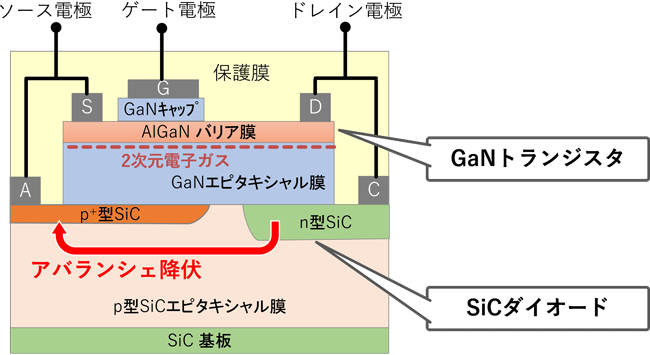
而開發(fā)氮化鎵和碳化硅的混合晶體管,需要建設(shè)開發(fā)氮化鎵和碳化硅集成器件原型的環(huán)境,所以AIST擴(kuò)建了一條SiC功率器件的4英寸原型線,將其作為SiC和GaN的共享原型線,并用于開發(fā)混合晶體管原型。
審核編輯:劉清
-
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27708瀏覽量
222645 -
氮化鎵
+關(guān)注
關(guān)注
59文章
1646瀏覽量
116620 -
MOCVD
+關(guān)注
關(guān)注
2文章
82瀏覽量
30236 -
GaN
+關(guān)注
關(guān)注
19文章
1965瀏覽量
74239 -
擊穿電壓
+關(guān)注
關(guān)注
1文章
59瀏覽量
9061
原文標(biāo)題:氮化鎵的發(fā)展難題及技術(shù)突破盤點(diǎn)
文章出處:【微信號(hào):DT-Semiconductor,微信公眾號(hào):DT半導(dǎo)體】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦




 氮化鎵的發(fā)展難題及技術(shù)突破盤點(diǎn)
氮化鎵的發(fā)展難題及技術(shù)突破盤點(diǎn)










評(píng)論