
最近,在先進封裝領域又出現了一個新的名詞“3.5D封裝”,以前聽慣了2.5D和3D封裝,3.5D封裝又有什么新的特點呢?還是僅僅是一個吸引關注度的噱頭?
今天我們就詳細解讀一下。
首先,我們要了解以下幾個名詞的確切含義,2.5D,3D,Hybrid Bonding,HBM。
2.5D
在先進封裝領域,2.5D是特指采用了中介層(interposer)的集成方式,中介層目前多采用硅材料,利用其成熟的工藝和高密度互連的特性。 雖然理論上講,中介層中可以有TSV也可以沒有TSV,但在進行高密度互聯時,TSV幾乎是不可缺少的,中介層中的TSV通常被稱為2.5D TSV。 2.5D封裝的整體結構如下圖所示。
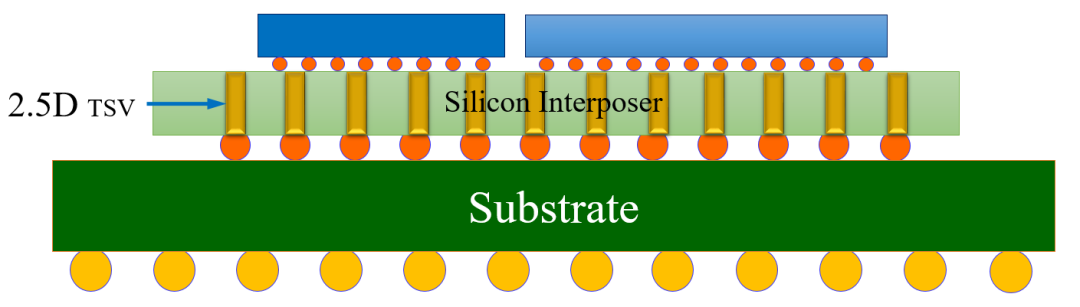
3D
和2.5D是通過中介層進行高密度互連不同,3D是指芯片通過TSV直接進行高密度互連。 大家知道,芯片面積不大,上面又密布著密度極高的電路,在芯片上進行打孔自然不是容易的事情,通常只有Foundry廠可以做得到,這也是為什么到了先進封裝時代,風頭最盛的玩家成了TSMC, Intel, Samsung這些工藝領先的芯片廠商。因為最先進的工藝掌握在他們手里,在這一點上,傳統的OSAT還是望塵莫及的。 在芯片上直接生成的TSV則被稱為3D TSV,3D封裝的整體結構如下圖所示。
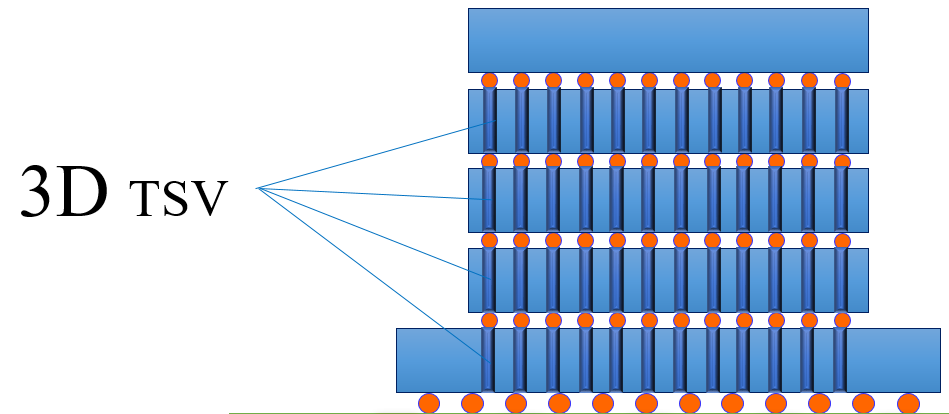
Hybrid Bonding
Hybrid Bonding混合鍵合技術,是一種在相互堆疊的芯片之間獲得更密集互連的方法,并可實現更小的外形尺寸。 下圖是傳統凸點和混合鍵合技術的結構比較,傳統凸點間距是 50 微米,每平方毫米有大約 400 個連接。混合鍵和Hybrid Bonding大約 10 微米的間距,可達到每平方毫米 10,000 個連接。
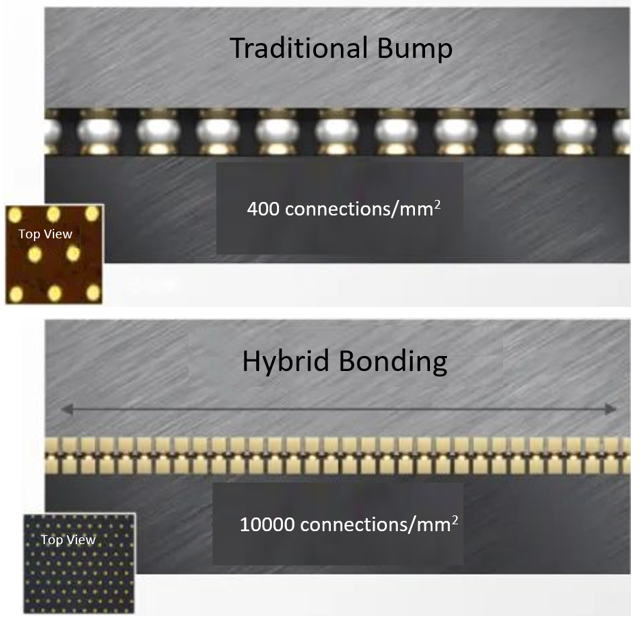
采用Hybrid Bonding技術可以在芯片之間實現更多的互連,并帶來更低的電容,降低每個通道的功率。 下圖是傳統凸點技術和混合鍵合技術的加工流程比較,混合鍵合技術需要新的制造、操作、清潔和測試方法。
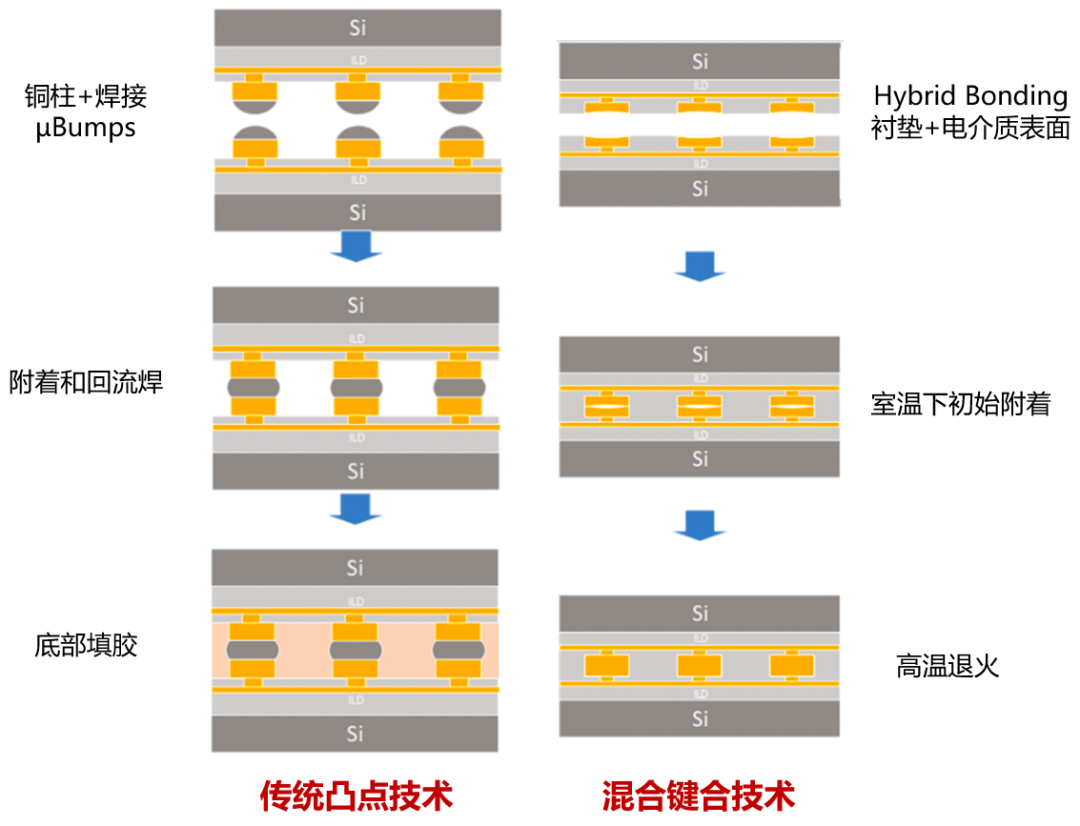
從圖中我們可以看出,傳統凸點焊接技術兩個芯片中間是帶焊料的銅柱,將它們附著在一起進行回流焊,然后進行底部填充膠。 混合鍵合技術與傳統的凸點焊接技術不同,混合鍵合技術沒有突出的凸點,特別制造的電介質表面非常光滑,實際上還會有一個略微的凹陷。在室溫將兩個芯片附著在一起,再升高溫度并對它們進行退火,銅這時會膨脹,并牢固地鍵合在一起,從而形成電氣連接。 混合鍵合技術可以將間距縮小到10 微米以下,可擴展的間距小于1微米,可獲得更高的載流能力,更緊密的銅互聯密度,并獲得比底部填充膠更好的熱性能。
HBM
隨著人工智能技術的發展和需求,HBM現在越來越火熱。 HBM(High-Bandwidth Memory )高帶寬內存,主要針對高端顯卡GPU市場。HBM使用了3D TSV和2.5D TSV技術,通過3D TSV把多塊內存芯片堆疊在一起,并使用2.5D TSV技術把堆疊內存芯片和GPU在Interposer上實現互連。下圖所示為HBM技術示意圖。
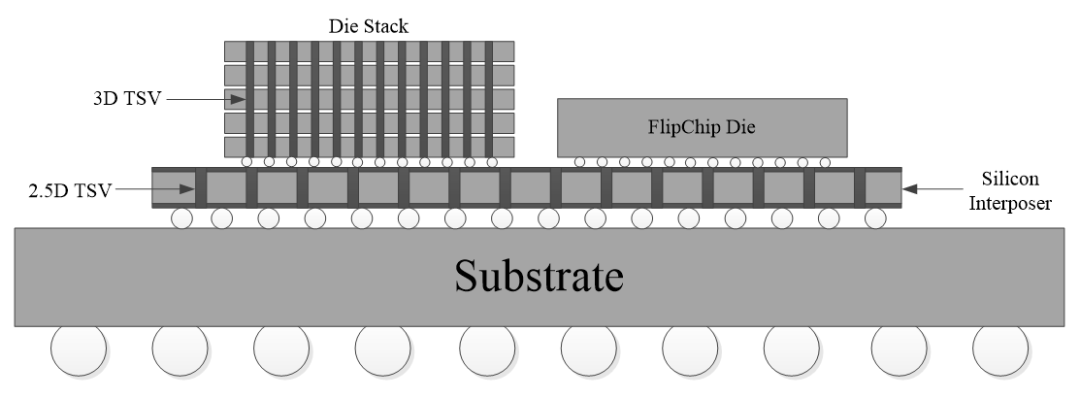
HBM既使用了3D封裝技術和2.5D封裝技術,應該歸屬于哪一類呢?有人認為HBM屬于3D封裝技術,也有人認為屬于2.5D封裝技術,其實都不確切。 通過和HMC的比較,就能得出正確的結論。 HMC(Hybrid Memory Cube)混合存儲立方體,和HBM結構非常相似,HMC通過3D TSV集成技術把內存控制器(Memory Controller)集成到DRAM堆疊封裝里。下圖所示為HMC技術示意圖。
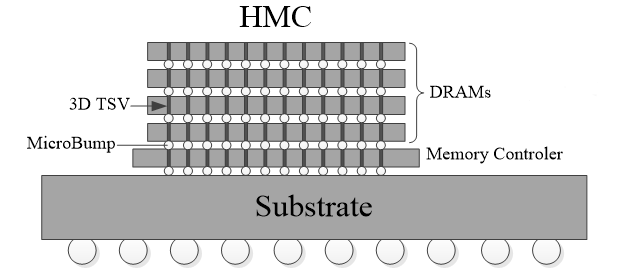
對比HBM和HMC,我們可以看出,兩者很相似,都是將DRAM芯片堆疊并通過3D TSV互連,并且其下方都有邏輯控制芯片。 兩者的不同在于:HBM通過Interposer和GPU互連,而HMC則是直接安裝在Substrate上,中間缺少了Interposer和2.5D TSV。 在《基于SiP技術的微系統》一書中,我總結了12種當今最主流的先進封裝技術。下表是對這些主流先進封裝技術橫向比較。

可以看出,現有的先進封裝技術中,HBM是唯一一種具備3D+2.5D的先進封裝技術。 如果HMC被稱為3D封裝,那么比其多了Interposer和2.5D TSV的HBM應該被稱為什么呢? 一種新的封裝命名需要呼之欲出了! 按照以往的命名規則,2D封裝加上Interposer后就變成了2.5D,那么3D封裝加上Interposer自然就變成了3.5D,既合情合理,又符合了通用的命名法則。
3.5D
什么是3.5D,最簡單的理解就是3D+2.5D,不過,既然有了全新的名稱,必然要帶有新的技術加持,這個新技術是什么呢? 就是我們前文講述的混合鍵和技術Hybrid Bonding。 混合鍵合技術應用于3D TSV的直接互連,省卻了Bump,其界面互連間距可小于10um甚至1um,其互連密度則可達到每平方毫米10000~1000000個點。
這是傳統的凸點互連遠遠無法達到的,因此,在高密度的3D互連中,凸點最終會消失,如下圖所示,這一點也是我在以前的文章中闡述過的。
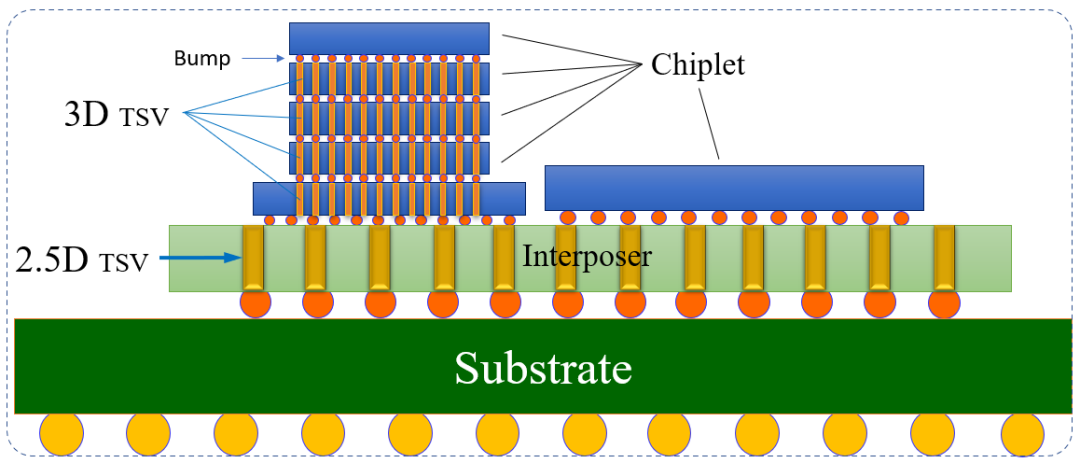

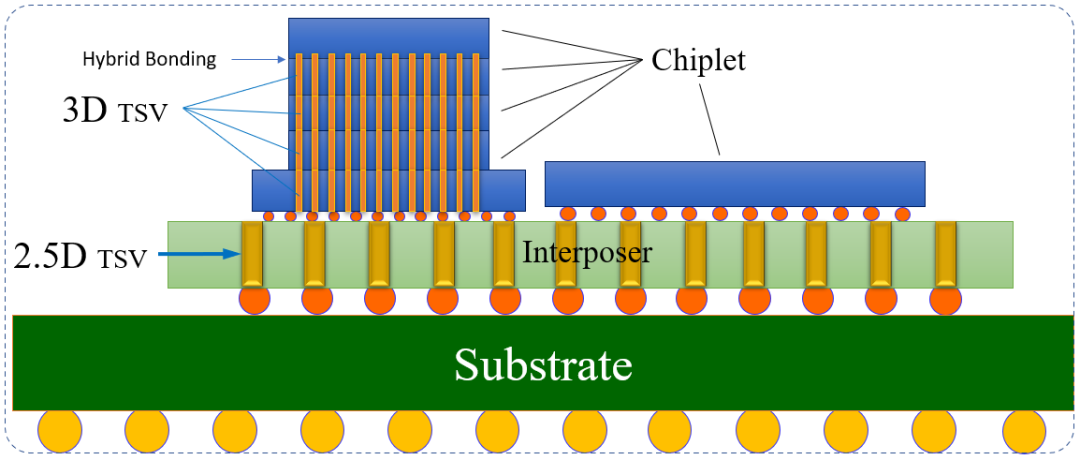
目前來說,3.5D就是3D+2.5D,再加上Hybrid Bonding技術的加持。
封裝技術分類
由于3.5D的提法已逐漸被業界所普遍接受,我因此也更新一下電子集成技術的分類法,將3.5D放到了列表中。 這樣,電子集成技術就分為:2D,2D+,2.5D,3D,3.5D,4D六種,如下圖所示:
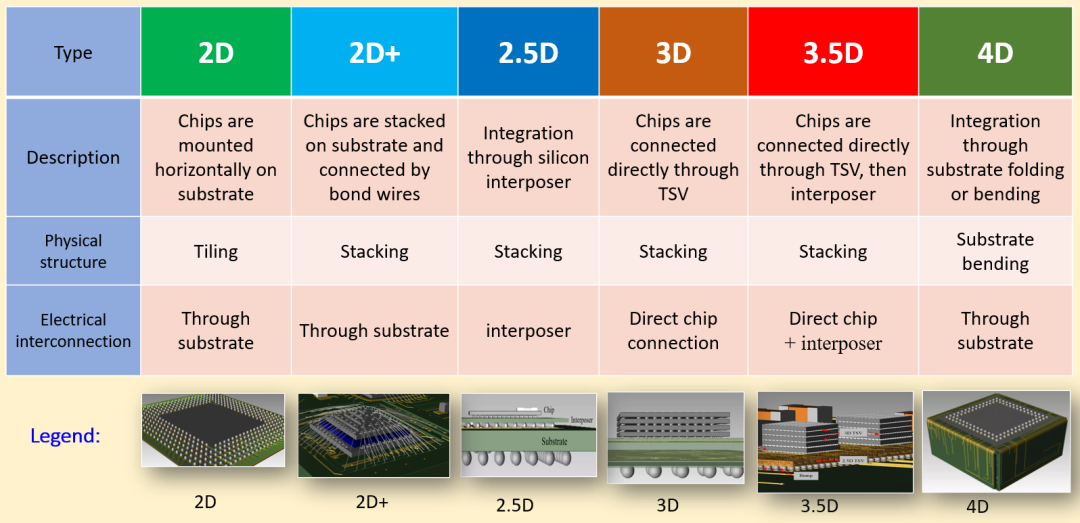
在更新的分類方法中,我并未強調Hybrid Bonding混合鍵合技術,因此,3.5D最簡單的理解就是3D+2.5D。
在高密度先進封裝的3D互連中,凸點必將消失,混合鍵合Hybrid Bonding是必然的趨勢,因此也就無需特意強調了。
在12種當今最主流的先進封裝技術中,只有HBM滿足3D+2.5D結構,因此,HBM可以說是第一種真正的3.5D封裝技術。
審核編輯:湯梓紅
-
芯片
+關注
關注
456文章
51179瀏覽量
427268 -
半導體
+關注
關注
334文章
27707瀏覽量
222645 -
3D封裝
+關注
關注
7文章
135瀏覽量
27205 -
先進封裝
+關注
關注
2文章
427瀏覽量
286
原文標題:什么是3.5D封裝?
文章出處:【微信號:射頻美學,微信公眾號:射頻美學】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
HRP晶圓級先進封裝替代傳統封裝技術研究(HRP晶圓級先進封裝芯片)

12種當今最主流的先進封裝技術

巨頭們先進封裝技術的詳細解讀
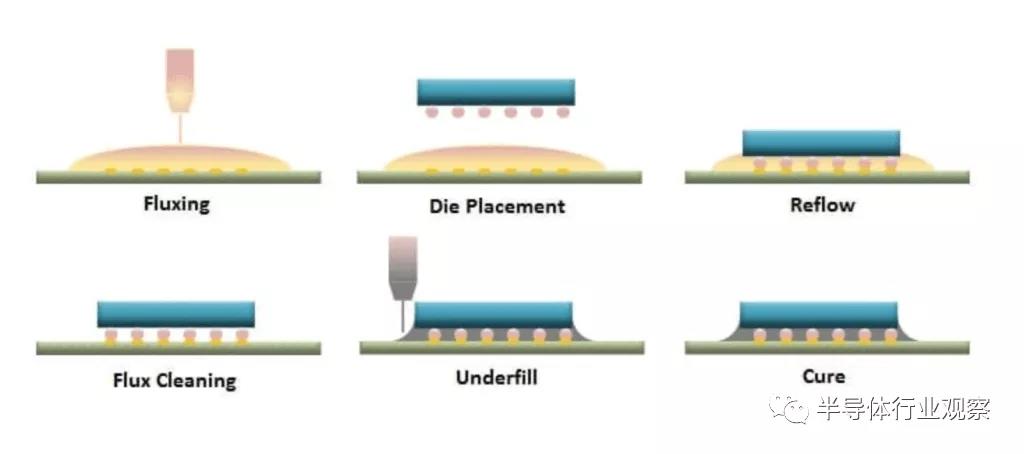
先進封裝技術的發展與機遇
什么是先進封裝?先進封裝技術包括哪些技術





 詳細解讀先進封裝技術
詳細解讀先進封裝技術

















評論