云天半導體突破2.5D高密度玻璃中介層技術
隨著人工智能的興起,2.5D中介層轉接板作為先進封裝集成的關鍵技術,近年來得到迅猛發展。與硅基相比,玻璃基(TGV)具有優良的高頻電學、力學性能、工藝流程簡化和成本低等優勢,并能實現光電合封,是理想的芯粒三維集成解決方案。
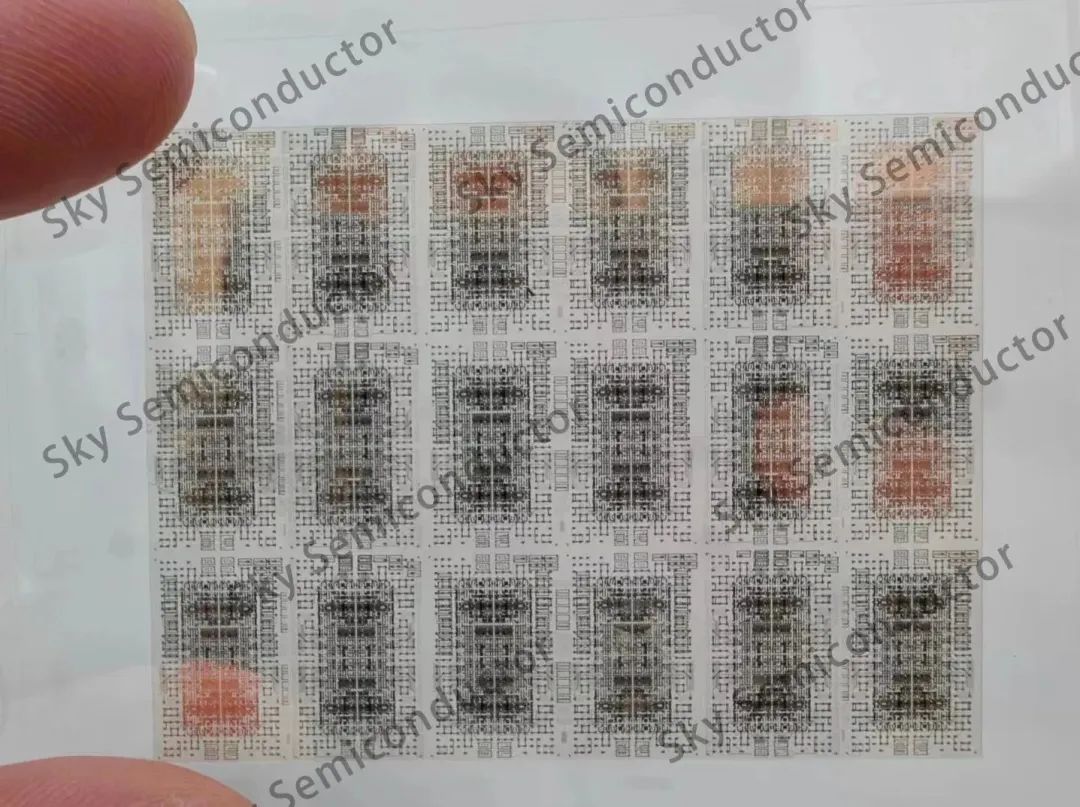 ?
?
圖1 封裝面積為2700mm2的TGV轉接板
近年來,廈門云天半導體科技有限公司致力于研發玻璃通孔及其集成技術,開發了高精度、高深寬比玻璃孔制備技術、高性能玻璃基IPD技術,并實現了規模化量產。面向高性能芯粒集成需求,云天半導體成功研發了高密度玻璃轉接板技術。大尺寸TGV轉接板樣品如圖1所示,該玻璃轉接板面積為2700mm2(60mm×45mm),厚度為80μm,TGV開口直徑25μm,實現8:1高深寬比的TGV盲孔無孔洞填充。金屬布線采用無機薄膜介質材料,實現3層RDL堆疊,通過調試干法刻蝕參數、優化CMP拋光能力實現細間距RDL,其中最小L/S可達1.5/1.5μm(如圖2)。并通過多場reticle拼接技術可滿足大尺寸轉接板制備,其中拼接精度可控在100nm以內(如圖3)。電性測試結果表明基于玻璃基的無機RDL結構較有機RDL損耗降低10%。
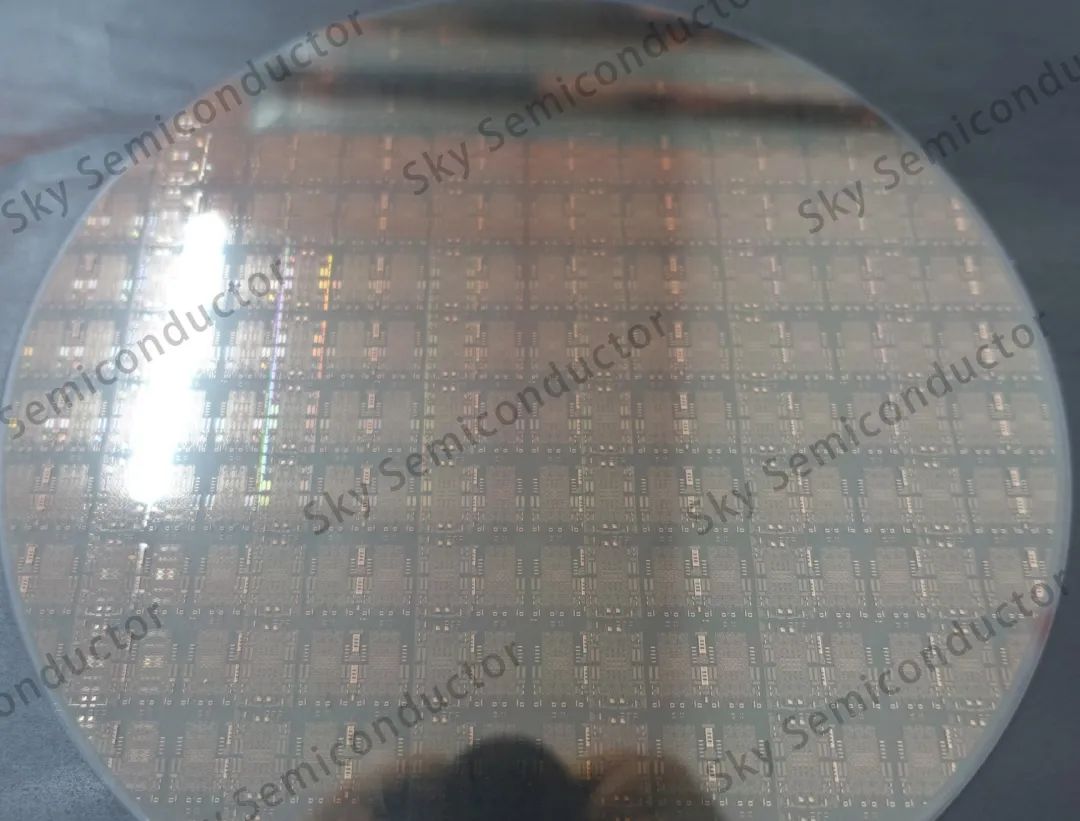 ?
?
圖2 多層RDL堆疊晶圓

圖3 細長RDL拼接
基于玻璃基板的綜合性能以及近期Intel發布的未來發展規劃,業界高度重視玻璃基板技術發展和產品應用。云天半導體的高密度玻璃中介層技術未來將助力AI等應用的CPU、GPU產品的先進封裝。
云天半導體
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
原文標題:云天半導體突破2.5D高密度玻璃中介層技術
文章出處:【微信號:today_semicon,微信公眾號:今日半導體】歡迎添加關注!文章轉載請注明出處。
相關推薦
。 2.5D封裝將die拉近,并通過硅中介連接。3D封裝實際上采用2.5D封裝,進一步垂直堆疊die,使die之間的連接更短。通過這種方式直接集成IC,IC間通信接口通常可以減少或完全
![的頭像]() 發表于
發表于 01-14 10:41
?357次閱讀

2.5D封裝技術是一種先進的異構芯片封裝技術,它巧妙地利用中介層(Interposer)作為多個芯片之間的橋梁,實現
![的頭像]() 發表于
發表于 12-25 18:34
?1393次閱讀
隨著電子技術的飛速發展,高密度集成電路(IC)的需求日益增長,而高密度有機基板作為支撐這些先進芯片的關鍵材料,其重要性也日益凸顯。本文將詳細介紹高密度有機基板的分類、特性、應用以及未來
![的頭像]() 發表于
發表于 12-18 14:32
?419次閱讀

原創 StrivingJallan 芯片SIPI設計 為了克服硅中間層技術的尺寸限制,并實現更好的處理器和存儲器集成,開發了一種基于硅interposer的新型2.5D SiP,如圖所示。多個芯片
![的頭像]() 發表于
發表于 12-10 10:38
?413次閱讀
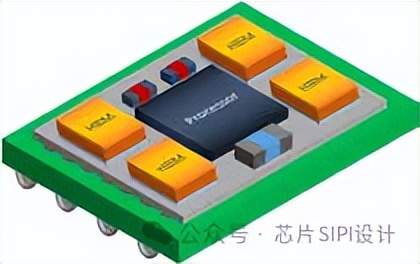
本文要點在提升電子設備性能方面,2.5D和3D半導體封裝技術至關重要。這兩種解決方案都在不同程度提高了性能、減小了尺寸并提高了能效。2.5D
![的頭像]() 發表于
發表于 12-07 01:05
?554次閱讀

CTE與Si匹配良好的無堿玻璃的玻璃通孔 (TGV) 形成技術。3D封裝目前引起了廣泛的關注。中介層
![的頭像]() 發表于
發表于 11-22 09:37
?369次閱讀

?? 隨著制程技術的不斷逼近極限,進一步提升晶體管密度和性能變得愈發艱難,成本也日益高昂。在此背景下,先進封裝技術,特別是2.5D封裝,成為了半導體
![的頭像]() 發表于
發表于 11-22 09:12
?1582次閱讀

隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝
![的頭像]() 發表于
發表于 11-11 11:21
?1758次閱讀

的數據,并且支持在時鐘信號的上升沿和下降沿都進行數據傳輸,從而實現了數據傳輸速率的倍增。高密度DDR芯片的內部結構復雜而精細,采用了先進的納 米級制程技術和多層布線技術。芯片內部集成了大量的存儲單元、控制邏輯、I/O接口和時鐘電
![的頭像]() 發表于
發表于 11-05 11:05
?524次閱讀
隨著基于半導體技術的電子器件和產品在生產和生活中廣泛應用,以集成電路為核心的半導體產業已成為推動國民經濟發展的支柱型產業。為了滿足消費者對電子產品輕薄化、高性能和低功耗的發展需求,半導體
![的頭像]() 發表于
發表于 10-30 09:43
?599次閱讀
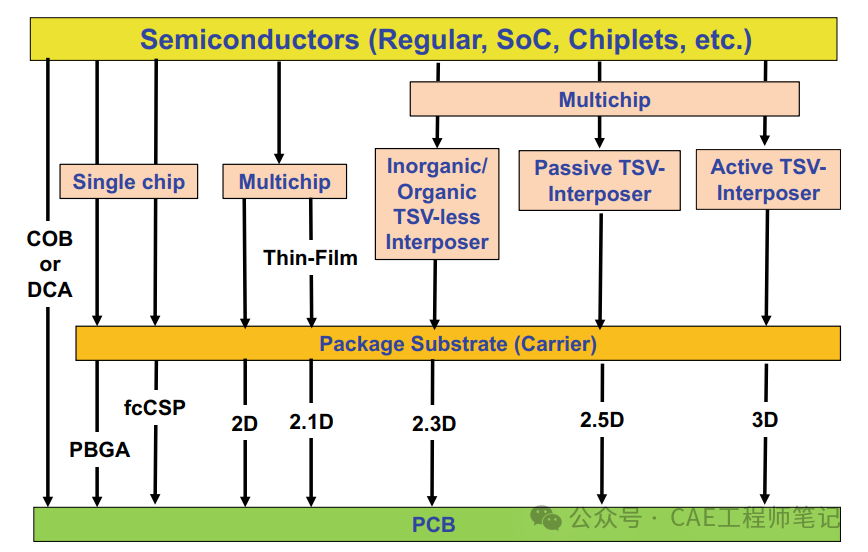
領域中正成為新的創新焦點,引領著超集成高密度互連技術的飛躍。通過持續的技術創新實現高密度互連,將是推動先進封裝技術在后摩爾時代跨越發展的關鍵
![的頭像]() 發表于
發表于 10-18 17:57
?346次閱讀

MPO(Multi-fiber Push On)高密度光纖配線架是一種采用多芯光纖連接技術的光纖配線設備,主要用于數據中心、機房、通信系統等需要高密度光纖連接和管理的場景。以下是對MPO高密度
![的頭像]() 發表于
發表于 09-10 10:05
?540次閱讀
2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個
![的頭像]() 發表于
發表于 07-30 10:54
?811次閱讀
7月17日,韓國財經媒體Money Today披露,半導體巨頭SK海力士正就硅中介層(Si Interposer)技術合作事宜,與業界領先的半導體
![的頭像]() 發表于
發表于 07-17 16:59
?689次閱讀
2.5D封裝技術指的是將多個異構的芯片,比如邏輯芯片、存儲芯片等,通過硅中介層(Interposer)連接在一起的技術。這個
![的頭像]() 發表于
發表于 04-18 13:35
?917次閱讀
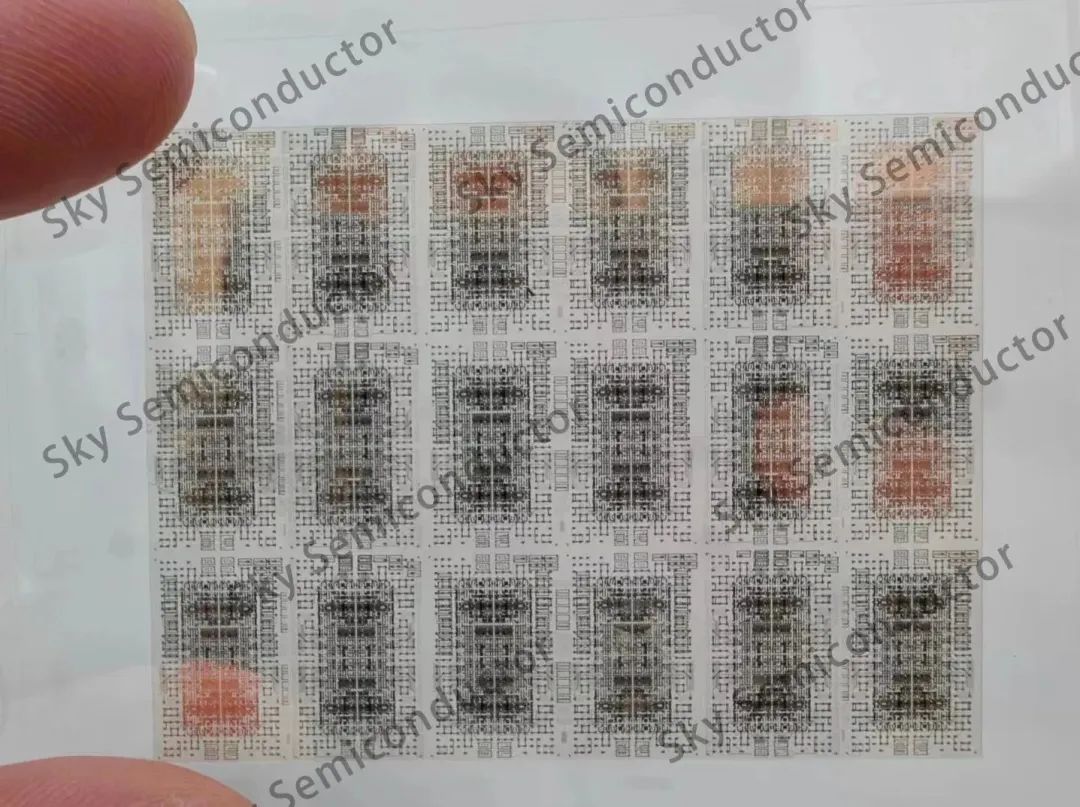 ?
?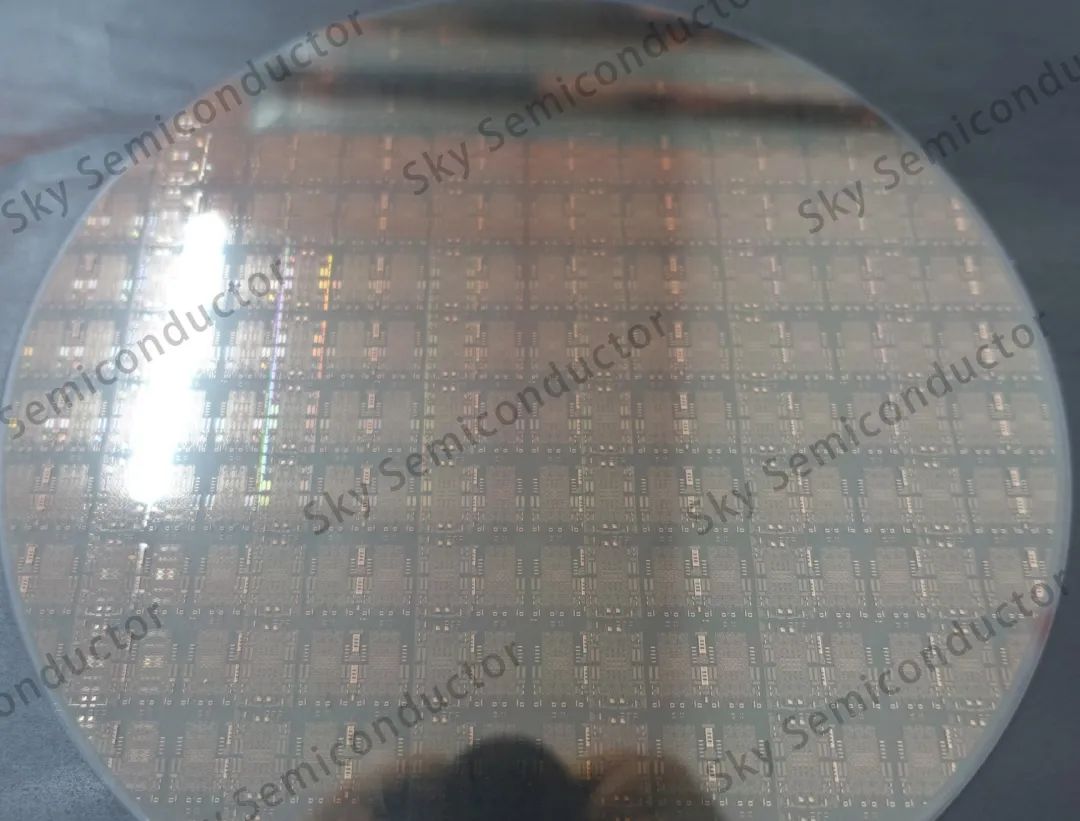 ?
?


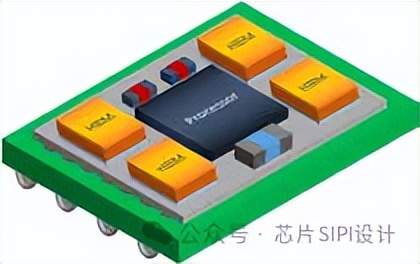
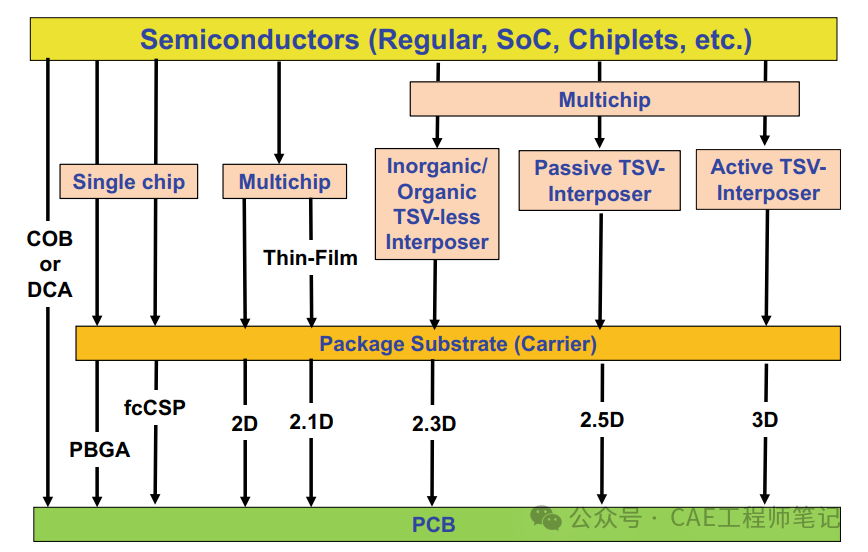




 云天半導體突破2.5D高密度玻璃中介層技術
云天半導體突破2.5D高密度玻璃中介層技術















評論