MBIST是Memory Build-In-Self Test的簡稱,意為存儲器內建自測試。“內建”的含義是指針對存儲器的測試向量不是由外部測試機臺(ATE:Auto-Test-Equipment)生成,而是由內建的存儲器測試邏輯自動產生,并進行結果的對比。MBIST測試中,只需要從機臺通過JTAG標準接口下達測試的指令,就可以從TDO接口獲取測試結果。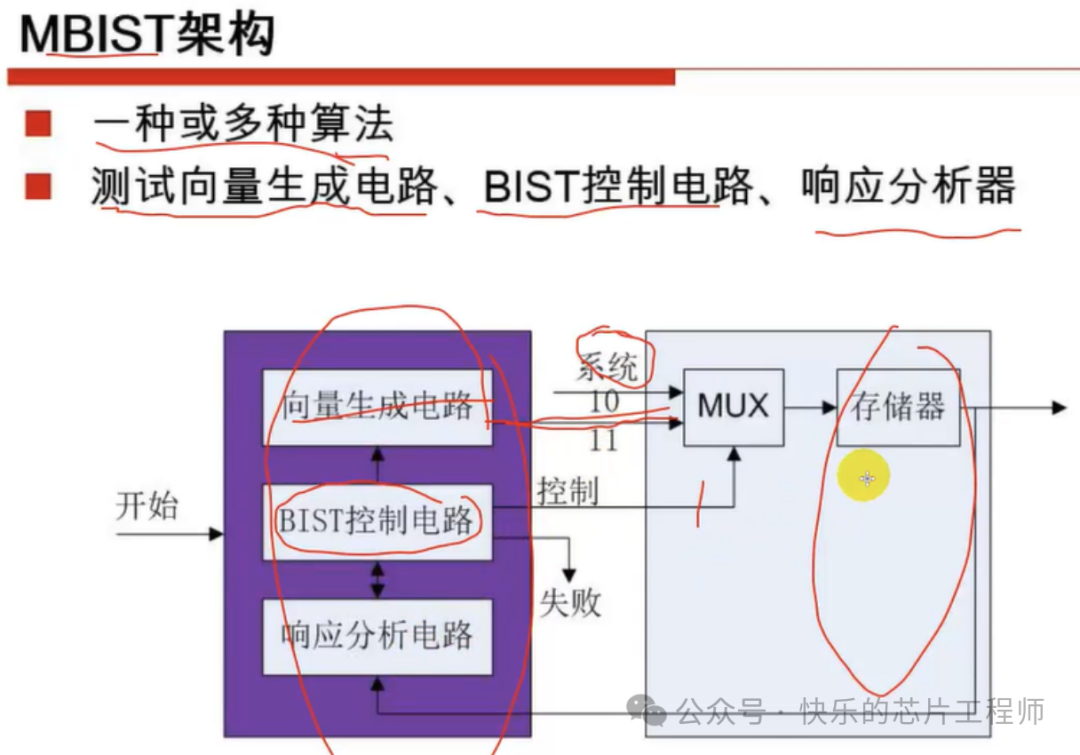
為什么要進行內建自測試呢?原因主要有:
a)存儲器在很小的面積內集成了很多存儲單元,對ATE的測試成本過高,不適用于從外部灌入針對存儲器的測試向量;
b)Memory測試的特殊性——需要測試的單元很多,但分布規整,可利用算法批量產生測試向量;
c)在線測試的需求——汽車電子的安全性,需求在芯片運行時仍保持在線測試(即不依賴測試機臺,可集成于板級、芯片內或由軟件調用,來實現隨時隨需的測試),隨時排除可能出現的故障。
因此我們可總結出內建自測試的優勢:因為測試向量由內部邏輯生成,相應模塊可同被測試的存儲器一同工作在內部的高速功能時鐘下,而無需由機臺慢速時鐘移入測試向量,可節省大量的測試時間;另一方面,對比驗證也同樣交給內部邏輯自行完成,測試機臺只需要收集測試結果,也可大幅減少測試時間。代價是內建自測試的邏輯對面積的占用很高,也不具備自由配置或更改測試向量的條件。
MBIST技術的缺點是增加了芯片的面積并有可能影響芯片的時序特性,然而,隨著存儲器容量的增加,這種方法所增加的芯片面積所占的比例相對很小,而且這種測試技術還有很多其它技術優勢。首先它可以實現可測性設計的自動化,自動實現通用存儲器測試算法,達到高測試質量、低測試成本的目的;其次MBIST電路可以利用系統時鐘進行“全速”測試,從而覆蓋更多生成缺陷,減少測試時間;最后它可以針對每一個存儲單元提供自診斷和自修復功能。
此外MBIST的初始化測試向量可以在很低成本的測試設備上進行。所以,從高測試質量、低測試成本的角度考慮,MBIST是目前嵌入式存儲器測試設計的主流技術。
-
存儲器
+關注
關注
38文章
7528瀏覽量
164342 -
JTAG
+關注
關注
6文章
401瀏覽量
71840 -
DFT
+關注
關注
2文章
231瀏覽量
22834
原文標題:DFT 之 MBIST存儲器內建自測試
文章出處:【微信號:快樂的芯片工程師,微信公眾號:快樂的芯片工程師】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
FinFET存儲器的設計挑戰以及測試和修復方法
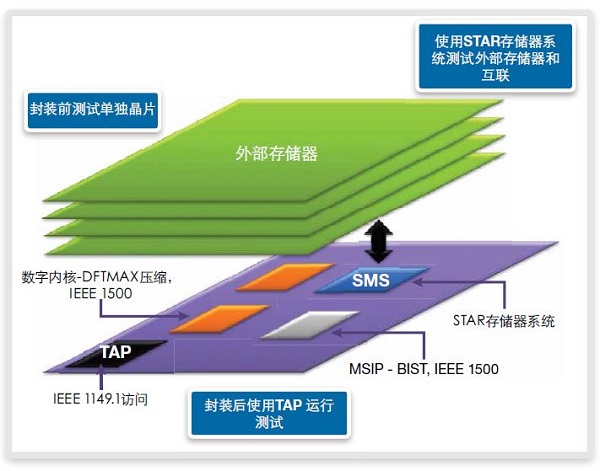
IC測試中三種常見的可測性技術
F28069的CAN通訊將自測試改成正常模式無法正常工作
運算放大器測試基礎之自測試電路與雙運算放大器測試電路配置
Arm PMC-100可編程MBIST控制器技術參考手冊
嵌入式存儲器內建自測試的一種新型應用
高速互連自測試技術的原理與實現
嵌入式存儲器內建自修復技術





 DFT之MBIST存儲器內建自測試原因
DFT之MBIST存儲器內建自測試原因













評論