摘要:本論文探討了在現代電子器件設計和制造中,封裝與散熱的關鍵優化策略。通過選擇封裝形式和材料,重建引腳布局,封裝密封的方法優化封裝設計,從而保護內部元件免受外部環境的影響,提高產品的壽命和可靠性;通過安裝散熱附加結構和設計液體冷卻結構的方法優化散熱設計,從而有效地管理和排除產生的熱量的,使電子元器件的溫度保持在適宜的工作溫度范圍內。這一研究對電子元器件設計和制造領域具有重要的指導意義,期望可以推動電子產品的發展和應用范圍的擴展。
關鍵詞:電子元器件;封裝與散熱;優化設計
0引言
隨著科技的快速發展,電子元器件在通信系統、醫療設備、工業自動化等各個領域中扮演著重要的角色。人們對于電子元器件的性能要求越來越高,封裝和散熱是影響電子元器件性能的重要因素。封裝是指將電子元器件封裝在外部材料中的過程,以保護器件免受環境因素的影響,如濕氣、灰塵和化學物質,并提供機械支撐以及實現電氣連接。電子元器件在封裝過程中也面臨著散熱問題的挑戰,散熱性能的不足會顯著影響電子器件的可靠性。為解決這一問題,本文從電子元器件的封裝和散熱兩方面進行了優化設計,通過對封裝的外部結構和內部材料以及散熱結構的優化,確保電子器件在滿足高性能和可靠性要求的同時,能夠在各種環境和工作條件下穩定運行。
1電子元器件的封裝設計優化
1.1選擇封裝形式和內部材料
為滿足現代電子設備對小型化和高性能的需求,應選用表面貼片的封裝形式,從而提高電子元器件的安全性能。以下是表面貼片工藝的流程,如圖1所示。

如圖1所示,劃片是表面貼片工藝的第一步,這是半導體晶圓的分離過程。在此步驟中,使用切割設備將由多個相同的電子器件組成的半導體晶圓進行切割或分離,形成一個個獨立的芯片。然后,利用裝架工藝將芯片封裝基板,并使用導熱膠將芯片粘貼在基板上,從而確保芯片與基板之間的電性連接。其次,將金屬線焊接到芯片和基板上,以建立電氣連接,完成引線鍵合。這個步驟確保信號和電力傳輸的順暢,是電子器件正常運行的重要環節。最后,將通過鍵合技術連接的封裝載體與蓋板組合,以確保氣密性封焊,從而保護電子元器件免受外部環境的干擾,確保其長期可靠性。在整個封裝過程中,焊料在封裝結構中主要起到導電、導熱和粘接等作用,焊料層的材料和厚度會影響電子元器件的散熱效果和可靠性。以下是幾種常見的焊料層材料的熱參數如表1焊料層材料的熱參數表所示。

熱導率表示單位時間內通過單位面積的物質傳導熱量的量度,熱導率越大表明物體的導熱性能越好,由表1可知,納米銀焊膏熱導率為240,遠大于其他兩種材料,導熱性最好,但是目前燒結工藝不成熟。SnAg焊料熱導率比SnPb焊料稍高,SnPb焊料含有有毒物質且高溫下容易出現焊料空洞。綜合成本和散熱考慮,選用SnAg焊料作為電子元器件的封裝材料。以下是三種材料厚度對電子元器件結溫的影響,如圖2所示。
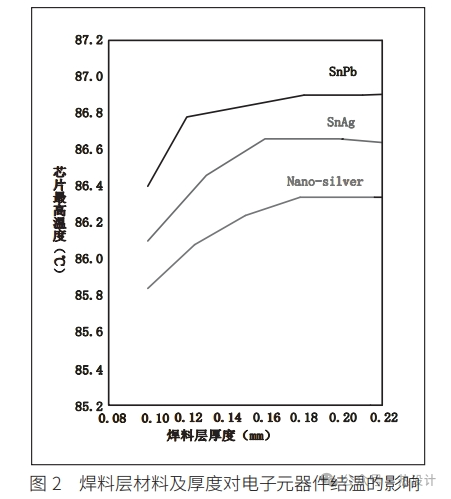
如圖2所示,增大焊料層厚度將會導致熱阻的增大,進而引起芯片最高溫度的增高,但是焊料層厚度增大與芯片結溫升高不是成比例的。當厚度一致時,納米銀焊膏對應的芯片最高溫度是最低的,SnAg焊料和SnPb焊料對應的芯片最高溫度相差不大,這是由材料本身的熱導率決定的,當厚度為0.1mm時,納米銀焊膏焊料對應的芯片最高溫度為85.87℃,其值比SnPb焊料低0.53℃,比SnAg焊料低0.27℃。當焊料層厚度大于0.18mm時,三種焊料對芯片結溫影響基本穩定且芯片最高溫度相差不大。從散熱角度考慮,焊料層厚度越小越好,但是焊料層厚度太薄會影響器件的導電和芯片粘接能力,所以焊料層材料確定為0.1mm的SnAg。
1.2重建引腳布局
選擇好封裝形式和材料后,為優化封裝內部改造,應根據封裝形式和材料重建引腳布局。引腳布局優化的具體步驟如下。(1)將相關信號的引腳靠近安排,以減小信號傳輸路徑的長度,降低信號失真。(2)將電源引腳與地引腳安排得近似對稱,以確保穩定的電源供應和地連接,從而有助于降低電源噪聲和提高信號完整性。(3)將差分信號的正負引腳對放置在相對靠近的位置,并使差分信號的兩個引腳在信號路徑長度上保持平衡,避免差分信號的引腳交叉或交叉路徑,從而減小差分信號之間的物理距離,防止信號互相干擾。(4)將時鐘信號、數據信號和控制信號分別放置在不同的引腳組中,使相似功能或相互關聯的信號引腳分組在一起。將電源引腳和地引腳分開布局,從而降低電源噪聲對信號的影響。將時鐘信號、復位信號和時序控制信號分組在一起,以確保可以同步操作與時序相關的信號。
1.3封裝密封
封裝密封是封裝環節的最后一個步驟,其表面材料的選擇則對于保護元器件免受外部環境因素的影響至關重要。以下是聚氨酯泡沫材料的主要性能,如表2所示。
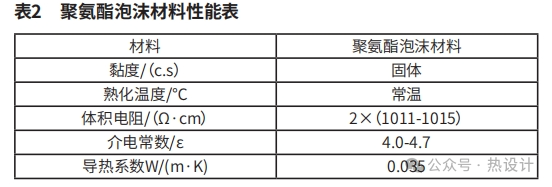
聚氨酯泡沫材料為高密度固體,所以機械強度高,穩定性好,不易變形,可在-80℃~60℃下正常發揮作用。且粘附力強,對鋼、鋁等金屬具有很好的附著力。聚氨酯發泡材料介電常數在4.0~7.5范圍內,體積電阻系數為2×1011-2×1015Ω·cm,具有比較優良的電性能導熱系數為0.035W/(m·K),絕熱效果很好。聚氨酯泡沫材料流動性很好,在發泡固化前為液體,封裝過程中能順利充滿復雜形狀的模腔或室間,不易出現空腔現象。聚氨酯發泡材料封裝工藝流程如圖3所示。

首先,在封裝工程中,維護高標準的衛生和安全要求至關重要。在操作過程中,工人必須佩戴適當的防護設備,包括防塵口罩和工作服,以避免呼吸到聚氨酯發泡材料的微粒或與其皮膚接觸。
然后,再進行封裝前的準備工作,清潔和準備電子元器件,確保其表面干凈,無灰塵和油污。然后,根據元器件的形狀和尺寸定制模具,并在清洗后的電子元器件上加裝模具,以確保元器件的位置和定位正確。其次,將電子元器件放置在封裝容器中,緩慢而均勻地倒入混合好的聚氨酯發泡材料,在這個過程中要使聚氨酯發泡材料充滿所有空隙,并均勻地包裹住元器件和模具。
此外,溫度和濕度的波動可能會影響聚氨酯發泡材料的性能,因此,發泡固化的過程中將溫度控制在26℃~30℃,濕度控制在30℃~35℃,使聚氨酯發泡材料更好地膨脹、硬化并粘附到元器件表面和模具上。時間控制在30min~60min,以確保材料完全硬化。材料固化之后,要進行檢漏工作,將封裝容器放入氣密測試裝置中,用氣壓或真空來檢測是否有氣體泄漏。
最后,去除模具。工人佩戴好必要的個人防護裝備,包括橡膠手套和護目鏡。檢查模具是否已經完全固化,以確保安全操作。并使用刮刀或削片,去除多余的聚氨酯發泡材料。再使用清潔劑和布等清潔工具,緩慢地清潔封裝的表面,確保去除所有的塵土、雜質或污垢,以確保最終產品的質量。清潔的過程中,應仔細檢查封裝表面,確保沒有裂縫、氣泡或其他缺陷。如果發現任何問題,需要及時修復或更換封裝。
2電子元器件的散熱設計優化
2.1安裝散熱附加結構
較高的溫度損害電子元器件的性能和壽命,所以電子元器件的封裝工作完成后,還應考慮電子元器件的散熱問題。安裝散熱附加結構是最簡單高效的一個方法,在安裝散熱器前,要根據電子元器件的熱阻選擇合適的散熱器和散熱措施,其中,熱阻的計算公式如式(1)所示。

其中,RJA為總熱阻,PD為電子元器件的最大功率損耗,TJ為電子元器件的結溫,TA為環境溫度。則散熱器到環境溫度的熱阻RSA,如式(2)所示。

其中,RCS為器件底部與散熱器之間的熱阻,RSA為散熱器散到周圍的熱阻,RJC為器件管芯傳到器件底部的熱阻。考慮極端氣溫環境下散熱器的散熱效果,設TJ為115℃,TA為30℃~55℃,RCS為2℃/W,求得RSA值,所以根據散熱器的功率,選用翅片散熱器即可。安裝散熱器時,在機箱或機殼上相應的位置開散熱孔,從而使冷空氣能夠有效地流入,熱空氣能夠順暢地散出,建立良好的氣流循環,提高散熱效率。并在安裝時應采用云母墊片進行絕緣,防止短路和電氣問題。同時,電子元器件的引腳要穿過散熱器,在散熱器上進行鉆孔,孔徑為2mm,深度為0.5mm,并使套管與引腳的直徑相匹配,再套上聚四氟乙稀套管,從而提供絕緣并保護引腳不受損壞。
如果大型電子元器件的功率較大,可以利用翅片和風扇進行散熱。將風扇安裝在翅片散熱器的出風口位置,以確保熱空氣能夠有效地被抽出,并使用螺絲或夾具來固定風扇,以防止振動和松動。并設計出3mm的通風口和通風槽,通風口應設置在散熱器的進風口和風扇的出風口附近,確保周圍環境中有足夠的自然或強制空氣流動,從而使風扇有效地冷卻電子元器件。
2.2設計液體冷卻結構
除了安裝散熱附加結構,對散熱裝置中的冷卻結構進行優化設計也可以提高電子元器件的散熱效率。首先,要選擇適合應用的冷卻液體,常用的冷卻液體包括水、液態冷卻劑乙二醇溶液,二者特質如表3所示。
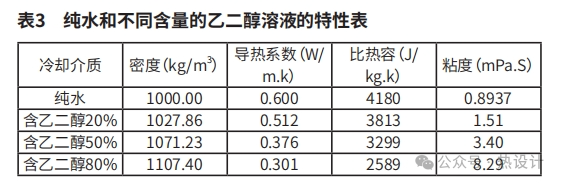
由表3可知,純水的導熱系數最大,比熱容是最高的,為4180。隨著乙二醇濃度的增加,其導熱系數逐漸減小,從0.512W/m.k降到0.301W/m.k。比熱容也逐漸減小,從3813J/kg.k降到2589J/kg.k。粘度逐漸增大密度也逐漸增大。導熱系數越大導熱性能越好;比熱容越大則在同等情況吸收和釋放熱量越多;粘度越大則壓力損失也大很難再流通。從以上特性可以得知,純水密度小、導熱系數大、粘度小、比熱容大,所以選擇純水作為冷卻液體。其次,冷卻通路的設計是液體冷卻系統的關鍵部分,它確保冷卻液體可以有效地流經電子元器件,吸收熱量并將熱量帶走。
其中,需要考慮冷卻液體的流動路徑、流速分布、流道形狀等因素。選擇回字形的串聯的流道形狀可以增大流體的流動和熱傳導。串聯流道模型結構與串聯電路有相似之處,都是從頭到尾經過多次轉折但始終都是一根流道,可以延長冷卻液與芯片之間的熱交換時間,提高散熱效率。冷卻工質從左側入口流入后,經過流道帶走從底部傳遞過來的熱量,然后冷卻水從右側出口流出,最后釋放熱量,從而達到冷卻降溫的目的。最后,根據液體冷卻系統的布局和流道設計選擇合適的高效泵,并根據流道的工作負荷來調整泵的運行,實現智能化的冷卻管理。
3結束語
綜上所述,電子元器件的封裝和散熱優化設計是電子技術領域的一個重要課題,為提升電子元器件的性能,本文從電子元器件的封裝和散熱兩方面進行優化設計,包括選擇的封裝材料和結構,改善散熱結構,期望這些策略可以幫助科學家繼續深入研究電子元器件的封裝和散熱,推動電子器件的發展,滿足未來的技術挑戰。
-
電子元器件
+關注
關注
133文章
3358瀏覽量
106210 -
通信系統
+關注
關注
6文章
1204瀏覽量
53460 -
散熱
+關注
關注
3文章
520瀏覽量
31846
發布評論請先 登錄
相關推薦




 電子元器件封裝與散熱的優化設計
電子元器件封裝與散熱的優化設計


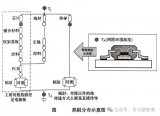

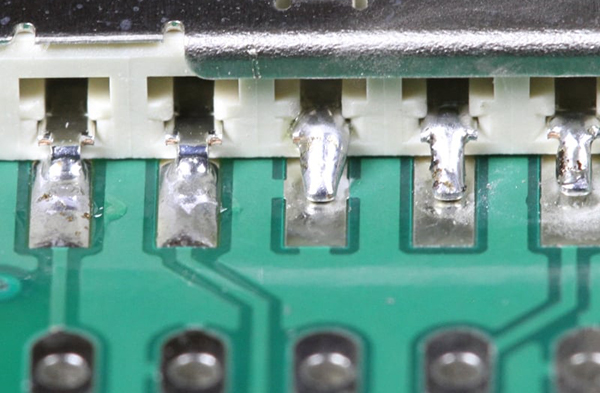










評論