在半導體制造領(lǐng)域,臺積電一直是技術(shù)革新的引領(lǐng)者。近日,有知情人士透露,這家全球知名的芯片制造商正在積極探索一種全新的芯片封裝技術(shù),即從傳統(tǒng)的晶圓級封裝轉(zhuǎn)向面板級封裝,這將可能帶來封裝效率的顯著提升和成本的降低。
據(jù)悉,臺積電所研發(fā)的這項新技術(shù)將使用矩形面板狀基板,而非目前普遍使用的圓形晶圓。這種設(shè)計上的轉(zhuǎn)變看似微小,但實際上卻能帶來革命性的變化。傳統(tǒng)的圓形晶圓在封裝過程中,由于圓形的特性,其邊緣部分往往會存在未使用的面積,這在一定程度上限制了封裝效率。而矩形面板狀基板則能最大限度地利用整個面板的面積,使得每片基板上能夠放置更多的芯片組,從而提高封裝效率。
據(jù)知情人士透露,臺積電目前正在試驗的矩形基板尺寸為510mm×515mm,這樣的尺寸使得其可用面積達到了現(xiàn)有12英寸圓形晶圓的三倍多。這一顯著的增長不僅意味著更高的封裝效率,同時也為未來的芯片設(shè)計提供了更大的靈活性和可擴展性。
此外,矩形形狀的設(shè)計也使得邊緣剩余的未使用面積大幅減少。在傳統(tǒng)的圓形晶圓封裝中,由于邊緣部分的面積無法被有效利用,往往需要進行額外的處理或切割,這不僅增加了制造成本,也降低了生產(chǎn)效率。而矩形面板狀基板則能有效避免這一問題,使得整個制造過程更加高效、經(jīng)濟。
值得注意的是,盡管臺積電的這一新技術(shù)目前仍處于早期研發(fā)階段,且可能需要數(shù)年時間才能實現(xiàn)商業(yè)化應用,但它無疑代表了半導體封裝技術(shù)的一個重要發(fā)展方向。隨著技術(shù)的不斷進步和市場需求的不斷增長,我們有理由相信,面板級封裝技術(shù)將在未來成為半導體制造領(lǐng)域的主流選擇。
臺積電的這一創(chuàng)新舉措不僅展示了其在技術(shù)研發(fā)上的前瞻性和決心,也體現(xiàn)了其對于市場需求變化的敏銳洞察和積極響應。隨著新技術(shù)的不斷發(fā)展和應用,我們有理由期待臺積電在未來的半導體制造領(lǐng)域繼續(xù)發(fā)揮引領(lǐng)作用,為全球科技產(chǎn)業(yè)的進步和發(fā)展做出更大的貢獻。
-
半導體
+關(guān)注
關(guān)注
334文章
27711瀏覽量
222652 -
臺積電
+關(guān)注
關(guān)注
44文章
5685瀏覽量
167002 -
晶圓
+關(guān)注
關(guān)注
52文章
4975瀏覽量
128315 -
芯片封裝
+關(guān)注
關(guān)注
11文章
514瀏覽量
30743
發(fā)布評論請先 登錄
相關(guān)推薦
臺積電進入“晶圓代工2.0”,市場規(guī)模翻倍,押注先進封測技術(shù)

一種新型RDL PoP扇出晶圓級封裝工藝芯片到晶圓鍵合技術(shù)

臺積電超大版CoWoS封裝技術(shù):重塑高性能計算與AI芯片架構(gòu)
臺積電布局FOPLP技術(shù),推動芯片封裝新變革
三星電子領(lǐng)先臺積電進軍面板級封裝
臺積電探索先進芯片封裝技術(shù):矩形基板引領(lǐng)創(chuàng)新
臺積電正研究一種新型的先進芯片封裝方法
今日看點丨傳臺積電研發(fā)芯片封裝新技術(shù);戴爾、超微電腦將共同為馬斯克xAI打造計算中心
臺積電研發(fā)超大封裝技術(shù),實現(xiàn)120x120mm布局
封裝技術(shù)新篇章:焊線、晶圓級、系統(tǒng)級,你了解多少?





 臺積電研發(fā)芯片封裝新技術(shù):從晶圓級到面板級的革新
臺積電研發(fā)芯片封裝新技術(shù):從晶圓級到面板級的革新


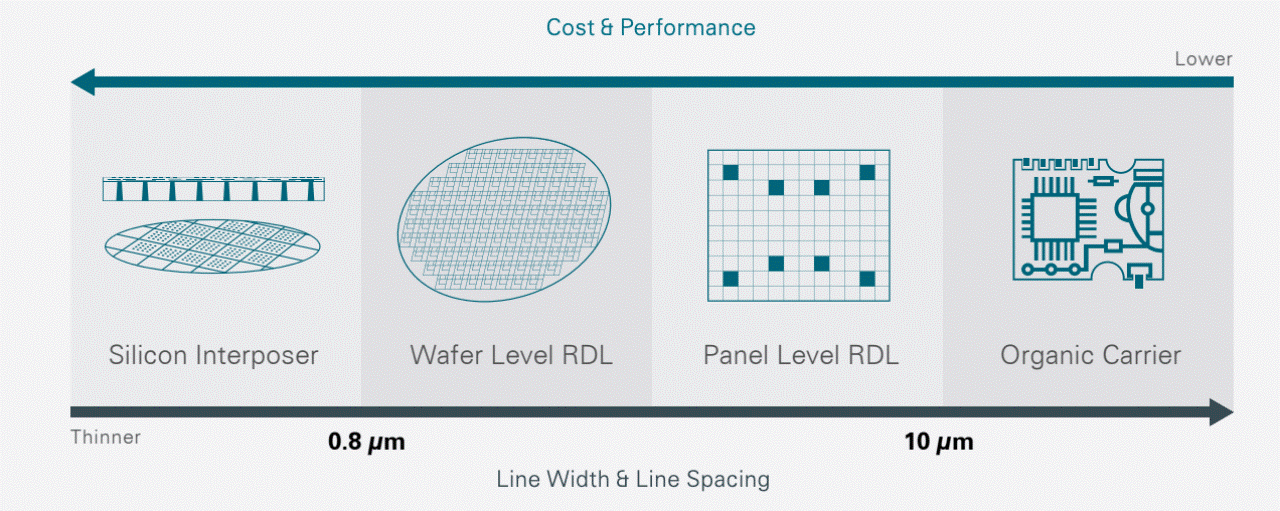












評論