Moldex3D芯片封裝模塊,能協(xié)助設(shè)計(jì)師分析不同的芯片封裝成型制程。
在轉(zhuǎn)注成型分析 (Transfer Molding) 與成型底部填膠分析 (Molded Underfill) 中,Moldex3D芯片封裝成型模塊能分析空洞、縫合線、熱固性塑料的硬化率、流動(dòng)型式及轉(zhuǎn)化率;透過(guò)后處理結(jié)果,能檢測(cè)翹曲、金線偏移及導(dǎo)線架偏移的現(xiàn)象。
在壓縮成型分析 (Compression Molding)/嵌入式晶圓級(jí)封裝分析 (Embedded Wafer Level Package)/非流動(dòng)性底部填膠分析 (No Flow Underfill)/非導(dǎo)電性黏著分析 (Non Conductive Paste)中,Moldex3D芯片封裝成型模塊能分析空洞、縫合線及流動(dòng)型式。
在毛細(xì)底部填膠分析 (Capillary Underfill) 中,能模擬毛細(xì)流動(dòng) (底膠材料受到的表面張力與底膠間接觸角的影響)、凸塊及填膠過(guò)程的基板。Moldex3D模擬真實(shí)的填膠過(guò)程步驟,預(yù)測(cè)可能產(chǎn)生的空洞位置。
注意:Moldex3D芯片封裝成型模塊支持solid與eDesign (僅轉(zhuǎn)注成型) 網(wǎng)格模型。
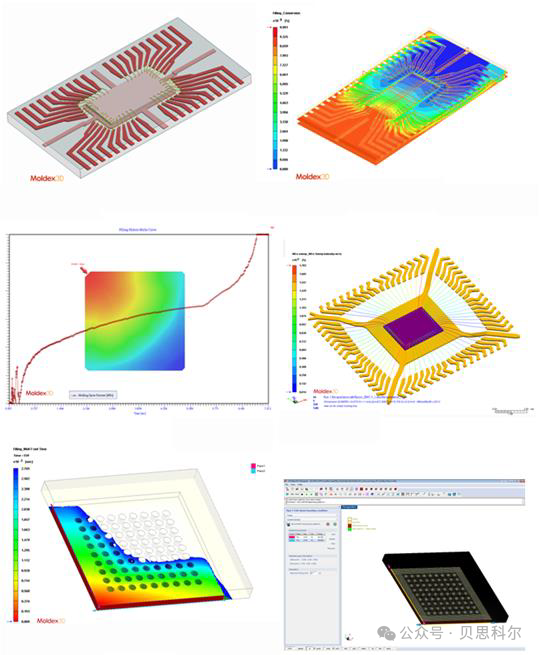
1、模塊導(dǎo)覽 (Modules Overview)
Moldex3D支持的芯片封裝成型制程:

轉(zhuǎn)注成型 (Transfer Molding)
轉(zhuǎn)注成型制程將芯片封裝,避免芯片受到任何外在因素的損傷。常用的材料為陶瓷與塑料(環(huán)氧成型塑料EMC),由于塑料成本較低,因此塑料轉(zhuǎn)注成型是常用的封裝制程技術(shù)。
在轉(zhuǎn)注成型制程中,許多問(wèn)題應(yīng)加以考慮,包含:微芯片與其他電子組件 (打線接合) 之間的交互連接、熱固性材料硬化及各種制程條件控制。此外,由于各種組件 (環(huán)氧塑料、芯片、導(dǎo)線架等) 有不同的材料,且在模穴中的金線密度極高,因此常見(jiàn)的缺陷如空洞、金線偏移、導(dǎo)線架偏移、翹曲及縫合線等都是非常重要的問(wèn)題。
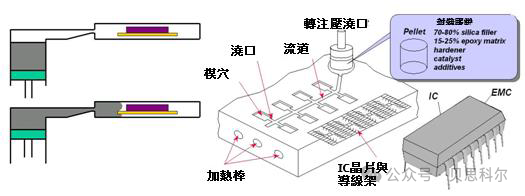
轉(zhuǎn)注成型制程:首先,環(huán)氧塑料被加熱且注入模穴中。當(dāng)模穴被充填完全時(shí),硬化過(guò)程開(kāi)始。
壓縮成型 (Compression Molding)
(壓縮成型/嵌入式晶圓級(jí)封裝/非流動(dòng)性底部填膠/非導(dǎo)電性黏著)
Moldex3D壓縮成型模塊能仿真底部填膠制程與晶圓級(jí)封裝制程。針對(duì)底部填膠封裝,能檢視堆棧芯片與基板之間的充填行為,并分析壓縮力作用之下的金線偏移現(xiàn)象。針對(duì)晶圓級(jí)封裝,能預(yù)測(cè)在壓縮成型過(guò)程中熔膠厚度的變化、基板偏移行為及最大剪切應(yīng)力分布。
透過(guò)壓縮成型制程的模擬分析,將能全面控制關(guān)鍵成型問(wèn)題,如晶粒封裝效率、錫球變化及金線打線優(yōu)化,以提升電子與尺寸設(shè)計(jì)更精密的產(chǎn)品質(zhì)量。
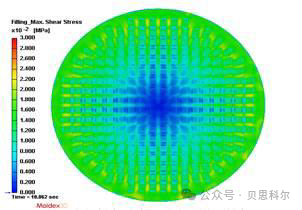
晶圓級(jí)封裝
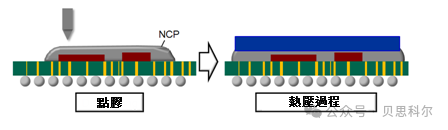
非導(dǎo)電性黏著
底部填膠 (Underfill)
底部填膠技術(shù) (Underfill) 是覆晶封裝成型 (Flip-Chip) 的制程之一。底部填膠區(qū)域夠薄以進(jìn)行毛細(xì)應(yīng)用,且沿著芯片的一側(cè)或兩側(cè)的周圍進(jìn)行環(huán)氧塑料放置。表面張力與熱,是主要對(duì)底部填膠產(chǎn)生毛細(xì)作用的兩項(xiàng)物理因素。而不同與毛細(xì)底部填膠 (CUF),成型底部填膠(MUF)的制程不僅有表面張力的作用,更施加了壓力來(lái)讓充填順利完成。
在熱與表面張力的驅(qū)動(dòng)之下,底膠材料在硬化前藉由毛細(xì)作用緩緩注入晶粒下的空間里。此驅(qū)動(dòng)力將會(huì)大幅受到塑料凸塊與基板之間表面張力的影響,并導(dǎo)致充填時(shí)間不同。填膠時(shí)間過(guò)長(zhǎng)可能造成塑料在填膠結(jié)束前即部分硬化,致使后續(xù)的制程延遲。
芯片封裝成型制程目前在塑料的尺寸縮減、厚度減少及半導(dǎo)體芯片的尺寸增加等議題仍有許多挑戰(zhàn),因此使用CAE工具來(lái)協(xié)助優(yōu)化成型設(shè)計(jì)已成為必然趨勢(shì)。
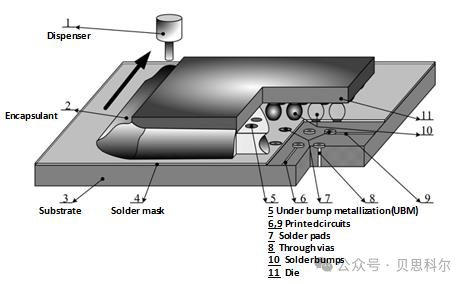
毛細(xì)底部填膠的覆晶封裝成型制程
Source: Hui Wang, Huamin Zhou, Yun Zhang, Dequn Li, Kai XuI., Computers & Fluids, 2011, 44:187-201.
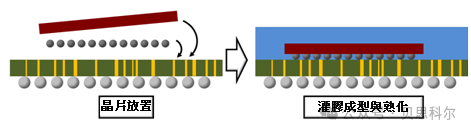

成型底部填膠
2、基本步驟(Basic Procedures)
Moldex3D芯片封裝成型模塊支持不同的芯片封裝成型分析:轉(zhuǎn)注成型分析、毛細(xì)底部填膠分析、成型底部填膠分析、壓縮成型分析、嵌入式晶圓級(jí)封裝分析,以及非流動(dòng)性底部填膠分析/非導(dǎo)電性黏著分析。在Moldex3D開(kāi)始使用時(shí),點(diǎn)擊新增來(lái)創(chuàng)建新的芯片封裝項(xiàng)目或開(kāi)啟來(lái)使用既有的。請(qǐng)注意要將制程類型設(shè)為芯片封裝來(lái)啟用相關(guān)功能。

以下將列出芯片封裝成型的一般步驟,將分為三個(gè)階段:準(zhǔn)備模型、分析設(shè)定及后處理。如圖所示,其個(gè)別流程也詳列在圖中,此外,紅色字體的步驟應(yīng)不同模塊將會(huì)不同,詳細(xì)內(nèi)容將分別在各章節(jié)中介紹。
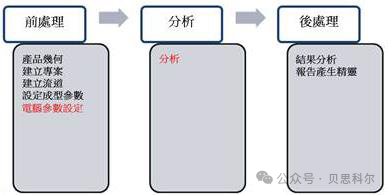
生產(chǎn)模擬
準(zhǔn)備模型
步驟1:建模
匯入模型 & 屬性設(shè)定 & 邊界設(shè)定:基于不同模塊,所需的邊界和屬性設(shè)定也不同。將各自介紹于在各模塊章節(jié)中。
○導(dǎo)線架 (Leadframe)
○金線 (Wire)
流道系統(tǒng)建立
冷卻/加熱系統(tǒng)建立
實(shí)體網(wǎng)格建立
確認(rèn)網(wǎng)格
準(zhǔn)備分析
步驟2:建立新項(xiàng)目。
步驟3:建立新組別。
步驟4:成型條件設(shè)定。
因應(yīng)成型模塊的不同,成行條件設(shè)定界面也略有不同。這些差異將會(huì)分別于各章節(jié)中介紹。
步驟5:計(jì)算參數(shù)設(shè)定。
除了一般填膠和熟化的設(shè)定頁(yè)面,"封裝" 和 "后熟化" 是重要的設(shè)定頁(yè)面,用戶可以設(shè)定導(dǎo)線架邊界和選擇計(jì)算引擎。另外,壓縮成型的預(yù)填料設(shè)定也同樣在此頁(yè)面。
步驟6:執(zhí)行分析。
在分析順序的下拉式選單中,選擇完整分析并點(diǎn)擊現(xiàn)在執(zhí)行。任務(wù)管理器將會(huì)啟動(dòng)以顯示實(shí)時(shí)的計(jì)算狀態(tài)。
后處理
在分析結(jié)束后,從分析結(jié)果中偵測(cè)潛在問(wèn)題。使用 "報(bào)表生成程序" 產(chǎn)生報(bào)告。以下詳列封裝分析步驟。
掃描二維碼關(guān)注我們
-
封裝
+關(guān)注
關(guān)注
127文章
7997瀏覽量
143410 -
晶片
+關(guān)注
關(guān)注
1文章
403瀏覽量
31582 -
3D芯片
+關(guān)注
關(guān)注
0文章
52瀏覽量
18462
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
Moldex3D模流分析之晶圓級(jí)封裝(EWLP)制程

Moldex3D模流分析之CUF Simulation Quick Start

標(biāo)準(zhǔn)模胚的尺寸的選擇及成型
什么是3D打印?什么是快速成型?主流快速成型工藝的成型原理及優(yōu)缺點(diǎn)分析
半導(dǎo)體制冷的巧克力3D打印成型
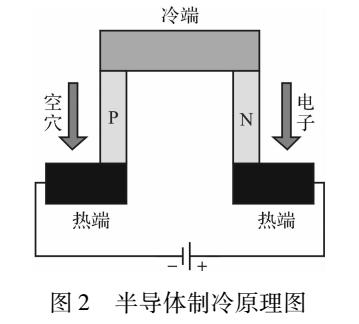
3D打印在熔模精密鑄造技術(shù)中應(yīng)用

什么是3d打印快速成型技術(shù)與其優(yōu)點(diǎn)及原理
塑料插座面板的模流分析及參數(shù)優(yōu)化分析
電子灌膠封裝——成就高精度電子灌膠未來(lái)

Moldex3D模流分析之建立IC組件

在Moldex3D Mesh建模 (Prepare Model in Moldex3D Mesh)

Moldex3D模流分析之Electronic Potting Process Simulation Quick Start

【Moldex3D丨產(chǎn)品技巧】使用金線精靈與樣板快速建立金線組件





 Moldex3D模流分析之晶片轉(zhuǎn)注成型
Moldex3D模流分析之晶片轉(zhuǎn)注成型











評(píng)論