來源:Trend Force

據STDaily援引日本沖繩科學技術研究生院(OIST)官網近日報道稱,該大學設計出一種超越半導體制造標準邊界的極紫外(EUV)光刻技術。
基于此設計的光刻設備可以使用更小的EUV光源,功耗不到傳統EUV光刻設備的十分之一,可降低成本并大幅提高設備的可靠性和壽命。
在傳統光學系統(如照相機、望遠鏡和常規紫外光刻技術)中,光圈和透鏡等光學元件沿直軸對稱排列。這種方法不適用于極紫外射線,因為其波長極短,大部分會被材料吸收。
因此,EUV光使用新月形鏡子進行引導,但這會導致光偏離中心軸,犧牲重要的光學特性并降低系統的整體性能。
為了解決這個問題,新的光刻技術通過將兩個帶有微小中心孔的軸對稱鏡子排列在一條直線上來實現其光學特性。由于EUV的吸收率很高,每次鏡子反射都會使能量減弱40%。
按照行業標準,EUV光源能量經過10面鏡子后,僅有約1%能夠到達晶圓,這對EUV光輸出的要求非常高。
相比之下,將從EUV光源到晶圓的鏡子數量限制為總共四個,可使超過10%的能量穿透晶圓,這可以大大降低功耗。
新型 EUV 光刻技術的核心投影儀由兩面類似天文望遠鏡的鏡子組成,可以將光掩模圖像轉移到硅片上。該團隊聲稱,這種配置非常簡單,因為傳統投影儀至少需要六面鏡子。
這是通過重新思考光學像差校準理論實現的,其性能已經通過光學仿真軟件驗證,意味著它可以滿足先進半導體的生產要求。
此外,團隊還為此項新技術設計了一種名為“雙線場”的新型照明光學方法,即利用EUV光從正面照射平面鏡光罩,而不會干擾光路。
審核編輯 黃宇
-
半導體
+關注
關注
334文章
27719瀏覽量
222695 -
EUV
+關注
關注
8文章
608瀏覽量
86150
發布評論請先 登錄
相關推薦
臺灣精銳APEX減速機在半導體制造設備中的應用案例
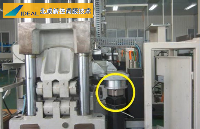
半導體制造里的ALD工藝:比“精”更“精”!

日本半導體制造設備銷售額預期上調,創歷史新高!

鎵在半導體制造中的作用
無塵車間半導體制造設備的振動標準

【「大話芯片制造」閱讀體驗】+ 半導體工廠建設要求
半導體制造行業MES系統解決方案

ESD靜電對半導體制造的影響
上揚軟件MES系統助力青島惠科布局半導體制造領域
半導體制造設備革新:機床需求全面剖析
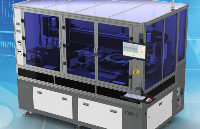
半導體制造設備對機床的苛刻要求與未來展望
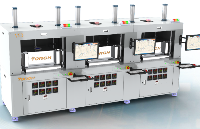




 新型EUVL技術問世,超越半導體制造標準線
新型EUVL技術問世,超越半導體制造標準線













評論