隨著光電元器件和集成電路等微納結(jié)構(gòu)的制造工藝不斷突破,迫切需要高性能的測量設(shè)備來滿足日益增長的高精度表面形貌測量需求。目前,表面形貌測量法主要分為機(jī)械探針式測量法、掃描探針顯微鏡和干涉顯微測量法三種。
干涉顯微測量法具有操作簡易和無接觸等優(yōu)勢,其縱向分辨率可達(dá)納米級(jí),橫向分辨率和測量范圍取決于相機(jī)像元尺寸和像元數(shù)。常用的干涉顯微測量法包括四波橫向剪切干涉(quadriwave lateral shearing interferometry,QLSI)、數(shù)字全息和衍射相位成像等方法。其中,四波橫向剪切干涉法因存在魯棒、消色差和瞬態(tài)測量等優(yōu)勢,目前在表面形貌測量領(lǐng)域具有更為廣泛的應(yīng)用前景。
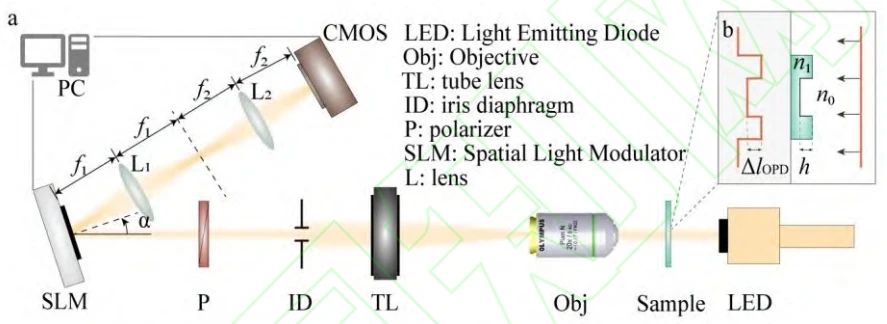
圖 1 基于四波橫向剪切干涉的表面形貌測量系統(tǒng)示意圖
a—實(shí)驗(yàn)裝置 b—石英樣品
為解決傳統(tǒng)四波橫向剪切干涉測量系統(tǒng)中特定分光器件存在的加工難度高、光譜適用范圍受限等問題,課題組提出了利用空間光調(diào)制器替代分光光柵將入射光分為4束橫向剪切相干子波,通過靈活調(diào)整光柵的折射率來調(diào)制子波衍射效率以適應(yīng)照明光源,再根據(jù)子波兩兩干涉效應(yīng)重建出反映樣品折射率和高度信息的光程差分布,即可實(shí)現(xiàn)寬光譜大尺寸范圍內(nèi)的表面形貌精確測量;結(jié)合傅里葉變換法研究了入射光不同波長對(duì)光程差重建精度的影響規(guī)律,并利用空間光調(diào)制器搭建了適用于可見光至近紅外的寬光譜四波橫向剪切干涉測量系統(tǒng)。

圖 2 基于 SLM 的四波橫向剪切干涉實(shí)驗(yàn)裝置圖
本文提出的基于空間光調(diào)制器(HDSLM80R,UPOLabs)的四波橫向剪切干涉表面形貌測量方法,采用SLM加載占空比為1/2的棋盤型相位光柵作為QLSI的波前分光器件,相比于傳統(tǒng)的分光光柵,通過SLM加載的光柵能在不改變各光路元器件位置的情況下靈活調(diào)整光柵折射率來保證子波衍射效率始終取得最高值,使得QLSI測量精度不受照明光源波段的影響,同時(shí)也可避免光柵加工誤差對(duì)測量結(jié)果的影響。
為了獲取待測樣品的表面形貌和刻蝕深度信息,采用圖2所示的實(shí)驗(yàn)裝置對(duì)待測樣品的取樣區(qū)進(jìn)行測量,相機(jī)收集的干涉圖如圖3所示。

圖3 CMOS 相機(jī)采集干涉圖
對(duì)樣品干涉圖進(jìn)行傅里葉變換后,然后采用濾波窗函數(shù)將x和y方向的正一級(jí)頻譜提取出來,如圖4a和4b所示。
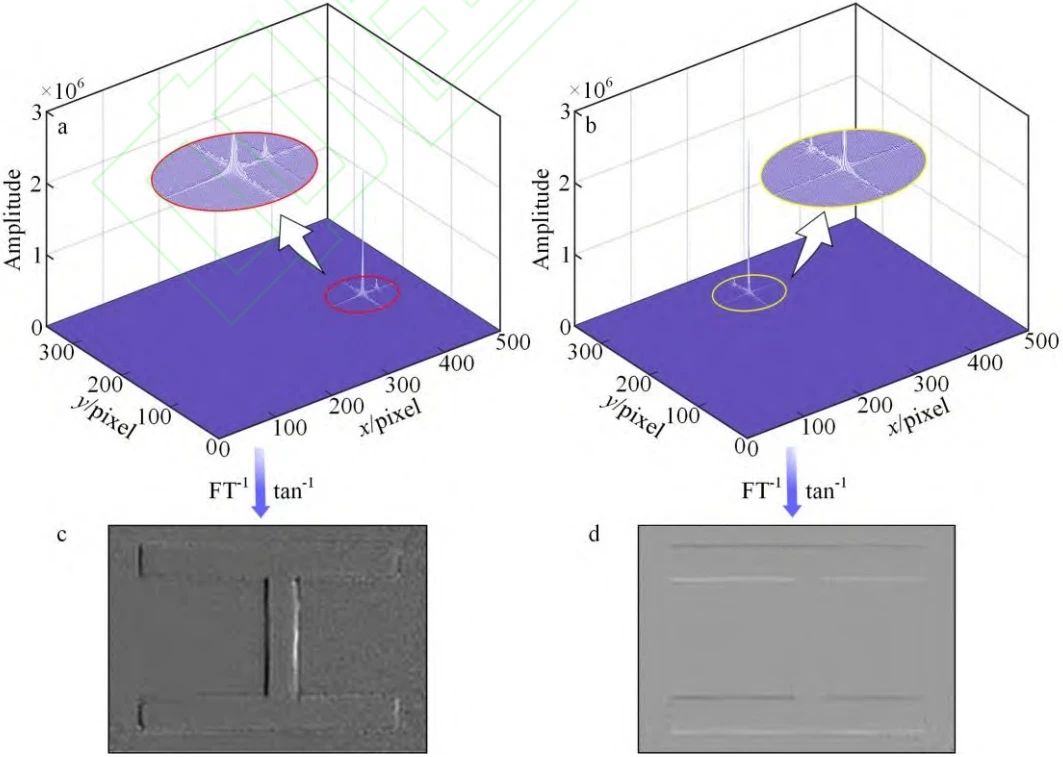
圖4 差分相位提取過程
根據(jù)式:

即可算出x和y方向的差分相位。再采用相同的方式算出背景光干涉圖的x和y方向差分相位,最后將兩幅干涉圖相同方向的差分相位相減即可得到消除靜態(tài)波前缺陷影響的差分相位,如圖4c和4d所示。
搭建的基于SLM的四波橫向剪切干涉測量系統(tǒng)分別對(duì)石英和硅晶圓的表面形貌進(jìn)行測量,并將測量結(jié)果與白光干涉儀的結(jié)果對(duì)比,驗(yàn)證了本文中方法對(duì)不同類型樣品的表面形貌測量的有效性和可靠性。
石英樣品表面形貌測量
在可見光波段石英玻璃的折射率 n1=1.45990,空氣的折射率 n0=1.00028,結(jié)合公式

計(jì)算得出的石英樣品的表面形貌信息如圖5a所示。沿圖5a的紅線剖開以進(jìn)一步獲得樣品的刻蝕深度信息,得到的刻蝕深度分布如圖5b所示。重復(fù)開展50次實(shí)驗(yàn)得出本實(shí)驗(yàn)搭建的QLSI系統(tǒng)測量過程較穩(wěn)定。
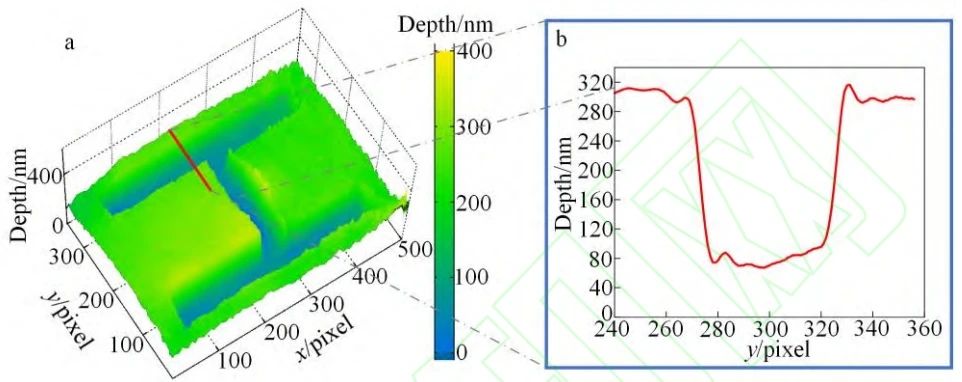
圖5石英樣品的表面形貌重建結(jié)果
a—三維圖; b—y 方向的高度剖線
為驗(yàn)證本文所提方法測量石英表面刻蝕深度的準(zhǔn)確性,采用白光干涉儀和本文所提方法對(duì)同一樣品的刻蝕深度進(jìn)行測量,兩種方法的測量結(jié)果均與樣品標(biāo)稱值吻合,表明本文中提出的方法能夠成功的探測納米級(jí)樣品的表面形貌,且具有較高的精度。其次,QLSI測量時(shí)間遠(yuǎn)小于白光干涉儀測量所用時(shí)間。

表 1 本文方法與白光干涉法測得石英樣品的刻蝕深度和相對(duì)誤差
硅晶圓樣品測量
通過將實(shí)驗(yàn)裝置的顯微成像系統(tǒng)從透射式改為反射式照明,再對(duì)硅晶圓樣品開展測量實(shí)驗(yàn)研究,在LED照明下獲取的三維形貌提取結(jié)果和y方向的高度剖線。表2所示為QLSI與白光干涉法分別開展50次重復(fù)性實(shí)驗(yàn)得到的臺(tái)階高度測量結(jié)果,兩種方法得出的測量結(jié)果與樣品標(biāo)稱值基本吻合,QLSI方法利用反射式測量時(shí)仍然具有較高的測量精度,進(jìn)而在很大程度上驗(yàn)證了本文中所提表面形貌測量方法的有效性和可靠性。
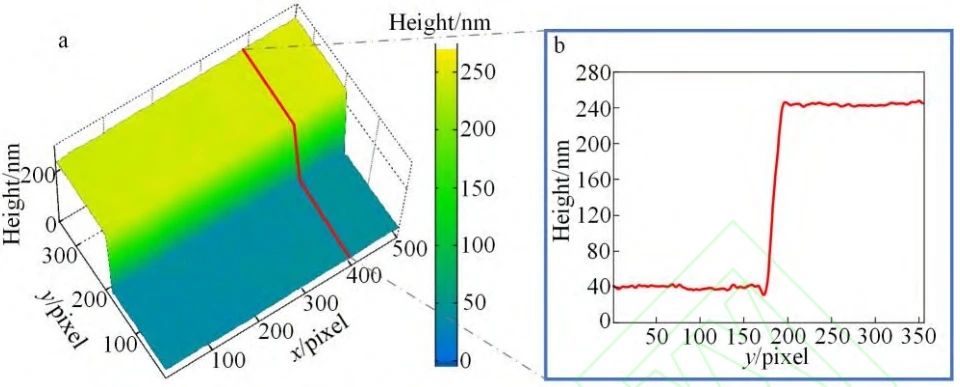
圖6 硅晶圓樣品的表面形貌重建結(jié)果
a—三維圖; b—y 方向的高度剖線

表 2 本文方法與白光干涉法測得硅晶圓樣品的高度和相對(duì)誤差
綜上所述,本文提出的基于SLM的四波橫向剪切干涉表面形貌測量方法具有科學(xué)性和適用性,通過對(duì)石英和硅晶圓的表面形貌進(jìn)行測量和結(jié)果對(duì)比實(shí)驗(yàn)驗(yàn)證了本文中方法對(duì)不同類型樣品的表面形貌測量的有效性和可靠性,該研究可為四波橫向剪切干涉技術(shù)在表面形貌測量領(lǐng)域的擴(kuò)展應(yīng)用提供理論參考。
-
集成電路
+關(guān)注
關(guān)注
5392文章
11622瀏覽量
363161 -
元器件
+關(guān)注
關(guān)注
113文章
4747瀏覽量
92815 -
空間光調(diào)制器
+關(guān)注
關(guān)注
1文章
67瀏覽量
8734 -
測量設(shè)備
+關(guān)注
關(guān)注
0文章
111瀏覽量
9528 -
SLM
+關(guān)注
關(guān)注
0文章
81瀏覽量
6888
原文標(biāo)題:基于四波橫向剪切干涉的表面形貌測量方法
文章出處:【微信號(hào):UPOLabs,微信公眾號(hào):UPOLabs】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
晶圓表面形貌及臺(tái)階高度測量方法

【ZDS2024 Plus示波器申請(qǐng)】波長輪換與相移掃描相結(jié)合的表面形貌干涉測量方法
白光干涉儀只能測同質(zhì)材料嗎?
白光干涉儀在半導(dǎo)體封裝中對(duì)彈坑的測量
高斯光束傳輸特性及雙向剪切干涉法的應(yīng)用

白光干涉儀能測哪些三維形貌?

白光干涉儀可以看顯微形貌嗎?

一種晶圓表面形貌測量方法-WD4000





 基于SLM的四波橫向剪切干涉表面形貌測量方法
基于SLM的四波橫向剪切干涉表面形貌測量方法













評(píng)論