隨著半導體技術的飛速發展,小型化和集成化已成為行業發展的主流趨勢。在這種背景下,鋁帶鍵合作為一種新型的半導體封裝工藝,因其優良的導電性能、極小的接觸電阻以及較高的熱疲勞能力等特性,逐漸在功率器件中取代了傳統的粗鋁絲鍵合,尤其在小型貼片封裝SOP和PDFN中得到了批量性應用。然而,鋁帶鍵合工藝在推廣應用過程中,鍵合點根部損傷問題日益凸顯,成為制約其進一步發展的關鍵因素。本文將對鋁帶鍵合點根部損傷的原因進行深入分析,并提出相應的解決措施。
一、鋁帶鍵合工藝概述
鋁帶鍵合是引線鍵合工藝的一種,通過超聲鍵合技術將芯片焊接區與引線框架管腳焊接區域連接起來。與粗鋁線鍵合相比,鋁帶鍵合使用矩形截面的鋁帶替代了圓形截面的鋁線,從而提高了鍵合點的焊接強度和可靠性。鋁帶材料通常由純度高達99.99%的高純鋁線摻雜少量鎂、硅等微量元素制成,具有良好的導電性和耐蝕性。
鋁帶鍵合過程主要包括以下幾個步驟:
設備圖像系統識別:芯片焊接區域被設備圖像系統識別,焊頭降至芯片焊接區域上方。
第一焊點鍵合:通過超聲焊接完成第一焊點的鍵合。
移動至框架管腳焊接區域:焊頭帶動鋁帶移動至框架管腳焊接區域上方。
第二焊點鍵合:再次通過超聲焊接完成第二焊點的鍵合。
切斷鋁帶:焊頭帶動鋁帶向后移動,切刀落下切斷鋁帶,完成整個焊接過程。
二、鋁帶鍵合點根部損傷原因分析
鋁帶鍵合點根部作為鋁帶整段線弧中受過機械外力擠壓摩擦且厚度最薄的區域,其機械強度相對較弱,容易發生損傷。以下是對鋁帶鍵合點根部損傷原因的具體分析:
2.1劈刀端面設計因素
不同型號的鋁帶劈刀端面設計對鍵合點根部損傷有顯著影響。窄間距的462系列劈刀采用密集凸點端面設計,可以在更小的焊接平面上帶來更高的焊接強度,但其兩側端面凸起同樣會導致鋁帶鍵合焊接點根部機械強度降低。此外,劈刀端面的磨損和鋁屑積累也會加劇鍵合點根部的損傷。
2.2劈刀端面沾污積鋁
鋁帶劈刀端面沾污積鋁是導致鍵合點根部損傷加劇的另一重要原因。隨著焊接次數的增加,劈刀端面會積累大量鋁屑,不僅會造成焊接強度損失,端面凸點面積增大同樣會加劇鋁帶焊點根部損傷。
2.3導線管高度與框架管腳壓合狀態
導線管高度過高會導致第一焊點鍵合點根部受到機械損傷。同時,引線框架管腳壓合狀態調試不當會直接導致鋁帶根部斷裂。例如,在PDFN和SOP系列封裝中,由于框架管腳具有高密度、高精度和低厚度的特點,壓合狀態調試不當極易造成焊接點根部斷裂。
2.4鍵合參數設置不當
鍵合參數設置不當也是導致鋁帶鍵合點根部損傷的重要原因。超聲功率、鍵合壓力和時間等參數的設置直接影響焊接效果。功率過大或時間過長會導致劈刀積鋁速度加快和鍵合點根部機械強度降低;而功率過小或時間過短則可能導致焊接強度不足或虛焊。
三、解決措施與優化方案
針對鋁帶鍵合點根部損傷問題,本文提出以下解決措施和優化方案:
3.1劈刀選型及管控
針對劈刀選型問題,在芯片表面焊接面積足夠的情況下,優先選用470系列劈刀,該型號劈刀端面設計相對平緩,可以有效降低鋁帶根部損傷的風險。如果必須使用462型號劈刀,應通過批量性的清洗壽命驗證試驗后,同比降低該型號劈刀的單次上機使用壽命和總壽命,以保證劈刀端面的清潔度和磨損程度在可控范圍內。
此外,加強對劈刀端面的定期檢查和清洗,減少鋁屑積累。可以采用壓縮氣吹劈刀端面的方法,進一步清除端面殘留物。
3.2導線管高度與框架管腳壓合狀態調試
合理設置導線管高度,避免導線管高度過高導致的第一焊點根部機械損傷。同時,加強對框架管腳壓合狀態的調試和驗證,確保框架管腳在焊接過程中被牢牢鎖定,避免焊接區域傾斜和非垂直狀態導致的根部斷裂。
在框架管腳設計方面,可以采用倒梯型墊塊的設計方案,通過V型墊塊卡住框架管腳的重要位移方向,并配備壓爪機械壓合固定其他方向的位移,確保框架管腳在焊接過程中的穩定性和可靠性。
3.3鍵合參數優化
通過DOE(試驗設計)方法確定最佳焊接參數窗口,包括超聲功率、鍵合壓力和時間等參數。在量產過程中不斷調整和優化這些參數,確保在提供足夠焊接強度的同時,避免對鍵合點根部造成過應力損傷。
同時,注意爬坡時間、超聲功率和鍵合力的平衡關系,避免過大的功率和壓力導致鋁帶受損或根部斷裂。在設定鍵合線弧度時,應確保鋁線距離鍵合面邊緣的高度至少滿足兩倍線徑要求,以減少因弧度設置不當導致的熱循環應力集中和微裂紋擴展。
3.4超聲清洗與污染控制
針對鋁帶鍵合過程中的污染問題,可以采用超聲清洗方法去除焊接區域的助焊劑、錫膏等有機物污染。選擇合適的清洗劑和清洗工藝參數(如超聲頻率、功率和時間)可以有效提高鋁帶焊接強度和焊接區域的一致性。通過全流程封裝驗證確保清洗后的產品滿足設計要求并提高封裝良率。
四、結論與展望
鋁帶鍵合作為一種新型的半導體封裝工藝,在提高焊接強度和可靠性方面具有顯著優勢。然而,鋁帶鍵合點根部損傷問題制約了其進一步發展和推廣。通過對劈刀選型及管控、導線管高度與框架管腳壓合狀態調試、鍵合參數優化以及超聲清洗與污染控制等方面的深入研究和實踐探索,可以有效降低鋁帶鍵合點根部損傷的風險并提高封裝良率。
未來隨著半導體技術的不斷進步和封裝工藝的持續優化創新,鋁帶鍵合工藝有望在更多領域得到廣泛應用和推廣。同時,針對鋁帶鍵合點根部損傷等關鍵問題的深入研究也將推動半導體封裝技術的整體進步和發展。
-
芯片
+關注
關注
456文章
51170瀏覽量
427241 -
半導體
+關注
關注
334文章
27703瀏覽量
222628 -
導線
+關注
關注
5文章
412瀏覽量
24863 -
貼片封裝
+關注
關注
2文章
22瀏覽量
11167
發布評論請先 登錄
相關推薦
《炬豐科技-半導體工藝》用于半導體封裝基板的化學鍍 Ni-P/Pd/Au
混合電路內引線鍵合可靠性研究
半導體集成電路鍵合強度原理、試驗程序、試驗條件、失效判據分享!
IGBT模塊銀燒結工藝引線鍵合工藝研究
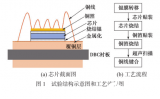
半導體芯片鍵合裝備綜述

半導體制造的鍵合線檢測解決方案
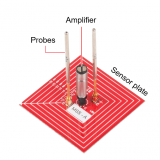
TCB熱壓鍵合:打造高性能半導體封裝的秘訣





 鋁帶鍵合點根部損傷研究:提升半導體封裝質量
鋁帶鍵合點根部損傷研究:提升半導體封裝質量
















評論