如今我們的生活中充滿了各種智能化設(shè)備,從智能手機(jī)到智能家居,再到可穿戴設(shè)備,它們已經(jīng)成為我們?nèi)粘I畈豢苫蛉钡囊徊糠帧.?dāng)我們沉浸在這些設(shè)備帶來的便利時(shí),是否曾想過,是什么技術(shù)支撐了這些設(shè)備的核心功能?在眾多關(guān)鍵技術(shù)中,晶圓鍵合技術(shù)雖然不像光刻技術(shù)那樣廣為人知,但它卻默默地在我們的手機(jī)圖像傳感器、重力加速傳感器、麥克風(fēng)、4G和5G射頻前端,以及部分NAND閃存中發(fā)揮著重要作用。那么,這一技術(shù)中的新興領(lǐng)域——混合鍵合究竟是什么呢?
一、晶圓鍵合技術(shù)是什么?
晶圓鍵合(wafer bonding),這一術(shù)語或許對許多人來說并不熟悉,但它卻是半導(dǎo)體制造中不可或缺的一環(huán)。與傳統(tǒng)的引線鍵合(wire bonding)和貼片鍵合(die bonding)不同,晶圓鍵合是在晶圓級別上實(shí)現(xiàn)不同材料或結(jié)構(gòu)的連接。在日語中,“bonding”被翻譯為“接合”,這一翻譯更直觀地描繪了這一工藝的本質(zhì)——將兩個(gè)或多個(gè)晶圓通過特定的工藝過程緊密結(jié)合在一起。
二、兩大類晶圓鍵合技術(shù)
永久鍵合
永久鍵合意味著一旦兩個(gè)晶圓被結(jié)合在一起,它們將永久性地保持連接狀態(tài),無需再解鍵合(debonding)。
臨時(shí)鍵合
臨時(shí)鍵合則需要在后續(xù)工藝中重新打開已經(jīng)接合在一起的晶圓。從界面材料的角度來看,晶圓鍵合又可以分為帶中間層的膠鍵合、共晶鍵合、金屬熱壓鍵、無中間層的熔融鍵合(fusion bonding)和陽極鍵合等多種類型。
三、混合鍵合——技術(shù)的革新與突破
在晶圓鍵合的眾多類型中,混合鍵合以其獨(dú)特的優(yōu)勢和廣泛的應(yīng)用前景而備受矚目。混合鍵合是一種結(jié)合了多種鍵合技術(shù)的先進(jìn)工藝,它能夠在不同材料之間實(shí)現(xiàn)高精度、高強(qiáng)度的連接。長江存儲的Xtacking技術(shù)就是混合鍵合技術(shù)的典型應(yīng)用之一。
通過混合鍵合技術(shù),Memory晶圓和CMOS晶圓可以在后道制程中構(gòu)建觸點(diǎn),并通過這些觸點(diǎn)實(shí)現(xiàn)垂直方向的互聯(lián)。這種互聯(lián)方式不僅簡化了傳統(tǒng)工藝中的引線連接和TSV(Through Silicon Via,硅通孔)穿透,還大大提高了互聯(lián)的效率和可靠性。
四、混合鍵合的優(yōu)勢
更短的互聯(lián)距
混合鍵合技術(shù)通過直接連接Memory晶圓和CMOS晶圓的后道銅觸點(diǎn),實(shí)現(xiàn)了更短的互聯(lián)距離。這不僅避免了傳統(tǒng)工藝中使用引線互相聯(lián)通的繁瑣過程,還無需用TSV穿過整個(gè)CMOS層。這種短距離互聯(lián)不僅減少了信號傳輸?shù)难舆t和損耗,還提高了整個(gè)系統(tǒng)的性能。
更高的互聯(lián)密度
混合鍵合工藝中的銅觸點(diǎn)面積非常小,相比直徑百微米的錫球和TSV,銅觸點(diǎn)的pitch size(觸點(diǎn)間距)甚至都不足10微米。這意味著在相同的面積內(nèi),可以布置更多的觸點(diǎn),從而實(shí)現(xiàn)更高的互聯(lián)密度。這種高密度互聯(lián)對于提高芯片的集成度和性能至關(guān)重要。
更低的成本
傳統(tǒng)的互聯(lián)方式往往需要對每顆DIE進(jìn)行單獨(dú)的互聯(lián)操作,這不僅耗時(shí)費(fèi)力,還限制了生產(chǎn)效率。而混合鍵合技術(shù)通過晶圓級別的鍵合,實(shí)現(xiàn)了大面積高密度的互聯(lián),從而大大提高了生產(chǎn)效率。這種效率的提升不僅降低了生產(chǎn)成本,還加快了新產(chǎn)品的上市速度。
五、混合鍵合的未來應(yīng)用
混合鍵合技術(shù)的出現(xiàn)和發(fā)展,不僅推動(dòng)了半導(dǎo)體制造技術(shù)的進(jìn)步,還為未來的應(yīng)用提供了無限可能。在智能手機(jī)、智能家居、可穿戴設(shè)備等領(lǐng)域,混合鍵合技術(shù)可以助力實(shí)現(xiàn)更加高效、可靠的芯片互聯(lián),從而提升設(shè)備的性能和用戶體驗(yàn)。
在存儲領(lǐng)域,混合鍵合技術(shù)可以應(yīng)用于3D NAND閃存的制造中,通過垂直堆疊的方式實(shí)現(xiàn)更高的存儲容量和更快的讀寫速度。在傳感器領(lǐng)域,混合鍵合技術(shù)可以助力實(shí)現(xiàn)更加敏感、精確的傳感器芯片,從而推動(dòng)物聯(lián)網(wǎng)、醫(yī)療健康等領(lǐng)域的發(fā)展。
此外,混合鍵合技術(shù)還可以應(yīng)用于高性能計(jì)算、人工智能等領(lǐng)域,通過優(yōu)化芯片間的互聯(lián)方式,提高整個(gè)系統(tǒng)的計(jì)算效率和性能。隨著技術(shù)的不斷進(jìn)步和應(yīng)用領(lǐng)域的不斷拓展,混合鍵合技術(shù)將成為半導(dǎo)體制造領(lǐng)域的重要發(fā)展方向之一。
盡管混合鍵合技術(shù)具有諸多優(yōu)勢和應(yīng)用前景,但其發(fā)展仍面臨一些挑戰(zhàn)。例如,混合鍵合過程中需要精確控制各種工藝參數(shù),以確保鍵合的質(zhì)量和可靠性。此外,混合鍵合技術(shù)還需要與現(xiàn)有的半導(dǎo)體制造工藝相兼容,以實(shí)現(xiàn)大規(guī)模的生產(chǎn)和應(yīng)用。為了克服這些挑戰(zhàn),業(yè)界正在不斷探索和創(chuàng)新。研究人員正在開發(fā)更加先進(jìn)的混合鍵合工藝和技術(shù),以提高鍵合的精度和可靠性、另外,制造商正在優(yōu)化現(xiàn)有的半導(dǎo)體制造工藝和設(shè)備,以適應(yīng)混合鍵合技術(shù)的需求。
-
晶圓
+關(guān)注
關(guān)注
52文章
4927瀏覽量
128096 -
鍵合
+關(guān)注
關(guān)注
0文章
60瀏覽量
7901 -
半導(dǎo)體制造
+關(guān)注
關(guān)注
8文章
410瀏覽量
24081
原文標(biāo)題:【微納加工】混合鍵合,重塑半導(dǎo)體互聯(lián)技術(shù)的未來!
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
TCB熱壓鍵合:打造高性能半導(dǎo)體封裝的秘訣

帶你一文了解什么是引線鍵合(WireBonding)技術(shù)?

從發(fā)展歷史、研究進(jìn)展和前景預(yù)測三個(gè)方面對混合鍵合(HB)技術(shù)進(jìn)行分析

三維堆疊封裝新突破:混合鍵合技術(shù)揭秘!

混合鍵合的基本原理和優(yōu)勢

晶圓鍵合技術(shù)的類型有哪些
鋁帶鍵合點(diǎn)根部損傷研究:提升半導(dǎo)體封裝質(zhì)量
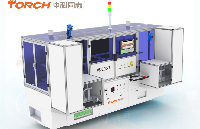
半導(dǎo)體制造的鍵合線檢測解決方案
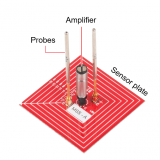
倒計(jì)時(shí)1天 | 第三屆OpenHarmony技術(shù)大會(huì)——明天,上海見!
混合鍵合技術(shù):開啟3D芯片封裝新篇章

SK海力士將在HBM生產(chǎn)中采用混合鍵合技術(shù)
半導(dǎo)體芯片鍵合裝備綜述





 混合鍵合:開創(chuàng)半導(dǎo)體互聯(lián)技術(shù)新紀(jì)元
混合鍵合:開創(chuàng)半導(dǎo)體互聯(lián)技術(shù)新紀(jì)元











評論