文章來(lái)源:學(xué)習(xí)那些事
原文作者:小陳婆婆
本文介紹了硅的晶體缺陷測(cè)量。
硅的晶體缺陷測(cè)量
半導(dǎo)體晶體在生長(zhǎng)和加工過(guò)程中會(huì)產(chǎn)生多種結(jié)構(gòu)缺陷,這些缺陷對(duì)集成電路(IC)器件的性能和合格率有著重要影響。因此,對(duì)晶體缺陷的觀察、檢測(cè)及研究至關(guān)重要。硅作為半導(dǎo)體材料的重要代表,其晶體缺陷的測(cè)量與控制尤為關(guān)鍵,現(xiàn)分述如下
點(diǎn)缺陷及其測(cè)量、位錯(cuò)、堆垛層錯(cuò)
1、點(diǎn)缺陷及其測(cè)量
晶體缺陷分類(lèi)
硅的晶體缺陷可分為宏觀缺陷和微觀缺陷兩大類(lèi)。
宏觀缺陷:包括雙晶、雜質(zhì)析出及夾雜、星形結(jié)構(gòu)、系屬結(jié)構(gòu)等。這些缺陷通常較大,易于觀察和檢測(cè)。
微觀缺陷:包括點(diǎn)缺陷、位錯(cuò)、層錯(cuò)、晶體的原生缺COP缺陷等微缺陷,以及晶格的點(diǎn)陣應(yīng)變、表面損傷等。這些缺陷尺寸較小,需要借助高精度儀器進(jìn)行檢測(cè)。
點(diǎn)缺陷是局限于小區(qū)域的缺陷,其特征是不完整區(qū)域可以被去除并代之以完整的截面,不產(chǎn)生附加的晶格畸變。常見(jiàn)的點(diǎn)缺陷有空位、間隙原子、復(fù)合缺陷(絡(luò)合體)及外來(lái)原子。

空位:空位可以與雜質(zhì)原子形成絡(luò)合體,影響半導(dǎo)體的電學(xué)特性。空位還可以聚集成團(tuán),崩塌后形成位錯(cuò)環(huán)。
間隙原子:間隙原子的形成能通常比空位小,可以與空位結(jié)合而相互湮滅,也可以自身聚集成團(tuán),崩塌后形成間隙性位錯(cuò)環(huán)。
復(fù)合缺陷(絡(luò)合體):復(fù)合缺陷通常是電活性的,可以影響半導(dǎo)體的載流子濃度。
外來(lái)原子:晶體中引入的非本征原子,其存在形式以間隙形式或替代形式存在。替代式雜質(zhì)是外來(lái)原子以替代晶格中原子的方式存在。測(cè)量方法通常是通過(guò)它們對(duì)半導(dǎo)體電學(xué)特性的影響進(jìn)行間接檢測(cè)。此外外來(lái)原子可以影響半導(dǎo)體的導(dǎo)電性、摻雜濃度等特性。
硅的晶體缺陷測(cè)量涉及多種方法和技術(shù),包括電子順磁共振、光學(xué)、電學(xué)測(cè)試以及原子背散射等。這些方法的綜合應(yīng)用可以實(shí)現(xiàn)對(duì)晶體缺陷的精確測(cè)量和深入研究。通過(guò)控制晶體缺陷的產(chǎn)生和消除,可以提高硅半導(dǎo)體材料的性能和穩(wěn)定性,進(jìn)而提升集成電路器件的性能和合格率。
2、位錯(cuò)
位錯(cuò)有兩種主要類(lèi)型:刃型位錯(cuò)和螺型位錯(cuò)。

刃型位錯(cuò):當(dāng)晶體受到剪切應(yīng)力作用,發(fā)生相對(duì)滑移后,在滑移面的一側(cè)會(huì)出現(xiàn)多余的原子半平面,形成刃型位錯(cuò)。這種位錯(cuò)的特點(diǎn)是位錯(cuò)線(xiàn)與滑移面垂直,且位錯(cuò)線(xiàn)周?chē)Ц窕冚^大。

螺型位錯(cuò):另一種滑移方式是晶體的一部分繞某一軸線(xiàn)旋轉(zhuǎn)一定角度后,與另一部分發(fā)生錯(cuò)動(dòng)。此時(shí),錯(cuò)動(dòng)的分界線(xiàn)即為螺型位錯(cuò)線(xiàn)。螺型位錯(cuò)的特點(diǎn)是位錯(cuò)線(xiàn)呈螺旋狀,且位錯(cuò)線(xiàn)周?chē)木Ц窕兿鄬?duì)較小。

為了觀察位錯(cuò),通常采用化學(xué)腐蝕法。通過(guò)擇優(yōu)腐蝕,位錯(cuò)處由于晶格畸變較大,腐蝕速度較快,從而可以在晶體表面形成可見(jiàn)的蝕坑或蝕線(xiàn),進(jìn)而用光學(xué)顯微鏡進(jìn)行觀察。
3、堆垛層錯(cuò)
堆垛層錯(cuò)通常是由于晶體生長(zhǎng)過(guò)程中原子層的堆垛順序發(fā)生錯(cuò)誤所致。

堆垛層錯(cuò)會(huì)導(dǎo)致晶體結(jié)構(gòu)的局部改變,從而影響晶體的物理和化學(xué)性質(zhì)。
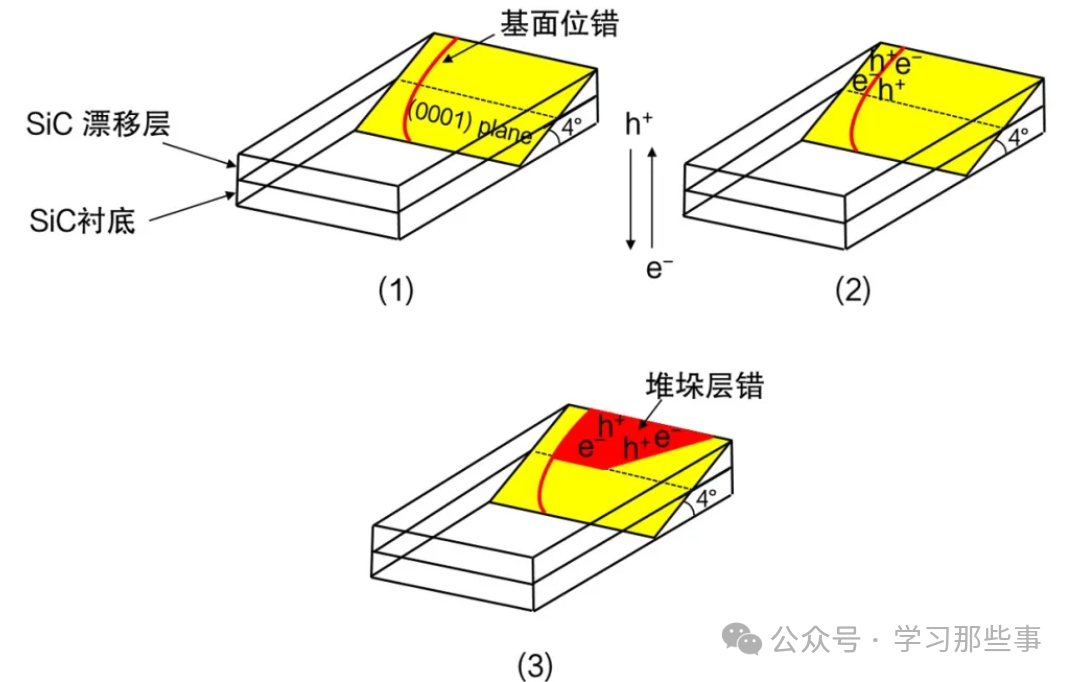
與位錯(cuò)類(lèi)似,堆垛層錯(cuò)也可以通過(guò)化學(xué)腐蝕法顯示出來(lái)。在腐蝕過(guò)程中,堆垛層錯(cuò)處由于晶格結(jié)構(gòu)的改變,腐蝕速度也會(huì)發(fā)生變化,從而在晶體表面形成可見(jiàn)的蝕坑或蝕面。

這些蝕坑或蝕面可以用光學(xué)顯微鏡進(jìn)行觀察和研究。
半導(dǎo)體晶體缺陷檢測(cè)方法
目前,半導(dǎo)體晶體缺陷的檢測(cè)方法大多數(shù)仍然采用擇優(yōu)腐蝕后再用光學(xué)顯微鏡進(jìn)行觀察的金相顯微技術(shù)。除了光學(xué)顯微鏡外,還有其他比較先進(jìn)的測(cè)試方法可以用于觀察和研究半導(dǎo)體內(nèi)的缺陷,如X射線(xiàn)形貌技術(shù)、紅外顯微鏡、透射電子顯微技術(shù)等。具體選擇取決于晶體的類(lèi)型、缺陷的種類(lèi)以及腐蝕條件等因素。通過(guò)合理選擇腐蝕劑和腐蝕條件,可以有效地顯示出晶體中的缺陷,為后續(xù)的分析和研究提供有力支持。
-
集成電路
+關(guān)注
關(guān)注
5388文章
11564瀏覽量
362106 -
半導(dǎo)體
+關(guān)注
關(guān)注
334文章
27450瀏覽量
219513 -
晶體
+關(guān)注
關(guān)注
2文章
1356瀏覽量
35459
原文標(biāo)題:硅的晶體缺陷測(cè)量
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
晶體位錯(cuò)理論的提出及晶體缺陷的研究
可控硅的測(cè)量方法
晶體電路測(cè)量方法
模擬測(cè)量方法和數(shù)字測(cè)量方法
熱工測(cè)量的概念和測(cè)量方法
電力功率測(cè)量方法
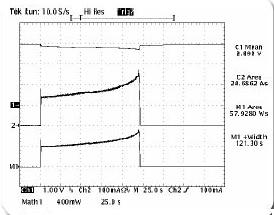
串聯(lián)電阻的構(gòu)成及晶體硅太陽(yáng)電池的測(cè)量方法的介紹
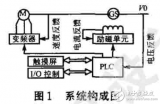
基于聲卡的直流信號(hào)測(cè)量方法分析

晶體缺陷的常見(jiàn)的三種類(lèi)型
什么是晶體缺陷 晶體缺陷的類(lèi)型

一文詳解SiC的晶體缺陷
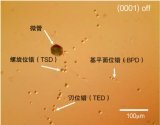
硅拋光片的主要技術(shù)指標(biāo)、測(cè)試標(biāo)準(zhǔn)及硅片加工參數(shù)的測(cè)量方法





 硅的晶體缺陷測(cè)量方法
硅的晶體缺陷測(cè)量方法













評(píng)論