本文主要介紹光刻機的分類與原理。
光刻機分類
光刻機的分類方式很多。按半導體制造工序分類,光刻設(shè)備有前道和后道之分。前道光刻機包括芯片光刻機和面板光刻機。面板光刻機的工作原理和芯片光刻機相似,但是由于面板光刻機針對的是薄膜晶體管,芯片光刻機針對的是晶圓,面板光刻機精度要求遠低于芯片光刻機,只要達到pm級別即可。后道光刻機則是單質(zhì)封裝光刻機,封裝光刻機的作用相較于前道光刻機來說較小,所以其精度和價值遠遠比不上前道光刻機。光刻技術(shù)采用的光源類別涵蓋紫外光刻(UV)、深紫外光刻(DUV)以及極紫外光刻(EUV)。光刻機的迭代往往伴隨著光源的革新,具體表現(xiàn)為光波波長的持續(xù)縮減,因此,光源類型常被用作界定光刻機世代的標準。至于光刻機當前主流的劃分依據(jù),則是依據(jù)其曝光機制,分為直寫光刻、接近式接觸光刻、光學投影光刻及浸沒式光刻四大類別。

a)直寫式光刻b)接近接觸式光刻c)光學投影式光刻
如下圖所示,直寫光刻是最基礎(chǔ)的光刻技術(shù),其曝光范圍有限,因此主要應(yīng)用于掩模版的制造。接近接觸光刻則包含接觸與接近兩種模式:接觸式光刻機中,掩模版直接與光刻膠接觸,設(shè)備成本較低,分辨率通常高于0.5μm,但受限于光刻膠厚度,可能導致掩模版受損,污染物直接成像于硅片,引發(fā)硅片變形,進而影響成像均勻性;而接近式光刻機中,掩模版與光刻膠保持微小間隙,同樣具備成本效益,且避免了掩模版直接接觸光刻膠導致的損傷,然而,接近式光刻會引發(fā)衍射效應(yīng),降低圖像傳遞的精確度,其分辨率較接觸式低。光學投影光刻則是利用光學系統(tǒng)在掩模版與光刻膠間聚焦光線進行曝光,顯著提升了分辨率。光學投影光刻機分為步進-重復與步進-掃描兩種類型,它們以縮小比例的方式將掩模版圖像投影至硅片上。這種曝光技術(shù)不僅分辨率高,對掩模版損耗小,且對污染物敏感度低,但設(shè)備成本高昂,系統(tǒng)構(gòu)造極為復雜。
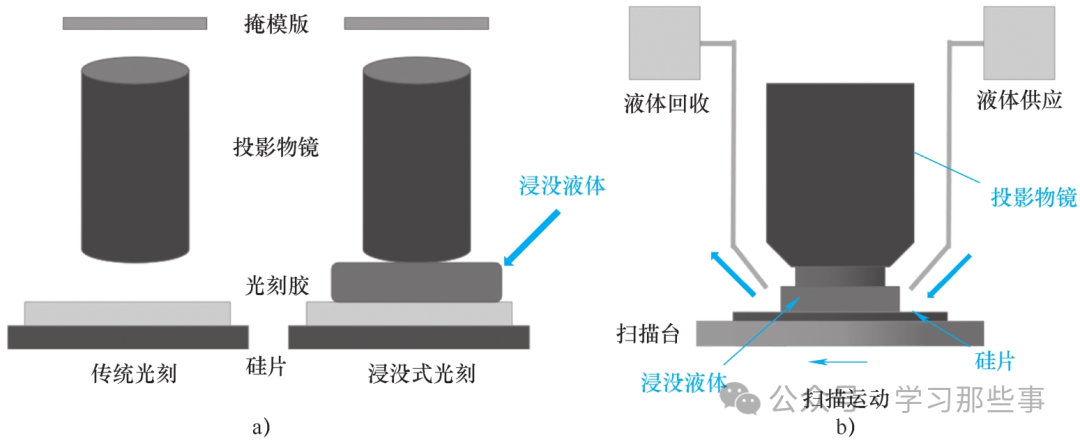
除此之外,隨著芯片制造技術(shù)不斷發(fā)展,又陸續(xù)發(fā)展出雙工作臺式光刻、浸沒式光刻等多種先進的新型光刻技術(shù),極大程度提高了光刻工藝效率和工藝精度。在硅片開始光刻之前,必須經(jīng)過精確的測量和對準流程。早期,光刻機僅設(shè)計有一個工作臺,負責從測量、對準直至光刻的完整作業(yè)流程。然而,隨著雙工作臺系統(tǒng)的應(yīng)用,光刻機能夠在保持原有速度和加速度穩(wěn)定的情況下,實現(xiàn)兩個工作臺的同時運作:一個工作臺專注于曝光作業(yè),而另一個則同步進行曝光前的預對準準備。這一改進將光刻機的生產(chǎn)效率提升了約35%。盡管從表面上看,僅僅是增加了一個工作臺,但背后的技術(shù)挑戰(zhàn)卻相當艱巨。雙工作臺系統(tǒng)對工作臺切換的速度與精確度提出了嚴苛要求:切換速度若慢,會拖累光刻機整體效率;而切換精度不足,則可能干擾后續(xù)的掃描光刻等關(guān)鍵環(huán)節(jié)。在傳統(tǒng)光刻機與光刻技術(shù)中,這樣的設(shè)計尚未普及。投影透量系統(tǒng)與光刻膠之間是折射率近似為t的空氣層,如上圖所示,與傳統(tǒng)的光刻機結(jié)構(gòu)不同,浸沒式光刻機在其投影物鏡系統(tǒng)未端(即最后一面投影物鏡的下表面)與基底的感光材料之間加入高折射率的液體,依照應(yīng)用光學理論;光在通過高折射率的液體層時其光波長會相應(yīng)縮短,因此可以使得193nm的光源波長折算等效為134nm,以一種巧妙的方式降低了光源的波長,提高了光刻機的分辨精度。
光刻機原理
如前文所述,光刻機種類繁多,不同種類光刻機原理不同,由于目前主流光刻機是EUV類型光刻機。如圖所示,EUV光刻機就是一個大的投影曝光系統(tǒng),主要包括計算機控制臺、治源、橫片,光罩和基底等,在光刻機工作的過程中,由光源發(fā)射的激光光束會照射到帶有電路圖的掩模版和光學鏡片土,從而對帶有感光材料的基底進行曝光,隨后用化學方法對曝光圖加以昂影,得到最終的圖形。光刻機內(nèi)部結(jié)構(gòu)的核心組件包括光源系統(tǒng)和光校正系統(tǒng)。光源系統(tǒng)依賴于激光器作為激發(fā)裝置,以發(fā)射激光束;而光校正系統(tǒng)則通過物鏡來彌補光學偏差。通常,光刻機的光校正系統(tǒng)配備有15至20個直徑范圍在200至300毫米之間的透鏡,且每一個鏡片的精度要求極高,這也是光刻機成本極高的主要原因之一凹。下圖所示為光刻機簡易工作原理圖,接下來詳細闡述一下光刻機中各個部分的作用。
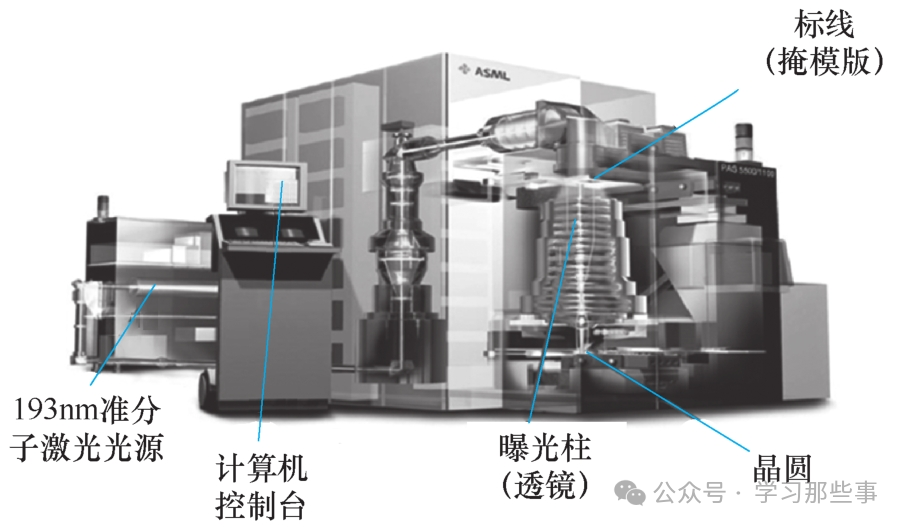
光刻機外觀圖
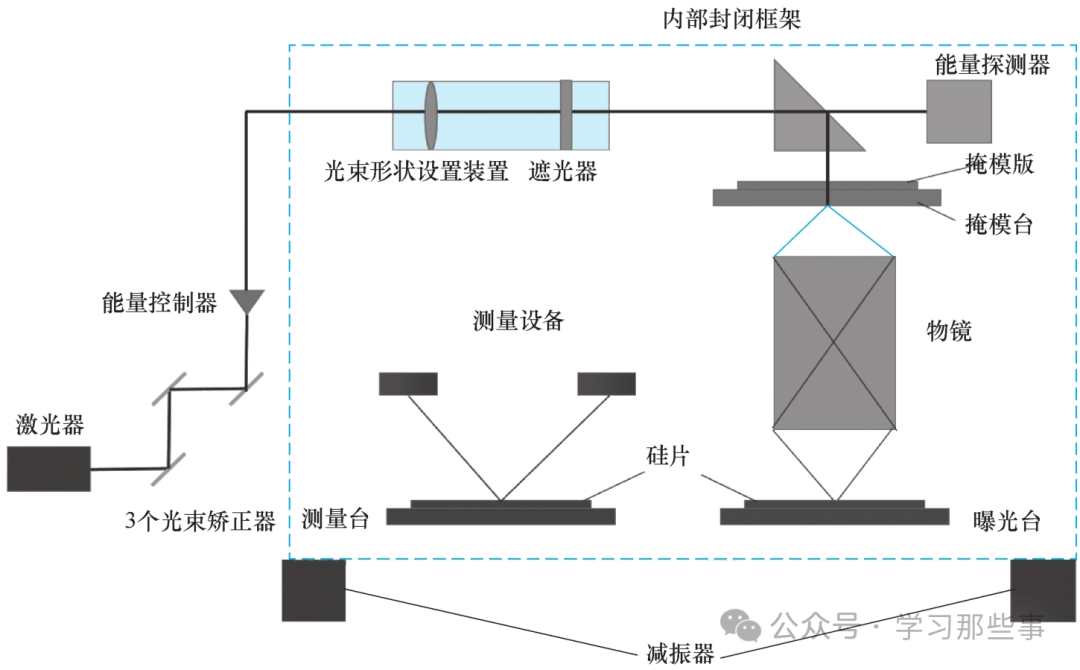
光刻機簡易工作原理圖
首先光刻機中有兩個平臺,分別是測量臺和曝光臺,二者雖然都起著承載基底硅片的作用,但是前者主要進行測量,后者主要進行曝光。內(nèi)部封閉框架和減振器屬于光刻機外圍裝置,主要作用包括保持工作臺的封閉性和水平性、避兔外部機械振動的干擾以及維持相對穩(wěn)定的溫度激勵。激光器的作用是產(chǎn)生具有良好相干性的激光光源,如前文所述,光源作為光刻機的關(guān)鍵組件,其波長直接決定了光刻機的工藝水平。如下表所示,早期的光刻技術(shù)采用汞燈作為紫外光源,經(jīng)歷了從g線到i線的逐步發(fā)展,波長從436納米縮短至365納米,從而達到了200納米以上的分辨率水平。跨入21世紀后,光刻行業(yè)引入了準分子激光激發(fā)的深紫外光源,波長進一步縮減到ArF的193納米,再次顯著提高了光刻效率,進一步強調(diào)了光源在光刻技術(shù)中的關(guān)鍵作用。
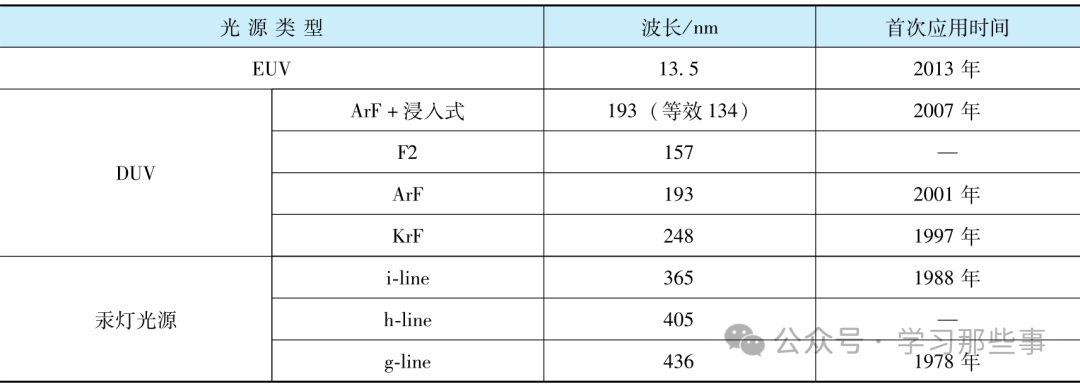
各光刻機光源的參數(shù)
光束校正裝置的主要功能是調(diào)整光束入射方向,確保激光束盡可能平行入射。能量調(diào)節(jié)器負責控制照射至硅片上的光能量,避免曝光不足或過度導致的成像質(zhì)量下降。光束整形裝置能夠根據(jù)需要,將光束調(diào)整為圓形、環(huán)形等形狀,以改變光的特性。遮光裝置則用于在不需要曝光時阻擋光束,防止其照射到硅片上。能量監(jiān)測器負責檢測光束的最終入射能量是否符合曝光標準,并向能量調(diào)節(jié)器提供反饋進行調(diào)整。
掩模版是一塊刻有電路設(shè)計圖的玻璃板,其價格通常高達數(shù)十萬元。掩模版由掩模臺支撐,掩模臺的運動控制精度可達納米級。下方的物鏡用于補償光學誤差,并將電路圖按光學系統(tǒng)特性等比例縮小。硅片基底是由硅晶制成的圓形基片,尺寸多樣,且尺寸越大,生產(chǎn)效率越高。根據(jù)硅片上缺口形狀的不同,硅片通常分為flat型和notch型兩種。
-
半導體
+關(guān)注
關(guān)注
334文章
27703瀏覽量
222628 -
光刻機
+關(guān)注
關(guān)注
31文章
1157瀏覽量
47580
原文標題:光刻機分類及原理介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
光刻機工藝的原理及設(shè)備
光刻機是干什么用的
魂遷光刻,夢繞芯片,中芯國際終獲ASML大型光刻機 精選資料分享
光刻機結(jié)構(gòu)組成及工作原理





 光刻機的分類與原理
光刻機的分類與原理










評論