隨著科學技術的飛速發展,IC產品的尺寸設計越來越小,性能越來越高,涵蓋范圍越來越廣。微電子技術的微型研究帶來了各行業的巨變,不僅使計算機與信息技術等領域面貌一新,而且在許多領域引發了一場微小型化的革命。機械制造領域的微小型化誕生了微機電系統即MEMS(Microelectro Mechanical Systems)。它將電子功能與機械、光學、熱學、磁學等其他功能結合在一起,形成綜合集成系統。經過四十多年的發展,MEMS已成為世界矚目的重大領域之一。許多世界大國都將MEMS技術作為戰略性的研究領域之一,投入巨資進行專項研究。
MEMS傳感器是采用微機械加工技術制造的新型傳感器,是MEMS器件的一個重要分支。隨著MEMS技術產業的日益成熟,MEMS傳感器種類越來越多,性能也越來越強大,產品已廣泛應用于汽車、醫療、軍事等領域。而相對于工藝的迅速發展,MEMS可靠性的研究落后了很多。目前MEMS可靠性的評估方法在行業內還沒有標準化,工廠針對MEMS產品也僅有PCM參數測量。沒有可行的可靠性測試方法,就無法驗證和監控MEMS工藝的可靠性。因此,標準化可靠性評估方法的建立已迫在眉睫。
基于微電子行業器件失效機理研究和可靠性評價體系的完備,這些可靠性評價經驗在預測MEMS產品的使用可靠性方面是有借鑒作用的。但是MEMS壓力傳感器對環境的依賴度較高,必須考慮在嚴酷的使用環境下傳感器獨特的失效模式。
本文基于硅壓阻式MEMS壓力傳感器的結構和工作原理等信息,反推至芯片相關工藝參數,并設計針對關鍵工藝參數的可靠性測試方法。
1 MEMS壓力傳感器結構
與傳統的壓力傳感器相比,MEMS壓力傳感器不僅體積小,而且具有較高的測量精度、較低的功耗和極低的成本。絕大多數的MEMS壓力傳感器的感壓元件是硅膜片,根據敏感機理的不同,可將MEMS壓力傳感器分為3種:壓阻式、電容式和諧振式 。其中,硅壓阻式MEMS壓力傳感器采用高精密半導體電阻應變片組成惠斯頓電橋,利用半導體材料的壓阻效應和良好的彈性來進行力電變換。
華潤上華(CSMC)制備的硅壓阻式MEMS壓力傳感器的標準流程如下:首先在拋光的硅襯底上經光刻注入生成四根電阻應變片,電阻應變片被設計在硅膜表面應力最大處,組成惠斯頓電橋。然后在圓片背面,從硅片中部刻蝕出一個應力杯。最后鍵合圓片背面。根據產品應用,即可以在應力杯中抽真空制成絕壓MEMS器件,也可以維持應力杯和大氣相通制成表壓MEMS器件。其結構如圖1所示。
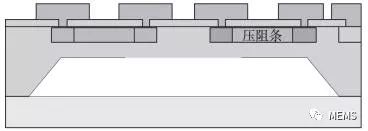
圖1 硅壓阻式MEMS壓力傳感器結構示意圖
產品封裝后,當硅膜兩邊的壓力差發生變化時,應力硅膜會發生彈性形變,破壞原先的惠斯頓電橋電路平衡,產生電橋輸出與壓力成正比的電壓信號。
2 測試結構的確定
MEMS壓力傳感器的特性參數包含有零位輸出、電壓輸出、線性度、回滯特性等。這些特性參數與惠斯頓電橋強相關。因此,惠斯頓電橋的可靠性一定程度上反映了MEMS壓力傳感器的可靠性。我們在圓片上設計一個典型的惠斯頓電橋結構,用來監控MEMS器件的特性參數。如圖2所示:R1、R2、R3及R4是4根等電阻的壓阻應變條,它們在硅膜上組成惠斯頓電橋,無外力作用時,電橋平衡,輸出電壓為零。當膜片受到外界壓力作用時,電橋失去平衡,若對電橋加激勵電源,便可得到與被測壓力成正比的輸出電壓,從而達到測量壓力的目的。
結合器件的實際使用,綜合考慮器件的工作條件和環境,從高溫存儲、高溫高濕、溫度沖擊、過電壓、壓力過載、溫濕循環等方面全面建立MEMS壓力傳感器圓片級和封裝級的可靠性考核方法。
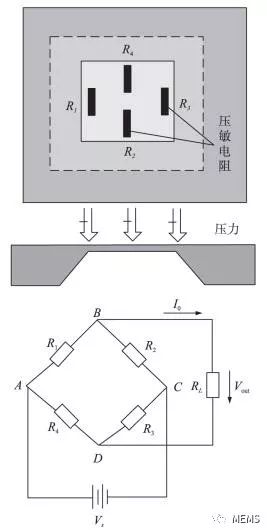
圖2 測試模塊結構示意圖
3 圓片級MEMS可靠性考核方法
目前工廠中MEMS圓片級產品的工藝監控基本上是依賴PCM參數測量。在這里,我們結合MEMS產品的實際使用條件,通過監控零位輸出電壓的高溫存儲、高溫高濕特性,考核圓片級(應力杯未釋放狀態)惠斯頓電橋的環境可靠性。
3.1 高溫存儲可靠性考核
在125℃高溫下,將MEMS圓片分別老化12h、48h和168h后,測試零位輸出電壓(Voff) 。通過與初始零位輸出電壓的對比,考核電阻應變片的工藝可靠性。
從老化數據可見,經過125℃的高溫存儲,各時間段的零位輸出電壓變化量都很小。即使經過168h的高溫存儲,未釋放狀態下的壓阻應變片電阻仍然比較穩定,可靠性風險較低。

圖3 高溫存儲Voff變化圖(125 ℃和168h)
3.2 高溫高濕可靠性考核
在85℃和85%RH高溫高濕條件下,將MEMS圓片分別老化24h、72h和168h后,測試零位輸出電壓(Voff)。通過與初始零位輸出電壓的對比,考核電阻應變片的工藝可靠性。

圖4 高溫高濕存儲Voff變化圖(85℃和85% 168h)
對比不同時間段的Voff值,發現經過85℃和85%RH的老化,各時間段的零位輸出電壓變化量都很小。即使經過168h的高溫高濕存儲,未釋放狀態下的壓阻應變片電阻仍然很穩定,可靠性風險較低。
圓片級的測試結構由于未釋放應力杯,主要考核的是電阻應變片在高溫、高溫高濕老化后的工藝穩定性。除非工藝非常不穩定,一般情況下,電阻經過溫度老化和濕度老化的可靠性風險都較低。
4 封裝級MEMS可靠性考核方法
對于釋放應力杯并完成封裝的MEMS器件來說,高溫或高濕老化可能會影響硅膜的彈性形變,而長時間的壓力負載也可能導致硅膜疲勞。這些損害會造成MEMS特性參數的漂移,嚴重的話會引發器件開路和短路,從而影響產品最終的可靠性。因此,封裝級MEMS器件的環境負載考核更加重要。
4.1 高溫存儲可靠性考核
將封裝的絕壓MEMS器件在125℃高溫下老化72h后,分別測試器件在40kPa~100kPa下的輸出電壓、線性度、回滯特性參數。
由圖5可見,封裝器件進行72h高溫存儲老化后,線性度和回滯特性良好; 不同壓力下的輸出電壓與初始值相比shift<1%。根據工藝給出的輸出電壓判定SPEC:shift≤±10%,可靠性風險較低。
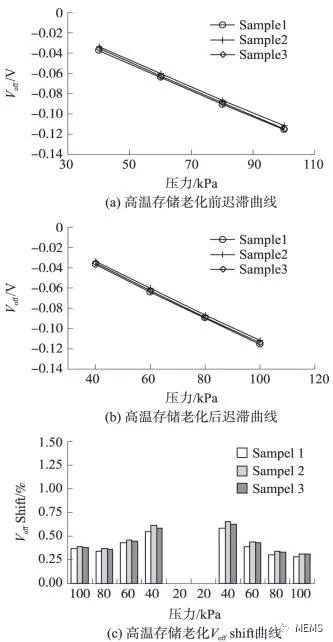
圖5 高溫存儲老化前、后壓力遲滯曲線和高溫存儲老化Voff shift曲線
4.2 溫度沖擊可靠性考核
將封裝的絕壓MEMS器件在-50℃和150℃高溫下,進行10次循環沖擊,然后測試器件在40kPa~100kPa下的輸出電壓、線性度、回滯特性參數。
由圖6可見,溫度沖擊對線性度和回滯特性影響較低,曲線線性度和重合度良好; 不同壓力下的輸出電壓在與初始值相比shift<1%。根據工藝給出的輸出電壓判定SPEC:shift≤±10%,可靠性風險較低。
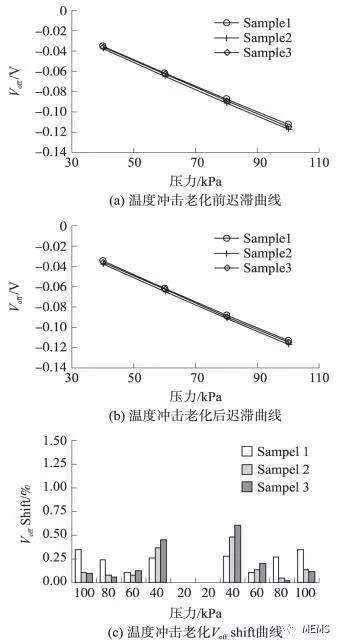
圖6 溫度沖擊老化前、后壓力遲滯曲線和溫度沖擊老化Voff shift曲線
4.3 溫濕循環可靠性考核
將封裝的絕壓MEMS器件置于40℃~65℃高溫,90%RH~95%RH環境下,以24h為一個循環周期,連續循環6次,然后測試器件在40kPa~100kPa下的輸出電壓、線性度、回滯特性參數。
由圖7可見,溫濕循環老化對線性度和回滯特性影響也較低,曲線線性度和重合度良好; 不同壓力下的輸出電壓與初始值相比shift<1%。根據工藝給出的輸出電壓判定SPEC:shift≤±10%,可靠性風險較低。
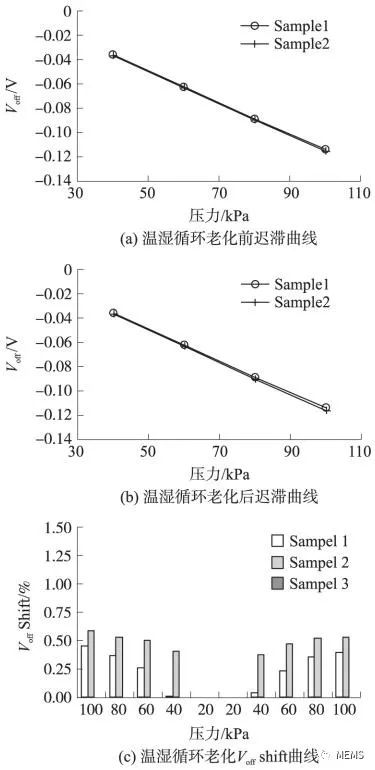
圖7 溫濕循環老化前、后壓力遲滯曲線和溫濕循環老化Voff shift曲線
4.4 電壓過載可靠性考核
MEMS產品一般都是電子產品,基本都需要接電源使用,所以考核產品的電壓過載可靠性也是非常必要的。將封裝的絕壓MEMS器件在32倍的工作電壓下持續過電壓1min,然后測試器件在40kPa~100kPa下的輸出電壓、線性度、回滯特性參數。
由圖8可見,短時電壓過載對線性度和回滯特性影響較小,曲線線性度和重合度良好; 不同壓力下的輸出電壓與初始值相比shift<0.6%。根據工藝給出的輸出電壓判定SPEC: shift≤±10%,可靠性風險低。
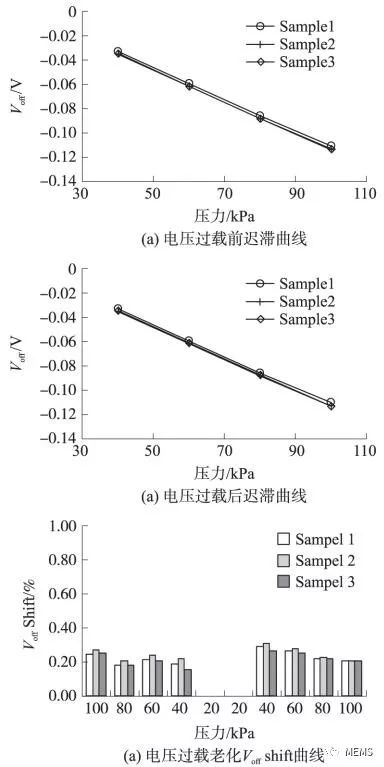
圖8 電壓過載前、后壓力遲滯曲線和電壓過載老化Voff shift曲線
4.5 壓力過載可靠性考核
壓力MEMS產品最重要的產品特性是壓力與輸出電壓的線性特性,而長時間的壓力負載會如何影響產品的使用性能,就需要通過壓力過載實驗來驗證。將封裝的絕壓MEMS器件在120℃和2atm下老化24h后,分別測試器件在40kPa~100kPa下的輸出電壓、線性度、回滯特性參數。
由圖9可見,壓力過載老化對線性度和回滯特性影響也較小,曲線線性度和重合度良好; 不同壓力下的輸出電壓與初始值相比shift<5%。根據工藝給出的輸出電壓判定SPEC:shift≤±10%,可靠性風險較低。
對比論文中所有的測試發現,壓力MEMS器件對壓力過載試驗最敏感。壓力過載考核是判斷壓力MEMS器件可靠性的重要測試方法。
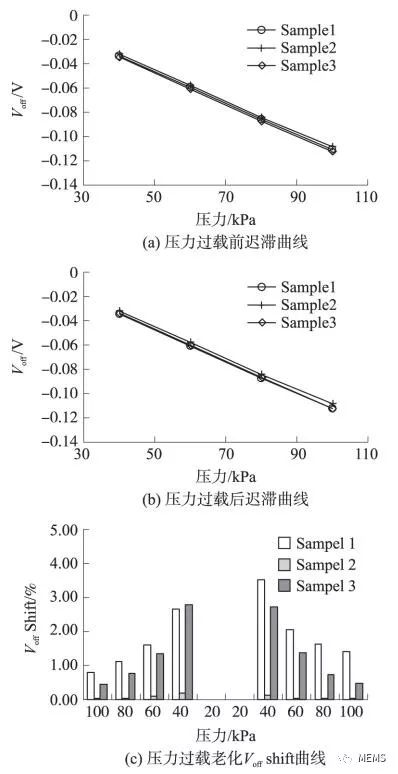
圖9 壓力過載前、后壓力遲滯曲線和壓力過載老化Voff shift曲線
5 結論
對于未釋放應力杯的圓片來說,零位輸出參數在高溫和高溫高濕老化后變化都不太明顯,除非工藝非常不穩定,否則圓片級環境負載測試并不能有效的監控電阻應變條的工藝和質量。
而針對釋放后的封裝MEMS器件,輸出電壓在高溫存儲、溫度沖擊、溫濕循環老化、電壓過載、壓力過載后,均有不同程度的shift。參照工藝SPEC可以有效監控電阻應變條的工藝和質量。
-
傳感器
+關注
關注
2553文章
51407瀏覽量
756631 -
壓力傳感器
+關注
關注
35文章
2243瀏覽量
163589 -
MEMS傳感器
+關注
關注
16文章
425瀏覽量
42564
原文標題:MEMS壓力傳感器工藝可靠性測試評價
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦




 基于硅壓阻式MEMS壓力傳感器的結構和工作原理
基于硅壓阻式MEMS壓力傳感器的結構和工作原理














評論