0引言
以色列Semiconductor Device(SCD)公司是一家處于國際領(lǐng)先地位的高端紅外探測(cè)器供應(yīng)商。SCD在過去的30 年里積累了很多研發(fā)和制造上的經(jīng)驗(yàn),其產(chǎn)品被世界上許多頂級(jí)的公司所選擇。SCD 生產(chǎn)研發(fā)能力包括了半導(dǎo)體器件工藝、液相外延(LPE)和分子束外延(MBE)薄膜生長(zhǎng),超大規(guī)模集成電路設(shè)計(jì)、杜瓦和真空技術(shù)、裝配、輻照建模及測(cè)試。SCD的紅外探測(cè)器產(chǎn)品包括制冷型和非制冷型兩大類。制冷型又包括了碲鎘汞(MCT)、InSb、InAsSb、InAs/GaSb二類超晶格4個(gè)材料體系,其中MCT和InAs/GaSb 二類超晶格用于長(zhǎng)波探測(cè)器,而InSb和InAsSbHOT用于中波探測(cè)器。非制冷型只有VOx微型測(cè)熱輻射計(jì)一類,主要用于長(zhǎng)波探測(cè)器。SCD產(chǎn)品分類如圖1所示。目前為止SCD的熱像儀(包括制冷型與非制冷型)年產(chǎn)量能夠達(dá)到5800套。
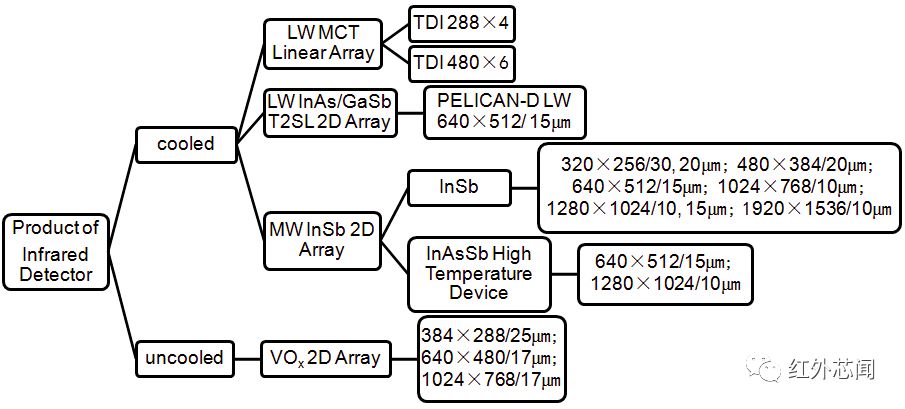
圖1 SCD產(chǎn)品分類
SCD的優(yōu)勢(shì)及主流產(chǎn)品主要是III-V族紅外探測(cè)器。20世紀(jì)90年代開始,SCD的研發(fā)重心就放在InSb上,早期主要研究離子注入型平面結(jié)工藝,工藝成熟后開始發(fā)展大面陣、小像元焦平面,目的在于減小整機(jī)的尺寸,功耗,重量與成本。2004年開始啟動(dòng)第三代紅外探測(cè)器的研發(fā)。第三代紅外探測(cè)器的研發(fā)重點(diǎn)在于III-V族材料的MBE外延技術(shù)。研發(fā)前期主要關(guān)注InSb的外延成結(jié)工藝(p型InSb外延到n型InSb襯底)。后來,于2008年提出XBn和XBp勢(shì)壘型器件(其中X是加偏置的電極層,B是勢(shì)壘層,n或是p是吸收層)以抑制器件的暗電流,從而提高器件的工作溫度或靈敏度。提出XBn和XBp勢(shì)壘型器件結(jié)構(gòu)之后,SCD將其應(yīng)用于InAsSb薄膜和InAs/GaSb二類超晶格材料,用以制備中波高溫器件和高性能長(zhǎng)波器件。研發(fā)重心從此轉(zhuǎn)向?qū)nAsSb中波高溫器件(nBn結(jié)構(gòu))和高性能InAs/GaSb二類超晶格長(zhǎng)波器件(pBp結(jié)構(gòu))的研制上。SCD在兩種器件的研發(fā)過程中思路清晰(器件結(jié)構(gòu)設(shè)計(jì),單元器件測(cè)試,焦平面驗(yàn)證,推出產(chǎn)品),值得紅外探測(cè)器研發(fā)人員借鑒。
本文主要介紹SCD關(guān)于InAsSb nBn中波高溫器件和InAs/GaSb二類超晶格pBp長(zhǎng)波器件的研發(fā)歷程。文中將先介紹XBn和XBp型器件的工作原理,然后總結(jié)SCD對(duì)InAsSbnBn中波高溫器件和InAs/GaSb二類超晶格長(zhǎng)波pBp器件的研究。
1 XBn及XBp型器件工作原理
紅外探測(cè)器的工作溫度,主要是由器件的暗電流決定,而暗電流隨溫度指數(shù)增加的。對(duì)于材料質(zhì)量高的碲鎘汞,其暗電流主要由擴(kuò)散電流主導(dǎo),因此它的暗電流比較接近理論的擴(kuò)散極限。擴(kuò)散電流是在窄禁帶吸收層材料中通過熱激發(fā)產(chǎn)生電子-空穴對(duì),然后擴(kuò)散到內(nèi)建電場(chǎng)區(qū)(耗盡層),被電場(chǎng)加速到電極層從而被收集產(chǎn)生的,這種暗電流隨溫度的變化滿足Arrhenius公式:
Idiff=Trexp(-Ediff/kBT)
式中:Idiff是擴(kuò)散電流;Ediff是擴(kuò)散激活能,約為吸收層材料零溫下的帶隙;kB是玻爾茲曼常數(shù);r~3。而對(duì)于III-V族材料,InSb、InAsSb 或者二類超晶格來說,它的暗電流主要是由器件耗盡區(qū)中所謂的產(chǎn)生復(fù)合(G-R)中心(也叫Shockley-Read-Hall陷阱)引起。當(dāng)在器件上外加反向偏壓時(shí),耗盡區(qū)內(nèi)的G-R中心將被激活,提供接近帶隙中心位置的能級(jí),使得將電子激發(fā)出價(jià)帶(產(chǎn)生空穴)或者激發(fā)進(jìn)入導(dǎo)帶(產(chǎn)生電子)的熱激活能降低一半。耗盡區(qū)內(nèi)產(chǎn)生的電子空穴對(duì)將立即被其中的電場(chǎng)分開,從而被收集,形成暗電流,我們將這種暗電流簡(jiǎn)稱為G-R電流(實(shí)際上,這里描述的SRH復(fù)合電流,而產(chǎn)生復(fù)合電流包括了SRH復(fù)合電流,輻射復(fù)合電流,俄歇復(fù)合電流等等,但SCD報(bào)道中都以G-R電流來簡(jiǎn)稱,所以文中我們也采用G-R電流作為簡(jiǎn)稱)。IG-R電流同樣滿足 Arrhenius 公式:IG-R=Trexp(-EGR/kBT),只不過其激活能 EGR僅為吸收層帶隙的一半,r~1.5。
一般情況下,工作在液氮溫度下的中波器件,擴(kuò)散電流要比G-R電流小幾個(gè)量級(jí),而室溫下,擴(kuò)散電流卻要大幾個(gè)量級(jí)。將G-R電流和擴(kuò)散電流相等時(shí)的溫度定義為溫度T0。對(duì)于中波紅外探測(cè)器來說,T0大約在130~150 K。在暗電流隨溫度的變化圖中(圖2),在溫度大于T0時(shí),logI與溫度倒數(shù)呈線性關(guān)系,其斜率乘以玻爾茲曼常數(shù)就是擴(kuò)散激活能(約等于材料在低溫下的帶隙),而溫度小于T0時(shí),logI與溫度倒數(shù)也呈線性關(guān)系,其斜率是高溫下斜率的一半,乘以玻爾茲曼常數(shù)以后就是 G-R 電流激活能(約為材料低溫帶隙的一半)。一般器件的工作溫度都在T0以下,因此想要提高工作溫度或者降低暗電流就必須抑制G-R電流,使得器件工作在擴(kuò)散限。
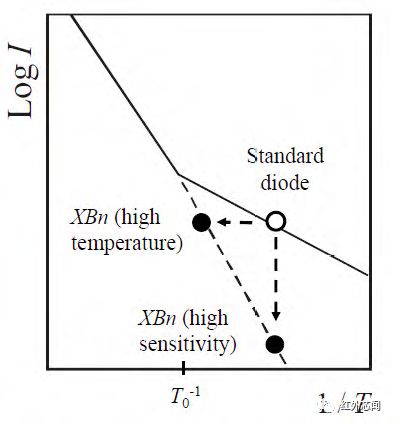
圖2 普通二極管器件(實(shí)線)與XBn器件(虛線)的暗電流與溫度的關(guān)系
為了抑制G-R電流,有兩種方法可行,一種是提高吸收層材料的晶體質(zhì)量,減少SRH復(fù)合中心;另外一種是制作勢(shì)壘型探測(cè)器,將器件的耗盡區(qū)排除在吸收層外,進(jìn)入勢(shì)壘層中,從而抑制G-R電流。SCD選擇了后者,于2008年提出了XBn和XBp型勢(shì)壘型器件,思路是通過控制摻雜使得產(chǎn)生G-R電流的耗盡區(qū)排除在窄禁帶的吸收層之外,進(jìn)入寬帶隙的勢(shì)壘層。只要寬帶隙勢(shì)壘材料的帶隙足夠大,勢(shì)壘層耗盡區(qū)內(nèi)產(chǎn)生的G-R電流將小于吸收層的擴(kuò)散電流,使得材料進(jìn)入擴(kuò)散限,從而達(dá)到抑制G-R電流的作用。具體有兩種方法可以使得耗盡區(qū)進(jìn)入勢(shì)壘材料,一種是勢(shì)壘層與吸收層同型摻雜,如圖3所示;另一種是勢(shì)壘層與吸收層反型摻雜,但吸收層需要高濃度摻雜。一般采用前一種方法,因?yàn)槲諏訐诫s過高會(huì)使得吸收層截止波長(zhǎng)藍(lán)移,并且少子壽命變短。G-R電流得到抑制以后,可以在相同暗電流的情況下,提高探測(cè)器的工作溫度;或者在相同工作溫度下,提高探測(cè)器靈敏度,如圖2。SCD提出XBn和XBp型器件結(jié)構(gòu)后,將其應(yīng)用于InAsSb薄膜和InAs/GaSb超晶格材料體系中,以研制InAsSb nBn中波高溫器件和InAs/GaSb超晶格pBp長(zhǎng)波器件。
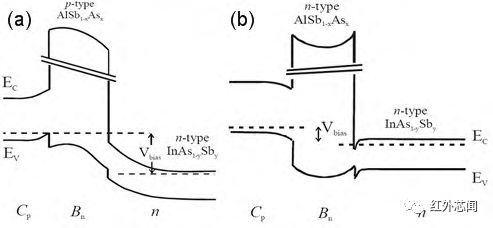
圖3 XBn 器件抑制G-R電流的原理:(a)勢(shì)壘層與吸收層反型摻雜,G-R 電流沒有得到抑制;(b)勢(shì)壘層與吸收層同型摻雜,G-R 電流被抑制
2 InAsSb nBn中波高溫器件
SCD提出XBn和XBp器件結(jié)構(gòu)后,最早將其應(yīng)用于InAsSb中波高溫器件,器件結(jié)構(gòu)為nBn型勢(shì)壘結(jié)構(gòu)。2010-2012年分別報(bào)道了InAsSb nBn中波高溫探測(cè)器的單元器件性能和焦平面性能。并于2013-2014年推出了兩款I(lǐng)nAsSb nBn中波高溫探測(cè)器產(chǎn)品。
2.1單元器件研究
2010 年,SCD 生長(zhǎng)了 3 個(gè) nBn 結(jié)構(gòu),命名為 A1、A2、B1,用于單元器件暗電流和光響應(yīng)譜測(cè)試。A1、A2 勢(shì)壘層為 n 型摻雜,B1 勢(shì)壘層為 p 型摻雜。A1、A2、B1 器件的吸收層的摻雜分別為,A1:4×1016 cm-3,A2:4×1015 cm-3,B1:1.5×1017 cm-3。
1)暗電流
對(duì)于暗電流,SCD 的研究主要關(guān)注兩個(gè)方面:第一,暗電流與溫度的關(guān)系,以得到暗電流的主導(dǎo)機(jī)制,從而確認(rèn) G-R 電流是否得到抑制;第二,暗電流與尺寸的關(guān)系,以區(qū)分體電流和邊界電流對(duì)暗電流的貢獻(xiàn)。
SCD 研究人員制作了100~300 μm尺寸的單元器件用于暗電流測(cè)試。圖 4 是 A1 樣品制作的器件(尺寸200μm × 200 μm)在-0.2 V和-1 V偏壓下,暗電流與溫度的關(guān)系[4]。從圖中得出:低偏壓下,直到 125 K 都是線性,激活能與吸收層的帶隙接近,可以認(rèn)為整個(gè)溫度區(qū)域都是擴(kuò)散電流限制,證實(shí) G-R 電流得到很好的抑制。而高偏壓下,當(dāng)溫度低于 T0~200 K時(shí),電流溫度依賴關(guān)系開始偏離擴(kuò)散電流,表明 G-R 電流開始起作用。對(duì)于 nBn 器件,當(dāng)外加偏壓增加到某一個(gè)臨界值時(shí),吸收層的價(jià)帶將完全變成平帶,空穴積累層將消失,進(jìn)一步增加外加電壓,吸收層將開始耗盡,使得 G-R 電流的抑制作用消失。A2、B1樣品的結(jié)果與 A1 結(jié)果相似。3 個(gè)樣品在低偏壓下的暗電流都是擴(kuò)散限,說明 nBn 結(jié)構(gòu)對(duì) G-R 的抑制在吸收層摻雜濃度跨度為兩個(gè)量級(jí)范圍內(nèi)都有效。B1、A1、 A2 在 150 K 下的電流密度分別為 6.0×10-8 A/cm2、1.3×10-7 A/cm2、3.2×10-7A/cm2。
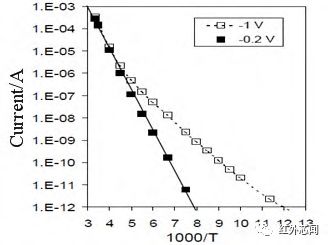
圖4 A1 樣品器件的(200 μm × 200 μm)暗電流與溫度關(guān)系
為了研究體電流與邊界電流分別對(duì)暗電流的貢獻(xiàn),SCD 研究人員測(cè)量了不同尺寸單元器件的暗電流。圖 5是 A1(偏壓為-0.2 V)和 A2(偏壓-0.1 V)兩個(gè)樣品制作的單元器件在 150 K 下,電流與臺(tái)面尺寸的比值(I/L)與臺(tái)面尺寸(L)的關(guān)系。B1的結(jié)果與 A1 的結(jié)果類似。一般情況下,暗電流隨著尺寸的變化滿足 I=L+L2,L 和L2兩項(xiàng)分別對(duì)應(yīng)了邊界和體電流密度。從圖可以得到 A1 樣品的邊界電流貢獻(xiàn)可以忽略;而 A2 樣品的邊界電流卻有相當(dāng)?shù)呢暙I(xiàn)。SCD 研究人員認(rèn)為這樣的結(jié)果可以解釋為少子壽命及遷移率隨著吸收層的摻雜濃度降低而增加,少子的擴(kuò)散長(zhǎng)度也隨之增加,因此,臺(tái)面結(jié)構(gòu)以外區(qū)域的載流子也將通過橫向擴(kuò)散,對(duì)暗電流起到貢獻(xiàn)(SCD并沒有將其歸結(jié)于側(cè)壁漏電流,因?yàn)榕_(tái)面結(jié)構(gòu)的制作僅刻蝕到勢(shì)壘層,可以認(rèn)為不存在側(cè)壁漏電流)。
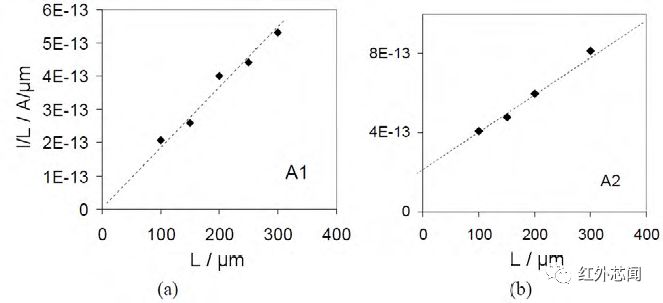
圖 5 暗電流與器件臺(tái)面尺寸的關(guān)系:(a) 樣品 A1 在-0.2 V 偏壓下 (b) 樣品 A2 在-0.1 V 偏壓下
2)光響應(yīng)
除暗電流外,SCD 研究人員還研究了器件的光響應(yīng)。對(duì)光響應(yīng)的研究包括了兩方面工作:第一,測(cè)量光響應(yīng)譜,從而得到探測(cè)器對(duì)不同波長(zhǎng)光的響應(yīng)率,以及探測(cè)器的截至波長(zhǎng);第二,光響應(yīng)隨偏壓的變化,以獲得合適的工作電壓。
圖6 是 150 K 下 3 個(gè)樣品的光響應(yīng)譜,從圖中可以得到,隨著摻雜濃度增加,樣品的截止波長(zhǎng)隨著摻雜濃度增加而減短。B1、A1、A2 的截止波長(zhǎng)分別3.65 μm、3.82 μm、3.96μm。為了使探測(cè)器盡可能覆蓋中波窗口,應(yīng)盡量選擇低的摻雜濃度。利用吸收系數(shù)的公式,通過標(biāo)準(zhǔn)的轉(zhuǎn)移矩陣技術(shù),SCD研究人員模擬了樣品 B1 的光響應(yīng)譜。由模擬結(jié)果得到,nBn器件的內(nèi)量子效率很高,基本接近 100%。
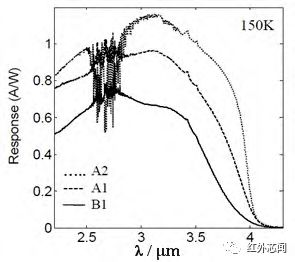
圖6 150 K 和-0.6 V 偏壓下,A1、A2 及 B1 樣品(200 μm × 200 μm尺寸器件)的光響應(yīng)譜
為了確定器件的工作電壓,SCD 研究人員測(cè)量了 3 個(gè)樣品在 150 K 下光響應(yīng)與偏壓的關(guān)系,如圖 7。由圖 7 可以得到,從-0.1 V 到-0.6 V,光響應(yīng)的偏差不到 5%。因此,-0.1 V 可以作為器件的工作電壓。
由于 A2 樣品(吸收層低摻雜)內(nèi)量子效率高,擴(kuò)散長(zhǎng)度大,SCD 研究人員認(rèn)為利用低吸收摻雜濃度的樣品制作的 nBn 探測(cè)器,將在 3~4 μm波段范圍得到大于 70%的外量子效率。探測(cè)器在 150 K 和 f/3 光圈條件下的光電流將達(dá)到~4×10-6A/cm2,比其暗電流(~3×10-7 A/cm2)大接近一個(gè)量級(jí)。即使工作溫度提高到160 K,樣品A2 的暗電流升高到~9×10-7 A/cm2,依舊只有光電流的 1/4,說明直到 160 K,探測(cè)器都將工作在背景限條件。
2.2焦平面研究
為了研究焦平面性質(zhì),SCD 制作了兩種規(guī)格的焦平面:Blue Fairy(BF)和Pelican。Blue Fairy 焦平面陣列規(guī)模 320×256,像元中心距 30 μm;Pelican 焦平面陣列規(guī)模 640×512,像元中心距 15 μm。
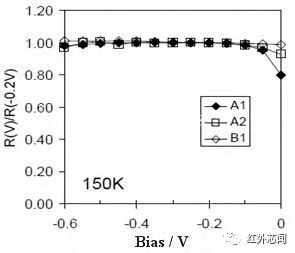
圖7 A1、A2 及 B1 樣品在 150 K 下光響應(yīng)與偏壓的關(guān)系
1)量子效率
2011 年,SCD 報(bào)道了 BF 焦平面量子效率譜的測(cè)量與計(jì)算的結(jié)果,如圖 8中單程曲線(實(shí)線為測(cè)量結(jié)果,虛線為計(jì)算結(jié)果)。單程曲線是器件的單程量子效率結(jié)果,頂電極反射率只有 20%。為了改進(jìn)器件工藝,SCD 優(yōu)化了抗反膜的厚度,并將單程設(shè)計(jì)改為雙程(通過將頂電極的反射率提高到 95%實(shí)現(xiàn))。圖中的雙程曲線展示了器件工藝優(yōu)化后的效果(計(jì)算結(jié)果)。即使在吸收層厚度只有 2.6 μm 的情況下,3~4 μm波段之間的量子效率依然可以超過 60%。
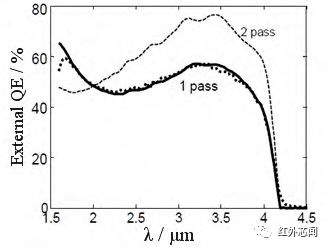
圖8 BF 焦平面量子效率譜的測(cè)量(實(shí)線)與計(jì)算(虛線)結(jié)果
2)暗電流統(tǒng)計(jì)分布
2012 年,SCD 測(cè)量了 Pelican 焦平面在150 K 下的暗電流,其統(tǒng)計(jì)分布如圖 9所示。暗電流平均值為200 fA,F(xiàn)WHM 為均值的 15%。一般在平均量子效率70%的情況下,器件光電流約為 12 pA,是暗電流的60 倍。在 150 K 下,焦平面達(dá)到了很好的背景限。這種情況下,背景限工作溫度可進(jìn)一步提升到175 K。
3)NETD 和有效像元率
同年,SCD 報(bào)道了Pelican-D 焦平面(數(shù)字化讀出電路)的NETD 和有效像元率與溫度的關(guān)系,如圖10 所示。結(jié)果顯示當(dāng)溫度高于170 K,NETD 與有效像元率才開始改變,同樣證實(shí)器件的背景限工作溫度可以達(dá)到175 K。

圖9 Pelican 焦平面在 150 K 下的暗電流統(tǒng)計(jì)分布

圖 10 Pelican-D 焦平面的 NETD、有效像元率與溫度的關(guān)系(在 50℃黑體面前放置 F/3.2 光闌情況下測(cè)量)
2.3兩款焦平面探測(cè)器產(chǎn)品——Kinglet和Hercules
1)Kinglet
Kinglet 是SCD 第一款nBn 中波高溫產(chǎn)品,于2013年推出,焦平面陣列規(guī)模為 640×512,像元中心距 15 μm,讀出電路為 SCD 自己的“Hot Pelican-D”,制冷機(jī)為 Ricor’s K562S 循環(huán)斯特林制冷機(jī)。Kinglet探測(cè)器組件如圖 11 所示,具體性能指標(biāo)列于表 1。
2)HOT Hercules
HOT Hercules 是SCD 第二款nBn 中波高溫產(chǎn)品,2014年推出,焦平面陣列規(guī)模 1280×1024,像元中心距 15 μm,讀出電路為 SCD 自己的數(shù)字化讀出電路“Hercules”,制冷機(jī)為 Ricor’s K508N 循環(huán)斯特林制冷機(jī)。Hercules 探測(cè)器具體性能指標(biāo)列于表2,組件如圖12 所示。
圖11 Kinglet 探測(cè)器組件
表1 Kinglet 探測(cè)器的典型性能指標(biāo)
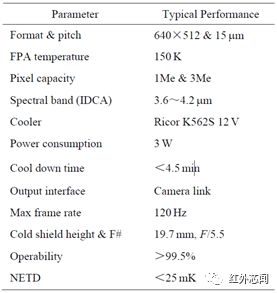
表2 Hercules 探測(cè)器的典型性能指標(biāo)

圖12 Hercules 探測(cè)器組件
3InAs/GaSb二類超晶格pBp長(zhǎng)波器件
SCD 的InAs/GaSb 二類超晶格長(zhǎng)波器件同樣采用 XBn 和 XBp 器件結(jié)構(gòu),與 InAsSb 中波高溫器件不同的是,超晶格采用 pBp 器件結(jié)構(gòu),其能帶排列示意圖如圖 13所示。pBp 器件結(jié)構(gòu)吸收層和電極層是 13 ML InAs/7 ML GaSb 超晶格,勢(shì)壘層是 15 ML InAs/4 ML AlSb 超晶格。
SCD 在 2014 年報(bào)道了在 InAs/GaSb 二類超晶格長(zhǎng)波焦平面探測(cè)器的研究進(jìn)展。SCD 關(guān)于 InAs/GaSb 二類超晶格長(zhǎng)波焦平面探測(cè)器的研究包括3 方面:計(jì)算模擬軟件的開發(fā)與應(yīng)用;單元器件性質(zhì)研究;Pelican-D LW 焦平面產(chǎn)品。
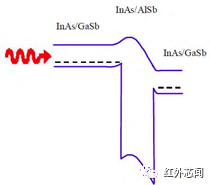
圖13 pBp 器件的能帶排列示意圖
3.1計(jì)算模擬軟件的開發(fā)與應(yīng)用
2010 年開始,SCD 發(fā)展了一個(gè)模擬程序包,可以用來計(jì)算超晶格的能帶和 pBp 器件的響應(yīng)光譜。具體流程如下:通過軟件計(jì)算超晶格能帶結(jié)構(gòu)以及態(tài)密度,從而得到 XBp 器件的能帶排列和吸收層的吸收光譜,進(jìn)一步通過光學(xué)轉(zhuǎn)移矩陣技術(shù)計(jì)算出 XBp 器件的響應(yīng)光譜,如圖 14 所示。

圖 14 超晶格器件的模擬計(jì)算流程
他們能帶結(jié)構(gòu)的計(jì)算是用于晶格匹配材料的基于kp 模型的改進(jìn)版本,改進(jìn)模型中需要輸入的參數(shù)比早期的模型要少。這個(gè)模型是由 SCD 的 P. C. Kipstein 發(fā)展的,模型比較新穎的地方包括:
1)對(duì)于無公共原子的超晶格,比如 InAs/GaSb、InAs/AlSb,其界面矩陣式對(duì)角化的,包括了 3 個(gè)主要的參數(shù):DS、DX、DZ。
2)而對(duì)于有公共原子的超晶格,比如 GaSb/AlSb、InAs/InAsSb,界面矩陣是非對(duì)角化的,包括了兩個(gè)主要的參數(shù):α和β。
3)減少了獨(dú)立 Luttinger 參數(shù)的數(shù)量。對(duì)于超晶格的 6 個(gè) Luttinger(每種材料 3 個(gè))參數(shù)中的 4 個(gè)可以由另外 2 個(gè)來表示。由這個(gè)結(jié)果可以得到,基于 InAs/GaSb 和 InAs/AlSb 的 XBpp 器件,只需要 2 個(gè) Luttinger 參數(shù)(InAs 的γ1和γ2),而不是 9 個(gè)。
進(jìn)一步計(jì)算光譜響應(yīng)過程中需要輸入的參數(shù)有每個(gè)超晶格層帶隙、周期厚度、折射率、少子擴(kuò)散長(zhǎng)度、表面復(fù)合速率,以及抗反膜的光學(xué)厚度。
圖15 是模型計(jì)算得到的超晶格材料帶隙與 10 K 溫度下測(cè)量得到的熒光峰位的比較。對(duì)于帶隙能量100 meV 到 300 meV 之間的超晶格,測(cè)量和計(jì)算得到的能量偏差在 77 K 下的kBT之內(nèi)。

圖 15 超晶格計(jì)算帶隙和 10 K 熒光峰位的比較
圖16 是 MWIR 和 LWIR 超晶格材料的吸收光譜的測(cè)量和模擬結(jié)果。模擬結(jié)果與測(cè)量結(jié)果中的主要特征都可以對(duì)上,包括在 3 μm 以下由布里淵區(qū)邊界HH2→E1躍遷產(chǎn)生的強(qiáng)烈的吸收峰。模擬結(jié)果表明,如果不考慮界面矩陣元,計(jì)算的帶隙將會(huì)藍(lán)移,中波超晶格材料將藍(lán)移 0.75μm,長(zhǎng)波將藍(lán)移 4.5 μm。證明界面對(duì)于超晶格的能帶結(jié)構(gòu)的貢獻(xiàn)不可忽略。

圖16 MWIR(a)和 LWIR(b)超晶格材料的吸收光譜的實(shí)驗(yàn)值(灰線)與計(jì)算值(黑線)
3.2單元器件性質(zhì)研究
隨后,SCD 報(bào)道了對(duì) InAs/GaSb 二類超晶格 pBp單元器件暗電流的研究[11]。暗電流研究中,首先對(duì)比pBp 器件和 n+-on-p 二極管器件的暗電流,二者具有相同的 p 型超晶格吸收層,厚度都為 1.5 μm,截至波長(zhǎng)都是 10 μm。兩種器件(100 μm×100 μm臺(tái)面)在工作偏壓下的暗電流密度的溫度依賴關(guān)系如圖17所示。圖中垂直虛線是器件的理想工作溫度 77 K,在 77 K 下,二極管的暗電流比 pBp 器件的高一個(gè)量級(jí),證實(shí)了在 pBp 器件中 G-R 電流得到了抑制。 pBp 器件的暗電流直到 71 K 都是由擴(kuò)散電流主導(dǎo)的,而二極管器件在溫度低于120 K 時(shí),由G-R 電流主導(dǎo)。

圖17 InAs/GaSb 100 μm×100 μm臺(tái)面器件的暗電流隨溫度的變化關(guān)系:(a) pBp 器件@0.6 V;(b)n+-on-p 二極管@ 0.1 V
pBp 器件的暗電流包括了兩部分,一部分是垂直擴(kuò)散電流部分,由光生非平衡少子沿著生長(zhǎng)方向輸運(yùn)到電極層被收集;另一部分是平行于勢(shì)壘層的橫向擴(kuò)散部分,進(jìn)入到臺(tái)面的邊界。這兩部分對(duì)應(yīng)了體電流和邊界電流的貢獻(xiàn),具體由 IDark=JBL2+4JPL給出,JBJP分別是體電流和邊界電流密度,L 是臺(tái)面尺寸。在理想的 FPA 中,所有的像元都外加同樣的偏壓,所以邊界電流部分可以忽略,因此體電流才是超晶格材料和器件質(zhì)量的重要參數(shù)。通過測(cè)量 8 個(gè)不同臺(tái)面尺寸pBp 器件的暗電流,得到了器件暗電流與臺(tái)面尺寸的關(guān)系,如圖 18所示。結(jié)果顯示體電流與邊界電流都對(duì)暗電流有貢獻(xiàn),利用公式 IDark/L=JBL+4JP對(duì)結(jié)果進(jìn)行擬合,可以得到體電流密度為 6.0×10-6A cm-2。通過這種方法 SCD 研究人員測(cè)量了超過 10 個(gè)pBp 器件在 77 K 下的體電流密度,并且與 MCT 的 Rule 07 暗電流對(duì)比。結(jié)果表明 InAs/GaSb 超晶格 pBp器件的暗電流密度比MCT 的Rule07 暗電流大不到一量級(jí),如圖 19所示。
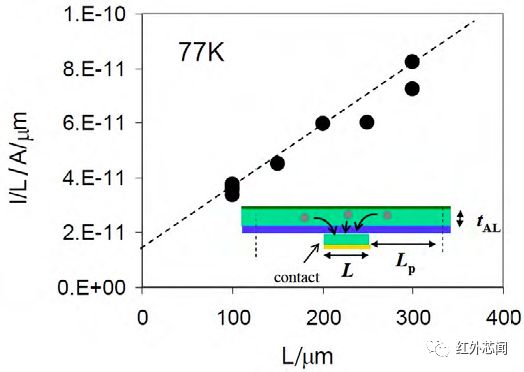
圖 18 不同臺(tái)面尺寸下,InAs/GaSb pBp 測(cè)試器件的暗電流
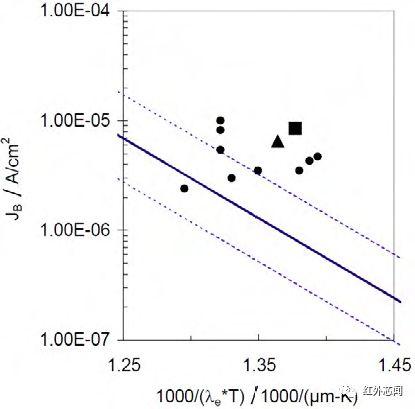
圖19 pBp 單元器件暗電流與溫度的關(guān)系,實(shí)線代表碲鎘汞Rule07
SCD 研究人員接著研究了InAs/GaSb 二類超晶格 pBp 器件的量子效率。圖 20(a)是臺(tái)面尺寸為 100 μm × 100 μm的器件(吸收層厚度為 3 μm)在不同偏壓下的量子效率。從圖中可以得到器件的工作電壓需要大于 0.6 V,在工作電壓下,器件的量子效率接近40%。圖 20(b)是量子效率實(shí)驗(yàn)值(點(diǎn))與臺(tái)面尺寸的關(guān)系,同時(shí)給出了公式 QE=QE∞(L+2Lp)2/L2的擬合結(jié)果(虛線),其中 Lp是橫向擴(kuò)散長(zhǎng)度。通過擬合得
QE∞=36%和 Lp=2.3 μm。
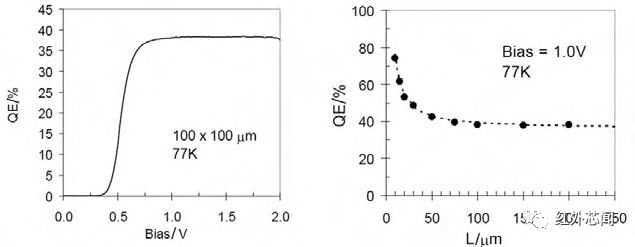
圖20 InAs/GaSb pBp 器件量子效率:(a)InAs/GaSb pBp 器件的量子效率(臺(tái)面尺寸100 μm × 100 μm吸收層厚度 3 μm);(b) 量子效率與臺(tái)面尺寸的關(guān)系
3.3 Pelican-D LW焦平面產(chǎn)品
2015 年,SCD 利用 pBp 結(jié)構(gòu)制研制了長(zhǎng)波焦平面陣列 Pelican-D LW,陣列規(guī)模為 640×512,像元中心距 15 μm,焦平面陣列被互連到 SCD 公司新開發(fā)的讀出電路上。“Pelican-D LW”是 SCD 第一款長(zhǎng)波 XBp 焦平面產(chǎn)品。探測(cè)器工作溫度為 77 K,截止波長(zhǎng)為 9.5 μm。
文獻(xiàn)[14]中同時(shí)報(bào)道了 Pelican-D LW 焦平面的光電性質(zhì)及輻照性質(zhì)。圖21是78 K 下“Pelican-D LW”焦平面的暗電流統(tǒng)計(jì)分布,中值暗電流約為 100 pA,
對(duì)應(yīng)暗電流密度 4.4×10-5 A/cm-2,僅比 MCT Rules 07 的暗電流大不到一個(gè)量級(jí)。暗電流的分布很窄,半高全寬大約為中值的 6%。窄的暗電流分布有利于焦平面陣列在微小溫度或偏壓波動(dòng)下的穩(wěn)定性。

圖21 Pelican-D LW 焦平面在 78 K 下 FPA 暗電流的統(tǒng)計(jì)分布
Pelican-D LW 焦平面在 78 K、240 Hz 的幀頻以及 F/2.7 下的 NETD 為36 mK。通過平均 8 個(gè)幀頻,器件的有效幀頻變?yōu)?30 Hz。這種情況下的 NETD 的統(tǒng)計(jì)分布情況如圖 22所示。從圖中可以得出峰值 NETD 為 13 mK,分布很窄,且不存在明顯的分布尾。
圖23是焦平面陣列的量子效率分布。失效像元數(shù)為 1446,相應(yīng)的有效像元率為 99.56%。圖中整個(gè)焦平面的量子效率值都在48%左右(吸收層厚度為4.5 μm,單程)。如果背景限溫度定義為暗電流與光電流相等時(shí)的工作溫度,可以得到光圈為 F/2.7 時(shí)焦平面的背景限溫度為 90 K。
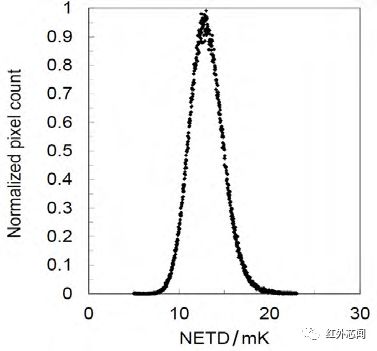
圖22 Pelican-D LW 焦平面 NETD 的統(tǒng)計(jì)分布(@78 K 溫度、30 Hz 的幀頻)
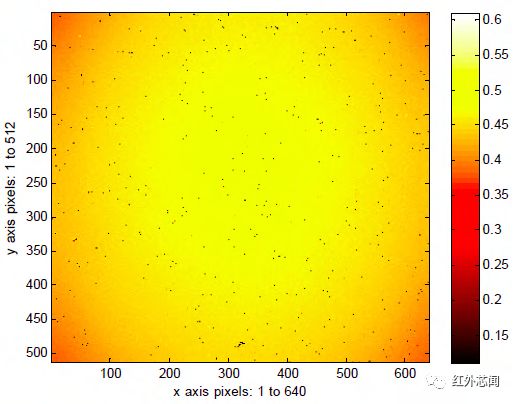
圖23 78 K 下,Pelican-D LW 焦平面陣列的量子效率分布
Pelican-DLW 探測(cè)器組件照片如圖 24 所示,具體性能指標(biāo)列于表 3。圖 25是 Pelican-DLW 焦平面相機(jī)在 77 K 下拍出的照片。
4小結(jié)
本文從材料結(jié)構(gòu)設(shè)計(jì)、單元器件測(cè)試、焦平面驗(yàn)證3 方面總結(jié)了 SCD 在 InAsSb nBn 中波高溫探測(cè)器和InAs/GaSb 二類超晶格pBp 長(zhǎng)波探測(cè)器兩種探測(cè)器的研發(fā)歷程。SCD 公司通過 XBn、XBp 勢(shì)壘型器件結(jié)構(gòu)設(shè)計(jì)抑制器件暗電流,成功研發(fā)出了中波高溫器件和高性能長(zhǎng)波探測(cè)器兩種三代探測(cè)器的重要產(chǎn)品。InAsSb nBn 中波高溫探測(cè)器工作溫度可達(dá) 150℃; InAs/GaSb 二類超晶格 pBp 長(zhǎng)波探測(cè)器 77 K 下的暗電流低至4.4×10-5A/cm-2,僅比 MCT 的 Rule 07 暗電流大不到一量級(jí)。表 4 對(duì)比了 SCD 公司與其他研究機(jī)構(gòu)III-V 族紅外焦平面探測(cè)器的相關(guān)參數(shù),從中可以看出,SCD 公司產(chǎn)品的部分典型性能處于領(lǐng)先地位。
圖24 Pelican-D 探測(cè)器組件
圖25 Pelican-DLW 焦平面在 77 K 下拍出的照片
表3 Pelican-DLW 焦平面探測(cè)器的性能指標(biāo)

表4 SCD 與其他或研究機(jī)構(gòu)紅外焦平面探測(cè)器性能對(duì)比
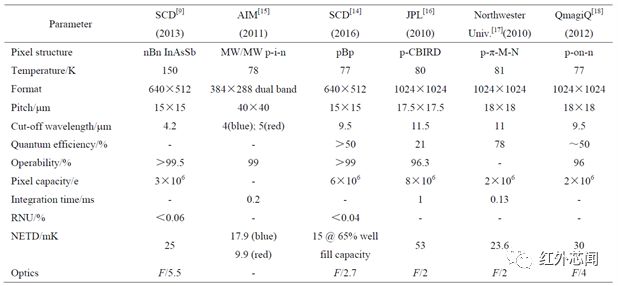
-
紅外探測(cè)器
+關(guān)注
關(guān)注
5文章
290瀏覽量
18157 -
器件
+關(guān)注
關(guān)注
4文章
324瀏覽量
27943 -
SCD
+關(guān)注
關(guān)注
0文章
9瀏覽量
10230
原文標(biāo)題:以色列SCD公司的III-V族紅外探測(cè)器研究進(jìn)展
文章出處:【微信號(hào):MEMSensor,微信公眾號(hào):MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
基于k·p方法的二類超晶格紅外探測(cè)器仿真進(jìn)展
InAs/GaSb II類超晶格長(zhǎng)波焦平面陣列臺(tái)面ICP刻蝕技術(shù)研究
總結(jié)近十年對(duì)中波紅外探測(cè)器的研究熱點(diǎn)
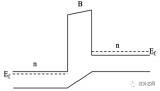
基于InAs/GaSbII類超晶格的長(zhǎng)波紅外探測(cè)器
高性能銻化物超晶格中紅外探測(cè)器研究進(jìn)展
基于銻化物Ⅱ類超晶格InAs/InAsSb的研究進(jìn)展
II類超晶格紅外探測(cè)器原理
綜述:銦砷銻(InAsSb)紅外探測(cè)器的研究進(jìn)展
華北光電技術(shù)研究所研制中/長(zhǎng)波雙色二類超晶格紅外探測(cè)器
InAs/GaSb Ⅱ類超晶格長(zhǎng)波紅外探測(cè)器的表面處理研究
晶格失配對(duì)InAs基室溫中波紅外探測(cè)器性能的影響
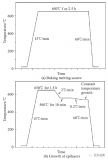
二類超晶格制冷紅外焦平面探測(cè)器

InAs/GaSb Ⅱ類超晶格長(zhǎng)波紅外探測(cè)器研究進(jìn)展
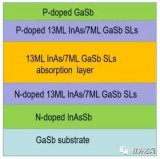
基于Ⅱ類超晶格的中波紅外帶間級(jí)聯(lián)探測(cè)器設(shè)計(jì)實(shí)現(xiàn)





 SCD關(guān)于InAsSb nBn中波高溫器件和InAs/GaSb二類超晶格pBp長(zhǎng)波器件的研發(fā)歷程
SCD關(guān)于InAsSb nBn中波高溫器件和InAs/GaSb二類超晶格pBp長(zhǎng)波器件的研發(fā)歷程











評(píng)論