多層堆疊封裝又稱為:POP,是一個(gè)封裝在另一個(gè)封裝上的堆疊。從3D解析圖中我們可以看到,很多的POP工藝都是2層以上,復(fù)雜程度相當(dāng)之高。那么在smt貼片加工中POP的質(zhì)量就變得非常重要。因?yàn)镻OP返修真的相當(dāng)困難。在貼片中返修已經(jīng)是一個(gè)大難題了,POP的返修更是災(zāi)難。首先第一步如何將需要返修的元件移除并成功重新貼片加工,而不影響其他堆疊元件和周圍元件及PCB是值得研究的重要課題。今天靖邦電子小編就跟大家一起來分析一下相關(guān)的返修流程。
POP返修步驟與BGA返修步驟基本相同。
1、拆除芯片。拆除芯片的正確方法是一次性將POP整體從PCB印制板上取下來。目前市場上針對(duì)POP返修已經(jīng)開發(fā)了一些采用特殊材料制成的卡子,在200℃時(shí)會(huì)自動(dòng)彎曲大約2m,能夠整體夾住POP,一次性將POP整體從PCB上取下來。
2、清理PCB焊盤。
3、浸蘸狀助焊劑或焊。浸蘸要求與貼裝POP的方法相同。
4、放置器件。用返修臺(tái)的真空吸嘴拾取器件,將底部器件貼放在PCB相應(yīng)的位置,然后遂層取、放置上層器件。Smt加工時(shí)注意壓力(z軸高度)的控制
5、再流焊。再流焊時(shí)需要進(jìn)行細(xì)致地優(yōu)化設(shè)計(jì)溫度變化曲線。由于返修臺(tái)再流焊是開在空氣中進(jìn)行的,
散熱快,因此更要注意底部熱和提高加熱效率。流行元件的再流焊要注意全預(yù)熱,pcb 和芯片必須保持平整和不變形,盡可能縮短液相時(shí)間。頂部溫度達(dá)到265℃會(huì)造成芯片封裝變形。
fqj
 電子發(fā)燒友App
電子發(fā)燒友App










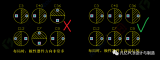



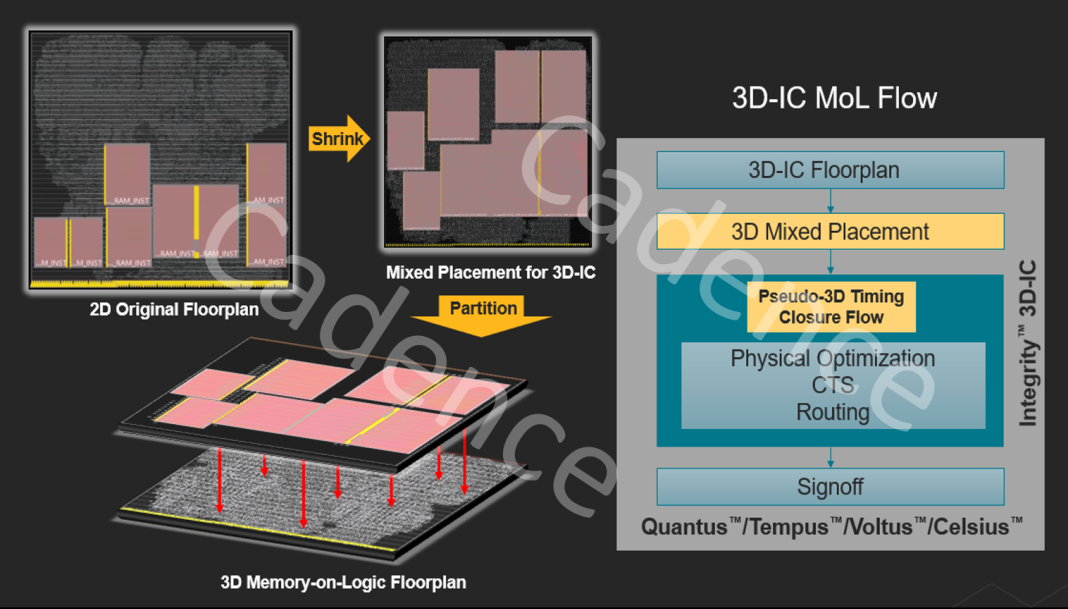



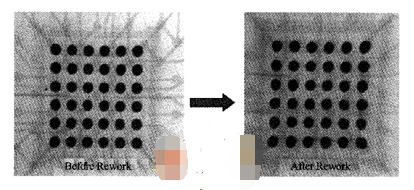


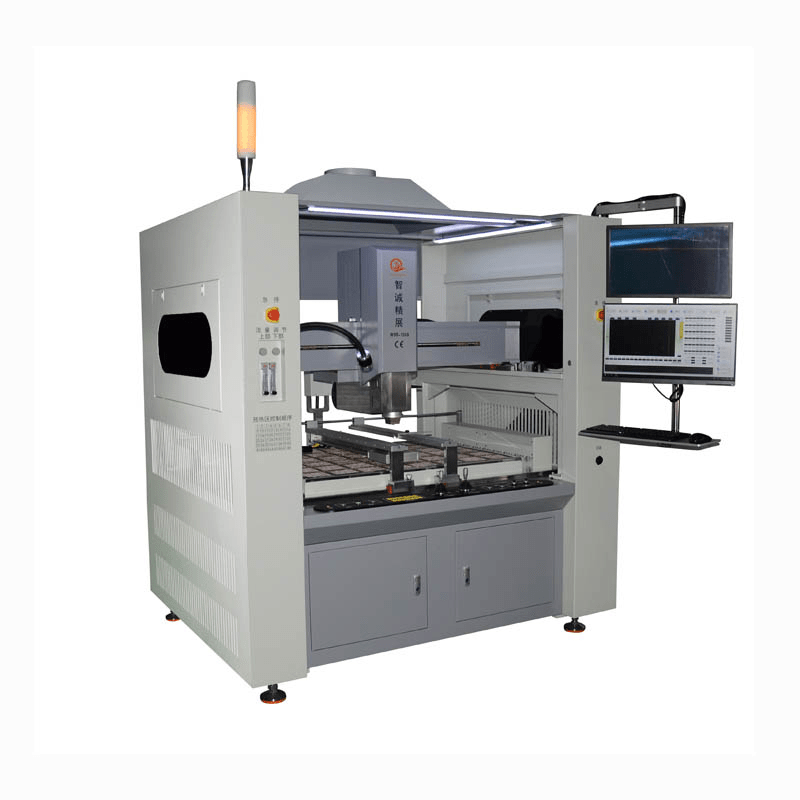



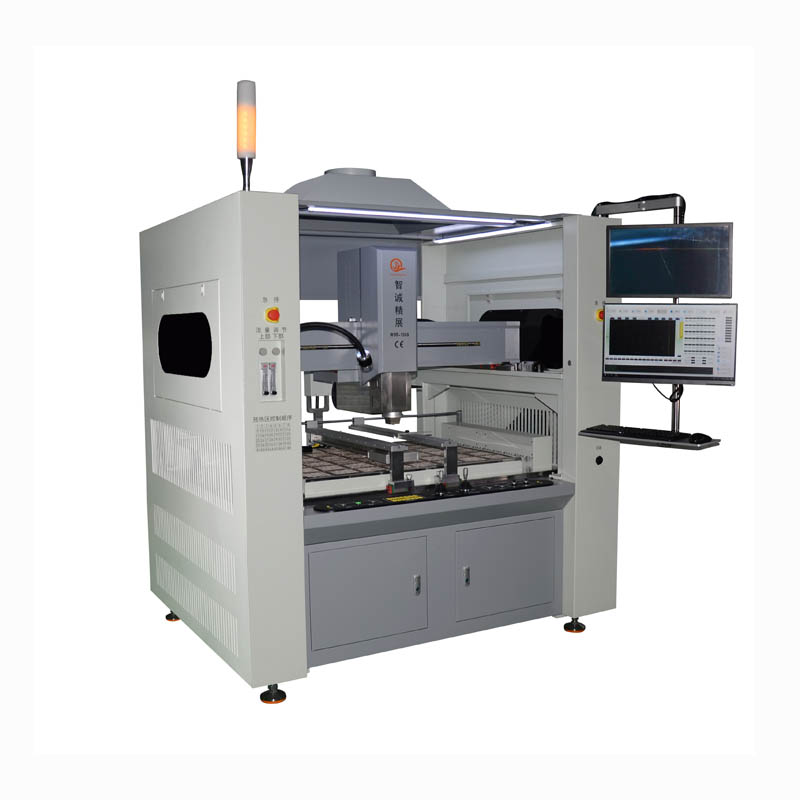
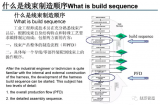


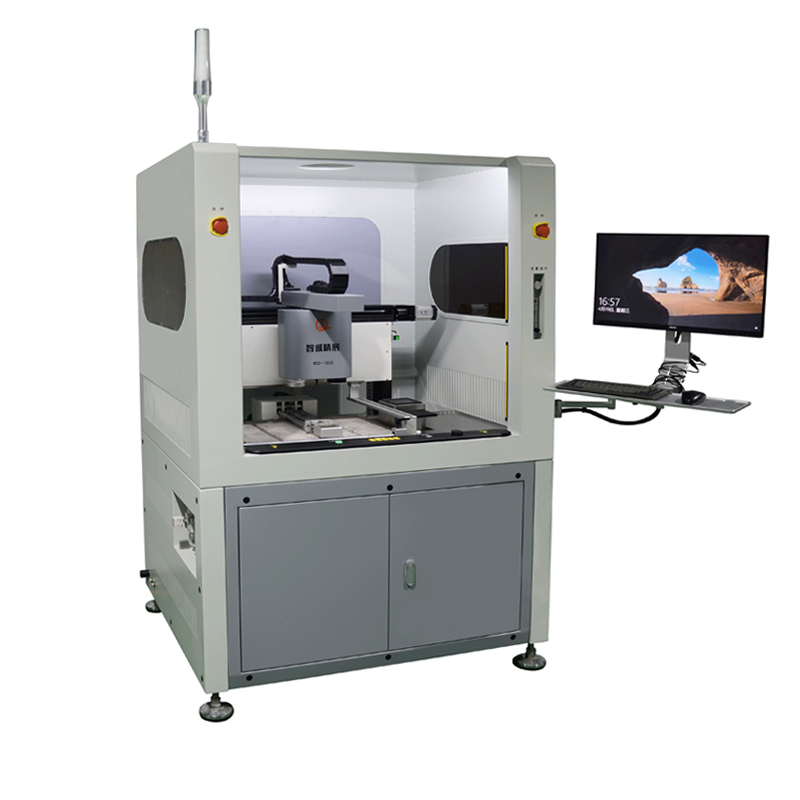


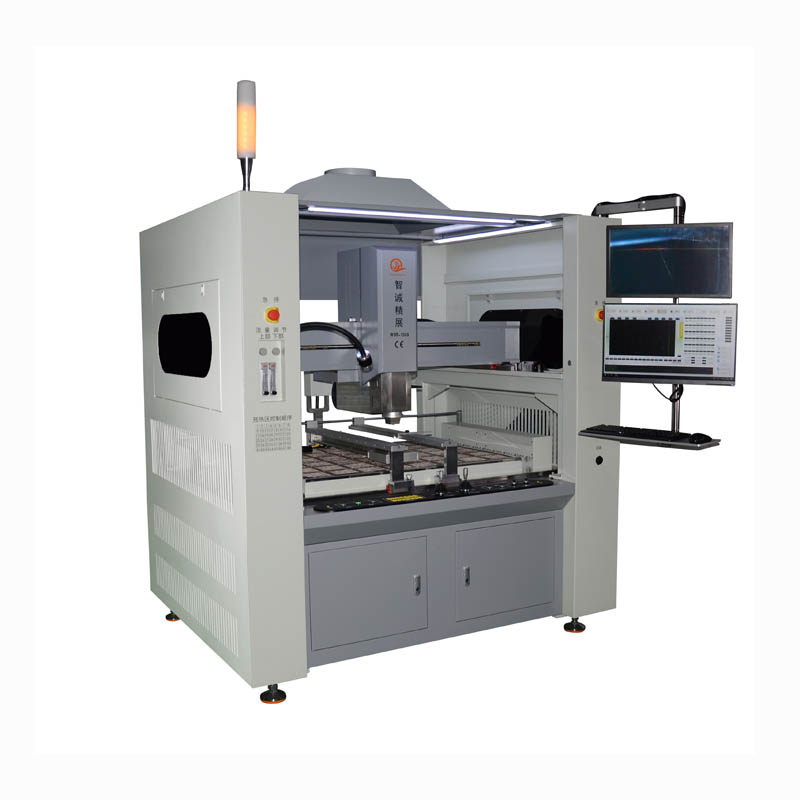
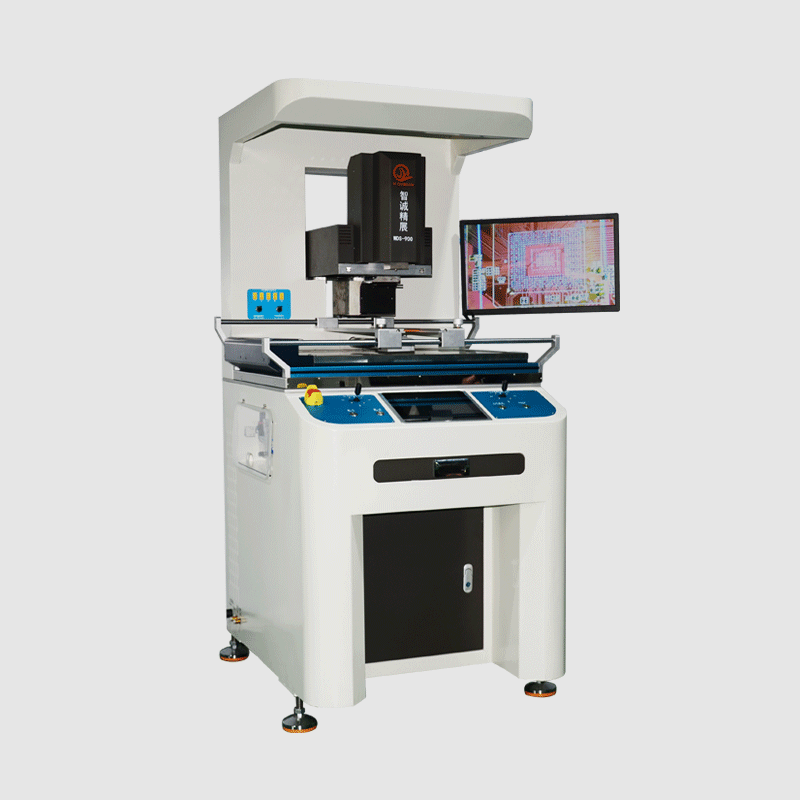

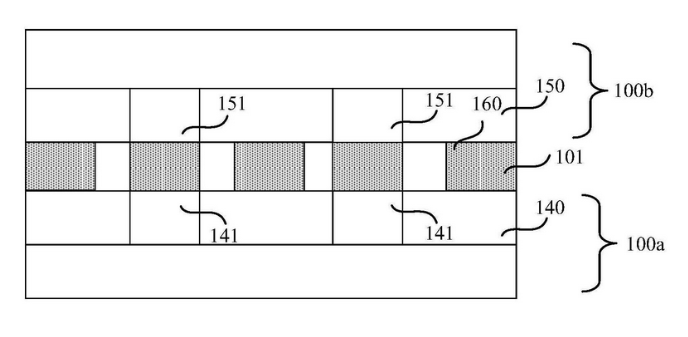


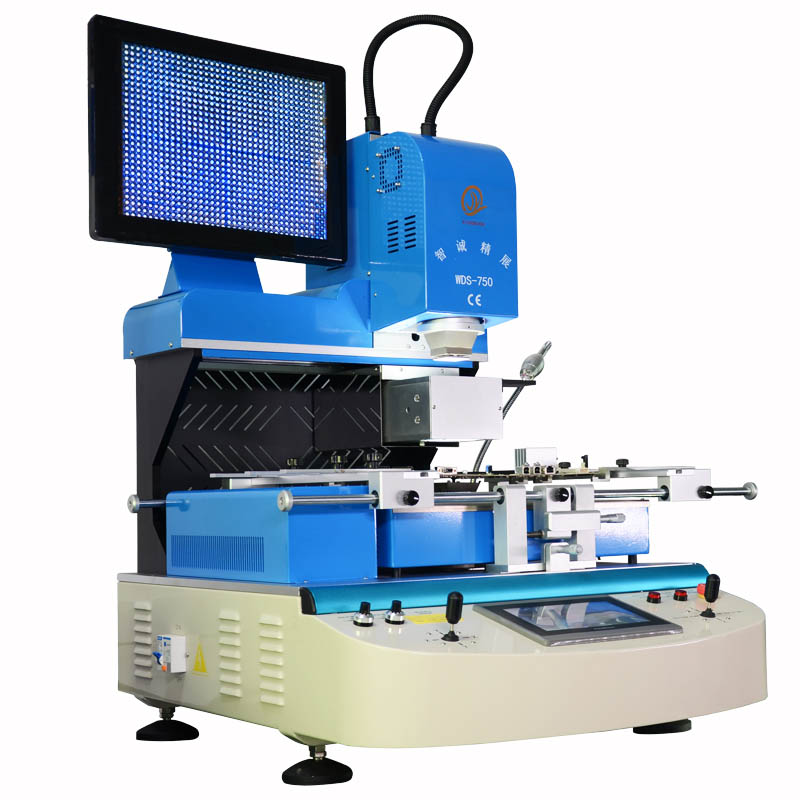



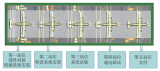



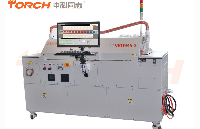






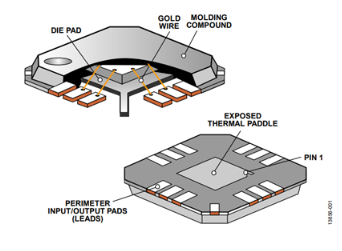
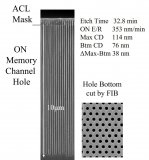
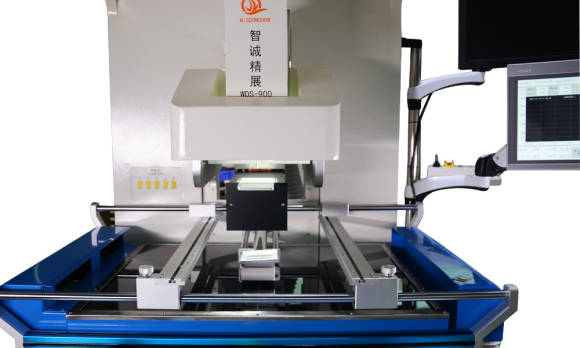
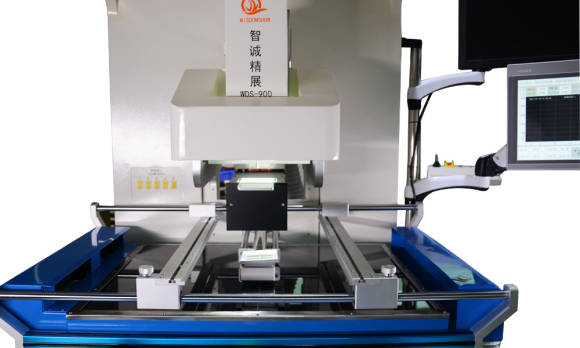

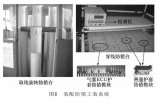
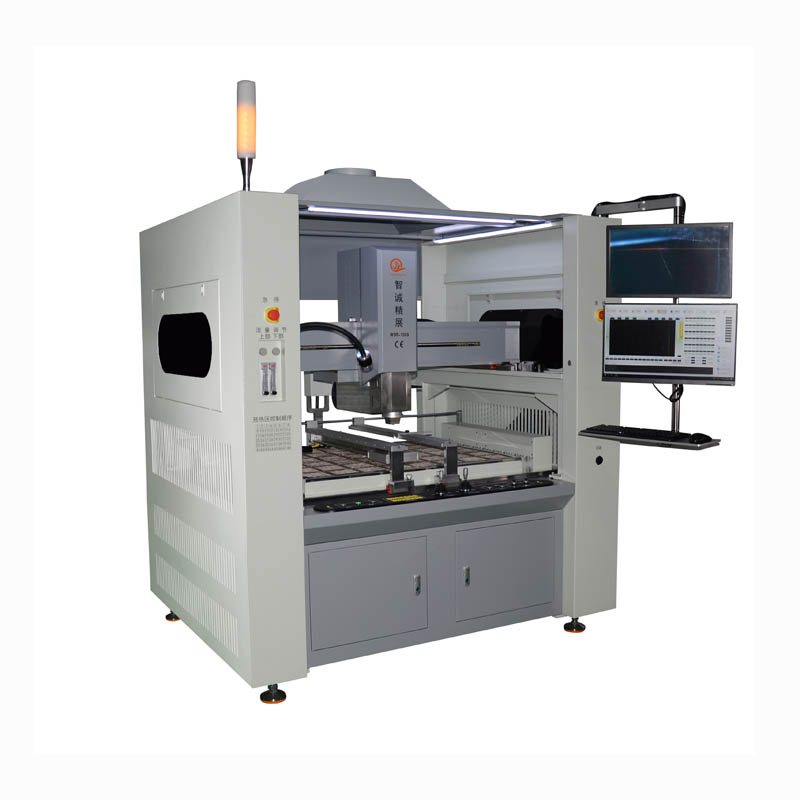

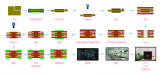


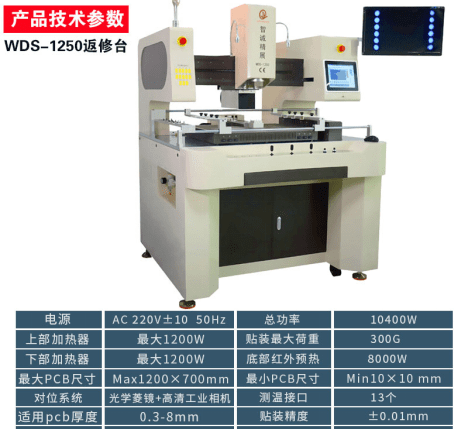
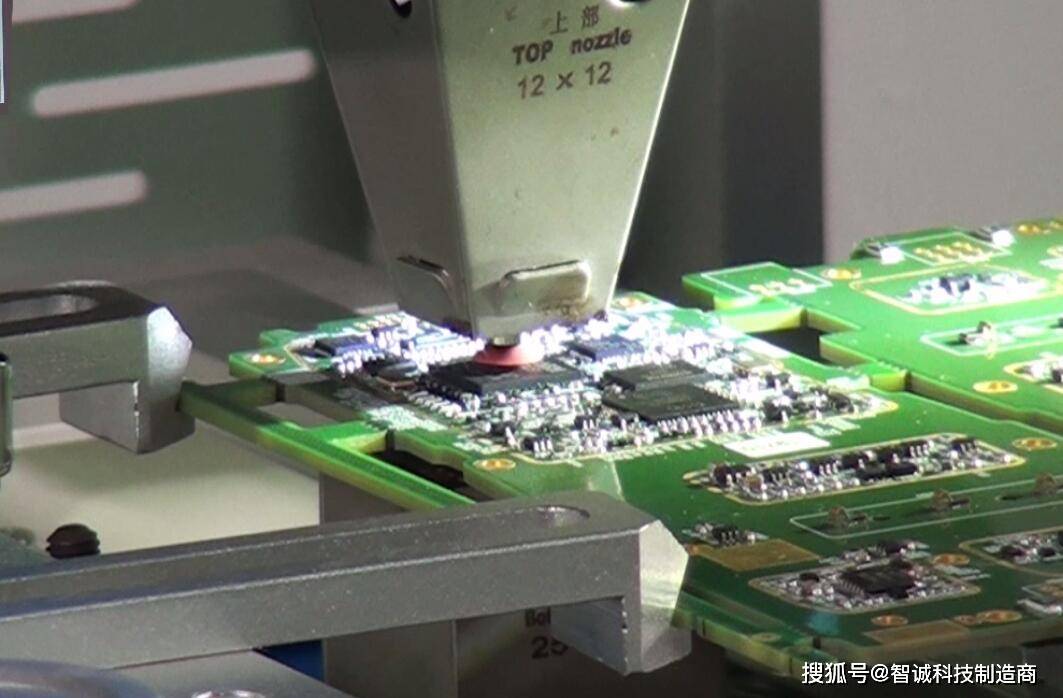
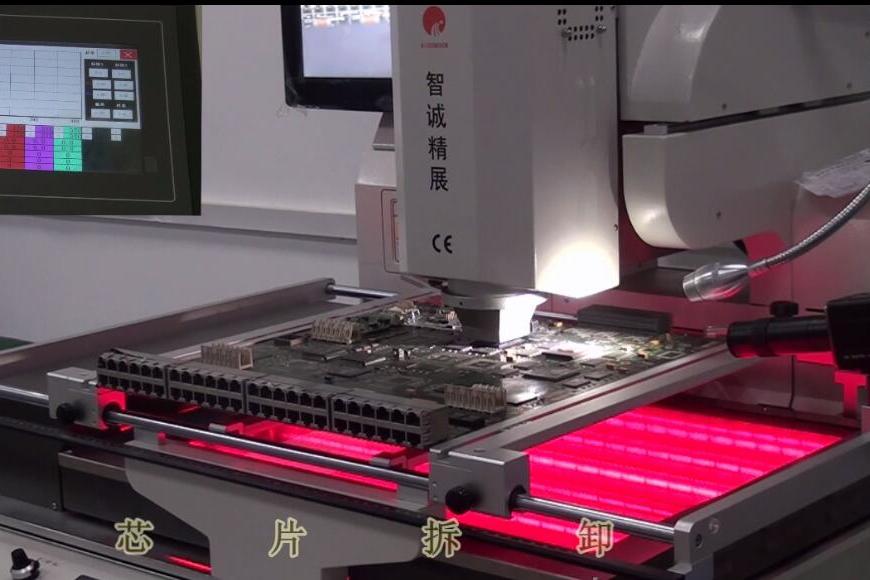
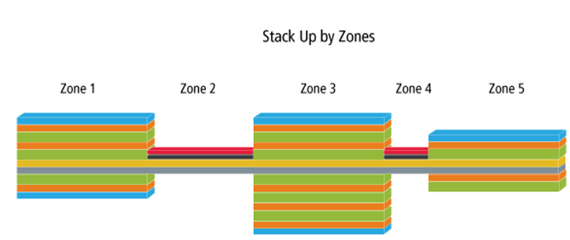










評(píng)論